

光刻各环节对应的不同模型种类
制造/封装
描述
在上一节计算光学小讲堂中,我们学习了光刻可制造性检查(Lithography Manufacture Check,LMC)的相关知识。这一节我们将基于ASML公司的FEM+ (Focus Exposure Matrix modeling) 工具,继续学习计算光刻中的建模,并了解其如何在计算光刻的各环节中,提供版图在工艺窗口下精确的模拟结果。
光刻小讲堂关于计算光刻的前几节课内容大家还记得吗?



而光刻模型则是以上所有光刻仿真方法的基础保障。一个优秀的光刻模型,可以预测工艺窗口下的图形关键尺寸与缺陷热点,大大节省测试流片的周期和成本。并且工艺节点越先进,光刻模型发挥的作用也越大。
随着光刻掩模版上的图形尺寸越来越小,当图形尺寸小于光照波长时,入射光的衍射所带来的光学临近效应也愈发强烈,光刻出的图形和掩模版上的图形也越来越“长得不像”;同时,更小的图形尺寸也意味着更高的模型精度要求。
因此,光刻模型的复杂度随着工艺节点的演进而节节攀升:从最开始excel都可以处理的规则修正表到由数百个参数构成、需要耗费大量算力的的复杂物理化学模型,再进一步进化到深度神经网络模型,不断迭代的光刻模型在持续支持着半导体芯片制造的发展前行。
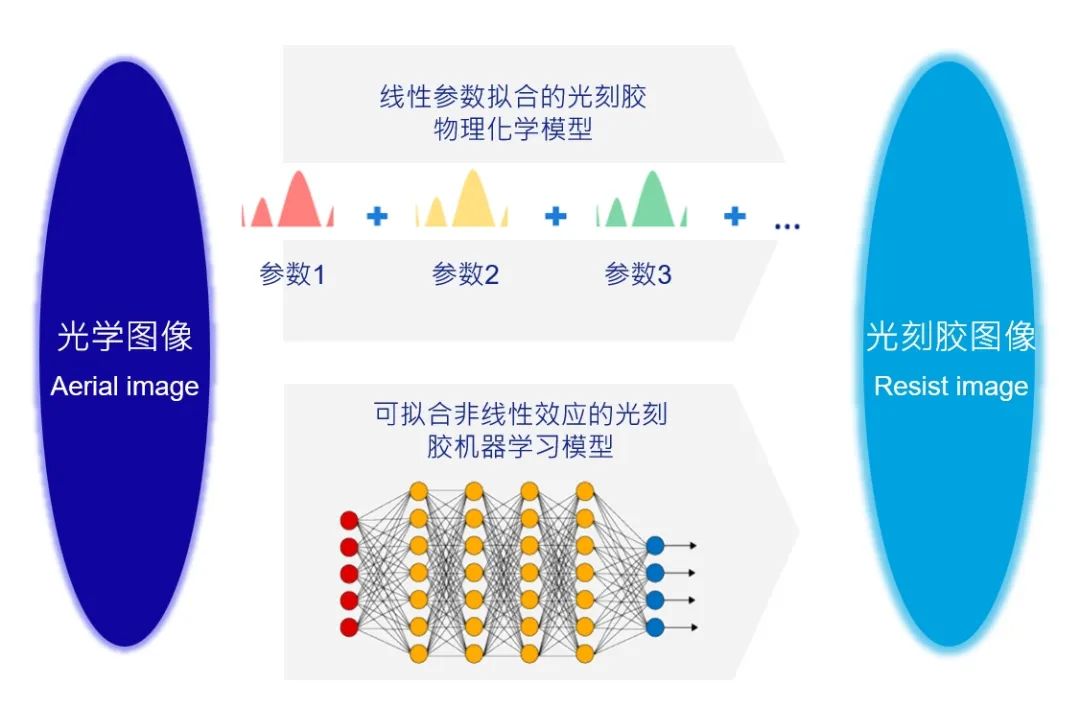
图片2.光刻胶物理化学模型及机器学习模型原理示意
那么
一个优秀的模型需要具备哪些特性呢?
1. 优秀模型特性之——准确性
光刻建模需要涉及到光学、物理、化学、力学等多学科,覆盖了光刻的各个环节。

图片3. 光刻各环节对应的不同模型种类
1.1 掩模模型(Mask Model)
光刻是将掩模版上的图案,通过曝光、显影、刻蚀等一系列工艺,转移到晶圆上的技术,可简单分为光学、化学两大模块。在进行模拟之前,我们首先要确认,进入光刻系统的掩模图案,就是设计版图上的图形吗?
其实不然。由于在掩模制作过程中电子束直写条件的限制,我们需要对掩模图案的几何形状做一些优化,比如将直角改成圆角。对于先进节点,实际光刻系统中的掩模不能再被简化成为非黑即白的二维图形。
因此,在FEM+中的三维掩模模块中,我们针对掩模的三维层状结构,依据光源产生的不同入射角度,对光的近场分布进行计算,再对掩模图案进行处理,得到实际的掩模成像。
在一些情况下,我们还需要进一步考虑掩模版边与边之间散射光的相互作用,进一步优化掩模图案,从而得到更精确的计算结果。
1.2 光学模型(Optical Model)
光学模型是基于霍普金斯(Hopkins)光学成像理论,预先计算出透射相交系数(TCCs),从而描述***的光学成像。光学模型中,经过优化的光源,通过***的照明系统,照射在掩模上。如果在实际光刻中,入射光的波长大于掩模线宽,成像效果由衍射效应主导,一些衍射级次通过了一定数值孔径的投影系统入射光瞳,再在晶圆上成像。前面得到的掩模像经过光学模型计算,就得到了掩模图案的空间像。
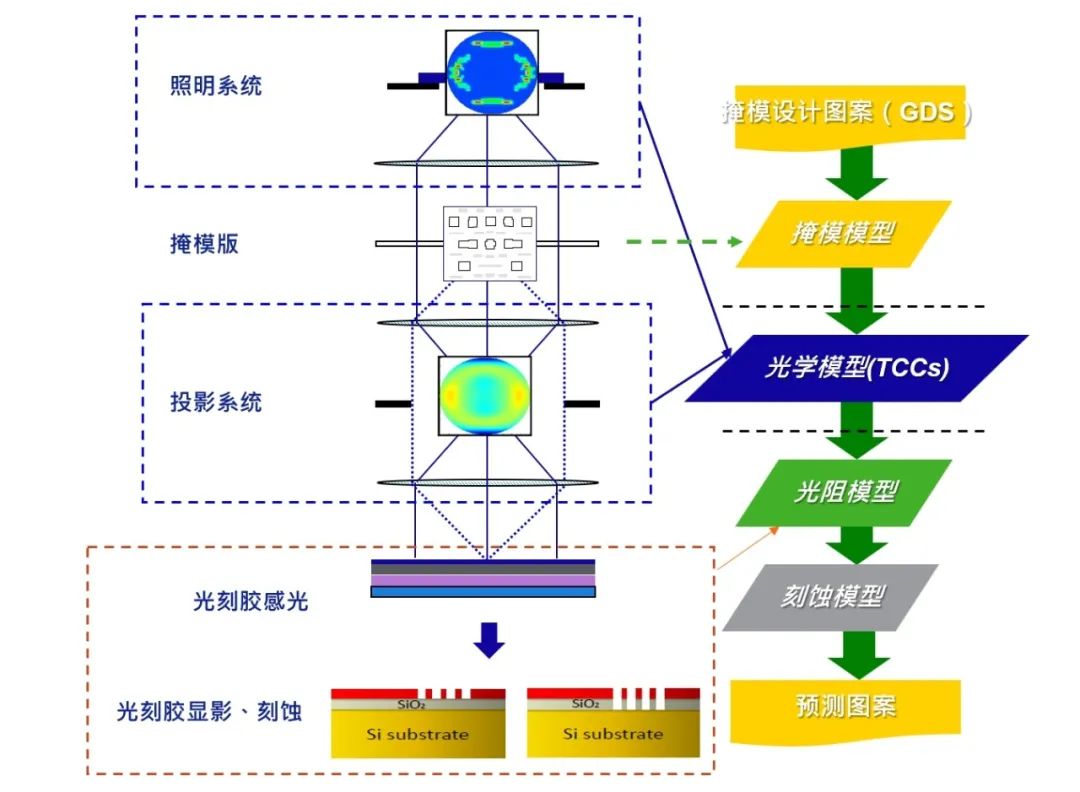
图片5. 光学模型在光刻环节中的位置示意
1.3 光阻模型(Resist model)
接下来的光刻过程,就要交给光阻模型接棒。光阻模型就像一道桥梁,用一系列参数对光刻过程中光刻胶的变化进行模拟,将光学成像和显影后的光刻胶图形联系起来。
光刻胶是一种感光材料,在晶圆进入***曝光之前,就需要首先旋涂上光刻胶。当图像投影在光刻胶上后,就会激发光刻胶的化学反应,在胶内形成与图像明暗强度相对应的光酸、光碱分布。
曝光完成后,会进行后烘,使曝光期间产生的化学产物进一步反应、扩散,达到在一定曝光剂量下加速显影、减小驻波效应的目的。
在接下来的显影过程中,显影液将部分光刻胶溶解带走,晶圆上残留光刻胶的形状就是我们想要的显影后图形。在显影过程中,曝光产物的化学浓度同局部显影速率直接相关,显影速率与显影时间积分,就可计算出显影后的光刻胶厚度。
1.4 刻蚀模型(AEI model)
在更进一步的刻蚀过程中,光刻胶的图案会被转移到最终的晶圆上,刻蚀的物理化学过程也很复杂,FEM+中的刻蚀模型可以用来模拟从显影后的图形到刻蚀后图形的过程。
//
///
将上述的几个子模型结合起来,构成一个从版图设计图形到光刻胶显影后图形或者刻蚀图形的模型,才能应用在计算光刻中。
在建模的过程中,首先需要我们提前确定包括***型号、光源形状、偏振、掩模版结构、光刻胶膜系结构等各种参数。除此之外,还会引入大量待校正的参数。
我们会先设计出一块测试掩模版,涵盖设计版图中的关键特征尺寸、结构,进行曝光。通过收集晶圆上的关键线宽数据以及光刻胶形状轮廓,来校正模型里的参数,使之计算出的结果和实验尽量吻合。
2. 优秀模型特性之——可外延性
我们考虑了光刻环节的方方面面,竭尽所能提升光刻模型的拟合精度,但不要忘了,提高模型的预测能力也必不可少。
一个优秀的模型可以基于简单的测试掩模版尺寸数据,预测实际设计中更加复杂的图形尺寸;也可以在有限的工艺窗口采样数据下,拥有足以覆盖工艺窗口的预测能力。

图片6. 模型预测能力示意
基于此,前文所述的测试曝光中,不仅要有曝光计量-聚焦深度标准状态下的数据,还需要特意调整曝光计量和焦距,得到工艺窗口状态下的数据,将这些数据都拿进模型拟合。
3. 优秀模型特性之——算力友好
模型中那么多参数,要拟合那么多量测数据,算力友好的重要性不言而喻。ASML的FEM+中的基因遗传算法,可以将量测数据分布式计算,在大规模参数搜寻范围内能快速收敛。基于神经网络的机器学习模型更是支持更大量的拟合数据,并有更强大的拟合能力。 综上所述,光刻模型是计算光刻中的核心,为其他计算光刻环节的准确性保驾护航。光刻模型涉及到算法、光学、物理、化学等多方面学科,是现代光刻技术的集大成者,推动着芯片制造不断发展。
今年,计算光刻小讲堂从光源掩模协同优化、光学邻近效应修正、光刻可制造性检查和光刻建模等工具出发,系统地为大家介绍了计算光刻的基本原理和具体过程,以期帮助小伙伴们对计算光刻建立框架性的认识,初步了解其在光刻环节中的重要性和在ASML全景光刻中的角色。
审核编辑:黄飞
-
光刻技术原理及应用2012-01-12 0
-
PSPICE 生成的模型和datasheet对应不上2012-04-23 0
-
光刻及资料分享—Optical Lithography2014-09-26 0
-
光刻胶2018-07-12 0
-
光刻机工艺的原理及设备2020-07-07 0
-
光刻工艺步骤2021-01-12 0
-
MRAS模型和可调模型参考2021-08-27 0
-
国科大《集成电路先进光刻技术与版图设计优化》课程分享之二:浸没式光刻工艺缺陷种类、特征及自识别方法2021-10-14 0
-
OSI模型与TCP/IP协议的对应关系OSI模型与TCP/I2009-06-09 6901
-
光刻技术的基本原理!光刻技术的种类光学光刻2019-01-02 24284
-
芯片制作环节光刻的详细流程详解2019-04-20 10145
-
关于光刻的原理、光刻设备等知识点集合2021-10-13 3994
-
电子电路仿真基础:SPICE模型的种类2023-02-14 1378
-
光刻技术的种类介绍2023-04-25 1324
-
光刻胶黏度如何测量?光刻胶需要稀释吗?2023-11-13 702
全部0条评论

快来发表一下你的评论吧 !

