

英特尔宣布完成PowerVia背面供电技术的开发
描述
英特尔在2023年国际电子设备制造大会上宣布,他们已经成功完成了一项名为PowerVia的背面供电技术的开发。这个技术是基于英特尔的最新晶体管研究成果,它实现了互补金属氧化物半导体场效应晶体管(CFET)的60纳米栅极间距垂直堆叠。通过堆叠晶体管,该技术提高了面积效率和性能,同时还结合了背面供电和直接背面接触这两种技术。
英特尔解释说,过去几年芯片制造都是层层叠加的,从最小的元件-晶体管开始制造,之后需要创建更小的线路层,用于连接晶体管和金属层。这些线路被称为信号互连线,其中还包括用于给晶体管供电的电源线等。但是随着晶体管逐渐变小、密度日益提高,互连线和电源线共享的线路层变得越来越混乱。面对这个问题,英特尔开始寻找将电源线迁移到芯片背面的背面供电技术。
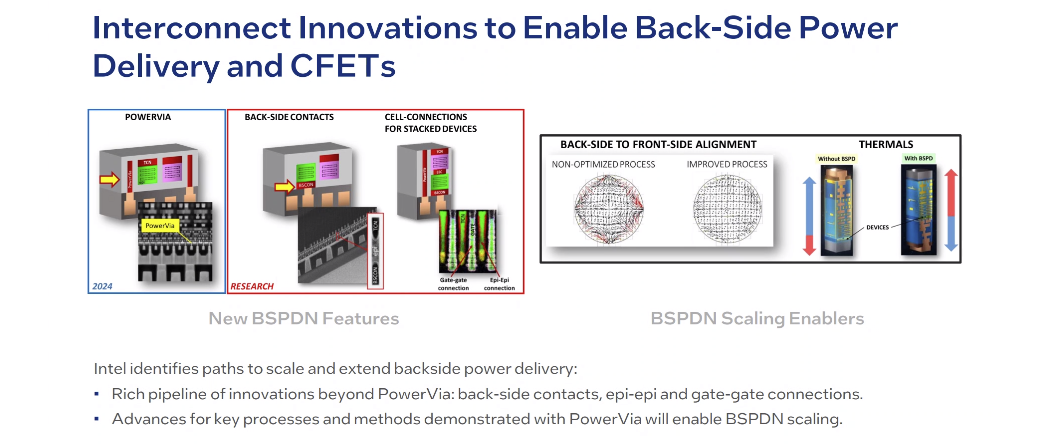
英特尔的背面供电解决方案PowerVia已经产生了具有竞争力的测试结果。这项技术解决了传统"披萨式"制造方法带来的问题,尤其是电源线和互连线的分离以及线径的扩大,从而改进了供电和信号的传输。

对于英特尔的晶体管堆叠和背面供电的技术,研究表明,它将在微缩晶体管的密度上发挥重要作用。英特尔强调,这将超越其"四年五个制程节点计划",以背面供电技术继续微缩晶体管。
目前,英特尔的这项技术在竞争对手中具有一定的优势。比如台积电将在2025年量产的第一代2纳米制程时引入全环绕栅极(GAA)架构,然后在2026年的第二代2纳米制程中引入背面供电技术。与此同时,尽管韩国三星在2022年量产的3纳米制程技术上已经引入了GAA架构,但是他们预计要到2025年量产的2纳米制程才会引入背面供电技术。从这个角度来看,英特尔确实领先了一步。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
#高通 #英特尔 #Elite 高通X Elite芯片或终结苹果、英特尔的芯片王朝深圳市浮思特科技有限公司 2023-10-27
-
英特尔将在2014年推出14纳米处理器芯片2011-12-05 0
-
苹果微软AMD抛弃英特尔加入ARM阵营2012-11-06 0
-
如何在您的英特尔® Edison 开发板上更新(刷新)固件2016-06-15 0
-
【AD新闻】英特尔解读全球晶体管密度最高的制程工艺2017-09-22 0
-
采用MMX技术的英特尔奔腾和奔腾2019-02-26 0
-
为什么选择加入英特尔?2019-07-25 0
-
英特尔的十款嵌入式智能处理器2019-07-29 0
-
苹果Mac弃用英特尔芯片的原因2020-06-23 0
-
英特尔重点发布oneAPI v1.0,异构编程器到底是什么2020-10-26 0
-
英特尔重新思考解决芯片短缺的常用基板2022-06-20 0
-
英特尔PowerVia技术率先实现芯片背面供电,突破互连瓶颈2023-06-06 367
-
王炸,英特尔PowerVia芯片背面供电即将量产,遥遥领先三星和台积电2023-06-07 737
-
英特尔在芯片中实现背面供电2023-06-20 385
全部0条评论

快来发表一下你的评论吧 !

