

电感耦合等离子刻蚀
电子说
描述
引言
众所周知,化合物半导体中不同的原子比对材料的蚀刻特性有很大的影响。为了对蚀刻速率和表面形态的精确控制,通过使用低至25nm的薄器件阻挡层的,从而增加了制造的复杂性。本研究对比了三氯化硼与氯气的偏置功率,以及气体比对等离子体腐蚀高铝含量AlGaN与AlN在蚀刻速率、选择性和表面形貌方面的影响。
蚀刻速率受偏置功率和气体化学性质的影响很大。英思特详细说明了AlGaN的Al组成的微小变化的影响,并显示了与AlN相比,相对于偏置功率的蚀刻速率的显著变化。
实验与讨论
本研究采用金属有机化学气相沉积(MOCVD)培养了三种不同的样品,包括Al0.71Ga0.29N、Al0.85Ga0.15N和AlN。所有三个样品都在1.3mm厚的蓝宝石基板上的AlN缓冲层上生长。为了评估偏置功率对蚀刻速率和表面形貌的影响,在腔室压力(3mTorr)、ICP功率(125W)和气体流量(20%三氯化硼+5sccmAr)的条件下,将偏置功率从10W扫到100W。
图1显示了所有三种成分的蚀刻速率。我们观察到随着蚀刻率的线性增加,Al0.71Ga0.29N组成的调查偏差功率为100W。然而,Al0.85Ga0.15N和AlN蚀刻率呈现非线性趋势,即使在较低偏置功率下,都显示接近饱和蚀刻率100W偏置功率。
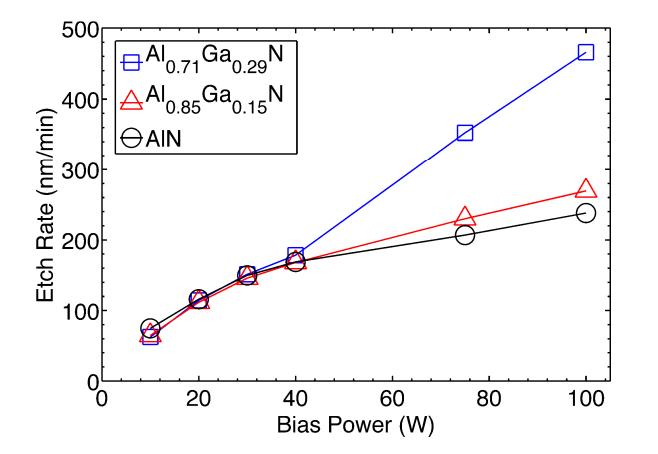 图1:偏置功率对蚀刻率的影响
图1:偏置功率对蚀刻率的影响
如图2所示,与Al0.85Ga0.15N和AlN相比,Al0.71Ga0.29N对偏压功率表面粗糙度的响应显示出不同的趋势,其类似于图1中显示出的不同趋势的蚀刻速率。与Al0.71Ga0.29N相比,Al0.85Ga0.15N和AlN在10W至20W范围内表现出更大的表面粗糙度,在更低的偏置功率下过渡到更光滑的表面。
随着Al含量的降低,这种蚀刻机制的平衡得到改善,并且与较高的含Al成分相比,在低偏压下会导致较低的表面粗糙度。总的来说,对于后处理制造来说,30W以上的所有三种组合物的亚纳米表面粗糙度都是可接受的。
结论
英思特实验发现,当保持压力、ICP功率和总气体流量不变时,Al0.71Ga0.29N的蚀刻速率在高达100 W的偏压功率下呈现线性趋势,而Al0.85Ga0.15N和AlN都呈现接近饱和的非线性蚀刻速率。其结果表明,即使Al的含量发生微小变化,也会导致显著的蚀刻速率和表面形态趋势。
同样,所研究的较低Al含量,Al0.71Ga0.29N,随着BCl3与Cl2比率的变化,显示出对表面形态的不同响应。此外,对于高Cl2含量的等离子体蚀刻,其表面氧化导致蚀刻速率的显著降低以及表面粗糙度的增加。
审核编辑 黄宇
-
等离子适合什么环境?2009-05-24 0
-
等离子体应用2022-05-18 0
-
电感耦合等离子体质朴分析的应用2017-02-07 806
-
中微推出电感耦合等离子体刻蚀设备用于批量生产存储芯片和逻辑芯片前道工序2018-04-18 2118
-
中微自研5纳米等离子体刻蚀机经台积电验证2018-12-29 4824
-
电感耦合等离子体质谱真空阀门的原理及设计2019-01-14 1426
-
中微发布了第一代电感耦合等离子体刻蚀设备2020-04-22 4162
-
电感耦合等离子体光谱仪的原理和优势2020-05-25 5311
-
电感耦合等离子体原子发射光谱仪简介2021-09-23 4049
-
如何对氮化镓基发光二极管结构进行干法刻蚀2022-04-26 1878
-
半导体制造之等离子工艺2022-11-15 2776
-
ICP-MS6880电感耦合等离子体质谱仪测定水中16种元素的应用方案2022-11-18 536
-
ICP刻蚀氮化镓基LED结构的研究2023-02-22 260
-
真空等离子清洗机的制造商正在引入氧和氢等离子体来蚀刻石墨烯2022-06-21 448
-
干法刻蚀常用设备的原理及结构2024-01-20 1819
全部0条评论

快来发表一下你的评论吧 !

