

浅谈BGA的封装类型
描述
BGA(Ball grid array,球栅阵列或焊球阵列),它是一种高密度表面装配封装技术,在封装底部,引脚都成球状并排列成一个类似于格子的图案,由此命名为BGA。
目前主板控制芯片组多采用此类封装技术,材料多为陶瓷。采用BGA技术封装的内存,可以使内存在体积不变的情况下,内存容量提高两到三倍。
随着3C电子产品越来越来向轻薄化发展,PCB主板及电子元器件包括BGA芯片也就必须向着高密、薄化设计发展,在SMT工艺质量控制相当成熟的今天,BGA的焊接一直是重要关注的环节;一个OEM代工电子厂的制程能力,在很大程度上取决于BGA的焊接水平。
电子行业的特点是:元件功能在不断的升级换代,电子产品的性能越来越强大,而外形、体积却越来越小,甚至有的元件采用了更为先进的工艺,这些元件、产品的变化给SMT生产制造不断提出挑战,特别是用在手机、超极本中的CPU芯片,以上特征尤其明显。
BGA的封装类型很多,根据焊料球的排布方式可分为:周边型、交错型和全阵列型。
而根据基板的不同主要分为
PBGA(Plastic BGA,塑封BGA)
CBGA(Ceramic BGA,,陶瓷BGA)
FCBGA(Filpchip BGA,倒装BGA)
TBGA(Tape BGA,载带BGA)
1. PBGA:
PBGA是常用的BGA封装形式,采用塑料材料和塑料工艺制作。其采用的基板类型为PCB基板材料(BT树脂/玻璃层压板),裸芯片经过粘接和WB技术连接到基板顶部及引脚框架后,采用注塑成型(环氧膜塑混合物)方法实现整体塑模。Intel系列CPU中,Pentium II、III、IV处理器均采用这种封装形式。
焊球材料为低熔点共晶焊料合金63Sn37Pb,直径约为1mm,间距范围1.27-2.54mm,焊球与封装体底部的连接不需要另外使用焊料。组装时焊球熔融,与PCB表面焊板接合在一起,呈现桶状。

PBGA封装特点主要表现在以下四方面:
1.制作成本低,性价比高。
2.焊球参与再流焊点形成,共面度要求宽松。
3.与环氧树脂基板热匹配性好,装配至PCB时质量高,性能好。
4.对潮气敏感,PoPCorn effect 严重,可靠性存在隐患,且封装高度之QFP高也是一技术挑战。
2. CBGA:
CBGA是将裸芯片安装在陶瓷多层基板载体顶部表面形成的,金属盖板用密封焊料焊接在基板上,用以保护芯片、引线及焊盘,连接好的封装体经过气密性处理,可提高其可靠性和物理保护性能。Pentium I、II、Pentium Pro处理器均采用过这种封装形式。
CBGA采用的是多层陶瓷布线基板,焊球材料为高熔点90Pb10Sn共晶焊料,焊球和封装体的连接使用低温共晶焊料63Sn37Pb,采用封盖+玻璃气封,属于气密封装范畴。
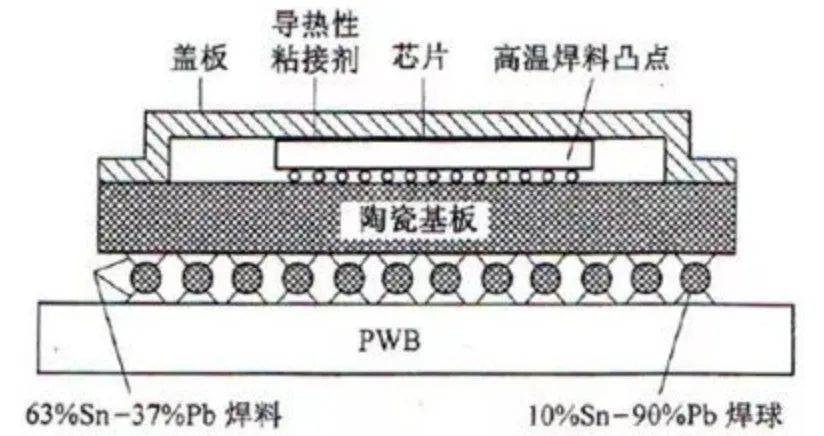
CBGA封装特点主要表现在以下六方面:
1.对湿气不敏感,可靠性好,电、热性能优良。
2.与陶瓷基板CTE匹配性好。
3.连接芯片和元件可返修性较好。
4.裸芯片采用FCB技术,互连密度更高。
5.封装成本较高。
6.与环氧树脂等基板CTE匹配性差。
3. FCBGA
FCBGA是目前图形加速芯片主要的封装格式,这种封装技术始于1960年代,当时IBM为了大型计算机的组装,而开发出了所谓的C4(Controlled Collapse Chip Connection)技术,随后进一步发展成可以利用熔融凸块的表面张力来支撑芯片的重量及控制凸块的高度,并成为倒装技术的发展方向。 这种封装使用小球代替原先采用的针来连接处理器。一共需要使用479个球,且直径均为0.78毫米,能提供短的对外连接距离。FCBGA通过FCB技术与基板实现互连,与PBGA的区别就在于裸芯片面朝下。
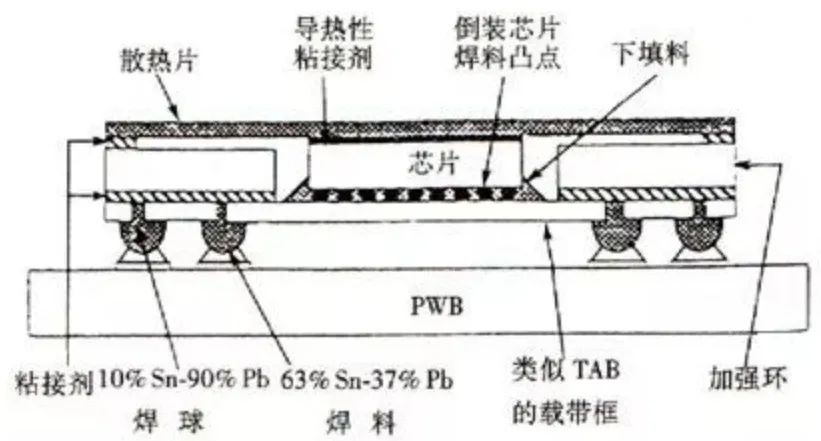
FCBGA封装特点主要表现在以下三方面:
1.优异的电性效能,同时可以减少组件互连间的损耗及电感,降低电磁干扰的问题,并承受较高的频率。
2.提高I/O的密度,提高使用效率,有效缩小基板面积缩小30%至60%。
3.散热性好,可提高芯片在高速运行时的稳定性。
4. TBGA:
TBGA又称阵列载带自动键合,是一种相对较新颖的BGA封装形式。其采用的基板类型是PI多层布线基板,焊料球材料为高熔点焊料合金,焊接时采用低熔点焊料合金。
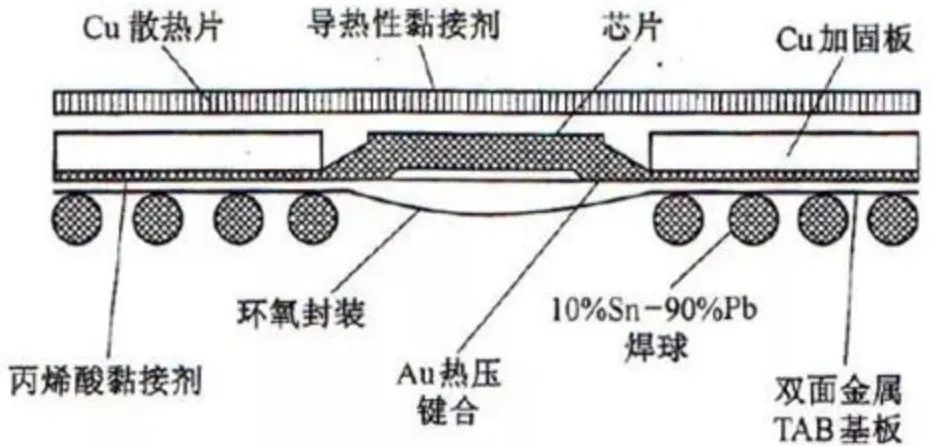
TBGA封装特点主要表现在以下五方面:
1.与环氧树脂PCB基板热匹配性好。
2.薄型BGA封装形式,有利于芯片薄型化。
3.相比于CBGA,成本较低。
4.对热度和湿度,较为敏感。
5.芯片轻且小,相比其他BGA类型,自校准偏差大。
由上面讲的这四类BGA的封装模式可以看出,BGA不仅仅在贴装PCB板上时会使用胶黏剂产品,而且在BGA加工时就已经有应用到胶黏剂产品了。
关于BGA所使用到的胶黏剂下一次给大家做分享吧。
审核编辑:汤梓红
-
BGA——一种封装技术2015-10-21 0
-
如何正确设计BGA封装?BGA设计规则是什么?2021-04-25 0
-
BGA封装是什么?BGA封装技术特点有哪些?2023-04-11 0
-
BGA封装设计及不足2009-11-19 880
-
表面贴片BGA封装,表面贴片BGA封装是什么意思2010-03-04 5674
-
BGA封装的类型和结构原理图2010-03-04 9759
-
半导体封装类型总汇(封装图示)2010-03-04 4465
-
BGA封装类别2019-08-05 6135
-
BGA封装的类型及焊盘设计的基本要求有哪些2020-03-26 17910
-
bga封装是什么意思 BGA封装形式解读2021-12-08 57516
-
使用 BGA 封装2022-11-15 234
-
BGA封装焊盘走线设计及制作工艺,你都知道吗2023-03-24 2884
-
从七种封装类型,看芯片封装发展史2023-07-20 888
-
什么是球栅阵列?BGA封装类型有哪些?2024-02-23 320
-
浅谈BGA、CSP封装中的球窝缺陷2024-04-10 137
全部0条评论

快来发表一下你的评论吧 !

