

芯片倒装Flip Chip封装工艺简介
描述
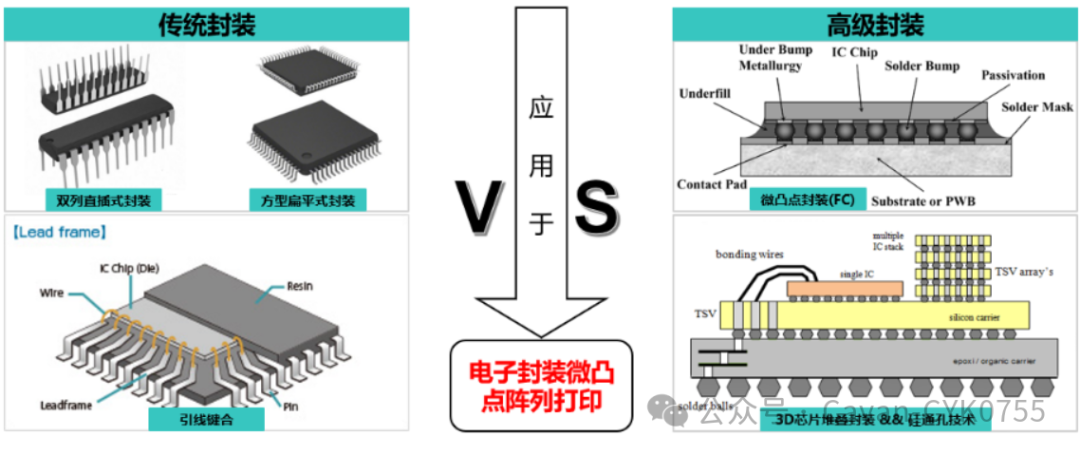 倒装芯片技术,也被称为FC封装技术,是一种先进的集成电路封装技术。在传统封装技术中,芯片被封装在底部,并通过金线连接到封装基板上。而倒装芯片技术则将芯片直接翻转并安装在封装基板上,然后使用微小的焊点或导电胶水进行连接。
倒装芯片技术,也被称为FC封装技术,是一种先进的集成电路封装技术。在传统封装技术中,芯片被封装在底部,并通过金线连接到封装基板上。而倒装芯片技术则将芯片直接翻转并安装在封装基板上,然后使用微小的焊点或导电胶水进行连接。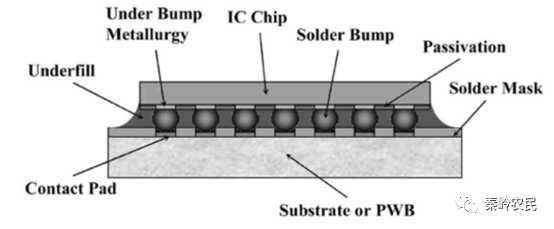 图1 倒装芯片封装基本结构
图1 倒装芯片封装基本结构
倒装芯片技术优势:尺寸更小:相比传统封装技术,倒装芯片技术更加紧凑,可以显著减小电子产品的尺寸和厚度。
电性能更好:倒装芯片技术可以缩短电信号传输距离,减少电阻、电感等不良影响,提高芯片的电性能。
散热更佳:由于芯片直接与封装基板接触,倒装芯片技术可以更好地散热,提高芯片的稳定性和可靠性。
抗冲击性强:倒装芯片技术中的芯片与封装基板紧密结合,具有更高的抗冲击性,对于移动设备和工业应用等领域具有重要意义。成本更低:倒装芯片技术可以简化封装流程,减少所需材料和设备,降低生产成本。倒装芯片技术虽然具有许多优点,但也存在一些潜在的缺点:
设计困难:倒装芯片技术需要在设计阶段考虑封装布局和连接方式,这增加了设计复杂性和挑战性。芯片和封装基板之间的连接方式需要精确控制,以确保可靠性和稳定性。
成本较高:倒装芯片技术在生产过程中需要更高级别的设备和技术,以确保倒装芯片的准确安装和连接。这可能导致制造成本的增加,尤其对于规模较小的生产批量而言。
散热管理挑战:倒装芯片技术中,翻转的芯片直接与封装基板接触,散热困难较大。由于倒装芯片的背面无法自由散热,需要采取额外的散热措施来保持芯片的温度稳定,否则可能出现过热的问题。
机械脆弱性:由于倒装芯片技术中芯片直接暴露在外,容易受到机械应力和物理损伤的影响。这可能导致芯片的可靠性和寿命下降,特别是在受到震动、冲击和弯曲等力量作用时。
可维修性差:倒装芯片技术中,芯片直接连接在封装基板上,一旦出现故障,更换或维修芯片将更加困难。这可能导致维修成本的增加,并且对于一些应用场景可能带来挑战。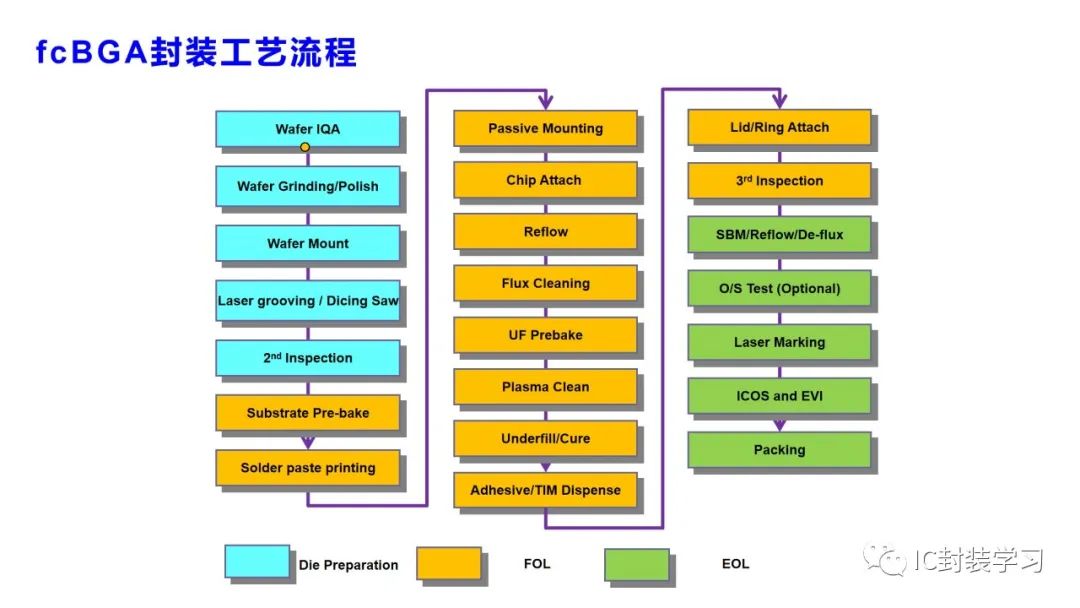


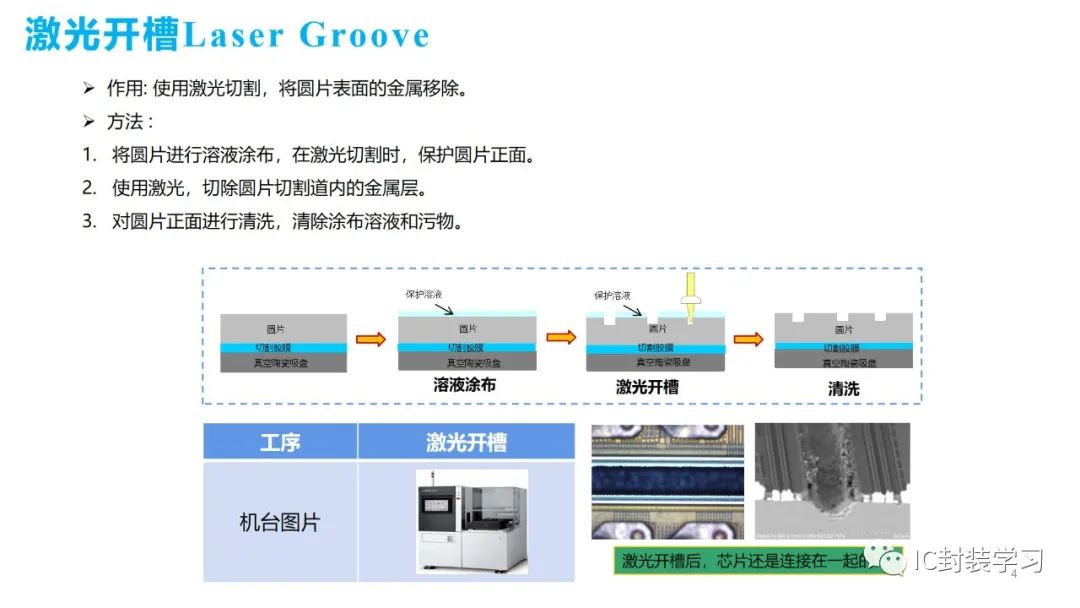
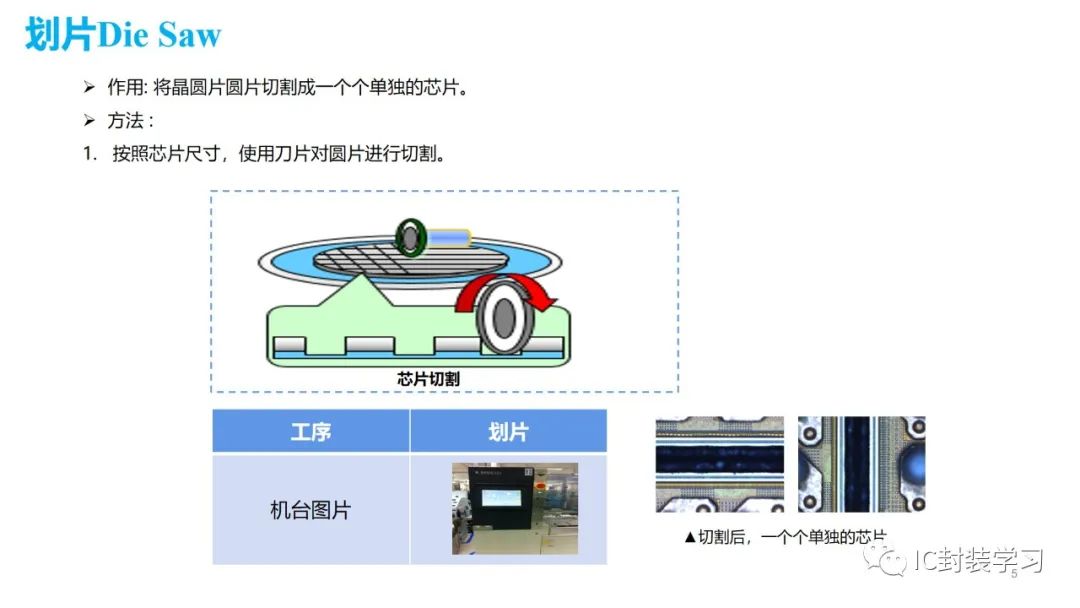
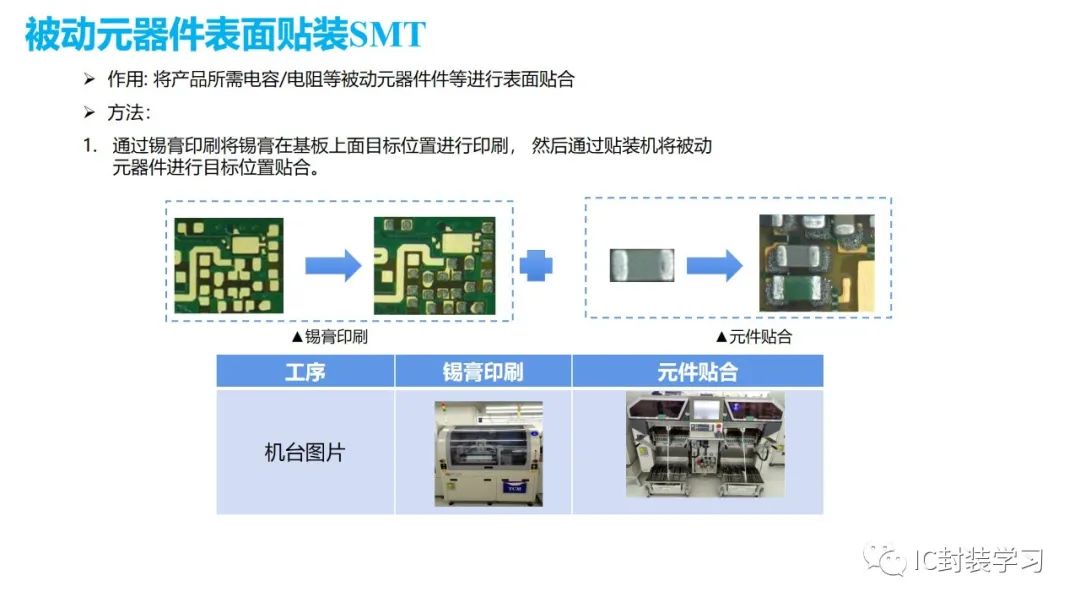
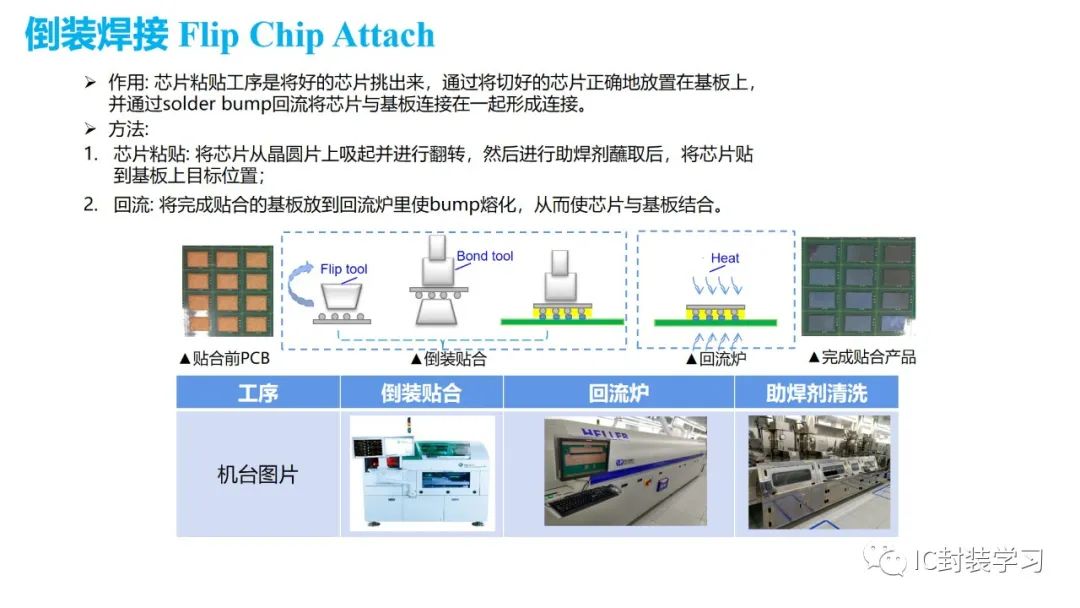
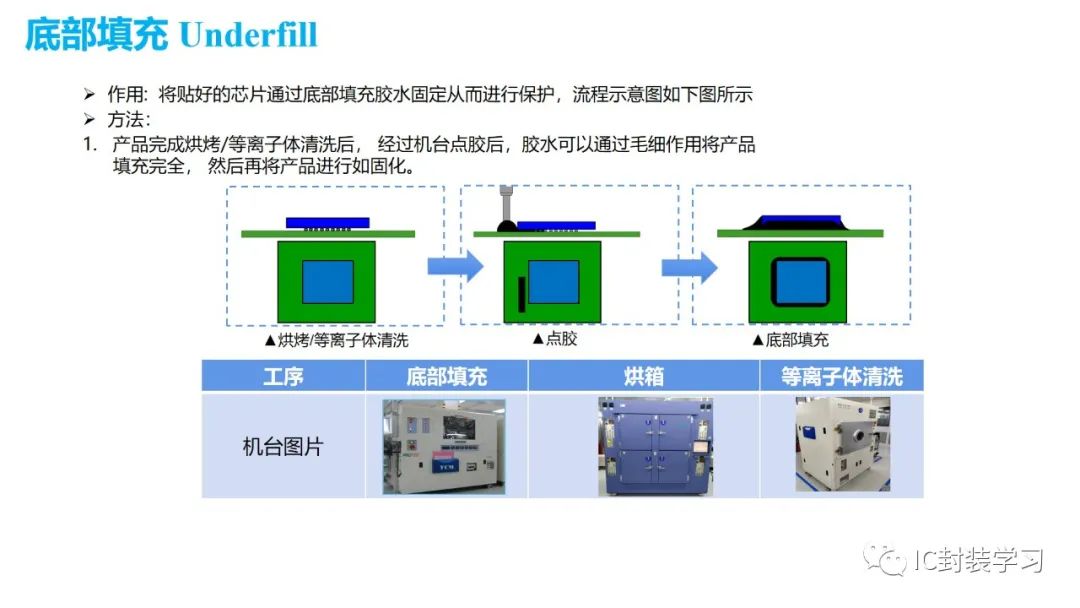
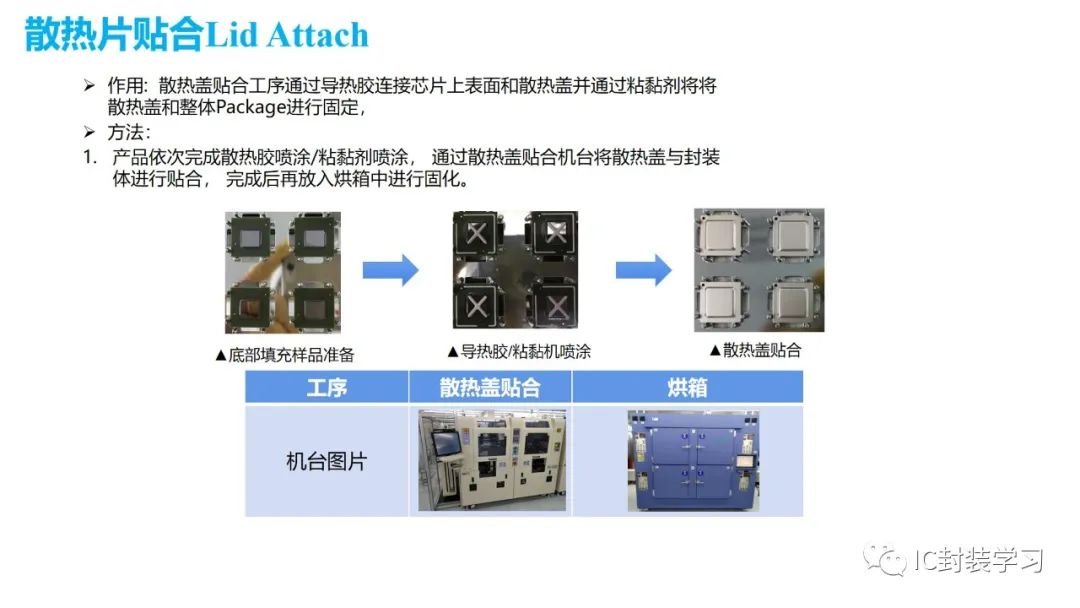
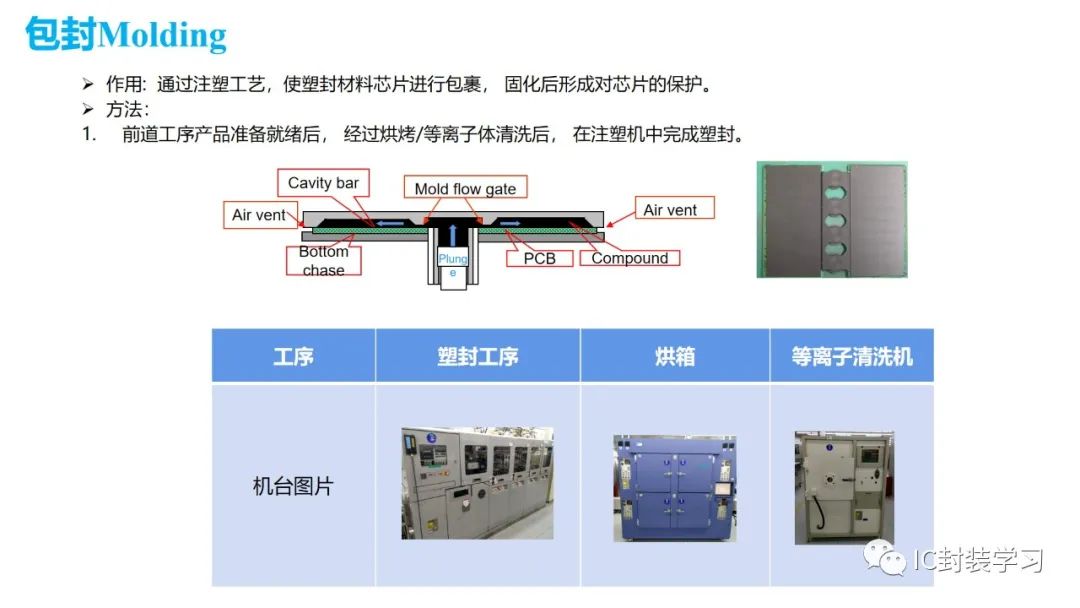
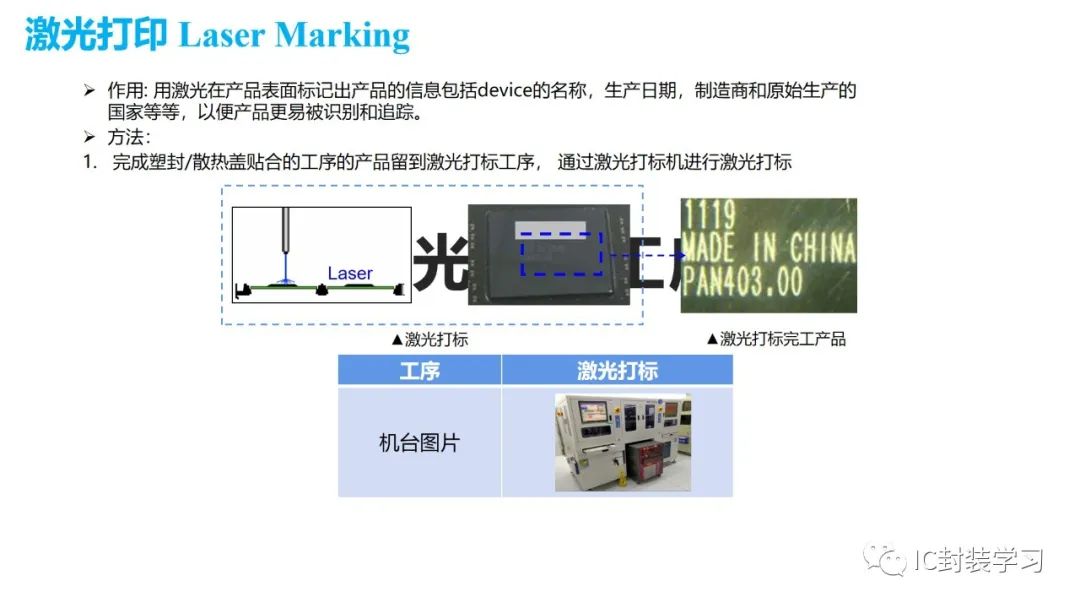
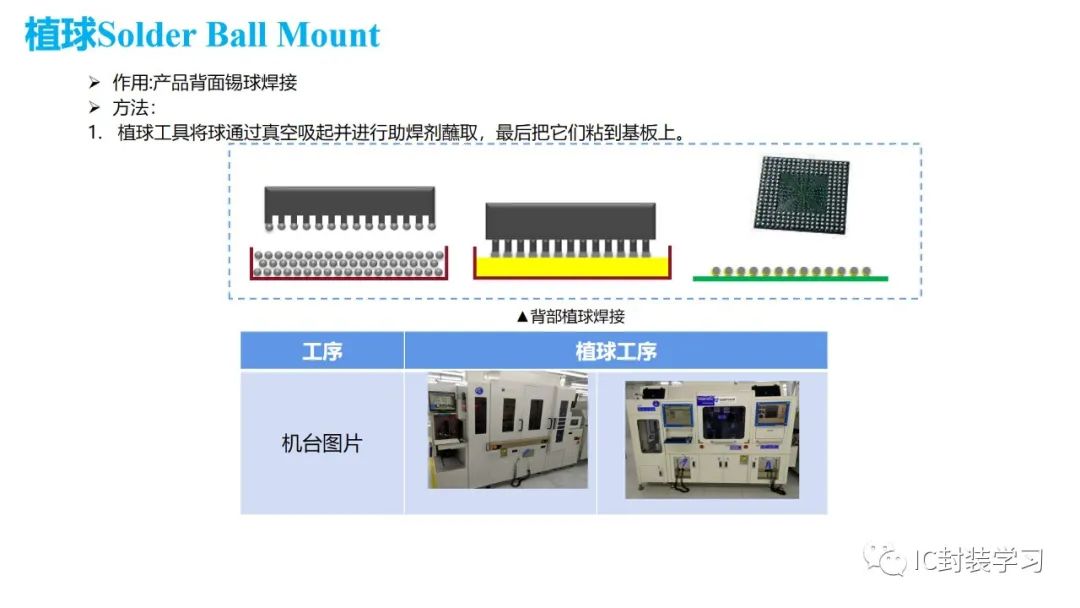

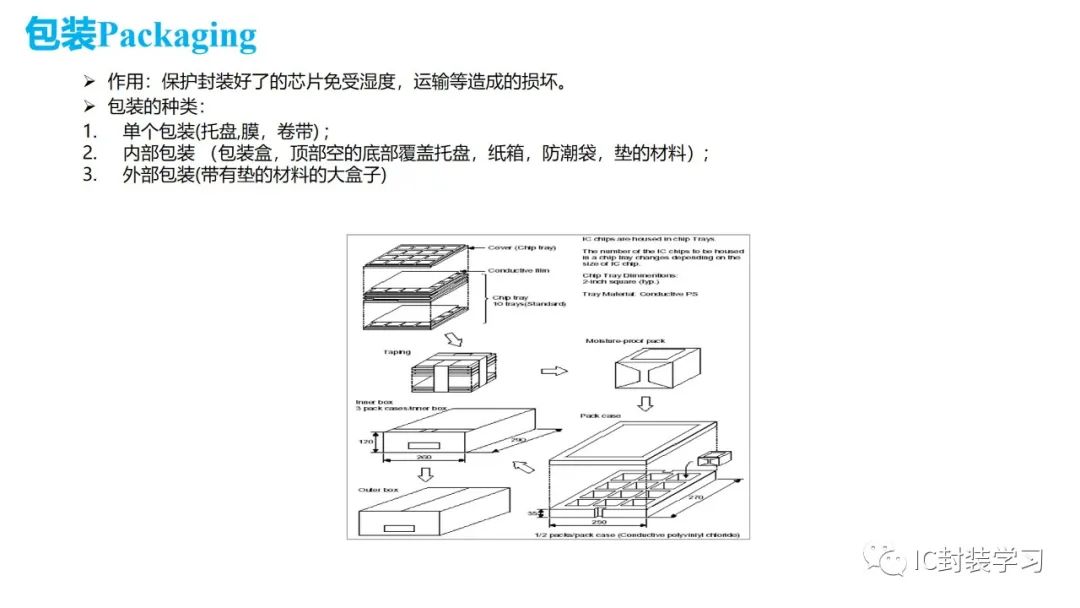
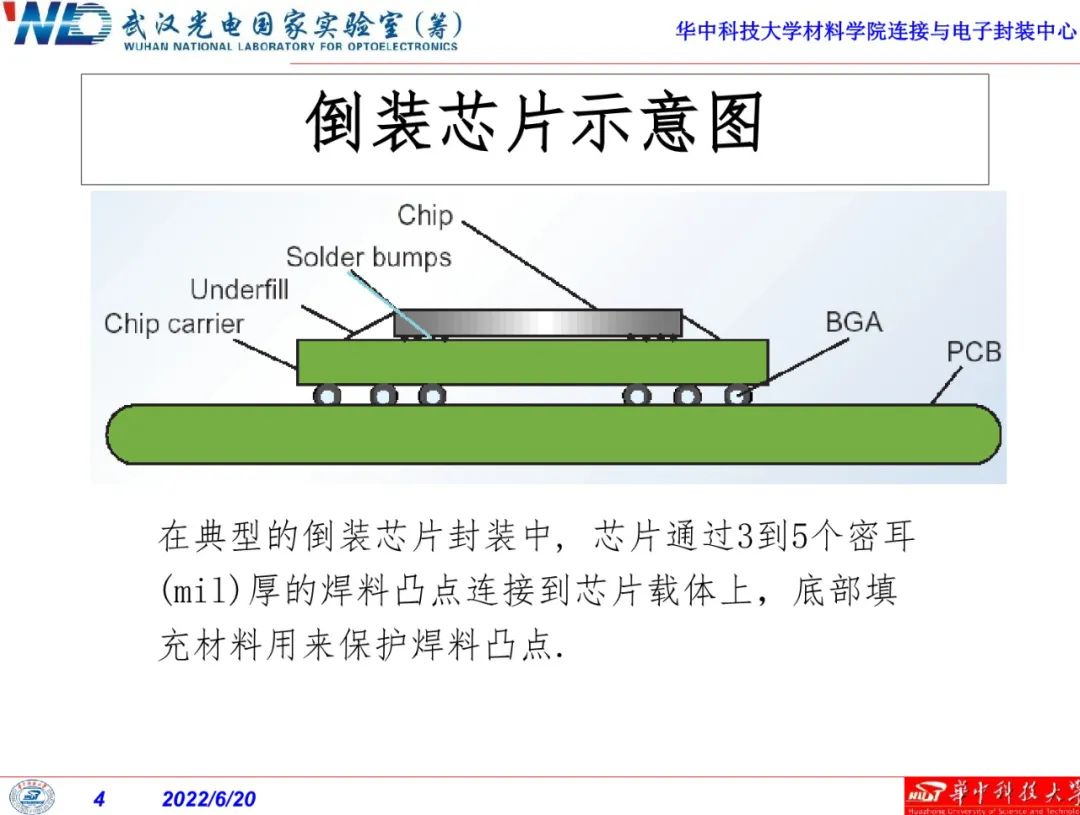












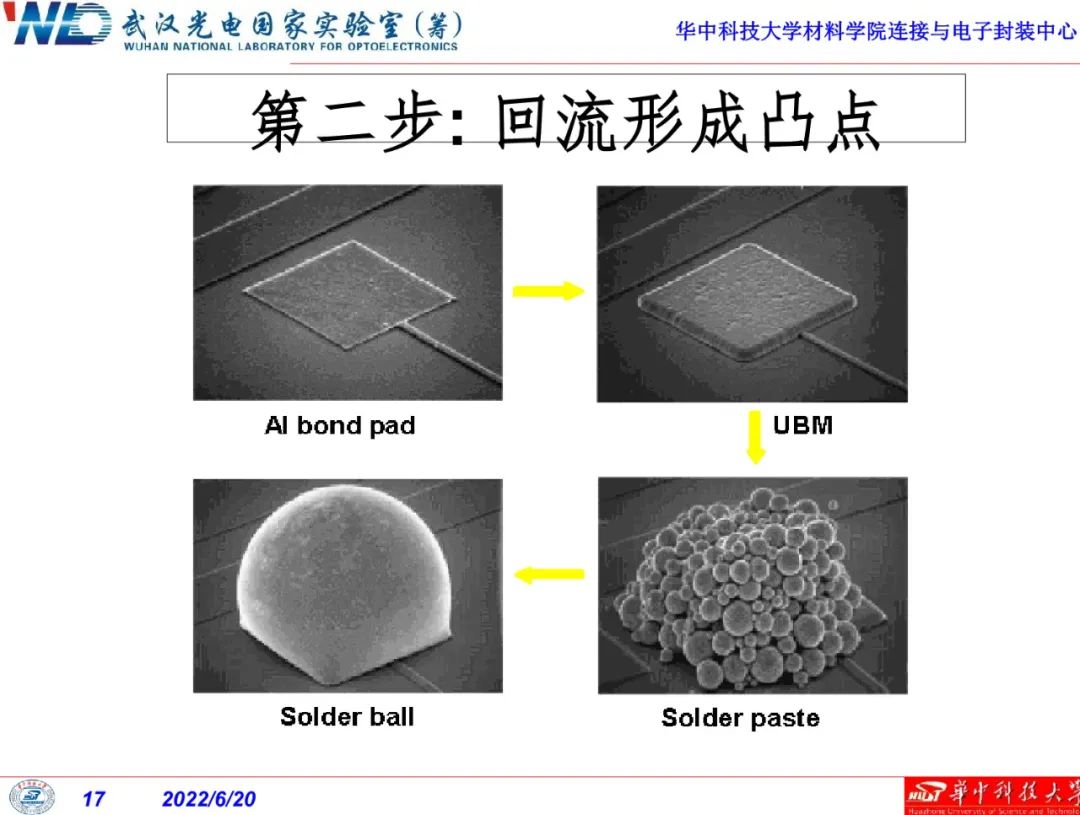
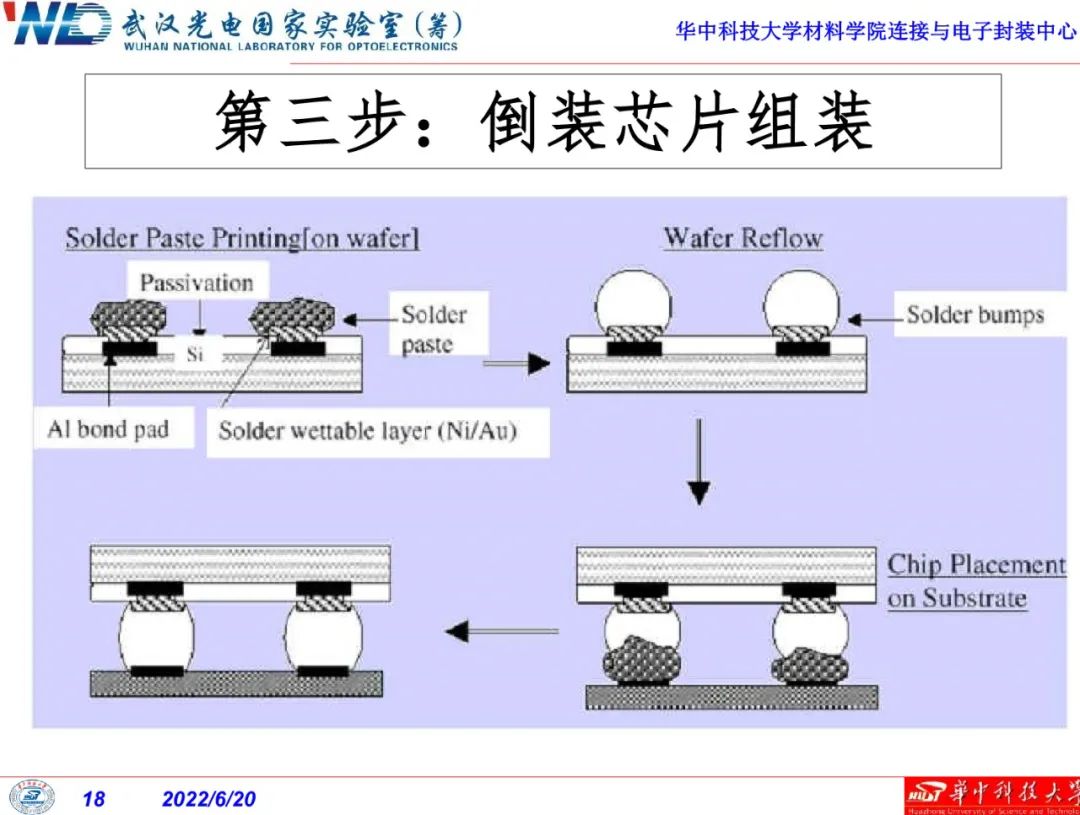
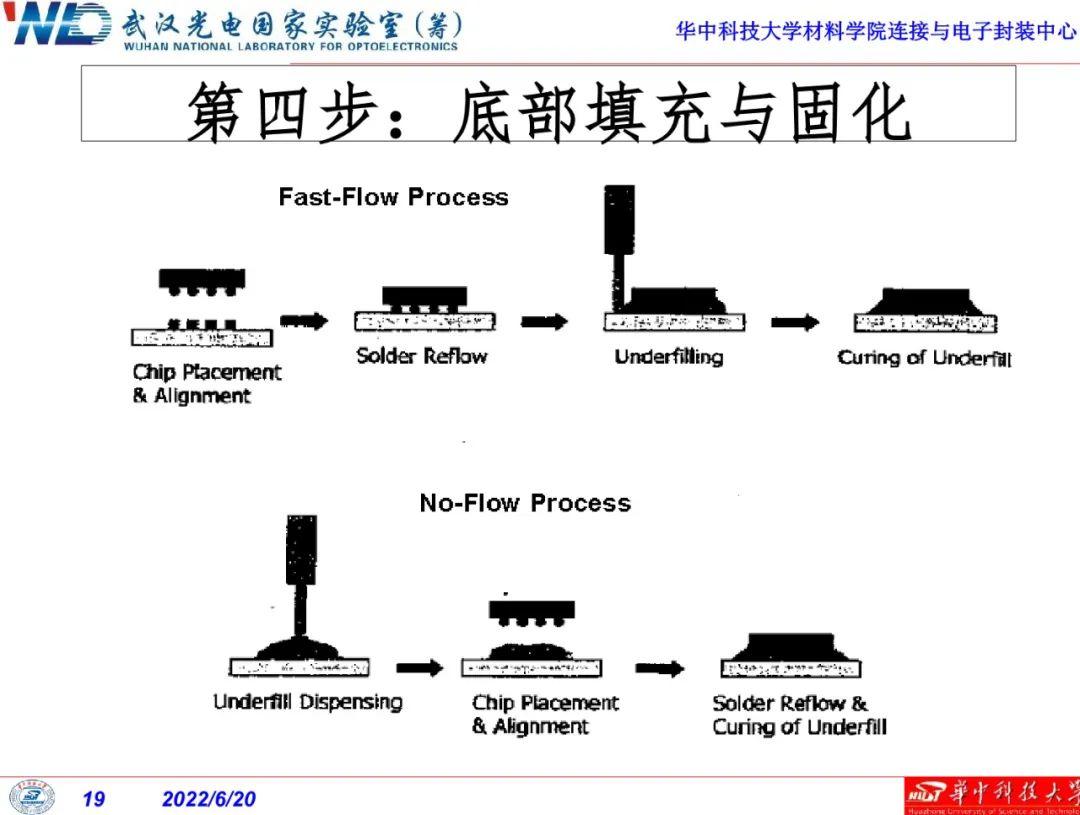
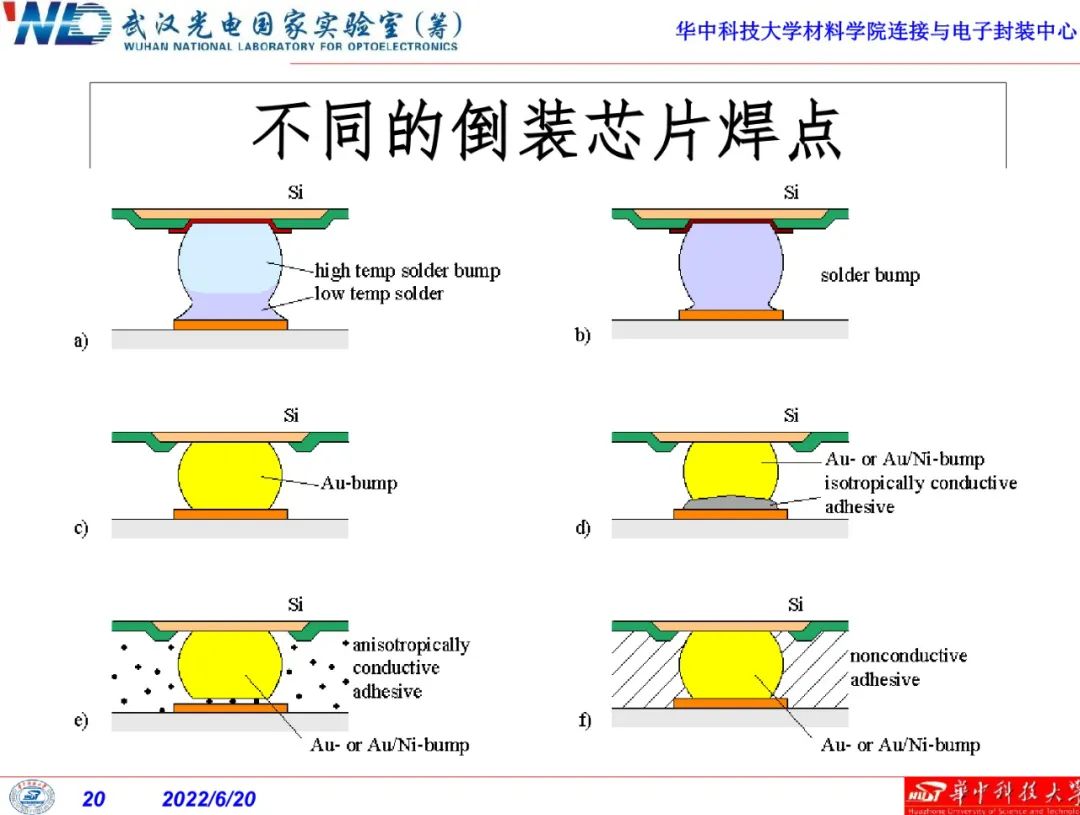
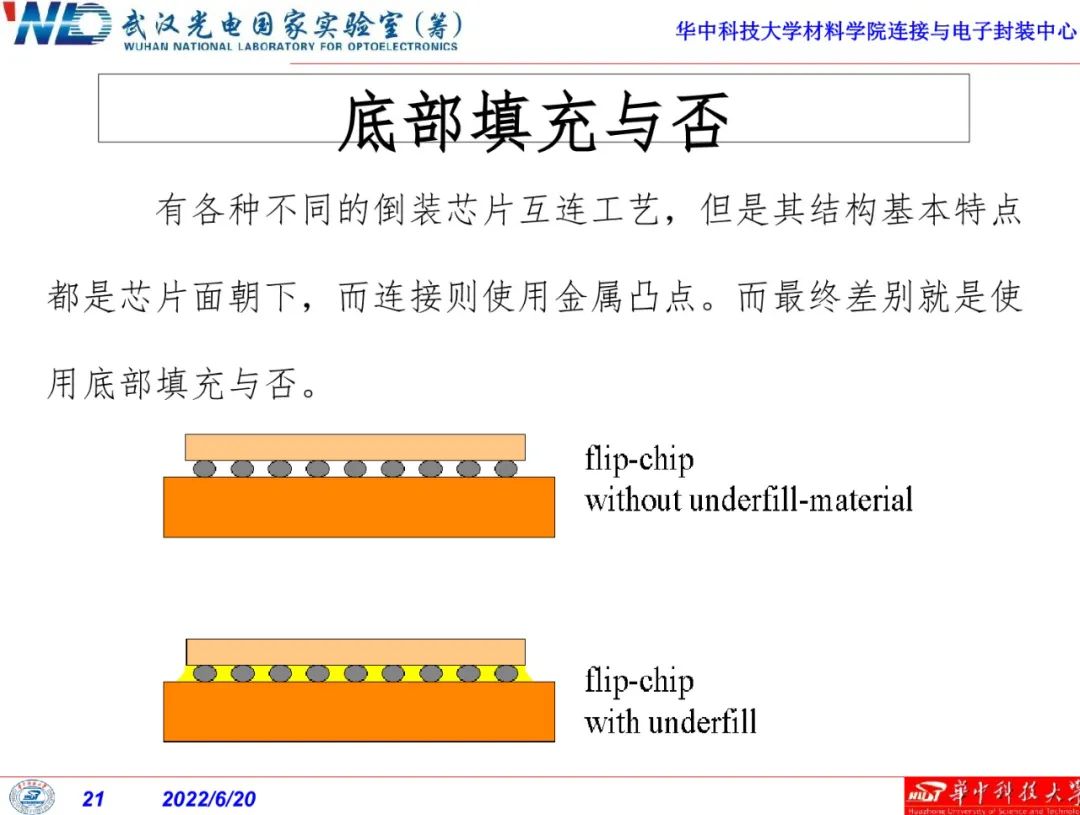






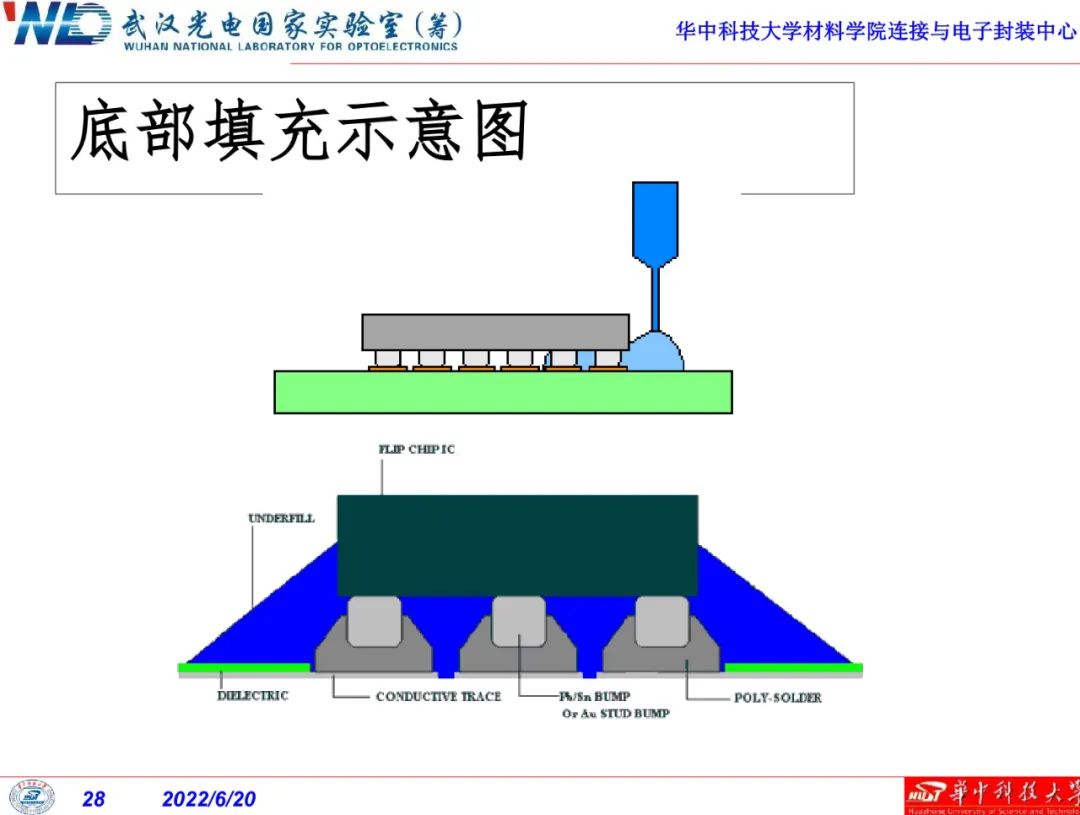

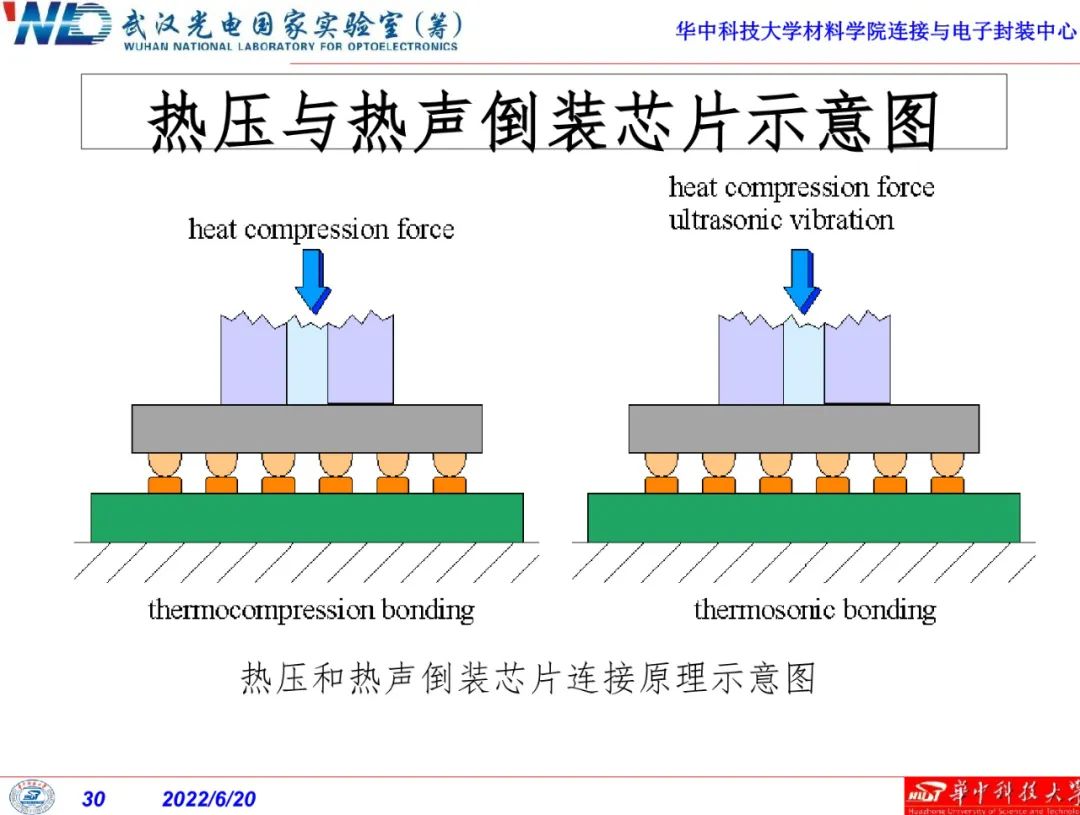















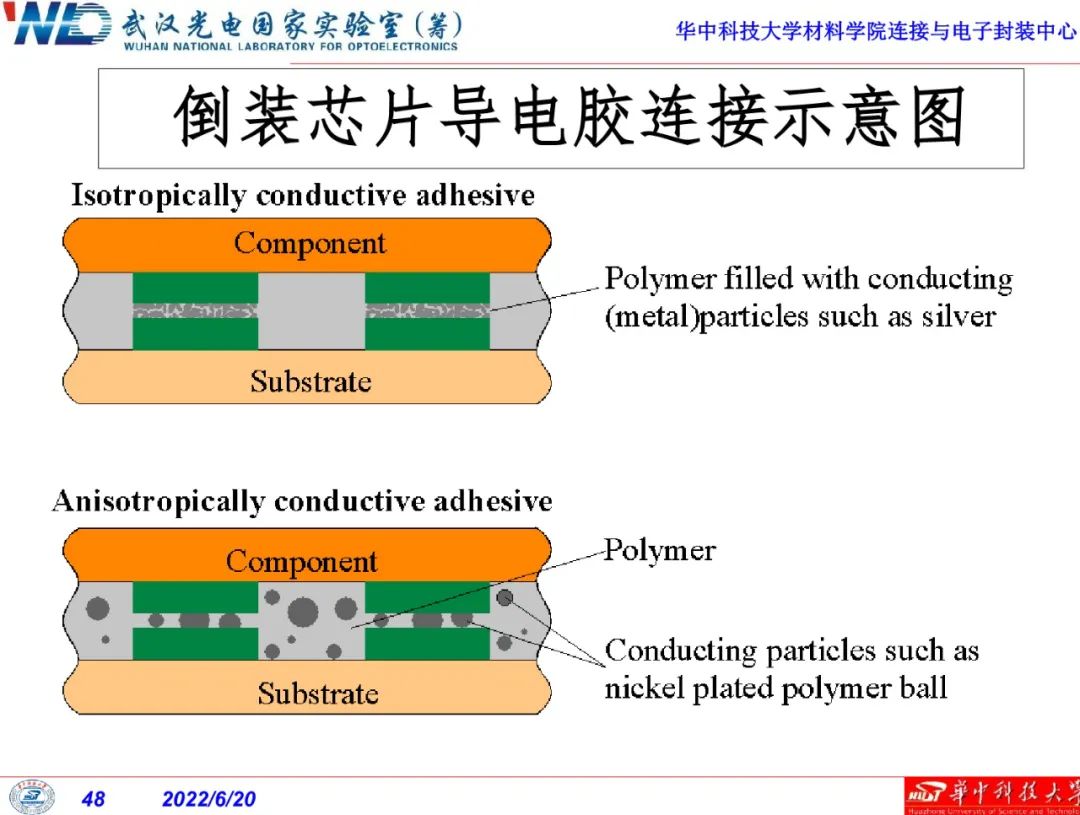




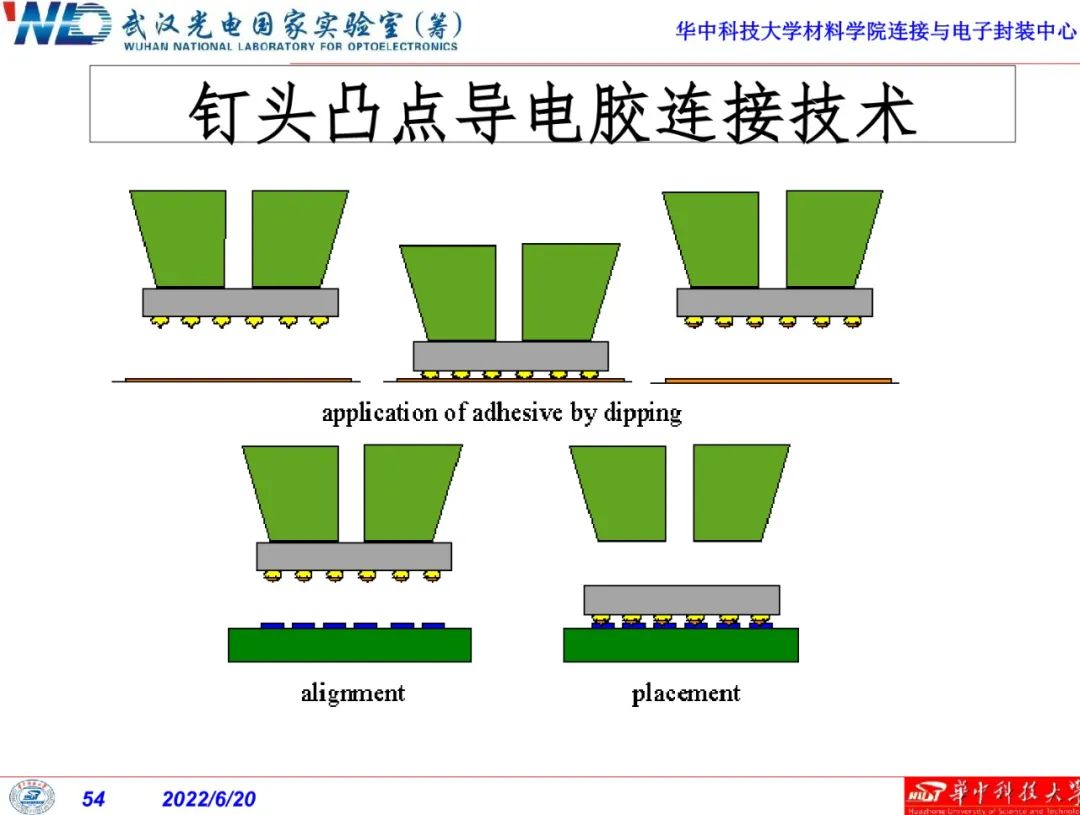




















-
芯片封装工艺详细讲解2016-06-16 0
-
Flip-Chip倒装焊芯片原理与优点2018-09-11 0
-
倒装晶片的组装工艺流程2018-11-23 0
-
倒装芯片与表面贴装工艺2018-11-26 0
-
倒装芯片的特点和工艺流程2020-07-06 0
-
(Flip-Chip)倒装焊芯片原理2009-11-19 1843
-
倒装焊芯片(Flip-Chip)是什么意思2010-03-04 22429
-
RFID封装工艺:Flip Chip和wire bonding2011-03-04 10970
-
芯片封装测试的流程你了解吗IC封装工艺详细PPT简介2019-05-12 28585
-
浅谈倒装芯片封装工艺2023-04-28 4017
-
倒装芯片球栅阵列工艺流程与技术2023-04-28 5392
-
什么是倒装芯片 倒装芯片技术的优点 倒装芯片封装工艺流程2023-07-21 4533
-
倒装芯片封装选择什么样的锡膏?2023-09-27 411
-
简单介绍硅通孔(TSV)封装工艺2023-11-08 3034
-
浅谈芯片倒装Flip Chip封装工艺2024-02-20 607
全部0条评论

快来发表一下你的评论吧 !

