

Intel宣布8大全新制造工艺:目标世界第二
描述
硬件世界2月22日美国圣何塞现场报道:
Intel CEO帕特·基辛格倡导的IDM 2.0半导体制造与代工模式进入全新阶段。
面向AI时代、更具韧性和可持续性的、全球第一个系统级代工服务——“Intel代工”(Intel Foundry),今日正式宣布成立!
Intel是当今半导体行业为数不多的同时具备先进芯片设计、制造能力的企业,而为了适应新时代、新形势、新需求的发展,Intel没有固守以往的模式,也没有简单粗暴地拆分设计与制造,而是提出了全新的IDM 2.0模式。
从此,Intel公司将分为两大部分,一是负责产品设计的Intel Product,二是负责代工制造的Intel Foundry。
二者是一家人,但又相对独立,财务单独核算,彼此互相激励。
Intel代工将技术开发、制造和供应链,以及原来的Intel代工服务整合在一起,平等地向Intel内部和外部客户提供服务。
一方面,Intel产品设计的芯片,可以使用Intel代工来制造,也可以寻求第三方外部代工,就看谁更好用,谁的性能、能效、成本更佳,这就要求Intel代工必须拿出最好的工艺。
另一方面,Intel代工可以制造Intel自己的产品,也可以为其他芯片设计企业代工,实现更灵活的运营和效益、竞争力的最大化,也要求Intel产品必须拿出最好的芯片。
Intel代工的目标,是在2030年成为全球规模第二的代工厂,仅次于台积电。
这个定位无疑是很理、现实的,但即便定位第二,Intel代工也必须竭尽全力推进制造工艺。
第一步,自然是实现“四年五代节点”的目标。
其中,Intel 7、Intel 4都已量产上市,后者就是刚推出的酷睿Ultra。
Intel 3已经做好了大规模量产的准备,今年上半年开始会陆续用于新一代至强Sierra Forest(首次纯E核最多288个)、Granite Rapids(纯P核)。
Intel 20A将开启埃米时代,引入全新的RibbonFET晶体管、PowerVia背部供电。
它在今年内推出,用于新一代消费级酷睿处理器,包括高性能的Arrow Lake、低功耗的Lunar Lake。
Intel 18A正在按计划推进,首发于下下代至强Clearwater Forest,现已完成流片,2025年登场。
基辛格现场首次展示了Clearwater Forest的样片,可以看到继续采用chiplet小芯片设计,并搭配EMID、Foveros Direct封装技术。
其中两组CPU模块都采用Intel 18A,还有两组IO模块,而基板则是Intel 3工艺。
按照Intel的一贯说法,18A将让Intel重新获得制程工艺的领先性。
再往后,Intel的下一代重大工艺节点将是Intel 14A,等效于1.4nm,从路线图上看大约会在2026年左右推出。
它的最大亮点,就是将在业界首次采用全新的高NA EUV光刻机,不久前刚从ASML接收到。
按照基辛格此前披露的说法,Intel将在德国建设的新晶圆厂极有可能就会引入14A。
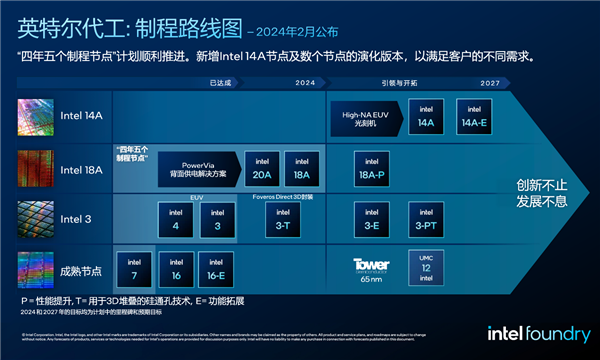
与此同时,Intel还将打造不同工艺节点的多个演化版本,一方面满足不同客户的不同需求,另一方面深挖节点潜力,实现应用和利益的最大化,台积电和三星也都是这么干的。
按照规划,Intel将每两年推出一个新的工艺节点,并一路推出各个节点的演化版本。
其中,先进工艺包括14A节点的A14-E,18A节点的18A-P,3节点的3-T、3-E、3-PT。
成熟工艺包括16节点及其16-E,以及12nm、65nm节点。
P代表Performance,也就是提升性能的增强版,幅度超过10%。
T代表Through Silicon,也就是加入TSV硅通孔技术的3D堆叠封装升级版。
E代表Extension,也就是功能拓展版本,更有针对性。
这些变化可以出现在同一个节点上,兼而有之,比如3-PT,不同节点也可用于同一款产品的不同子芯片。
16、16-E都是基于22nm、14nm工艺混合演化而来,也再次体现了14nm的强大生命力。
12nm则是来自Intel与联电的合作产物,面向移动通讯、通信基础设施、网络等领域。
此前,Intel和高塔半导体(Tower Semiconductor)将在Intel美国新墨西哥州工厂合作生产65nm芯片,将有效延长Intel现有产能的生产寿命,并提高投资回报率。
与先进工艺相辅相成的,是各种先进封装技术,也是chiplet实现的前提。
Intel代工还宣布,将FCBGA 2D+纳入Intel代工先进系统封装及测试(Intel Foundry ASAT)的技术组合之中。
这一组合包括:FCBGA 2D、FCBGA 2D+、EMIB 2.5、EMIB 3.5D、Foveros 2.5D、Foveros 3D、Foveros Direct 3D。
不过,这一次,Intel并未披露未来更先进的封装技术路线图。
对外的话,Intel在各个工艺节点和先进封装上,包括Intel 3、Intel 18A、Intel 16等等,都已经有大量的客户设计案例。
比如,微软CEO纳德拉就最新宣布,微软的一款芯片计划采用Intel 18A工艺制造。
就在上个月,Intel披露一家新的高性能计算客户将采用Intel代工服务制造其芯片,加上如今的微软,Intel 18A代工客户已达五家。
先进封装方面,Intel代工近期新增三家客户,2023年总共新增五家客户。
目前,Intel代工已经流片了超过75款生态系统和客户测试芯片。
2024-2025年,Intel代工已有超过50款测试芯片在准备中,其中75%将采用Intel 18A制程节点。
总体而言,在晶圆制造和先进封装领域,Intel代工的预期交易价值将超过150亿美元。
Intel代工之所以把自己称为系统级代工,就是因为有着系统级的全套服务能力,这也是他的差异化优势。
底层是各种先进制造工艺和封装技术,之上有基板技术(将引入玻璃材质)、散热技术(浸没式液冷散热能力可超过2000W)、内存技术(下一代HBM4)、互连技术(UCIe)、网络技术(光电子),等等。
再往上的顶层,则是各种软件与服务能力,做到软硬兼施。
Intel代工当然也不是自己单打独斗,而是与整个产业的众多生态伙伴都密切合作,官方公布的伙伴就有30多家。
比如IP(知识产权)、EDA(电子设计自动化)领域的Synopsys、Cadence、Siemens(西门子)、Ansys、Lorentz、Keysight,以及Arm、Rambus这样的顶级IP厂商。
他们的工具和IP都已准备就绪,在Intel的各个制程节点上启用,尤其是可以帮助代工客户加速基于Intel 18A工艺的先进芯片设计。
针对Intel EMIB 2.5D封装技术,多家供应商宣布计划合作开发组装技术和设计流程,可以让Intel更快地为客户开发、交付先进封装解决方案。
Intel还公布了“新兴企业支持计划”(Emerging Business Initiative),将与Arm合作,为基于Arm架构的SoC芯片提供代工服务。
这一计划支持初创企业开发基于Arm架构的技术,并提供必要IP、制造支持和资金援助。
Arm CEO Rene Haas也亲临会场,表达了与Intel代工的亲密合作关系。
此外,Inte代工与众多高校、科研机构也有着深度的合作,比如伯克利大学、密歇根大学都是Intel 18A工艺的伙伴。
可持续性方面,Intel也贯彻始终、坚守承诺。
据初步估算,2023年Intel全球工厂的可再生电力使用率达到了99%,将在2030年达成100%,同时实现水资源正效益、零垃圾填埋。
Intel还再次强调,将在2040年实现范围1和范围2温室气体(GHG)净零排放,2050年实现范围3温室气体净零上游排放的承诺。
《芯片战争》一书作者Chris Miller去年在向Intel员工发表演讲时直言:“Intel是过去50年最为重要的企业。”
相信在未来50年,Intel的行业地位同样不可撼动。
对于一家走过半个多世纪的顶级半导体企业而言,Intel当下确实面临着诸多挑战,无论外部环境还是内部发展。
但是,在帕特·基辛格的领导下,Intel一方面坚持技术与功程导向,一方面积极转型、走上新赛道,Intel代工的成立自然是最为核心的一步棋,起着承上启下、继往开来的关键作用。
无论对于半导体行业,还是对于普通消费者,Intel代工都预示着一个全新的未来。
审核编辑:刘清
-
机械制造工艺学2008-06-17 0
-
变压器铁心制造工艺2008-12-13 0
-
8寸晶圆盒的制造工艺和检验2010-08-04 0
-
pcb封装工艺大全2012-03-14 0
-
第二代Intel顶级CPU问世 芯片解密打破禁售垄断2015-11-30 0
-
论工艺制程,Intel VS台积电谁会赢?2016-01-25 0
-
算法大全_目标规划2016-01-14 460
-
IBM研发5纳米芯片全新制造工艺2017-06-07 1114
-
马云关于新制造的一些观点2018-10-06 13680
-
天合光能推出四大全新系列组件,直击光伏市场的需求2019-03-24 2221
-
Intel正式宣布第二代10nm工艺的处理器TigerLake 使用全新的CPU内核及GPU内核2019-05-09 1821
-
新制造正在从概念逐渐落地无人工厂将成为新制造的主流2019-07-29 1442
-
阿里新制造来临,智能制造的发展前景如何2020-11-18 1074
-
台积电或将提前投产3nm工艺 Intel、三星望尘莫及2021-03-03 1808
-
Intel酷睿Ultra CPU IPC性能实测2024-01-04 739
全部0条评论

快来发表一下你的评论吧 !

