

“芯”动未来,无图晶圆几何量测系统提升半导体竞争力
描述
在晶圆制造前道过程的不同工艺阶段点,往往需要对wafer进行厚度(THK)、翘曲度(Warp)、膜厚、关键尺寸(CD)、套刻(Overlay)精度等量测,以及缺陷检测等;用于检测每一步工艺后wafer加工参数是否达到设计标准,以及缺陷阈值下限,从而进行工艺控制与良率管理。半导体前道量检测设备,要求精度高、效率高、重复性好,量检测设备一般会涉及光电探测、精密机械、电子与计算机技术,因此在半导体设备中,技术难度高。
在wafer基材加工阶段,从第一代硅,第二代砷化镓到第三代也是现阶段热门的碳化硅、氮化镓衬底都是通过晶锭切片、研磨、抛光后获得,每片衬底在各工艺后及出厂前,都要对厚度、翘曲度、弯曲度、粗糙度等几何形貌参数进行系统量测,需要相应的几何形貌量测设备。
下图为国内某头部碳化硅企业产品规范,无论是production wafer,research wafer,还是dummy wafer,出厂前均要对几何形貌参数进行量测,以保证同批、不同批次产品的一致性、稳定性,也能防止后序工艺由于wafer warpage过大,产生碎片、裂片的情况。

中图仪器针对晶圆几何形貌量测需求,基于在精密光学测量多年的技术积累,历经数载,自研了WD4000系列无图晶圆几何量测系统,适用于线切、研磨、抛光工艺后,进行wafer厚度(THK)、整体厚度变化(TTV)、翘曲度(Warp)、弯曲度(Bow)等相关几何形貌数据测量,能够提供Thickness map、LTV map、Top map、Bottom map等几何形貌图及系列参数,有效监测wafer形貌分布变化,从而及时管控与调整生产设备的工艺参数,确保wafer生产稳定且高效。

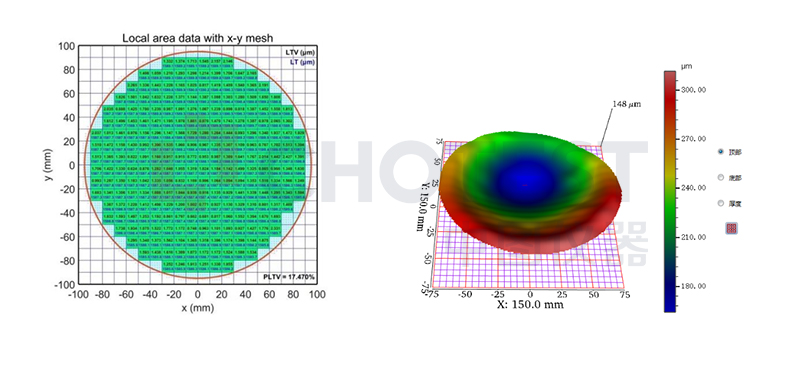
晶圆制造工艺环节复杂,前道制程所需要的量检测设备种类多、技术难度高, 因此也是所有半导体设备赛道中壁垒最高的环节。伴随半导体制程的演进,IC制造对于过程管控的要求越来越高,中图仪器持续投入开发半导体量检测设备,积极倾听客户需求,不断迭代技术,WD4000系列在诸多头部客户端都获得了良好反响!
千淘万漉虽辛苦,吹尽狂沙始到金。图强铸器、精准制胜,中图仪器与中国半导体产业共同成长。
-
EMC测试整改:提升产品合规性和市场竞争力?|深圳比创达电子2024-03-07 0
-
标题:群“芯”闪耀的半导体行业2008-09-23 0
-
半导体激光在晶圆固化领域的应用2011-12-02 0
-
论新兴智能产品的市场竞争力2015-06-25 0
-
2016上半年中国半导体产业研究报告2016-06-30 0
-
关于嵌入式的技术竞争力2019-05-16 0
-
5G会给半导体带来什么投资机会2019-06-11 0
-
电子半导体无尘车间在线式粒子计数器2020-09-23 0
-
什么是半导体晶圆?2021-07-23 0
-
嵌入式系统的核心竞争力是什么2021-11-08 0
-
喜讯!热烈祝贺武汉芯源半导体顺利通过CQC质量管理体系认证2023-01-10 0
-
“IMPROVE”提升欧洲半导体业的全球竞争力2012-09-25 819
-
韩政府宣布砸约13.4亿美元投资半导体,将提升半导体市场竞争力2018-07-31 3022
全部0条评论

快来发表一下你的评论吧 !

