

碲镉汞PIN结构雪崩器件的Ⅰ区材料晶体质量研究
描述
常规的碲镉汞PIN结构雪崩器件一般采用non-p结构,其中最为关键的雪崩Ⅰ区采用离子注入及推结退火的后成结工艺。这些工艺步骤将改变原生材料的性质,前期理论模拟研究表明,雪崩Ⅰ区的质量对APD器件的暗电流至关重要。因此,对于雪崩Ⅰ区真实材料性能的研究将对后续APD器件的工艺优化提供有效基础支撑。
据麦姆斯咨询报道,近期,中科院上海技术物理研究所红外材料与器件重点实验室的科研团队在《红外与毫米波学报》期刊上发表了以“碲镉汞PIN结构雪崩器件的Ⅰ区材料晶体质量研究”为主题的文章。该文章第一作者为沈川副研究员,通讯作者为陈路研究员,主要从事基于PIN结构的碲镉汞线性雪崩焦平面器件技术的研究工作。
本文通过单项实验对比与分析,选取原生HgCdTe材料,对其进行PIN结构雪崩器件的全过程工艺模拟,形成大面积的雪崩Ⅰ区。采用微分霍尔、微分少子寿命等测试手段进行材料表征,评估获得了关键雪崩区域的真实材料晶体质量。
实验过程
本文在CdZnTe衬底上采用LPE方法生长Hg空位掺杂的P型HgCdTe外延材料,经过B+离子注入以及退火工艺后,由于Hg原子的填隙扩散,形成PI-N结构的平面结雪崩器件。图1为其器件结构示意图,其中N-区域即为由后成结工艺形成的雪崩Ⅰ区。
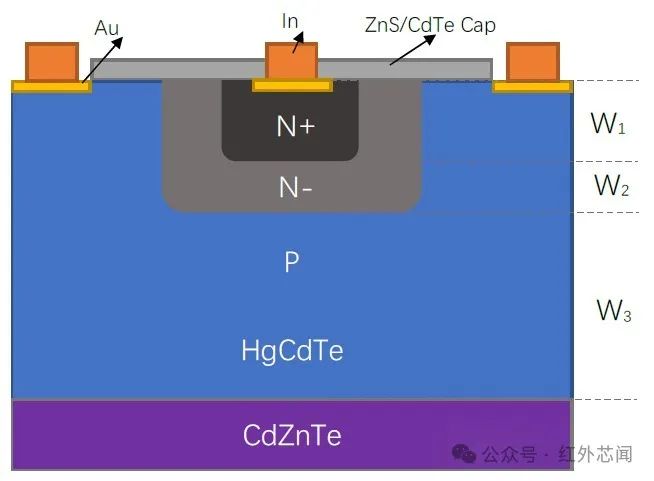
图1 HgCdTe APD的二维结构模型
单项实验中,我们先选取外延后的材料切片成边长为1 cm的正方形样品,样品组分为0.3254,HgCdTe层厚度为15.5 μm。成结工艺开始前,对实验材料进行表面缺陷以及XRD检测,确保材料初始质量性状满足并接近实际雪崩器件状态。接着,通过常规的PIN成结工艺对实验材料进行相同的器件全过程工艺模拟。实验材料经过表面清洗、腐蚀、P型退火、阻挡层生长、离子注入以及推结退火等工艺过程。整个实验过程几乎完全模拟常规的器件工艺,以求能最大限度地模拟真实器件的Ⅰ区,获得最接近真实器件的Ⅰ区材料状态。其中,唯一的区别为离子注入时是材料全面积的注入过程。
雪崩Ⅰ区成型后,我们对实验材料进行纵向的微分剥层,剥层精度控制在0.3~1 μm之间,测试温度为80 K。每次的微分剥层中进行霍尔浓度以及少子寿命的测量。整个纵向剥层从N+区经过Ⅰ区,一直到达最后的P区,覆盖整个PIN雪崩结构,从而获得了整个PIN结的材料霍尔浓度和少子寿命的分布情况。
结果分析
从前期的理论模拟以及暗电流研究可知,关键雪崩Ⅰ区的有效控制,是高性能HgCdTe雪崩焦平面器件制备的第一要素,包括Ⅰ区的轮廓参数和材料质量性质。因为是后成结工艺,且离子注入以及退火都会显著地改变原生材料性状,所以真实的Ⅰ区表征是考量后续工艺的关键因素。本文我们对Ⅰ区的材料质量进行了定量化的研究。
图2为整个PIN结的材料霍尔浓度和总少子寿命的分布曲线。其中,横坐标为微分剥层的深度,0 μm处即为材料的表层位置。三角形点为各层的材料总少子寿命随着深度的分布变化,圆形点为各层的材料霍尔浓度随着深度的分布变化。图2中,按照材料霍尔浓度的分布变化曲线,我们可以看到,其霍尔浓度在整个纵向有两个大的跳变,分别是深度1 μm左右和深度8 μm左右。结合PIN结构的成结特性,可以分析获得材料表层0~0.9 μm为N+区域,P区在深度8.5 μm以上,而我们最关键的雪崩Ⅰ区在0.9~8.5 μm之间。
由此,从图中我们分析Ⅰ区的少子寿命可以看到,随着深度的增加,Ⅰ区的少子寿命呈现先有一段稳定区然后慢慢降低的过程。结合霍尔浓度分布变化,可以确认3~8 μm处的分布变化是由于穿透深度的原因。当剥层表面到材料内部P区界面的距离小于穿透深度时,测试值会受到P区影响,造成测试获得的少子寿命值偏小,从而呈现随着深度下降的现象。而大于穿透深度时,因为未受到P区影响,所以认为是准确值。由此可见,图中1~3 μm段的少子寿命表征的是真实Ⅰ区内材料的少子寿命值,其均值约6.6 μs。

图2 整个PIN结的材料霍尔浓度和总少子寿命的分布曲线图
对于HgCdTe红外探测器,少子寿命是决定探测器性能的重要参数,其由三种机制代表的三种少子寿命组成,分别为辐射寿命、俄歇寿命和SRH寿命。辐射机制是一个导带非平衡电子和一个价带非平衡空穴直接复合,产生的能量(大约等于禁带宽度)以声子的形式释放。
俄歇机制是一种带带间的直接复合机制,一般分为俄歇1和俄歇7两种,而俄歇1是n型半导体中的主要机制。
SRH机制是非平衡载流子通过禁带中的复合中心能级复合的过程。SRH过程分两步进行:第一步是少子被复合中心俘获,第二步是俘获的少子和多子再结合,产生的能量以光子或声子的形式释放。SRH机制中的复合中心(简称为SRH复合中心)一般是由晶体的不完整性形成。所以,我们一般认为SRH寿命的大小能用来表征材料的质量。
这三种机制组成材料的总少子寿命,而且从公式可见,其随着材料的温度而变化。所以我们可以采用变温少子寿命的方式,测量不同温度下材料少子寿命的分布变化,然后拟合获得相应的SHR寿命,表征雪崩Ⅰ区的真实材料性能。
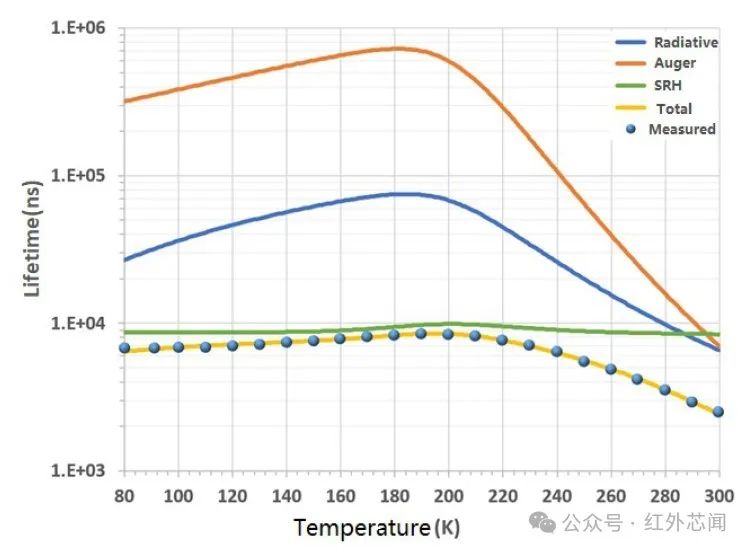
图3 实验材料剥层厚度1.68 μm处实验值和理论值曲线
图3为实验材料剥层厚度为1.68 μm处的少子寿命测量值随温度变化和各个机制下理论计算曲线。从80 K到280 K之间的温度范围内,辐射寿命和俄歇寿命都远大于SRH寿命,因此,SRH寿命占主导地位。我们拟合获得APD器件工作温度80 K下SRH寿命大小为8664 ns。同样的,对图3中深度1~3 μm内的所有测试数据点都进行变温少子寿命拟合,得到其80 K下都为SRH寿命占主导,且拟合获得的SRH寿命的波动范围为8212~8822 ns。由此,我们可以判断采用此材料下的PIN结构成结工艺形成的雪崩Ⅰ区的SRH寿命平均值为8556 ns。
基于此SRH寿命值,我们代入APD器件的暗电流拟合模型,此模型在前期研究中已经被证实与实验实测暗电流数据吻合度良好。经过模型拟合计算获得如图4的PIN结构HgCdTe APD器件的理论暗电流IV曲线,工作温度为80 K,光敏元大小为20 μm×20 μm,其中Ⅰ区的SRH寿命值即为8556 ns。由前期研究表明,APD器件的暗电流在小偏压下主要由SRH复合机制主导。图中可以看到,小偏压0~3 V下此材料能获得的理论暗电流大小约为1×10⁻¹⁴ A。

图4 基于8556 ns的Ⅰ区的APD暗电流拟合结果
进一步地,基于上述相同的研究方法,我们评估了多个材料的雪崩Ⅰ区的SRH寿命,如图5所示。图中可以看到,其范围值约在8~20 μs之间,这个范围值依然在我们原生N型HgCdTe材料的SRH寿命相当水平。相应的拟合小偏压下的理论暗电流最佳值为3.5×10⁻¹⁵ A,换算暗电流密度为8.7×10⁻¹⁰ A/cm²,满足高质量中波碲镉汞雪崩器件的研制要求。当然,最终决定实际APD器件的暗电流的因素中材料质量是最基础的,其他如PIN结的结构参数、器件工艺(包括钝化,接触等)都是十分重要的。

图5 多个HgCdTe材料的雪崩Ⅰ区的SRH寿命测试结果
结论
通过对PIN结构雪崩Ⅰ区的材料少子寿命进行表征,评估获得了关键雪崩区域的真实材料的晶体质量。研究发现,现有优化工艺下雪崩区域的晶体质量良好,拟合材料的SRH寿命最好能达到约20.7 μs,能达到原生材料SRH寿命的相当水平,理论最优的暗电流密度达到8.7×10⁻¹⁰ A/cm²,满足高质量中波碲镉汞雪崩器件的研制要求,为后续新型焦平面器件的研发提供基础。
论文链接:
http://journal.sitp.ac.cn/hwyhmb/hwyhmbcn/article/abstract/2023164
-
身体质量指数2014-03-24 0
-
Multisim里面雪崩晶体管的过压击穿怎么放着2014-08-08 0
-
Honeywell霍尼韦尔气体质量流量传感器2014-09-16 0
-
气体质量流量计2019-03-22 0
-
TSC-220气体质量流量计2020-05-26 0
-
气体质量流量计TSC-1502020-05-26 0
-
MKP气体质量流量控制器/气体质量流量计VIC-D2402020-11-20 0
-
MKP气体质量流量控制器/气体质量流量计VIC-D1452020-11-20 0
-
雪崩光电二极管基础知识点汇总2023-02-06 0
-
如何用数字万用表巧判石英晶体质量2009-08-03 1328
-
一氧化碳气体质量浓度智能检测仪的研究与设计2016-12-17 730
-
MBE技术在InN材料中的应用及其晶体质量和光学特性的影响介绍2017-10-10 676
-
浅谈PIN雪崩光电二极管建模部分2018-08-20 3172
-
功率器件的雪崩应用与分析2023-02-06 2671
-
基于PIN结构的碲镉汞线性雪崩焦平面器件技术2024-03-15 156
全部0条评论

快来发表一下你的评论吧 !

