

硅晶片清洗:半导体制造过程中的一个基本和关键步骤
电子说
描述
引言
半导体是一种导电率介于绝缘体和导体之间的固体物质。半导体材料的定义属性是它可以掺杂杂质,以可控的方式改变其电子属性。硅是开发微电子器件时最常用的半导体材料。半导体器件制造是用于制造日常电气和电子设备中存在的集成电路的工艺。在半导体器件制造中,各种处理步骤分为四大类,例如沉积、去除、图案化和电特性的改变。
最后,通过在半导体材料中掺杂杂质来改变电特性。晶片清洗过程的目的是在不改变或损坏晶片表面或衬底的情况下去除化学和颗粒杂质。进行晶片清洗是为了预扩散清洗方法,该方法产生了没有金属、颗粒和有机污染物的表面,金属离子去除干净即去除对半导体器件操作有不利影响的金属离子,颗粒去除清洁是指使用化学或机械擦洗从表面去除颗粒,使用兆频超声波清洁和蚀刻后清洁,其去除蚀刻过程后留下光刻胶和聚合物。
硅片清洗程序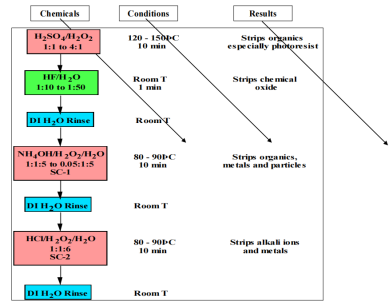
图1:RCA清洗的详细过程
RCA清洗是用于从硅片上去除有机物、重金属和碱金属离子的“标准工艺”。这里使用超声波搅动来去除颗粒。在图1中,讨论了RCA清洗方法。第一步,以1∶1-1∶4的比例加入硫酸和过氧化氢。将晶片浸入温度为100-150℃的溶液中10分钟。这一过程也被称为pirhana清洗。之后,将晶片浸入氢氟酸(HF)溶液中1分钟,其中HF和H2O的比例为1∶10。最后,在室温下用去离子水冲洗晶片一段固定的时间。另外两个过程,即SC-1和SC-2方法也包括在RCA清洗过程中。在每一步中,晶片都要用去离子水冲洗,以进行适当的清洗。
标准清洗包括两个步骤,即SC-1和SC-2。在SC-1法中,氢氧化铵(28%)、过氧化氢(30%)和水以1:1:5的比例加入,温度为70-80℃。硅晶片保持浸入其中溶液10分钟,并保持高pH值。这种方法氧化有机污染物(形成二氧化碳、水等)并与金属(金、银、铜、镍、锌、镉、钴、铬)形成络合物。在这个过程中,自然氧化物慢慢溶解并重新生长出新的氧化物,从而去除氧化物上的颗粒。NH4OH使用较少,因为它蚀刻硅并使其表面粗糙。
在SC-2法中,盐酸(73%)、过氧化氢(73%)和水的比例为1:1:6,温度为70-80℃。将硅片浸入该溶液中10分钟,并保持低pH值。该方法用于去除碱性离子和阳离子,它们在碱性溶液如SC-1中形成NH4OH不溶性氢氧化物。这些金属在SC-1溶液中沉淀到晶片表面,而在SC-1溶液中形成可溶性络合物。
结论
洁净室是所有这些清洁过程发生的地方,也是采取措施减少微粒污染的地方。洁净室中的温度、湿度和压力等所有参数都通过使用一些关键组件进行控制。污染物发生在微电子集成电路制造过程中。清洗是从晶片上去除污染物的最理想的工艺之一。英思特所有的清洁过程都发生在一个干净的房间里。在清洗过程中,通过超声波搅动,大部分颗粒被去除。有机物(光致抗蚀剂)在等离子体或硫酸/过氧化氢溶液中被去除,这被称为piranha清洗。“RCA清洗”用于去除金属和任何残留物硅片中存在有机物。清洗约占任何集成电路制造过程的四分之一。
审核编辑 黄宇
-
《半导体制造工艺》学习笔记2012-08-20 0
-
半导体制程2018-11-08 0
-
半导体制造的难点汇总2020-09-02 0
-
半导体制造车间的环境与生产要求以及设施规划2020-09-24 0
-
什么是半导体晶圆?2021-07-23 0
-
一文带你了解芯片制造的6个关键步骤2022-04-08 0
-
硅晶片清洗—半导体制造过程中的一个基础和关键步骤2022-01-18 1035
-
硅晶片清洗是半导体制造中的一个基础步骤2022-02-23 1495
-
半导体制造过程中的新一代清洗技术2022-03-22 3677
-
半导体制造过程中的硅晶片清洗工艺2022-04-01 3091
-
一种用湿式均匀清洗半导体晶片的方法2022-04-14 640
-
半导体器件制造过程中的清洗技术2022-04-20 3275
-
揭秘半导体制造全流程(中篇)2022-08-01 4660
-
湿清洗过程中硅晶片表面颗粒去除2023-03-30 1987
-
半导体制造背后的艺术:从硅块到芯片的旅程2023-09-22 1881
全部0条评论

快来发表一下你的评论吧 !

