

浅谈刻蚀的终点控制
制造/封装
描述
1.等离子体刻蚀的新进展
等离子体蚀刻过程需要达到高产量、高均匀性、高选择比、各向异性和无损伤等目标。对于传统的连续等离子体蚀刻而言,当器件尺寸缩小到14nm节点以下,达到上述蚀刻目标变得越来越困难。
1.1 脉冲等离子体刻蚀 Pulsed plasma etching
相对于传统的连续波等离子体刻蚀,脉冲等离子体技术能够在刻蚀选择比、各向异性和轻电荷累计损伤等方面展现出诸多优势。对于脉冲技术,不同的输入参数,如反应器结构、源功率、偏置功率、气压、频率、脉冲方式、脉冲重复频率、脉冲占空比等,都会影响刻蚀机台内等离子体的特性,如等离子体密度、反应基团活性、电子温度、中性离子和解离率等。完整的等离子体脉冲刻蚀循环包括4个阶段:
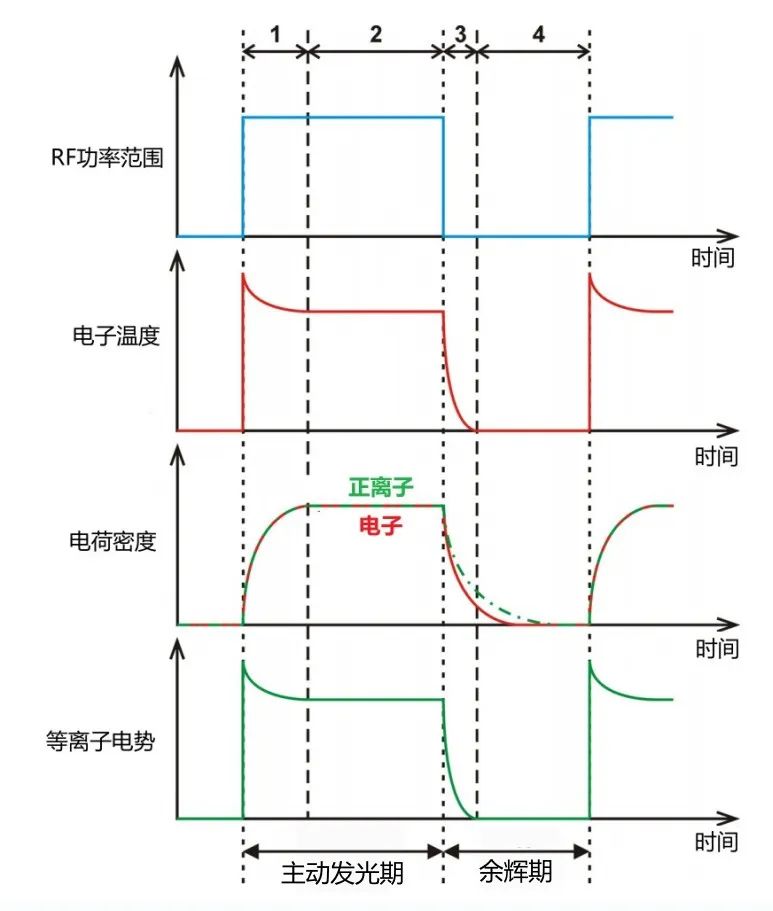
素材源自:Pulsed high-density plasmas for advanced dry etching processes.Samer Banna, Ankur Agarwal, Gilles Cunge, Maxime Darnon, Erwine Pargon, and Olivier Joubert
1. 初始活跃发光期
当电源瞬间打开,等离子体激发,电子(和离子)密度开始上升,但并未完全达到稳定状态。由于功率处于峰值且电子密度较低该时期的平均电子能量最初较高,等离子体电势和离子能量也很高。
2. 稳态主动发光期
当等离子体过渡到稳态主动辉光期时,电子和离子密度达到稳态值。电子温度和等离子体电势也达到稳态。这一时期的特点是高离子通量和几乎恒定的等离子体阻抗。
3. 初始余辉期
当功率暂时关闭时,负责电子加热的感应电场迅速减弱。当电子不再被加热时,它们在碰撞中通过逃逸到壁上来耗散能量,并且电子温度在此期间迅速下降。等离子体电势也开始迅速下降,鞘层相应地开始塌陷。在此期间离子通量和离子能量均迅速下降。
4.晚余辉期
当等离子体转变到这种状态时,电子密度处于最低水平。一般来说,等离子体密度下降的水平取决于占空比和脉冲频率。通过调整脉冲的占空比,可以将时间平均离子能量分布函数进行调整。此外,在余辉后期,随着鞘层塌陷,入射到晶圆上的离子的角度分布很宽,这有利于被蚀刻特征顶部附近的电荷中和。此外,在脉冲的这个阶段,塌陷的鞘层可能允许负离子到达特征的底部,从而减少正电荷的积累。最后,由于余辉中电子温度快速衰减,电子碰撞解离反应速率迅速下降,从而显著减少自由基的产生。与此同时,自由基在反应器壁上消失,在那里它们粘附或重新结合,它们的密度在余辉中衰减。然而,实现任何显著自由基密度变化的典型时间约为几毫秒,即比离子通量的脉冲周期长得多。在这种条件下,离子通量快速调节,而自由基通量恒定并且与占空比无关。这就是为什么高频等离子体脉冲可以几乎独立地控制到达晶片的离子通量和自由基通量。
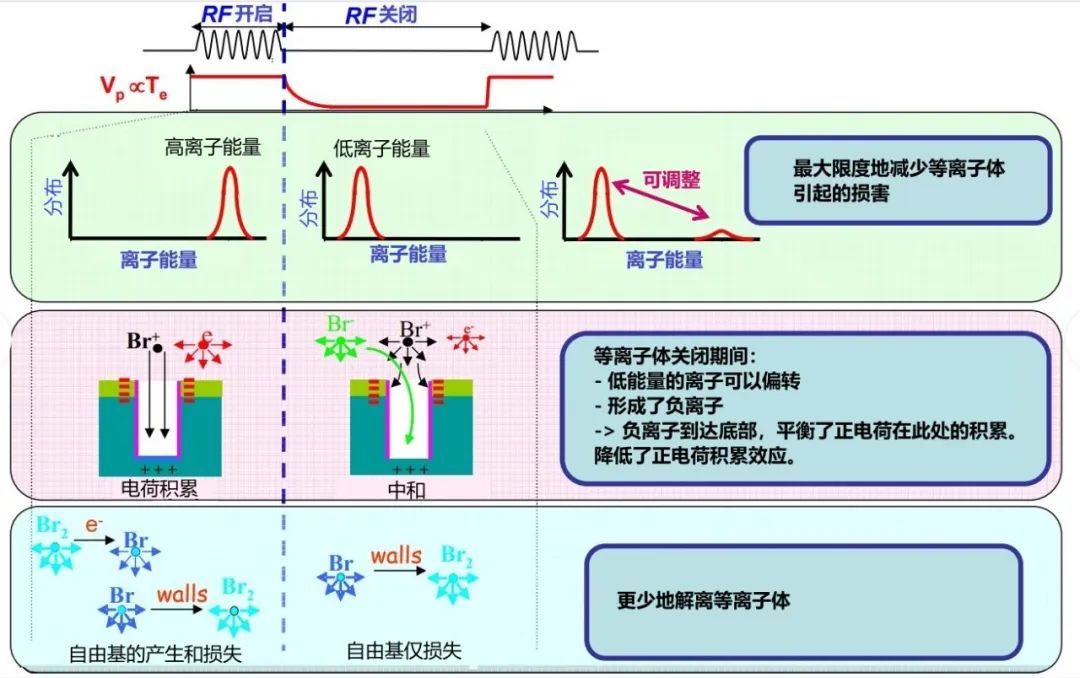
脉冲等离子体的作用
素材源自:Pulsed plasmas for etching in microelectronics.M. Darnon, G. Cunge, C. Petit-Etienne, M. Haass, P. Bodart, M. Brihoum, R. Blanc, E. Despiau-Pujo, S. Banna, O. Joubert
1.2 原子层刻蚀 Atomic layer etching (ALE)
随着行业从 10 纳米 finFET 迁移到 7 纳米 finFET,鳍之间的沟槽或间隙将缩小到约 5 个原子宽,传统蚀刻工具很难在这些先进节点上达到要求。
原子层刻蚀ALE 是一种利用连续自限反应去除材料薄层的技术,被认为是实现原子级时代所需的低工艺变异性的最有前途的技术之一。ALE可以选择性地去除超薄材料或仅原子,而不损坏其周围的结构。ALE 是单层蚀刻:它能够从基材上逐层受控地去除材料,蚀刻厚度约为单层的数量级。 ALE 基本步骤是是先形成反应层的改性,然后仅去除该改性层。使用离子可以实现形成深而窄的结构所需的定向蚀刻。
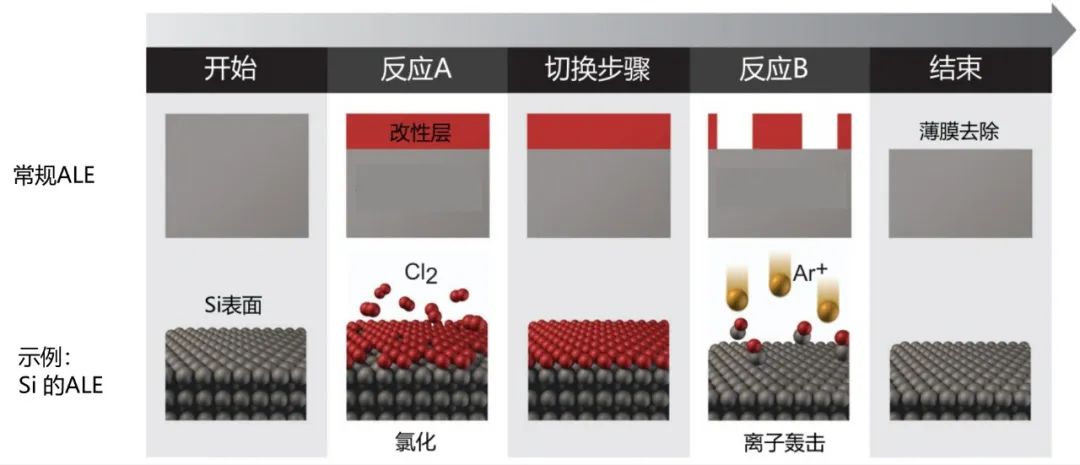
素材源自:Overview of atomic layer etching in the semiconductor industry. Keren J. Kanarik, Thorsten Lill, Eric A. Hudson, Saravanapriyan Sriraman, Samantha Tan,Jeffrey Marks, Vahid Vahedi, and Richard A. Gottscho
2. 刻蚀的终点控制
(1) 光谱分析
每个原子/分子都有自己的发射波长。蚀刻不同材料时等离子体颜色发生变化,可用光学传感器检测变化并指示等离子体蚀刻工艺的终点。
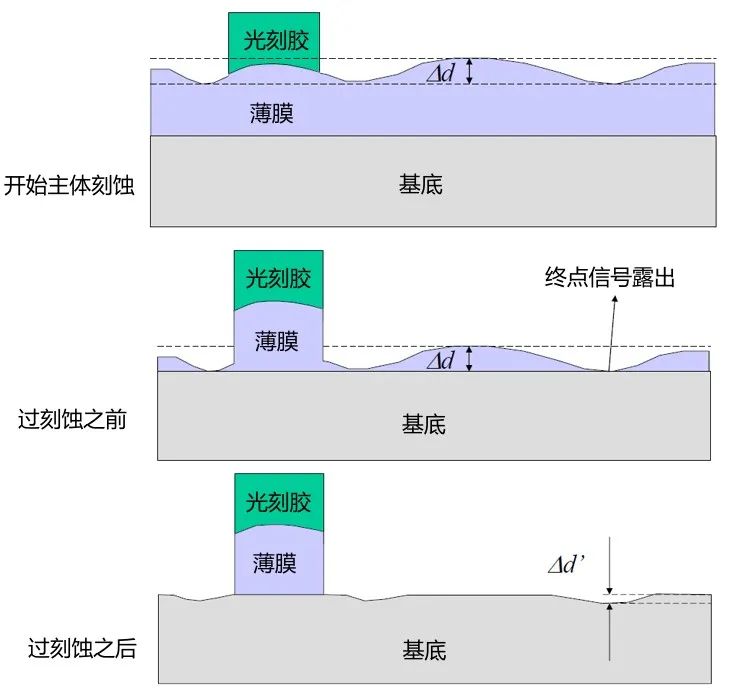
素材源自:https://slideplayer.com/slide/4180202/
来自主要刻蚀剂或副产物的发射信号在刻蚀终点处将开始上升或下降:
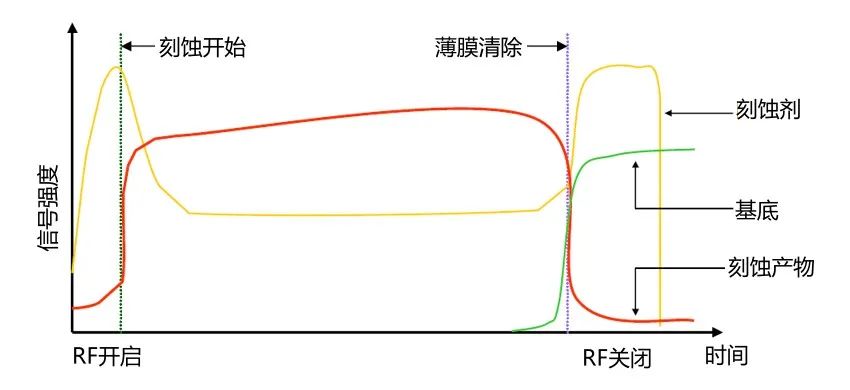
素材源自:https://slideplayer.com/slide/4180202/
(2) 激光干涉测量
激光干涉测量通过将小激光光斑(直径约 20-60μm,波长为 670、905 或 980nm)聚焦到晶圆表面并测量反射光强度来直接监测晶圆。刻蚀室顶部装有相机,提供晶圆表面的图像并将激光点聚焦到晶圆上。相机还收集反射的激光以提供晶圆反射率的测量。通过移动相机的 x-y 工作台,可以将光斑定位在晶圆表面上的特定点。

图源:https://slideplayer.com/slide/6877818/
在某些应用中,例如金属蚀刻,当层被去除时,反射率可能会发生简单的变化。如果蚀刻透明层,则可以通过计算反射强度的波纹来测量蚀刻深度。这些波纹来自于层厚度变化时层内的干涉效应。
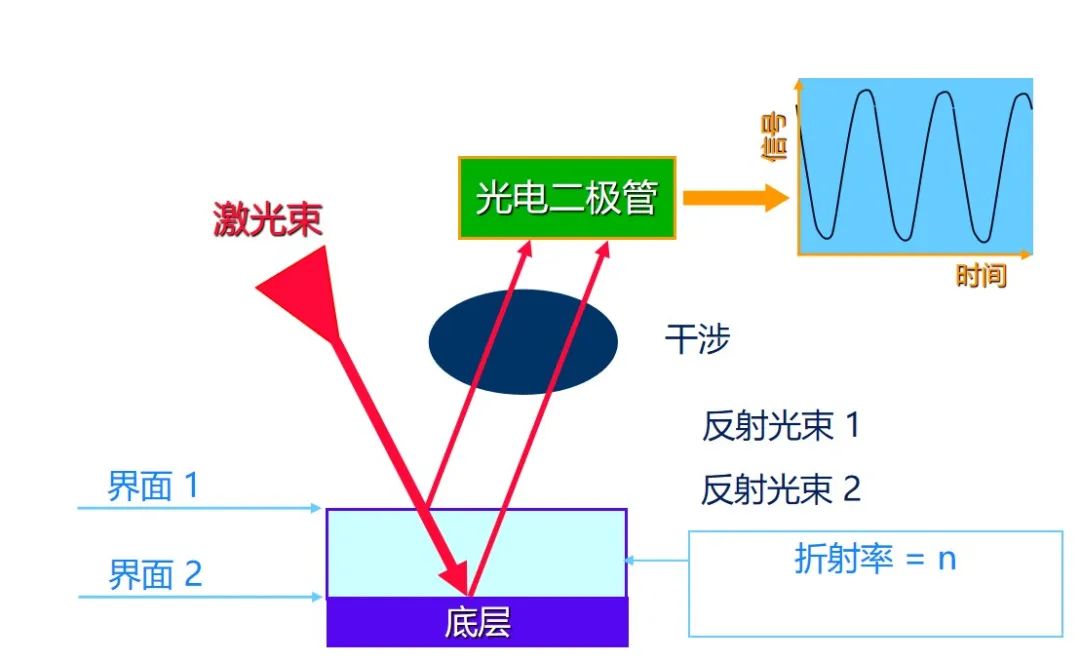
图源:https://slideplayer.com/slide/6877818/
审核编辑:黄飞
-
台面刻蚀深度对埋栅SITH栅阴击穿的影响2009-10-06 0
-
【新加坡】知名半导体晶圆代工厂招聘资深刻蚀工艺工程师和刻蚀设备主管!2017-04-29 0
-
【转帖】干法刻蚀的优点和过程2018-12-21 0
-
半导体光刻蚀工艺2021-02-05 0
-
请教碳化硅刻蚀工艺2022-08-31 0
-
AOE刻蚀系统2022-10-21 0
-
数控系统加减速控制与程序段终点速度规划2016-05-03 502
-
干法刻蚀之铝刻蚀的介绍,它的原理是怎样的2020-12-29 8788
-
刻蚀工艺基础知识简析2023-02-06 4521
-
纯化学刻蚀、纯物理刻蚀及反应式离子刻蚀介绍2023-02-20 2857
-
半导体刻蚀工艺简述(3)2023-03-06 1900
-
半导体行业之刻蚀工艺介绍2023-04-17 2168
-
干法刻蚀与湿法刻蚀各有什么利弊?2023-09-26 4017
-
为刻蚀终点探测进行原位测量2024-01-19 205
-
什么是线刻蚀 干法线刻蚀的常见形貌介绍2024-03-27 150
全部0条评论

快来发表一下你的评论吧 !

