

浅谈BGA、CSP封装中的球窝缺陷
电子说
描述
随着BGA、CSP封装器件向密间距、微型化的方向发展,无铅制程的广泛应用给电子装联工艺带来了新的挑战。球窝(Pillow-head Effect)缺陷是BGA、CSP类器件回流焊接中特有的一种缺陷形态。如图所示,焊料球和焊锡之间没有完全熔合,而是像枕头一样放在一个窝里或一个堆上。这种缺陷经常发生在BGA、CSP器件的回流焊接中,在无铅制程中更加明显。
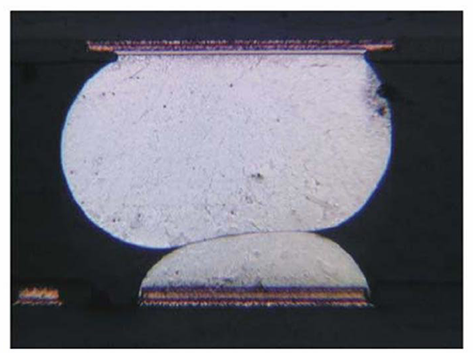
这种缺陷不易被检测出来,因为焊料球和焊锡之间往往有部分连接。所以电路可能能够通过功能测试、光学检查和ICT测试。但是,由于焊料之间没有真正熔混,焊点不牢固,可能会在后续的工艺或使用过程中导致失效。例如,在焊接工艺之后,存在球窝缺陷的PCBA可能会在后续的组装工艺、运输过程中因为热胀冷缩或者在现场经受长时间的电流负荷而失效。因此,球窝缺陷的危害性是极大的。
球窝产生的机理
1.锡膏或焊料球的可焊性不良。
2.锡膏印刷和贴片精度影响。如果锡膏印刷不均匀或不准确,或者贴片位置偏移,会导致焊料球和焊锡之间的接触不良,从而形成球窝。
4.BGA焊球的共面性不好。如果BGA封装器件的焊球高度不一致,会导致部分焊点受力不均匀,从而造成翘曲或断裂。
5.芯片翘曲或芯片温度不均匀,存在温差。如果芯片在回流焊接过程中受热不均匀,或者在回流焊接前后发生翘曲,都会导致芯片与PCB基材之间的热膨胀系数不匹配,从而产生应力和变形。这会使得部分焊点失去接触或分离,形成球窝。
抑制球窝现象的措施
1.优化回流工艺:选择温度较高、时间较长的均热区,确保焊料迅速达到液相线状态。
2.选用合适的锡膏:采用抗热坍塌能力强,去CuO(Cu2O)、SnO(SnO2)效果良好的锡膏;
3.改善热风回流的均热能力,最好采用“热风+红外”复合加热方式,能有效改善封装体上温度的均匀性。
4.加强对回流炉排气系统的监控,确保排气管道顺畅有效。
福英达锡膏
深圳市福英达公司自主研发和生产的SiP系统级封装锡膏Fitech siperiorTM 1550/1565,粒径T8、T9,最小印刷/点胶点φ=70/50μm,可稳定用于μBGA预置。在实际应用中体现出优异的印刷性、脱模转印性、形状和稳定保持性及足量且均匀的印刷量。长时间印刷后无锡珠、桥连缺陷。欢迎来电咨询。
审核编辑 黄宇
-
器件高密度BGA封装设计2009-09-12 0
-
厦门BGA返修,BGA植球,电路板焊接2012-05-20 0
-
BGA——一种封装技术2015-10-21 0
-
芯片BGA封装常用锡球直径与球间距2017-11-02 0
-
BGA封装设计规则和局限性2018-09-05 0
-
可以解决众多封装难题的CSP-ASIP2018-11-23 0
-
有没有人从赛灵思获得有缺陷的BGA?2020-06-17 0
-
BGA封装的焊球评测2011-11-29 4734
-
CSP封装是什么?具有什么特点2019-06-24 19936
-
浅谈CSP封装芯片的测试方法2021-12-03 2507
-
先进封装形式μBGA、CSP的回流焊接技术说明2022-05-06 592
-
BGA和CSP封装技术详解2022-07-26 5472
-
微电子封装技术BGA与CSP应用特点2023-06-14 1016
-
解读BGA、CSP封装中的球窝缺陷2023-10-08 388
全部0条评论

快来发表一下你的评论吧 !

