

BGA生产工艺设计规则
PCB设计
2494人已加入
描述
随着电子产业技术的进步,芯片集成度不断提高,IO引脚数急剧增加,功耗也随之增大,对集成电路封装的要求也更加严格。为了满足发展的需要,BGA (Ball Grid Array)-球状引脚栅格阵列封装技术被应用于生产,它是在封装体基板的底部制作陈列焊球作为电路的I/O端与印刷线路板(PCB)互连,采用该技术封装的器件是一种表面贴装器件。
随着芯片产业的发展,BGA间距越来越小,布线越来越密,以满足更多功能,此时给生产带来了不少挑战:1)BGA焊盘到线路距离近,且BGA焊盘需要开窗,那么就需要有一定的安全间距,传统生产中达不到此间距的只能削掉BGA焊盘2)为了从BGA焊点内部引线出来,常规的做法是在BGA焊盘间做过孔引线,若BGA间距近就没有再加过孔,只能把过孔钻在BGA焊盘上……这些都给后期的SMT组装带来难度与风险,为此,我们更新设备与提升工艺,已解决了这两大难题:
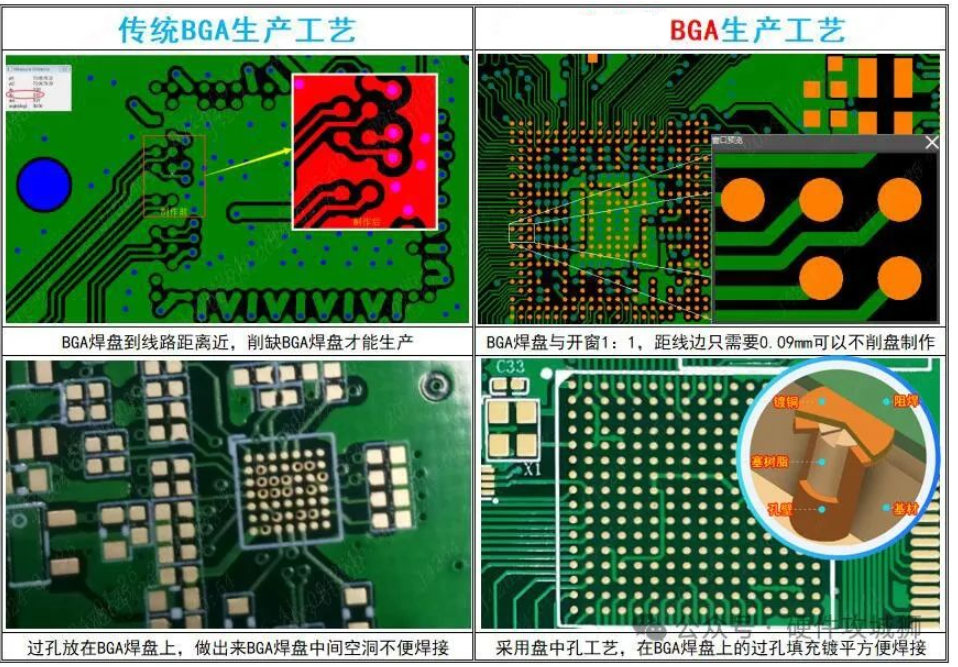
■
常规BGA过孔塞油墨生产工艺

■
高端BGA过孔盘中孔塞树脂/铜浆生产工艺
塞树脂/铜浆的应用,使盘中孔成为精密板布线的最佳选择。同时多层板更新了高端设备,可以制作更精密的BGA焊盘

提示:
1)盘中孔中间不能塞油墨,可以塞树脂或铜浆(铜浆相对树脂导热导电性能高),再镀平BGA盘中孔焊盘2)采用上述盘中孔塞孔工艺的,尽量把过孔(内径)做到0.2mm及以上,焊盘(外径)设计在0.35mm及以上。3)多层板少部分线宽可以做到极限0.076mm(即3mil),能够做宽的尽量按0.09mm制作。
审核编辑:黄飞
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
钽电容的生产工艺2012-09-25 0
-
试产资料、生产工艺和异常处理2013-03-28 0
-
电池生产工艺流程2013-10-30 0
-
贴片电阻的生产工艺流程如何2021-03-11 0
-
多层电路板的生产工艺,不看肯定后悔2021-04-26 0
-
芯片生产工艺流程是怎样的?2021-06-08 0
-
PCB六大生产工艺你都了解吗?2022-11-11 0
-
STM32WL MCU的生产工艺(nm)是多少?2022-12-26 0
-
饲料生产工艺流程图2009-03-30 10762
-
瓶酒灌装生产工艺流程图2009-03-30 3579
-
钢铁生产工艺流程图2009-03-30 7390
-
水泥生产工艺流程图2009-03-30 6290
-
太阳能电池生产工艺2009-10-22 944
-
电池钢壳生产工艺流程2009-11-18 8520
-
LCD生产工艺2016-12-29 876
全部0条评论

快来发表一下你的评论吧 !

