

IC Packaging芯片封装模拟方案介绍
描述
引言
IC封装是以固态封装材料 (Epoxy Molding Compound, EMC)及液态封装材料(Liquid Molding Compound, LMC)进行封装的制程,藉以达到保护精密电子芯片避免物理损坏或腐蚀。在封装的过程中包含了微芯片和其他电子组件(所谓的打线)、热固性材料的固化反应、封装制程条件控制之间的交互作用。由于微芯片封装包含许多复杂组件,故芯片封装制程中将会产生许多制程挑战与不确定性。常见的IC封装问题如:充填不完全、空孔、金线偏移、导线架偏移及翘曲变形等。
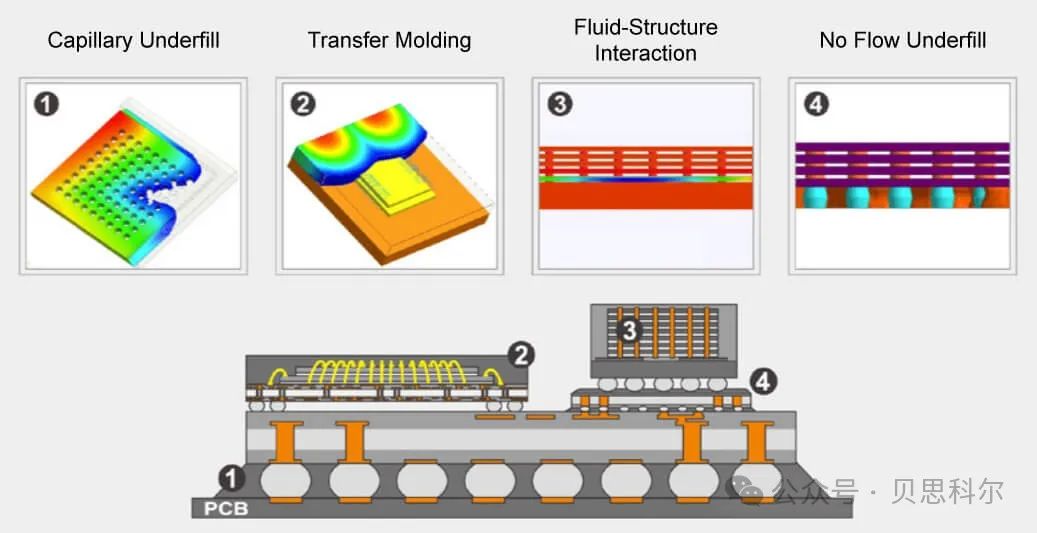
Moldex3D 解决方案
Moldex3D芯片封装模块目前支持的分析项目相当完善,以准确的材料量测为基础,除了基本的流动充填与硬化过程模拟;并延伸到其他先进制造评估,例如 : 金线偏移、芯片偏移、填充料比例、底部填充封装、后熟化过程、应力分布与结构变形等。透过精准的模拟可以预测及解决重大成型问题,将有助于产品质量提升,更可以有效地预防潜在缺陷;藉由模拟优化达到优化设计,并缩减制造成本和周期。
芯片布局评估
显示动态熔胶流动行为
评估浇口与流道设计
优化流动平衡
避免产生气泡缺陷
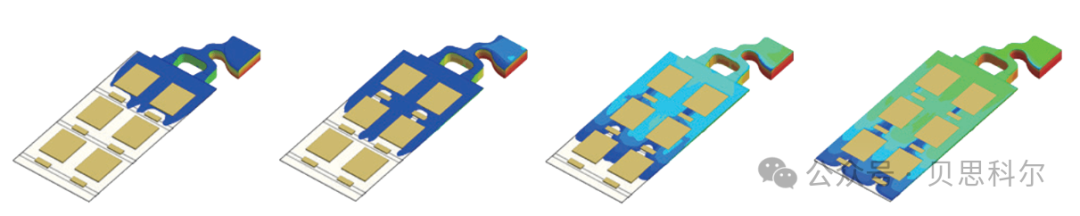
结构验证
应用流固耦合(fluid-structure interaction)算法预测金线、导线架、芯片偏移、芯片变形等行为
可与ANSYS及Abaqus整合,共同分析结构强度
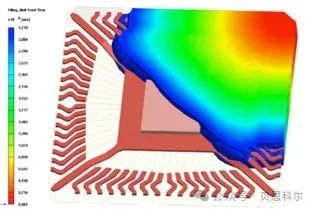

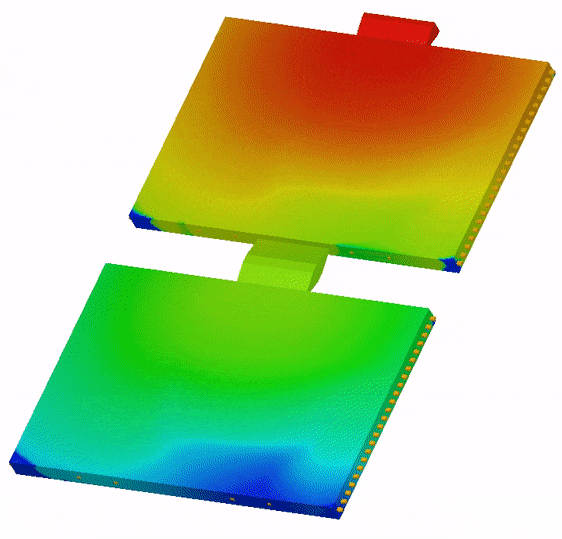
制程条件影响预测
模拟实际生产的多样化制程条件
计算制程改变所造成的温度、转化率和压力分布
预测气泡缺陷(考虑排气效果)与翘曲

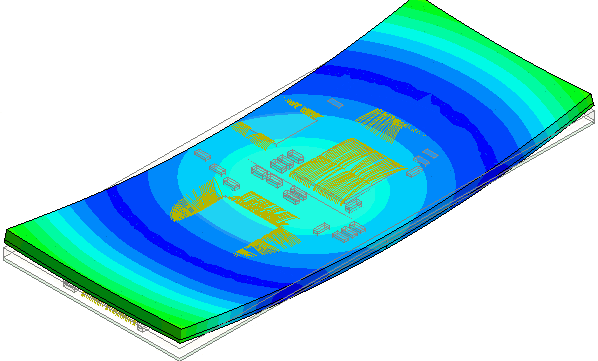
后熟化制程翘曲与应力分析
显示经过后熟化阶段的应力松弛和化学收缩现象
计算温度、转化率与应力分布并预测可能产生的变形

高阶材料特性量测
可量测反应动力、黏度、黏弹性提供流动仿真
黏弹应力释放、化学收缩率、热膨胀收缩效应达成精准预测翘曲
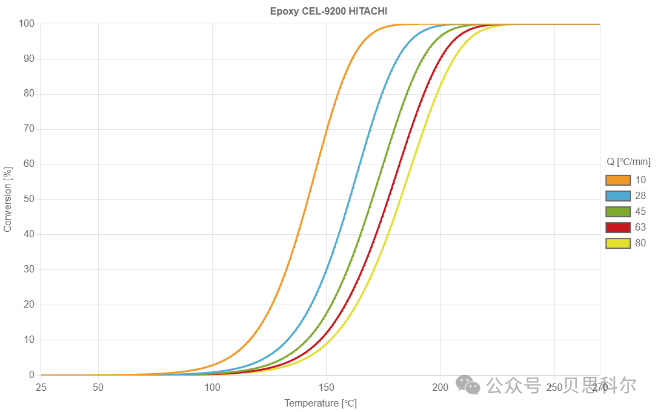
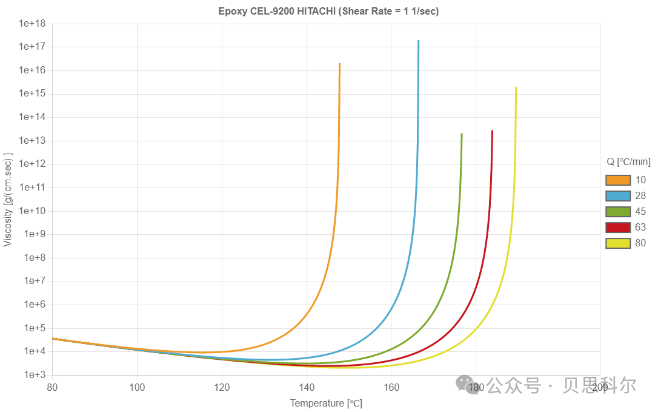
Moldex3D 支持多种封装制程模拟转注成型与覆晶底部填胶模拟。
转注成型与覆晶底部填胶模拟
显示流动与固化过程 ,优化浇口与流道设计
预测潜在成型瑕疵 ,仿真包封与短射
计算气体区域内的压降,优化排气设计
评估制程条件与材料特性,缩短周期时间
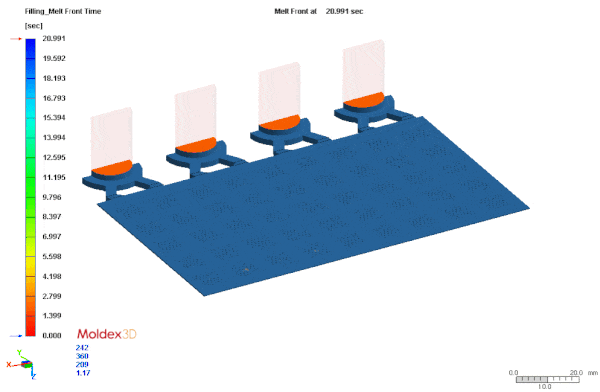
压缩成型与晶圆级封装模拟
显示压缩成型制程的动态流动波前
评估扇出型封装之芯片偏移、翘曲行为与剪切应力分布
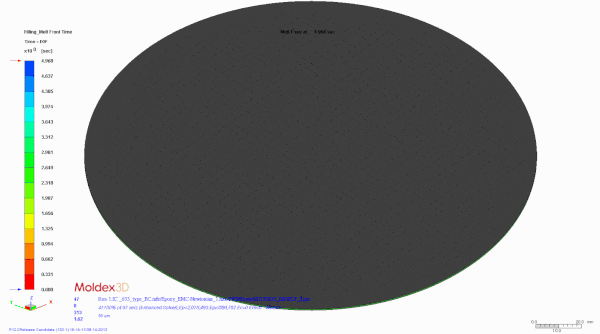
毛细底部填胶模拟
显示在不同表面张力与接触角度下,毛细力所产生的流动行为
评估接点间距与接点分布对流动的影响
优化底胶的点胶路径设定
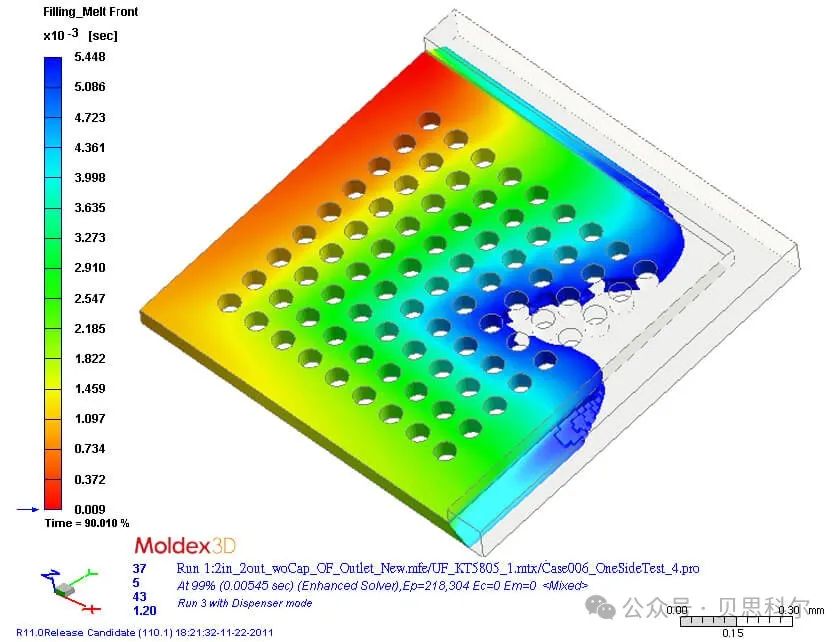

灌胶
更真实且详细的点胶头路径及给料的可视化 (支持potting & dotting)
利用完整的物理模型来仿真表面张力引发现象,如爬胶
方便的建模工具及设定接口来重现多样的制程设计
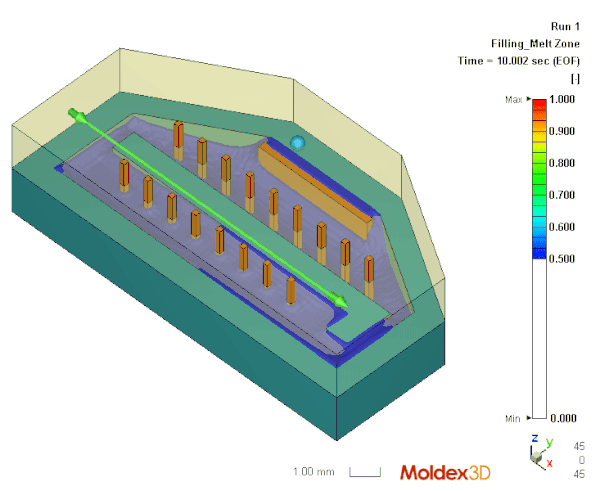
审核编辑:刘清
-
IC芯片封装形式类型2008-06-11 0
-
芯片封装详细介绍2008-06-14 0
-
简单介绍IC的高性能封装2010-01-28 0
-
常用IC封装技术介绍2012-12-05 0
-
电源管理ic芯片--集成电路介绍及原理应用(恒佳兴电子)2015-07-14 0
-
芯片封装介绍2017-07-26 0
-
芯片封装技术介绍2018-11-23 0
-
芯片IC封装形式图片介绍大全2007-11-10 6133
-
ic芯片封装尺寸2016-01-12 806
-
功率ic是模拟芯片吗?功率ic和模拟ic的区别是什么?2023-02-23 4863
-
IC封测中的芯片封装技术2023-08-25 1370
-
IC Packaging 芯片封装模拟方案2024-04-17 85
全部0条评论

快来发表一下你的评论吧 !

