

电子灌胶封装——成就高精度电子灌胶未来
描述
引言
使用聚氨酯(PU)、硅胶或环氧树脂进行电子灌封具有多重优势:
Moldex3D 解决方案
透过 Moldex3D 电子灌封仿真技术,可针对在灌封过程中的流动应力进行模拟,并有效预测气泡位置及大小。同时也提供温度变化、化学反应、固化程度、相变化及收缩过程等综合分析,以准确预测残留应力分布及评估产品外观等缺陷。制程设计确认并改善处理条件
流体、温度、相场和熟化程度的模拟
- 考虑表面张力、毛细力和重力的影响
- 优化浇口和流道设计
- 气泡包封预测
 后熟化翘曲模拟
后熟化翘曲模拟
透过数值模拟观察相变化过程
- 完整考虑应力释放及化学收缩
- 透过温度、熟化率及应力分布模拟,预测后熟化过程中的变形
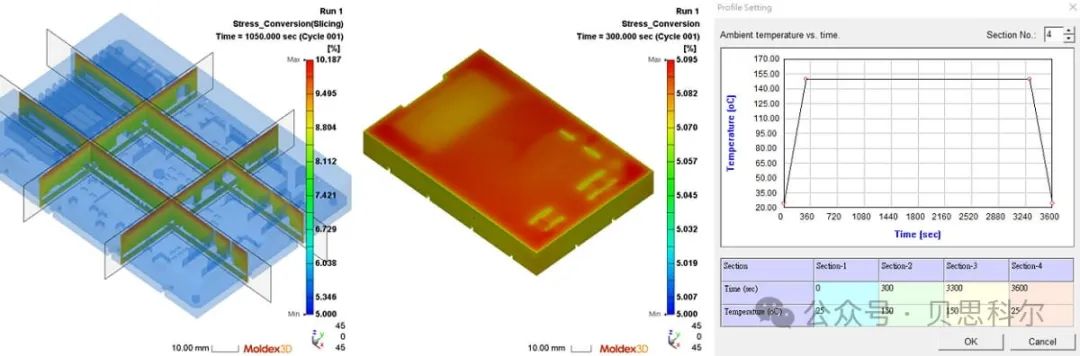 先进材料特性测量及模拟
先进材料特性测量及模拟
测量熟化反应动力学、黏度及黏弹性特性,以进行流动模拟
量测黏弹性应力释放、化学收缩及热膨胀效应,应用于翘曲预测
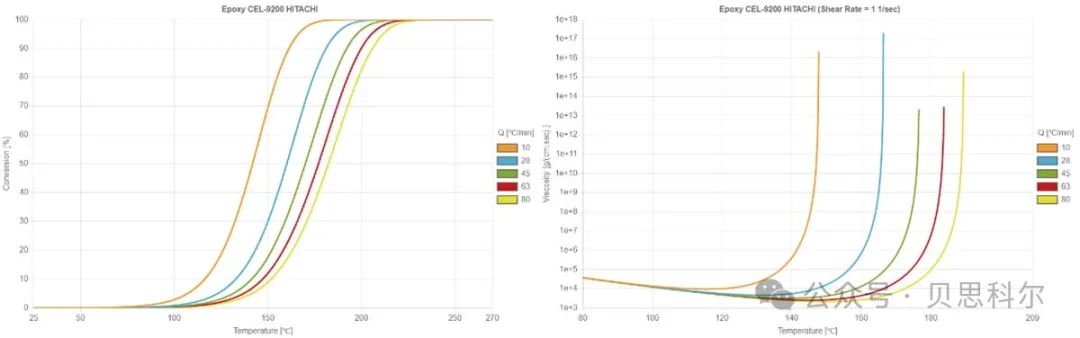
电子灌封常见应用
电子灌封 PCB 组件常应用于板级封装,特别是需以电子灌封增强 PCB 保护的各种电子产品。其封装质量通常取决于封装材料及封装厚度一致性,在灌封制程中,排气设计是最小化气泡数量的关键,以满足规格要求。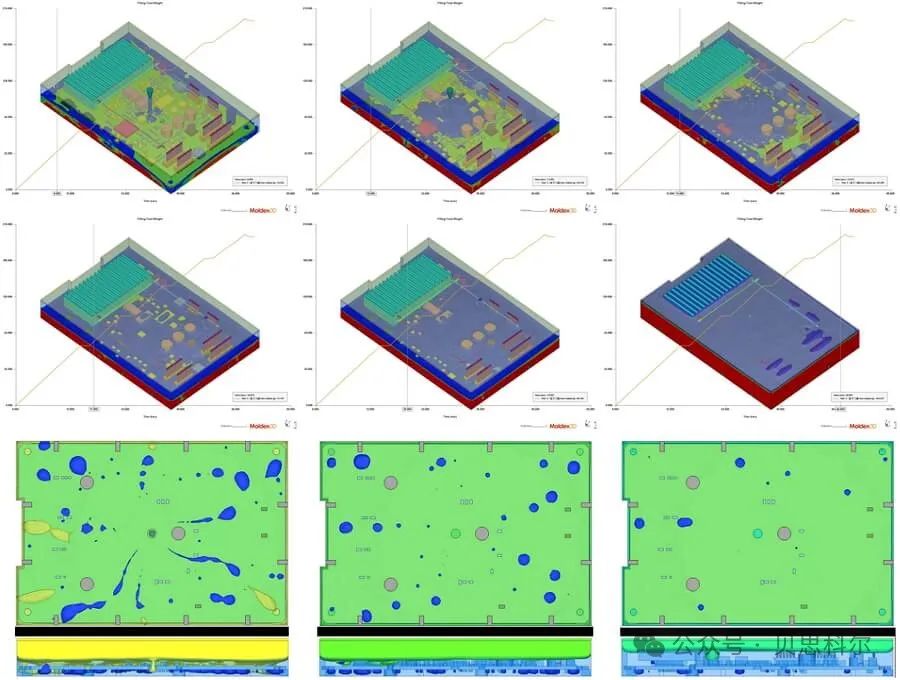 观察空气区的变化,在充填过程中气泡的运动趋势和停滞位置,帮助用户改进产品和排气设计,由于熟化及黏弹性效应,其应力分布会随着时间的推移而变化。Moldex3D 电子灌封仿真制程,有助预测最终残余应力和产品形状,并有效控制气体运动的态势及避免包封形成。
观察空气区的变化,在充填过程中气泡的运动趋势和停滞位置,帮助用户改进产品和排气设计,由于熟化及黏弹性效应,其应力分布会随着时间的推移而变化。Moldex3D 电子灌封仿真制程,有助预测最终残余应力和产品形状,并有效控制气体运动的态势及避免包封形成。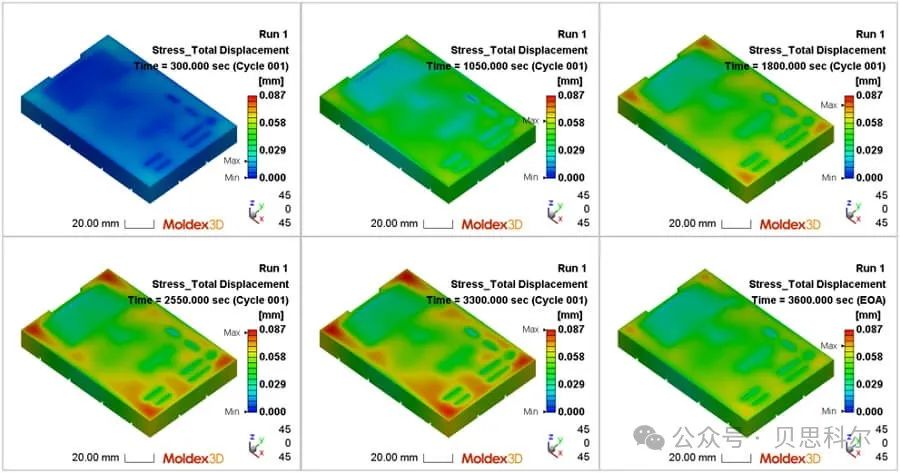 马达转子线圈的电子灌封广泛应用于马达,常使用聚氨酯(PU)或环氧(Epoxy)以保护线圈缠绕组件,有效防止高速旋转造成的磨损、因高频振动而导致的脱落风险,以延长产品的使用寿命。针对控制电路板和微控制器。
马达转子线圈的电子灌封广泛应用于马达,常使用聚氨酯(PU)或环氧(Epoxy)以保护线圈缠绕组件,有效防止高速旋转造成的磨损、因高频振动而导致的脱落风险,以延长产品的使用寿命。针对控制电路板和微控制器。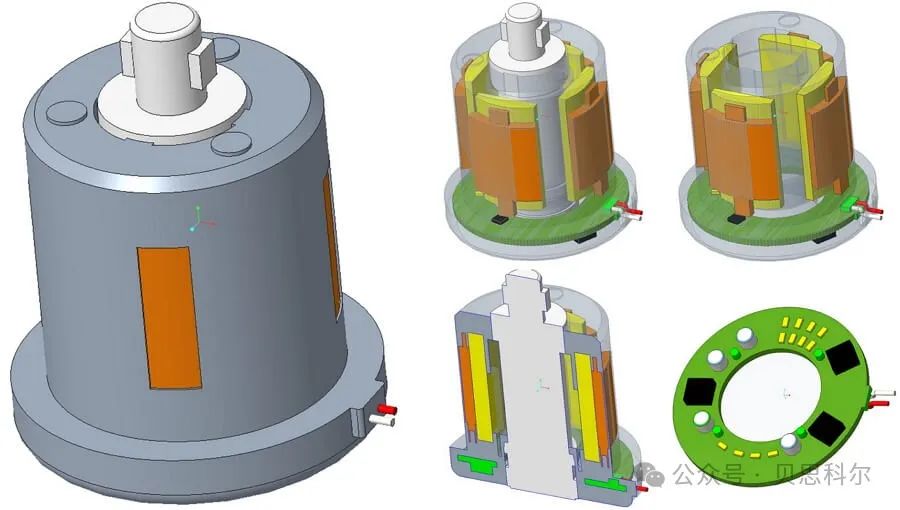 Moldex3D 可预测灌封过程中气泡行程和包封位置,有助选择最适合的材料和最佳的制程参数及制程优化。灌封后的后熟化分析,可深入了解固化时间、化学收缩、及因黏弹性效应引起的应力释放。
Moldex3D 可预测灌封过程中气泡行程和包封位置,有助选择最适合的材料和最佳的制程参数及制程优化。灌封后的后熟化分析,可深入了解固化时间、化学收缩、及因黏弹性效应引起的应力释放。 行动电子产品的封装填充应用于高功率氮化镓(GaN)充电器,能有效电气绝缘、高效散热,并保护电子触点免受物理冲击,使产品提高可靠性和产品寿命。
行动电子产品的封装填充应用于高功率氮化镓(GaN)充电器,能有效电气绝缘、高效散热,并保护电子触点免受物理冲击,使产品提高可靠性和产品寿命。 在灌封过程中,因组件间隙减少,产品设计和材料的选择会显著影响制造的良率和质量,利用数值仿真来获得最佳设计参数和材料选择至关重要。
在灌封过程中,因组件间隙减少,产品设计和材料的选择会显著影响制造的良率和质量,利用数值仿真来获得最佳设计参数和材料选择至关重要。
扫描二维码关注我们
全部0条评论

快来发表一下你的评论吧 !

