

GaN功率HEMT制造中的缺陷及其表征方法
描述
氮化镓具有许多内在材料优势,如宽能隙和高电子迁移率。当用作横向高电子迁移率晶体管(HEMT)器件时,这些特性可用于获得功率转换性能优势,因为其无反向恢复损失且电容相对较小。随着这项技术在更广泛的应用范围内推广,详细理解提高产量和可靠性的根本原因至关重要。本文中,我们总结了在GaN晶圆加工过程中常见的一些缺陷,以及用于检测这些缺陷的表征技术。
01
氮化镓晶体结构和基础衬底
氮化镓衬底的同质外延生长是具有挑战性的,因为它具有高熔点和高解离压力。异质外延生长是常用的方法,其中以Si和蓝宝石作为首选衬底,因为它们的成本(更大的晶圆尺寸)、广泛可用性、高电绝缘性(在蓝宝石的情况下),以及能够使用现有的CMOS工厂并有潜力与CMOS器件集成(在Si的情况下)。热力学稳定的氮面向的六方晶系结构(图1)通常在这些衬底上生长。
 图1
图1尽管碳化硅(SiC)与GaN有更好的晶格匹配和热膨胀系数(TEC)匹配,但这些衬底的成本更高,限制了其在RF和其他小众应用中的使用。表1列出了GaN和常用衬底的一些晶格特性。如今,GaN-on-Si是用于制造基于GaN的功率电子器件的主导技术,在几个6英寸和8英寸的工厂中进行大量生产。
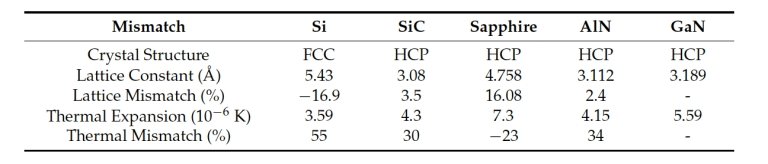 表1
表1
AlGaN/GaN异质结构的极化效应导致形成了用作导电通道的二维电子气(2-DEG),这是HEMT器件运行的基础。
02
氮化镓缺陷
1.生长过程中的螺旋位错和其他位错
GaN与Si之间的显著晶格失配导致了非常高水平的螺旋位错(TDs),大约为1×10^10 cm^2。这些缺陷起源于衬底,并向外延层传播,可以归类为一维或线缺陷。已经进行了大量的工作来优化放置在衬底和GaN通道之间的缓冲层。这些现在可以包括超晶格(例如,GaN/AlN)和一系列低温GaN或AlN中间层的组合。
其他可能出现的位错包括与单个原子位置相关的间隙点缺陷(例如,这些可以在离子注入过程中产生),可以在晶体平面之间出现的二维缺陷,如堆垛故障,以及如纳米管这样的三维体积缺陷。
2.粒子
粒子可以在制造过程中的许多步骤中沉积在晶圆的前表面或后表面。其中一些可能是金属的,如用来沉积缓冲层和外延层的金属有机化学气相沉积(MOCVD)室。晶圆处理也可能是这些问题的主要原因。在Si晶圆加工中使用的标准化学清洗可以用于GaN,以减少这些问题。
3.晶圆弯曲和破裂
GaN和Si之间的大晶格和TEC失配可能导致外延层裂纹、晶圆翘曲或破裂,特别是对于那些需要更厚膜层的更高电压器件。在缓冲层中的应力管理至关重要。晶圆制造中的其他步骤通常需要优化,例如工具中的晶圆夹紧力,退火过程中的温度上升和下降速率,调整擦洗器中的旋转速度等。
03
通常,氮化镓缺陷表征分为三类:
非破坏性:如光学和基于X光的测量
破坏性:如原子力显微镜(AFM)、二次离子质谱(SIMS)、透射电子显微镜(TEM)
在整个器件或测试结构上的电学测量。让我们来看看每种的示例。
光学和X光缺陷检测和表征
一个用于GaN缺陷检测的先进检测工具的例子是KLA Instruments的Candela® 8520。这个工具使用专有光学同时测量来自晶圆表面正常和斜射激光的散射强度,以及表面反射率、地形变化、相移和光致发光(PL)。使用多通道检测的自动全晶圆检查可以检测和分类广泛的缺陷,如图2所示。
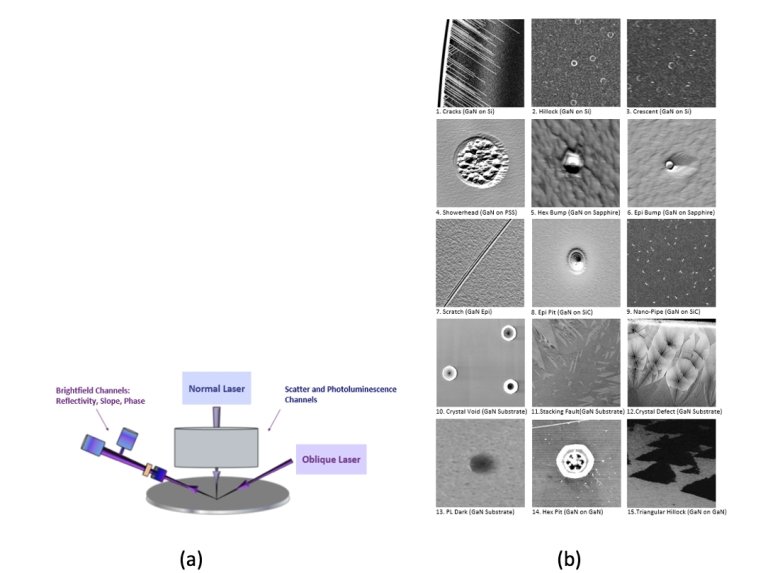 图2
图2
例如,Candela® 平台可以帮助检测在MOCVD生长过程中形成的小山丘和微坑,并标记反应器条件不当。
与用于PL的激光相反,阴极发光(CL)使用高能电子激发材料,然后分析产生的光子。在Horiba Scientifics的CL工具上,当在GaN的带边发射波长(362纳米)成像时,可以检测到GaN外延TD缺陷。
高分辨率X光衍射(HR-XRD)摇摆曲线也常用于表征外延生长中的晶体质量。在[6]中,作者展示了使用这项技术比较在蓝宝石和硅衬底上生长的AlGaN/GaN外延层的一个例子,其中蓝宝石衬底显示出在检测到的波形中更紧密的峰值。这可以归因于GaN与蓝宝石之间更好的晶格和TEC匹配。
04
微光显微镜和透射电子显微镜介绍
微光显微镜(EMMI)通常用于半导体产品和设备故障分析,当电气泄漏是故障特征时尤其如此。当泄漏在空间上局部化时,它可能非常有用。产品在特定泄漏水平下进行电偏置,可以使用红外检测来识别故障位置。EMMI的现场大小通常在1微米范围内,一般来说太大,无法精确定位晶体缺陷。
作者们用EMMI与扫描电子显微镜(SEM)和扫描透射电子显微镜(STEM)成像的创新组合,来识别在高温反向偏置应力测试(RBSTs)期间形成在GaN HEMT器件中的个别位错。一个集成的系列p-GaN电阻器被用来与该设备一起限制电流,防止设备遭受灾难性损坏。
EMMI最初被用来将RBST期间泄漏增加与2个不同设备宽度上的9个位置相关联。在EMMI站点附近用聚焦离子束(FIB)创建的孔洞,作为后续TEM分析期间的参考点。
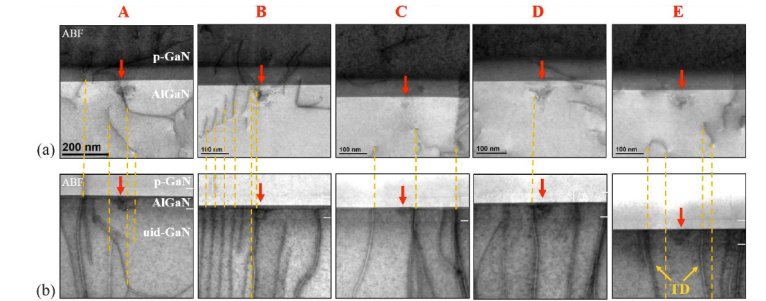 图3
图3接下来,使用平面STEM将这些站点与AlGaN屏障层的结构退化相关联。采用了环形亮场(ABF)和高角环形暗场(HAADF)检测的组合。
ABF将TDs突出为线条,而HAADF识别小裂纹和结构缺陷。然后使用横截面TEM成像来可视化这些缺陷,并进一步将它们与体积内某个特定位错相关联。因此,可以在缺陷地点创建一个三维位错路径,如图3所示。
这种分析组合被用来得出结论,AlGaN/GaN结构中的预存TDs并不总是导致RBST下观察到导致泄漏的缺陷的原因。在这项工作中,场板未用于降低栅附近的电场,可能是p-GaN/AlGaN界面处的高场是RBST泄漏的原因。
-
基于HEMT的ADS功率放大器软件仿真2018-11-13 0
-
GaN HEMT工艺全流程2023-05-25 1466
-
GaN HEMT在电机设计中有以下优点2019-07-16 0
-
为什么GaN会在射频应用中脱颖而出?2019-08-01 0
-
GaN HEMT可靠性测试:为什么业界无法就一种测试标准达成共识2020-09-23 0
-
基于GaN HEMT的半桥LLC优化设计和损耗分析2023-09-18 0
-
Teledyne e2v HiRel新增两款大功率GaN HEMT2021-01-09 2847
-
高功率GaN HEMT的可靠性设计2022-09-19 1779
-
GaN功率HEMT设计+GaN宽带功率放大器设计2023-01-30 597
-
GaN HEMT外延材料表征技术研究进展2023-02-20 999
-
GaN HEMT大信号模型2023-05-24 1523
-
GaN单晶衬底显著改善HEMT器件电流崩塌效应2023-06-14 1880
-
GaN HEMT为什么不能做成低压器件2023-12-07 426
-
微波GaN HEMT 技术面临的挑战2023-12-14 207
-
同是功率器件,为什么SiC主要是MOSFET,GaN却是HEMT2023-12-27 1550
全部0条评论

快来发表一下你的评论吧 !

