

SiC与GaN 功率器件中的离子注入技术挑战
描述
碳化硅 (SiC) 和氮化镓 (GaN) 等宽带隙 (WBG) 半导体预计将在电力电子器件中发挥越来越重要的作用。与传统硅 (Si) 设备相比,它们具有更高的效率、功率密度和开关频率等主要优势。离子注入是在硅器件中产生选择性掺杂的主要方法。将其用于宽带隙器件处理时存在一些挑战。在本文中,我们将重点介绍其中的一些,同时总结它们在 GaN 功率器件中的一些潜在应用。
01
有几个因素决定了离子注入掺杂剂物质在半导体器件制造中的实际用途:
在占据的晶格位点中存在低电离能。Si 具有可电离的浅施主(对于 n 型掺杂)和受主(对于 p 型掺杂)元素。带隙内较深的能级导致电离不良,尤其是在室温下,因此对于给定的注入剂量,电导率较差。
可以在商业离子注入机中离子化和注入的源材料。可以使用固体和气体源材料化合物,并且这些化合物的实际用途取决于温度稳定性、安全性、离子生成效率、产生可质量分离的独特离子的能力、实现给定目标所需的能量植入深度等

表 1:SiC 和 GaN 功率器件中常用的掺杂剂种类
植入材料内的扩散率。正常注入后工艺条件下的高扩散率可能会导致难以控制的结和掺杂剂移动到器件中不需要的区域,从而降低器件性能
激活和伤害恢复。掺杂剂激活涉及在高温下产生空位,从而允许注入的离子从间隙位置移动到替代晶格位置。损伤恢复是修复植入过程中产生的非晶化和晶体损伤的关键。
表1中列举了SiC 和 GaN 器件制造中常用的一些掺杂剂及其电离能。
SiC 和 GaN 中的 n 型掺杂都存在相对浅的掺杂物质,然而,通过离子注入创建 p 型掺杂的一个关键挑战是可用元素的高电离能。
02
GaN 的一些关键注入和退火特性包括:
与SiC不同的是,与室温相比,使用热注入并没有明显的优势。
对于GaN,常见的n型掺杂剂Si可以是两性的,即根据其占据的位置表现为和/或p型掺杂剂。这可能取决于 GaN 生长条件,并产生部分补偿效应。
GaN 的 P 掺杂更具挑战性,因为未掺杂的 GaN 中电子的高背景浓度需要高水平的镁 (Mg) p 掺杂剂来将材料转换为 p 型。然而,高剂量会产生高水平的缺陷,导致载流子在更深能级的捕获和补偿,从而导致掺杂剂活化不良。
GaN 在大气压下温度高于 840°C 时会分解。这会造成 N 的损失并在表面形成 Ga 液滴。SiO 2等覆盖层以及各种形式的快速热退火 (RTA) 都可以提供帮助。退火温度通常比 SiC 所用的温度低 (< 1500°C)。已经尝试了高压、多循环RTA、微波和激光退火等多种方法。即便如此,实现 p+ 注入结仍然是一个挑战。
03
在垂直 Si 和 SiC 功率器件中,边缘终止的常见方法是使用通过离子注入创建的 p 型掺杂环。如果可以实现这种选择性掺杂,垂直 GaN 器件的形成同样会变得更容易。镁掺杂离子注入结面临许多挑战,下面列出了其中一些挑战。
1.高电离势(如表1)
2.植入过程中产生的缺陷可能会产生永久性的簇,导致失活。
3.需要相对较高的温度(>1300°C)才能实现激活。这高于 GaN 的分解温度,因此需要特殊的方法。一个成功的例子是使用N 2压力为1 GPa 1的超高压退火(UHPA) 。1300-1480°C 退火导致> 70% 的活化,并具有良好的表面载流子迁移率。
4.在这些高温下,镁扩散与受损区域的点缺陷相互作用,可导致分级结。即使采用 MOCVD 或 MBE 生长工艺,p-GaN e 模式 HEMT 中 Mg 分布的控制也是一个关键挑战。
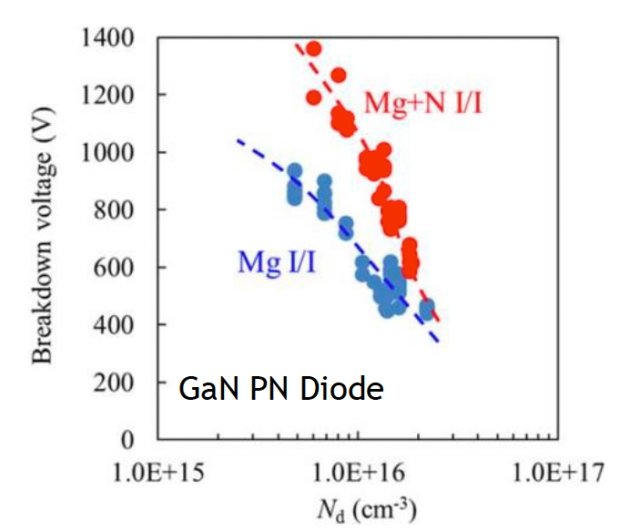
图 1:通过 Mg/N 共注入提高 pn 结击穿电压
使用氮 (N) 与 Mg 共同注入已被证明可以改善 Mg 掺杂剂的活化并抑制扩散 [3]。作者将激活的改善归因于 N 注入对空位聚集的抑制,这实际上是在 1200°C 以上的退火温度下与这些空位重新结合的原因。此外,N 注入产生的空位对 Mg 的捕获限制了扩散,从而导致结更陡。这一概念被用于通过全离子注入工艺制造垂直平面 GaN MOSFET 4。该 1,200 V 器件的特定通态电阻 R DSon达到了令人印象深刻的0.14 Ohms-mm 2。如果该流程能够用于大规模制造,则可以具有成本效益,并且遵循 Si 和 SiC 平面垂直功率 MOSFET 制造中常用的工艺流程。如图 1 所示,共注入方法的使用加速了 pn 结的击穿。
04
由于上述问题,在 p-GaN e 模式高电子迁移率晶体管 (HEMT) 中,镁掺杂 p-GaN 通常可以生长而不是注入。HEMT 中离子注入的一个应用是横向器件的隔离。这里,已经尝试了各种注入物种,例如氢(H)、N、铁(Fe)、氩(Ar)、氧(O)等。该机制主要是与损伤相关的陷阱形成机制。与台面蚀刻隔离流程相比,该方法的优点是器件平坦性。图 2-1描述了所实现的隔离薄层电阻与注入后退火温度的关系。如图所示,可以实现>10 7 Ohms/sq。
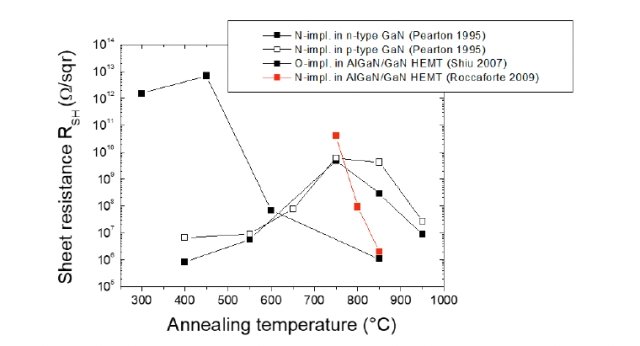
图 2:各种 GaN 隔离注入的薄层电阻与注入后退火温度的关系
虽然已经对使用硅注入在 GaN 层中创建 n+ 欧姆接触进行了多项研究,但由于高杂质浓度和产生的晶格损伤,实际实施可能具有挑战性。使用 Si 注入的动机之一是通过不使用金 (Au) 的 Si CMOS 兼容工艺流程或后续的后金属化合金工艺实现低电阻接触。
05
在HEMT中,已使用低剂量氟(F)注入,利用F的强电负性来提高器件的击穿电压(BV)。在2-DEG电子气的背面产生带负电的区域,其抑制源注入电子到达高场区域5。

图 3:垂直 GaN SBD 的 (a) 正向特性和 (b) 反向 IV 显示出使用 F 注入后的改善
GaN 中离子注入的另一个有趣的应用是在垂直肖特基势垒二极管 (SBD)中使用 F 注入[6]。这里,F 注入位于顶部阳极接触旁边的表面,用于创建高电阻边缘终端区域。如图 3 所示,反向电流降低了 5 个数量级,同时 BV 也提高了。
-
铒离子注入碳化硅后的射程分布和射程离散2010-04-22 0
-
离子注入工艺资料~还不错哦~2012-08-01 0
-
离子注入技术有什么特点?2019-10-30 0
-
如何改良SiC器件结构2020-07-07 0
-
GaN和SiC区别2022-08-12 0
-
4H-SiC离子注入层的欧姆接触的制备2009-02-28 933
-
什么是离子注入技术2011-05-22 5022
-
离子注入技术原理2011-05-22 19083
-
离子注入的特点2011-05-22 4444
-
离子注入设备和方法2011-05-22 7488
-
离子注入技术2011-05-22 1573
-
6.1.4 半绝缘区域的离子注入∈《碳化硅技术基本原理——生长、表征、器件和应用》2022-01-06 444
-
离子注入仿真用什么模型2023-12-21 426
-
离子注入机的简易原理图2024-04-18 384
-
日本住友重工将推出SiC离子注入机2024-05-20 145
全部0条评论

快来发表一下你的评论吧 !

