
资料下载

×
天线效应及其抑制方案探讨
消耗积分:0 |
格式:rar |
大小:0.1 MB |
2017-10-30
天线效应
天线效应或电浆导致闸氧损害是指在MOS晶片制程中,可能发生潜在影响产品良率与可靠性的效应。目前,微影制程采用‘电浆蚀刻’法(或‘干式蚀刻’)制造晶片。电浆是一种用于蚀刻的离子化/活性气体。它可进行超级模式控制(更锋利边缘/更少咬边),并实现多种在传统蚀刻中无法实现的化学反应。但凡事都有两面性,它还带来一些副作用,其中之一就是充电损害。
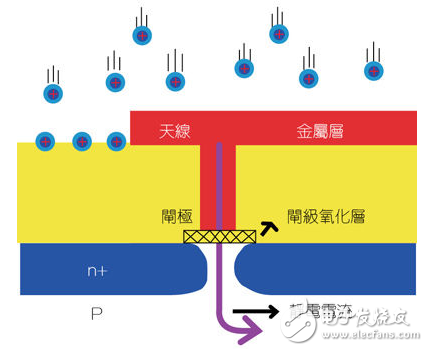
图1:电浆蚀刻过程中的天线效应。
电浆充电损害是指在电浆处理过程中,在MOSFET闸级氧化层上发生非预期的高场应力。在电浆蚀刻过程中,大量电荷聚集在多晶矽和金属表面。透过电容器耦合,在闸级氧化层中会形成较大电场,导致产生可能损害氧化层并改变设备阀值电压(VT)的应力。如下图所示,被聚集的静电荷被传输到闸极中,透过闸级氧化层,被电流穿隧中和。
显而易见地,暴露在电浆面前的导体面积非常重要,它决定静电荷聚集率和穿隧电流的大小。这就是所谓的‘天线效应’。闸极的导体与氧化层的面积比就是天线比率。一般来说,天线比率可看做是一种电流放大器,可放大闸级氧化层穿隧电流的密度。对于特定的天线比率来说,电浆密度越高,穿隧电流越大,也意味着更高的损害。
电浆制造包括3种程序。在导体层模式蚀刻过程中,累积电荷量与周长成正比。而在灰化过程,累积电荷量与面积呈正比。此外,接触蚀刻过程,累积电荷量与通过区域的面积成正比。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。 举报投诉
评论(0)
发评论
- 相关下载
- 相关文章








