

晶体管射频放大器参数测量的进展和意义
RF/无线
描述
2008年射频功率晶体管取得明显进展,以硅材料为主的双极和CMOS工艺都有突破性进展,特别是应用在L波段的场效应晶体管,输出峰值功率1000W的集成电路就有多种型号可供选择,为构建雷达、航空电子应用的KW级固体放大器提供方便。而在十年前,半导体业只能供应峰值功率100W的射频晶体管,为了获得1000W的峰值功率,末级放大器的驱动级需要采用功率分配器,由10个功率晶体管构成5组独立的推挽电路,再经功率合成器合成额定的输出功率。由此可知,相应的供电电源、电路板的占用面积、散热等问题都有一定难题,整个输出模块的成本随之增加。设备的可靠性却不高,因为末级功率放大器的器件、元件数的增加,导致故障率变坏。总的来说,峰值KW级的射频固体放大器的性能价格比还有待提高。
进入2000年后,集成电路的材料、工艺、设计、测量、封装各方面出现许多创新,例如材料方面Si的晶圆从150mm扩大到800mm,单位缺陷亦随着降低;工艺方面的离子注入、扩散外延、金属布线的可靠性提高,使器件线宽从1?m缩小到60nm以下,设计自动化覆盖从生产链的前段到后段;测量手段更加完善,电学参数可在晶圆级上实施;多芯片三维互连封装代替晶圆级颗片互连或多芯片电路板级互连等等,不但促进集成电路的发展,对射频功率晶体管的提高同样有效。
近年来功率晶体管参数测量的进展具有重要意义,功率晶体管往往要在非线性状态下工作,过去只有显示小功率状态下的特性曲线测试仪,只有测量线性状态下的网络分析仪、频谱分析仪和功率计,而无法获得功率晶体管在非线性工作条件下的直流参数和交流参数。结果影响到不能建立完整的高频放大器模型,妨碍高频功率晶体管的应用和发展。众所周知,高频晶体管在非线性工作状态下的各项参数的重要测量仪器陆续推出,解决KW级的射频/微波晶体管建模难点,设计自动化,提高高频晶体管的性能等问题亦迎刃而解。此外,高频晶体管大部分在封装内部或芯片上设置输入端和输出端的匹配网络,极大地简化外电路设计,提高频率、效率、功率都有帮助。加上集成电路的其它革新的推动,现今射频功率晶体管已进入KW级峰值的新阶段。
双极型射频功率晶体管
在当前的射频功率晶体管领域内,传统的Si衬底同质双极器件,以及性能更好的GaAs衬底异质结双极器件都有大量产品可供选择。Si基双极器件的工艺最成熟,成本较低,但频率响应亦较低。随着GaAs材料的出现,由于异质结的电子/空穴迁移率比Si的迁移率高得多,使得GaAs双极晶体管具有频率性能的优势,但成本亦相应较高。在射频功率放大器应用中,Si和GaAs两种材料各有优点和缺点,近年来两者都有创新,传统材料会重新挖潜以满足下一代产品的需要,新型材料会不断革新。
Si材料和GaAs材料在场效应晶体管方面取得比Si双极晶体管更大的进展,但Si双极晶体管仍然有不错的表现。2008年美国Microsemi公司推出TAN500的Si双极晶体管,在960MHz至1215MHz频带内产生500W的脉冲功率,主要针对TACAN(塔康)战术空中导航系统的应用。器件用+50V电源供电,在C类工作状态下由10?s脉冲调制的70W信号驱动,获得500W的峰值功率输出,功率增益最小10dB,集电极效率达到40%。
Si双极射频功率放大器末级采用共基极电路连接,器件内部布线由Au的薄膜金属化形成,基区的外延扩散和发射极的镇流扩散改善了器件的放大性能和提高电路的稳定,器件具有很高的平均故障率。器件的发射极输入和集电极输出预置了宽带匹配电路,散热体与基极之间的热阻很低,为射频末级功率放大器增加输出功率提供良好的基础。TAN500 Si双极晶体管的最大额定值如下:功率耗散Pd在25℃环境温度和脉冲工作状态下是2500W;集电极击穿电压BVc是65V;发射极击穿电压BVe是3V;集电极电流50A;存储温度是-65至200℃;工作结温+200℃。TAN500在25℃环境温度下的工作特性如表1所示。

表1 TAN500 Si双极晶体管的工作特性
TAN500的典型输入/输出特性曲线和集电极效率曲线如图1和图2所示。从图中可见,在90MHz、1090MHz和1215MHz频率下,输入功率/输出功率有不错的线性关系,而且在额定峰值输出功率500W下,集电极效率超过40%。对于Si双极晶体管射频末极功率放大器来说,TAN500的整体指标处在领先水平。目前TAN系列已有TAN300、TAN350和TA500等多种型号,分别是输出功率300W、350W和500W的同族产品,而且1000W以上的型号将很快推出。实际上,Microsem公司在2005年生产的MDS系列Si双极射频功率晶体管中,MDS1100是用于航空电子设备末级功放的器件。它在+50V电源和1030MHz下可提供超过1000W的峰值功率输出,在20℃环境温度下最大功耗是8750W,最高工作温度可达+200℃,最低集电极效率是45%。TAN系列晶体管的设计理念与MDS系列的完全相同,但是对设计参数进一步优化,达到特性参数最佳的目的。
由此可见,传统的双极功率晶体管,经过革新挖潜,能够以新的面目出现,用来满足新应用的需求。由于Si双极功率晶体管匹配性较好,并联应用可获得更大峰值输出,TAN500双管并联即可产生1000W的峰值功率。除Si双极之外,GaAs双极射频功率晶体管同样取得不少改进,限于篇幅,在此从略。
MOS场效应射频功率晶体管
自70年代开始,Si的CMOS集成电路一直是CPU、DSP和存储器的核心工艺,按摩尔定律不断发展,依靠缩小几何尺寸来提高性能价格比。相对来说,Si CMOS工艺应用到高频功率器件的困难较多,SiMOS场效应晶体管需要大几何尺寸,比增加功率和降低热耗,从而使频率特性不容易提高。早期的SiMOS场效应功率晶体管沿着横向扩大几何尺寸,称为横向扩散MOS晶体管(LDMOS),90年代出现沿着纵向布局的纵向扩散MOS晶体管(VDMOS),近年两种不同设计的MOS高频功率晶体管都取得硕果。
2008年飞思卡尔(Freescale)公司提供的MRF6系列针对L波段的雷达应用,峰值功率330W,它的结构如图4a所示。例如MRF6V14300H的功率增益Gps、漏极效率nD和回波损耗IRL的频率特性如图3所示,工作特性如表2所示。

表2 MRF6V14300H SiMOS场效应晶体管的工作特性
而且,借助MRF6V14300H的双管并联可实现峰值功率600W的输出功率。飞思卡尔公司提供与传统的横向扩散的MOS场效应晶体管不同,纵向扩散的MOS场效应晶体管向垂直布局,更适合于射频功率放大的应用。如图4b所示,前者的源极、栅极和漏极是在Si衬底上方横向布局,为了获得良好散热,源极和漏极都要经过约100?m厚的Si材料到达散热体,而后者的漏极处在Si衬底上面,源极和栅极处在Si衬底的底部,源极直接与散热体接触,漏极与散热体的距离缩短至10?m。结构的改变导致击穿电压增加,极间电容减小,导通电阻降低,纵向扩散布局使得SiMOS场效应晶体管的频率、峰值功率和功耗都有所提高。
例如利用纵向扩散布局来实现射频功率的MOS场效应晶体管是HVVi半导体公司,它的HVVFET高压垂直场效晶体管系列产品在2008年四月推出,目标是针对要求具有高的峰值/平均功率比的TACAN导航雷达、TCAS交通防撞系统、IFF敌我识别机、Mode-S询问机,以及3G无线移动通信发射机,如WCDMA、TD-SCDMA和光纤OFDM系统等的紧迫应用。
目前,HVVi公司已生产的HVV系列,包括三种按频率和输出功率划分的器件,它们分别是HVV-1011、HVV-1012、HVV-1214,覆盖L波段的1030-1090、1025-1150、1200-1400MHz频段,和25、30、50、100、200、300W输出功率的序号。这些高压垂直场效应晶体管全部采用+48V的漏极电压,功率增益15至20dB,效率48至49%,达到美国军标的HV400封装标准。以HVV1011-300为例,它的工作频率1030至1090MHz。峰值功率300W,工作电压+48V,工作电流100mA。在共源极AB类工作状态下具有如图5a和图5b所示的输出/输入和增益/效率特性曲线,以及表3所示的工作特性。根据表1、2、3的对比可见,除输出功率一项之外,SiMOS的场效应晶体管的工作特性显然优于Si双极型晶体管,而且HVVi公司即将推出输出功率更高的器件。一种HVV1011-300实验模块如图6所示。

表3 HVV1011-300Si高压垂直场效应晶体管的工作特性
HVVi公司还提供HVV系列器件的完整原型机开发套件和样管,以及测量器件参数的PCB布线图,双管并联运行等有用数据,应用手册等资料。
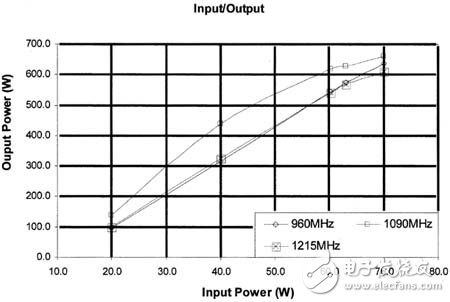
图1 TAN500 Si双极晶体管的输入/输出特性
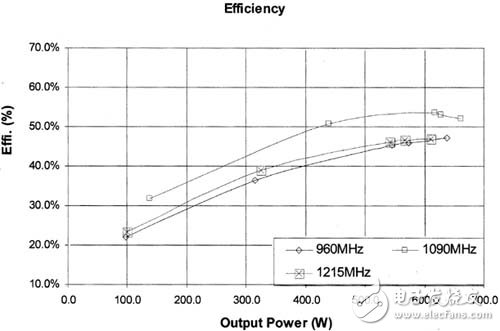
图2 TAN500 Si双极晶体管的效率特性
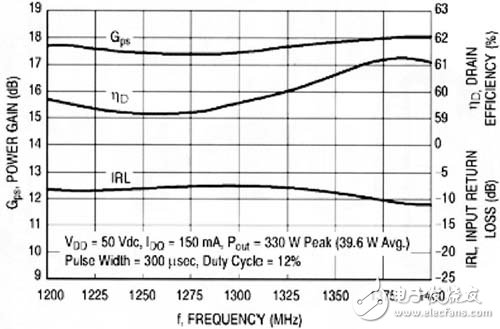
图3 MRF6V14300H Si场效应管的增益、效率和回波损耗特性

图4 LDMOS场效应管和VDOS场效应管的结构简图
-
晶体管放大器设计2009-03-20 0
-
射频放大器的种类和结构2017-11-03 0
-
【转帖】射频放大器的种类和结构2017-11-06 0
-
射频放大器基础知识分享2019-01-14 0
-
基于MOS场效应管的大功率宽频带线性射频放大器设计概述2019-06-19 0
-
运放式射频放大器与传统射频放大器相比,,有何不同?2021-04-14 0
-
什么是射频放大器?2021-05-17 0
-
晶体管低频放大器相关资料推荐2021-06-02 0
-
射频放大器的基础知识分享2023-11-20 0
-
射频放大器概述2016-06-29 762
-
什么是射频放大器_射频放大器的种类和结构2017-11-01 5978
-
如何选择合适的射频放大器,不同射频放大器之间有何区别?2022-08-11 2389
-
射频放大器作用是什么_射频放大器的主要指标2023-02-21 2091
-
射频放大器的原理和作用(射频放大器和功率放大器的区别)2023-05-16 1470
-
射频放大器的主要指标包括 射频放大器的作用2024-02-18 311
全部0条评论

快来发表一下你的评论吧 !

