

EUV微影技术7nm制程正在接近 5nm制程还比较遥远
半导体新闻
描述
EUV被认为是推动半导体产业制造更小芯片的重要里程碑,但是根据目前的EUV微影技术发展进程来看,10奈米(nm)和7nm制程节点已经准备就绪,就是5nm仍存在很大的挑战。
EUV微影技术将在未来几年内导入10奈米(nm)和7nm制程节点。 不过,根据日前在美国加州举办的ISS 2018上所发布的分析显示,实现5nm芯片所需的光阻剂仍存在挑战。
极紫外光(extreme ultraviolet;EUV)微影技术将在未来几年内导入10奈米(nm)和7nm制程节点。 不过,根据日前在美国加州举办的年度产业策略研讨会(Industry Strategy Symposium;ISS 2018)所发布的分析显示,实现5nm芯片所需的光阻剂(photoresist)仍存在挑战。
同时,EUV制造商ASML宣布去年出货了10台EUV系统,今年将再出货20至22台。 该系统将拥有或至少可支持每小时生产125片晶圆所需的250W雷射光源。
IC Knowledge总裁Scotten Jones表示:「在7nm采用EUV的主要部份已经到位,但对于5nm来说,光阻剂的缺陷仍然高出一个数量级。 」
经过20多年的发展,新的和昂贵的系统均有助于为下一代芯片提供所需的优质特性,并缩短制造时间。 Scotten说,这些系统将首先用于制造微处理器等逻辑芯片,随后再应用于DRAM,但现今的3D NAND闪存芯片已经不适用了。
「EUV大幅减少了开发周期以及边缘定位的误差。。.,但成本降低的不多,至少一开始时并不明显。 此外,还有其他很多的好处,即使没什么成本优势,它仍然具有价值。 」
Jones预计,ASML将在2019-2020年之间再出货70台系统。 这将足以支持在Globalfoundries、英特尔(Intel)、三星(Samsung)和台积电(TSMC)规划中的生产节点。

除了EUV系统本身,其他重要的挑战还包括薄膜、光罩测试仪和抗蚀剂
Jones表示,ASML计划将系统的正常运行时间从现在的75%提高到90%,这同时也是微影技术业者最关切的问题。 此外,他表示相信该公司将会及时发布所需的薄膜,以保护EUV晶圆避免微尘的污染。
为了开发针对5nm可用的抗蚀剂,「我们有12到18个月的时间来进行重大改善。 业界将在明年产出大量晶圆,这将有所帮助。 」Jones并估计,到2019年晶圆厂将生产近100万片EUV晶圆,到了2021年更将高达340万片晶圆。
ASML的目标是在2020年时,将其250W光源所能达到的每小时145片晶圆的吞吐量提高到155片/时。 ASML企业策略和营销副总裁Peter Jenkins在ISS上指出,该公司已经展示实验室可行的375W光源了。
目前该公司的薄膜已经能通过83%的光线了,至今也以245W光源进行超过7,000次的晶圆曝光测试了。 然而,第二代7nm节点在搭配用于250W或更高的光源时,预计还需要一个传输率达到90%的薄膜。
GF、英特尔、三星与台积电的7nm版本
Jones谈话中最有趣的部份内容就是对于10nm、7nm和5nm节点的详细分析。 台积电去年秋天通过7nm制程,目前正使用现有的光学步进器实现量产。 他说,Globalfoundries将在今年晚些时候推出类似的制程。
两家公司计划在明年初量产第二代7nm制程,采用EUV制作触点和通孔,将15个光学层数减少到5个EUV层。 这一制程可望缩短周期时间,而且不需要薄膜。
Globalfoundries去年六月份宣布在2019年采用EUV实现7nm的计划。 Jones「台积电私下告诉客户也计划如此。 」琼斯说。
芯片制造商可能必须使用30mJ/cm2剂量的抗蚀剂,这高于其目标的20mJ/ cm2。 他们还可能必须使用电子束系统检查光罩的缺陷,而不是像EUV系统一样使用13.5mm波长寻找缺陷的光化系统。
Globalfoundries、三星和台积电除了使用触点和通孔外,还计划为不同的7nm版本使用EUV和薄膜来制作1x金属层。 这些制程将提供微缩,并使23层光学层减少到9层EUV。
这正是三星将在明年初推出的首款7nm节点,即7LPP。 台积电的7FF+版本,预计将在2019年中期推出,Globalfoundries则将在明年年底推出7LP+。
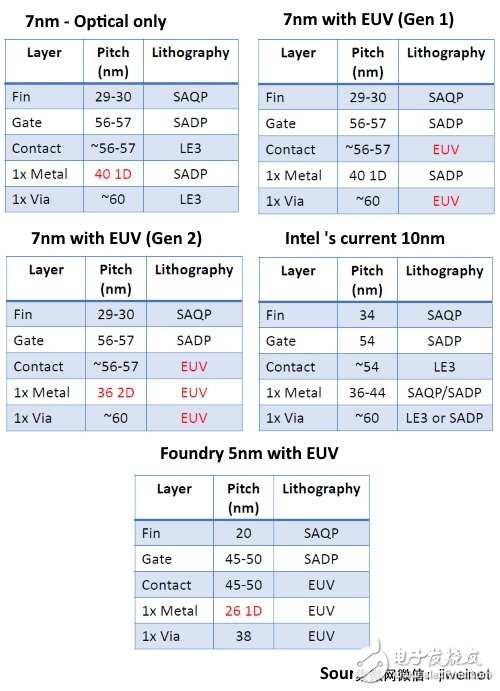
Jones详细介绍了他预计到2020年将会看到的各种10nm、7nm和5nm制程版本
Jones表示,英特尔目前使用的10nm制程采用光学步进器实现量产,提供的密度相当于其竞争对手所能实现的最佳7nm版本。 他预期英特尔将在2019年采用EUV升级10nm+制程。
三星和台积电已经在讨论可能在2019年底前提供5nm制程。 他们应该会是第一批使用EUV制造1D金属层的制造商。 他说,如果有更好的抗蚀剂出现,这个制程就能使用EUV减少多达5个切割光罩,让FinFET减少到仅使用1个光罩。
另外,Jenkins表示,ASML已经为支持高数值孔径(NA)的EUV系统完成光学设计部份了,而且整体设计「顺利」。 该公司已于2016年底宣布计划在2024年量产该新系统。
尽管EUV是推动半导体产业制造更小芯片的重要里程碑,但预计并不至于颠覆目前的芯片制造设备和装置市场。 Jones说,晶圆厂将会持续需要大量的现有资本设备和供应,才能与EUV一起迈向未来的制程节点。
-
最精尖的晶体管制程从14nm缩减到了1nm2016-10-08 0
-
EUV热潮不断 中国如何推进半导体设备产业发展?2017-11-14 0
-
10nm、7nm等制程到底是指什么?宏旺半导体和你聊聊2019-12-10 0
-
全球进入5nm时代2020-03-09 0
-
2020年半导体制造工艺技术前瞻2020-07-07 0
-
为何说7nm就是硅材料芯片的物理极限2021-07-28 0
-
从7nm到5nm,半导体制程 精选资料分享2021-07-29 0
-
台积电计划2020年量产5nm制程2016-11-28 757
-
台积电7nm开始量产 5nm制程将于明年年底投入量产2018-07-02 3061
-
台积电5nm制程试产 脸书5亿用户资料恐外泄2019-04-04 2910
-
苹果iPhone 12有望采用全新5nm EUV工艺制程的A14仿生芯片2019-04-04 1668
-
三星宣布成功完成基于EUV的5nm制程开发 彰显科技引领力2019-04-18 275
-
2020年新款iPhone将采用5nm工艺制程处理器带来了更好的性能和功能2019-06-17 1128
-
台积电在5nm制程和3nm制程之间,他们还将推出4nm制程2020-08-04 2736
-
台积电7nm制程降幅约为5%至10%2023-12-01 530
全部0条评论

快来发表一下你的评论吧 !

