

边界扫描测试技术的原理解析
电子说
描述
边界扫描介绍
边界扫描(Boundary Scan)测试发展于上个世纪90年代,随着大规模集成电路的出现,印制电路板制造工艺向小,微,薄发展,传统的ICT 测试已经没有办法满足这类产品的测试要求。由于芯片的引脚多,元器件体积小,板的密度特别大,根本没有办法进行下探针测试。一种新的测试技术产生了,联合测试行为组织(Joint Test Action Group)简称JTAG 定义这种新的测试方法即边界扫描测试。
随着表面贴装技术的使用,印制电路板(PCB)的密度越来越高,已不易采用传统的针床测试技术。而增加电路测试点、对复杂电路增加附加的测试电路来进行单独测试等方法只是对传统方法的改进,对提高电路可测性十分有限且通用性较差。为提高电路和系统的可测试性,1985年菲利浦电子公司首先倡议并联合欧洲、北美和亚洲其他电子设备制造公司组建了联合测试行动组(Jo int TestA ction Group,JTA G)。1990年2月JTA G与TEEE标准化委员会合作提出了“标准测试访问通道与边界扫描结构”的IEEE114911 1990标准。该标准要求在集成电路中加入边界扫描电路。在板级测试时,可以在模式选择的控制下,构成一条就集成电路边界绕行的移位寄存器链,对板内集成电路的所有引脚进行扫描,通过将测试数据串行输入到该寄存器链的方法,检查发现印刷电路板上的器件焊接故障和板内连接故障,极大地方便了系统电路的调试。IEEE114911标准的推广应用引起测试设备和测试系统的重大变革,边界扫描测试技术正日益成为超大规模集成电路的主流测试技术。
边界扫描测试有2大优点:一个是方便芯片的故障定位,迅速准确地测试两个芯片管脚的连接是否可靠,提高测试检验效率;另一个是,具有JTA G接口的芯片,内置一些预先定义好的功能模式,通过边界扫描通道使芯片处于某个特定的功能模式,以提高系统控制的灵活性和方便系统设计。
边界扫描技术的含义
边界扫描技术是一种应用于数字集成电路器件的测试性结构设计方法。所谓“边界”是指测试电路被设置在集成电路器件功能逻辑电路的四周,位于靠近器件输入、输出引脚的边界处。所谓“扫描”是指连接器件各输入、输出引脚的测试电路实际上是一个串行移位寄存器,这种串行移位寄存器被叫做“扫描路径”,沿着这条路径可输入由“1”和“0”组成的各种编码,对电路进行“扫描”式检测,从输出结果判断其是否正确。
边界扫描的硬件结构
BST的核心思想是在芯片管脚和芯片内部逻辑之间,即紧挨元件的每个输入、输出引脚处增加移位寄存器组,在PCB的测试模式下,寄存器单元在相应的指令作用下,控制输出引脚的状态,读入输入引脚的状态,从而允许用户对PCB上的互连进行测试。BST电路主要包括指令寄存器(IR)、旁路寄存器(BR)、边界扫描寄存器(BSR)和测试访问端口(TA P)控制器。BST电路一般采用4线测试总线接口,如图1所示,如果测试信号中有复位信号(nTRST),则采用5线测试总线接口。5个信号分别为:测试数据输入总线(TD I),测试数据输入至移位寄存器(SR);测试数据输出总线(TDO),测试数据从SR移出;测试时钟总线(TCK);测试模式选择总线(TM S),控制各个测试过程,如选择寄存器、加载数据、形成测试、移出结果等;复位信号总线(TRST),低电平有效。IEEEStd114911测试总线使用TCK的2个时钟沿,TM S和TD I在TCK的上升沿被采样,TDO在TCK的下降沿变化。
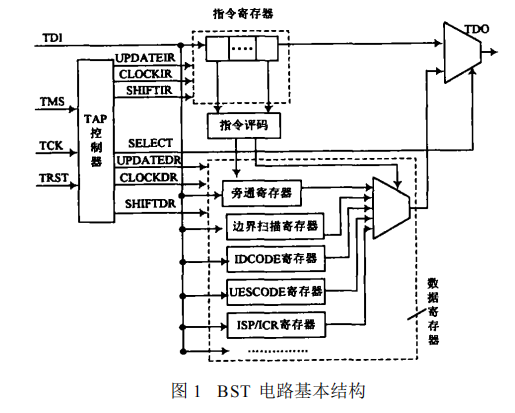
TA P 控制器
TA P控制器是边界扫描测试的核心控制器。在TCK和TM S的控制下,可以选择使用指令寄存器扫描或数据寄存器扫描,以及控制边界扫描测试的各个状态。TM S和TD I是在TCK的上升沿被采样,TDO是在TCK的下降沿变化。TA P控制器的状态机如图2所示。右边是指令寄存器分支,左边是数据寄存器分支。
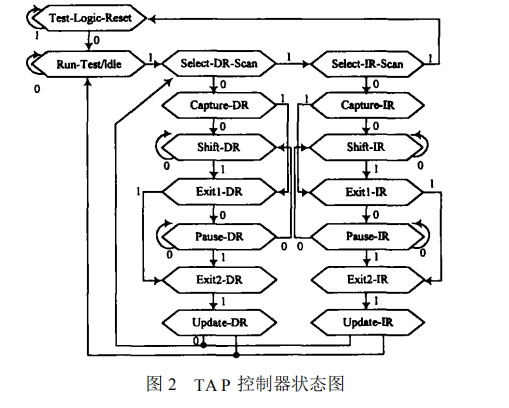
其中,TA P控制器的状态机只有6个稳定状态:测试逻辑复位(Test Logical Reset)、测试运行ö等待(RunTestöIdle)、数据寄存器移位(Shift DR)、数据寄存器移位暂停(Pause DR)、指令寄存器移位(Shift IR)、指令寄存器暂停(Pause IR):其他状态都不是稳态,而只是暂态。
在上电或IC正常运行时,必须使TM S最少持续5个TCK保持为高电平,则TA P进入测试逻辑复位态。这时,TA P发出复位信号使所有的测试逻辑不影响元件的正常运行。若需要进行边界扫描测试。可以在TM S与TCK的配合控制下,退出复位,进入边界扫描测试需要的各个状态。需要测试时,在TM S和TCK的控制下,TA P控制器跳出TLR状态,从选择数据寄存器扫描(Shift DRScan)或选择指令寄存器扫描(Shift IR Scan)进入图2所示的各个状态。Shift DR Scan和Shift IR Scan两个模块的功能类似。
进入每个模块的第一步是捕捉数据(Cap ture),对于数据寄存器,在Cap ture DR状态把数据并行加载到相应的串行数据通道中,对于指令寄存器,则是在Cap ture IR状态把指令信息捕捉到指令寄存器中。TA P控制器从捕捉状态进入移位(Shift)或跳出1(Exit1)状态。通常,Shift状态紧跟Cap ture状态,数据在寄存器中移位。在Shift状态之后,TA P控制器通过Exit1状态进入更新(U pdate)状态或者暂停(Pause)状态。在Pause状态,数据移位暂时终止,可以对数据寄存器或指令寄存器重新加载测试向量。从Pause状态出来通过跳出2(Exit2)状态可以再次进入Shift状态或者经过U pdate状态回到Run TestöIdle状态。在U pdate状态,移入扫描通道的数据被输出。
BST寄存器单元
测试数据寄存器
边界扫描数据寄存器至少应该包括3种:边界扫描寄存器、器件标识寄存器和旁路寄存器。
(1) 边界扫描寄存器构成边界扫描路径,他的每一个单元由存储器、发送ö接收器和缓冲器组成。边界扫描单元置于集成电路的输入ö输出端附近,并首尾相连构成一个移位寄存器链,首端接TD I,末端接TDO。在测试时钟TCK的作用下,从TD I加入的数据可以在移位寄存器链中移动进行扫描。
边界扫描单元(BSC)基本结构如图3所示。其主要作用是加载测试向量和捕捉测试响应。MU X2由M ode信号控制,M ode信号为0时,可以使单元的数据输出与数据输入相连;为1时,数据输出端的数据是DFF2的输出信号,与数据输入端的信号无关。Shift信号控制MU X1,为0时,DFF1采样数据输入端的信号;为1时,进行移位。BSC的工作按照以下4个步骤进行:MU X1在Shift DR模式,移入新的测试向量;MU X2在U pdate DR模式,加载测试向量到单元的数据输出端;MU X1在Cap ture DR模式,捕捉单元并行输入端的响应;MU X1在Shift DR模式,移出响应。
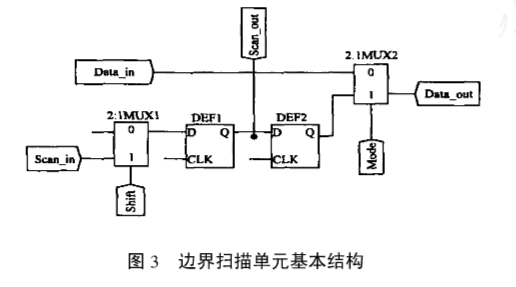
(2) 器件识别寄存器(ID)有32位,其中31~28位是版本号,27~12位是器件序列号,11~1位是厂家标识,第0位为1。借助他可以辨别板上元器件的生产商,还可以通过他来测试是否将正确的器件安装在PCB板的正确位置。器件标识寄存器和边界扫描寄存器可以使用相同的边界扫描单元。
(3) 旁路寄存器(BR)只有1位,他提供了一条从TD I到TDO之间的最短通道,用来将不参加串行扫描的数据寄存器的数据旁路掉,以减少不必要的扫描时间。旁路寄存器的结构如图4所示。在Shift DR模式下,数据直接从Data in到Data out,而不经过任何边界扫描寄存器。
指令寄存器
指令寄存器由串移位级和并行锁存级组成,进行指令的译码,两位指令的指令寄存器的结构如图5所示。其位数由所选指令数决定,常用指令很多。DFF1和DFF2在Cap ture IR和Shift IR的控制下,进行两位指令译码,在U pdate IR模式下指令数据加载到指令输出端,高位在IR out1,低位在IR out2。IEEE114911标准中定义了大量指令,有必须的,有可选的,而且也允许定义更多特定设计的指令来扩展测试逻辑的功能。

此外,除了上述数据寄存器以外,还可以包括用户定义的数据寄存器。
边界扫描测试方式
利用边界扫描技术,可以对集成电路芯片的内部故障、电路板的互连以及相互间影响有比较全面的了解,并通过加载相应指令到指令寄存器来选择工作方式。不同的测试在不同的工作方式下进行。
外测试(EXTEST)
外测试测试IC与电路板上其他器件的连接关系。此时边界扫描寄存器把IC的内部逻辑与被测板上其他元件隔离开来。在EXTEST指令下,给每个IöO端赋一个已知的值用于测试电路板上各集成电路芯片间连线以及板级互连的故障,包括断路故障和短路故障。图6中的3块芯片受相同的TCK和TM S总线控制,各芯片TDO的输出端连接到下一器件TD I的输入端,构成了一条移位寄存器链。测试向量从IC1的TD I输入,通过边界扫描路径加到每个芯片的输出引脚寄存器,而输入引脚寄存器则接收响应向量。图中IC2的B脚接收IC1的A脚寄存器的信号,正常情况下,B脚的值应该为1。但如果AB和CD线间出现了短路,则B脚寄存器接收到的值变成了0。IC3的F引脚寄存器接收IC1的E脚寄存器信号,正常情况下,F脚的值应该为1,但如果引线EF间出现了断路,则从F脚得到的值不是1,而是0。
在电路板的测试中出现最频繁的是断路和短路故障,传统的逐点检查的方法既麻烦又费时,而通过边界扫描技术的外部测试方式,把从TDO端输出的边界扫描寄存器的串行信号与正确的信号相比较,就可以方便有效地诊断出电路板引线及芯片引脚间的断路和短路故障。这是边界扫描技术一个非常显著的优点。
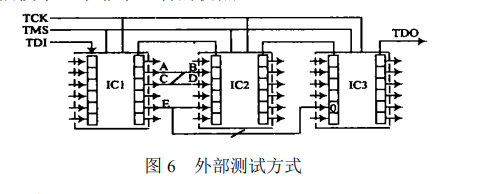
内测试 ( IN TEST )
内测试测试IC本身的逻辑功能,即测试电路板上集成电路芯片的内部故障。测试向量通过TD I输入,并通过边界扫描通道将测试向量加到每个芯片的输入引脚寄存器中,从输出端TDO可以串行读出存于输出引脚寄存器中各芯片的响应结果。根据输入向量和输出响应,就可以对电路板上各芯片的内部工作状态做出测试分析。
采样测试方式 (SAM PL EöPRELOAD )
采样测试方式常用于对一个正在运行的系统进行实时监控。取样ö预置(SAM PL EöPRELOAD),在捕捉阶段从输入端取样,在更新阶段预置BSC,为外测试做准备;移出器件标识(ID Code):选择旁路寄存器,使数据在A SIC间快速移位。此外还有多种测试指令,他们的存在和不断扩充,使边界扫描技术的应用得以拓展和延伸,进行更有效的集成电路测试。
边界扫描技术是一种新的测试技术,虽然他能够测试集成电路芯片的输入ö输出管脚的状态,也能测试芯片内部工作情况以及引线级的断路和短路故障,但是边界扫描技术还处于不断发展之中。他的应用是建立在具有边界扫描电路设计的集成电路芯片基础上的。对于电路板上安装的不带边界扫描电路的器件的测试,边界扫描是无能为力的。今后也不可能将所有的数字集成电路芯片设计上边界扫描电路,因此他也不可能完全代替其他的测试方法。这种方法的突出优点是具有测试性,可以只通过运行计算机程序就能检查出电路或连线的故障,这在可靠性要求高、排除故障要求时间短的场合非常适用。特别是在武器装备的系统内置测试和维护测试中具有很好的应用前景。
-
边界扫描测试技术简介及原理2009-10-15 0
-
一种新的PCB测试技术:边界扫描测试技术2018-09-10 0
-
边界扫描测试技术介绍2022-02-17 0
-
边界扫描测试技术在硬件实验中的应用2009-08-18 566
-
基于广义特征分析与边界扫描技术的混合信号测试系统2010-11-19 614
-
边界扫描与电路板测试技术2006-03-11 1625
-
基于USB总线的边界扫描测试系统2011-07-04 614
-
基于边界扫描技术的板级测试分析2012-05-30 1138
-
边界扫描测试的原理及应用设计2016-02-16 509
-
边界扫描测试技术在带DSP芯片数字电路板测试中的应用解析2017-11-03 1020
-
边界扫描测试的基本原理及其测试系统的设计2017-12-01 1034
-
DSP电路板测试中的边界扫描技术研究综述2021-04-13 580
-
JTAG(四) 边界扫描测试技术2021-12-20 650
-
边界扫描,一种系统级嵌入式测试的使能技术2022-11-15 277
-
边界扫描测试软件XJTAG和TopJTAG介绍2023-09-11 1566
全部0条评论

快来发表一下你的评论吧 !

