

封装/ PCB系统的热分析:挑战和解决方案
描述
越来越多的封装/ PCB系统设计需要热分析。功耗是封装/ PCB系统设计中的一个关键问题,需要仔细考虑热区域和电气区域。为了更好地理解热分析,我们可以以固体中的热传导为例,并使用两个域的对偶性。图1和表1给出了电场和热场之间的基本和基本关系。
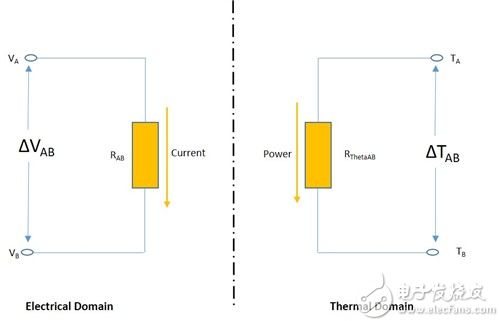
图1.电域和热域之间的基本关系

电和热域之间存在一些差异,例如:
-
在电学领域,电流被限制在特定电路元件内流动,但在热域中,热流通过三种热传导机制中的任何一种或全部从热源发出三维:传导,对流和辐射。
-
元件之间的热耦合比电耦合更加突出且难以分离。
-
测量工具是不同的。对于热分析,红外热像仪和热电偶取代了示波器和电压探头。
当温度梯度存在于固体或固定流体介质中时发生热传导。热对流和辐射是比传导更复杂的热传输机制。热对流发生在固体表面与不同温度下的流体材料接触时。热辐射是来自所有物质的电磁辐射的发射,温度大于绝对零度。图2显示了三种热传输工作图。所有上述热传递机制的一维应用的描述性方程可以表示为表2所示。
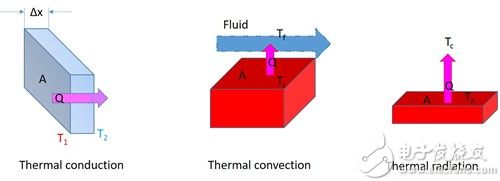
图2.三种热传输机制图

哪里:
Q是单位时间内传热量(J / s)
k是热导率(W /(Km))
A是物体的截面积(m 2)
ΔT是温差
Δx是材料的厚度
h c是对流换热系数
h r是辐射传热系数
T 1是一侧的初始温度
T 2是另一侧的温度
Ť 小号是固体表面的温度(Ô C)
T f是流体的平均温度(o C)
T h是热端温度(K)
T c是冷端温度(K)
ε是物体的发射率(对于黑体)(0〜1)
σ是Stefan-Boltzmann常数= 5.6703×10 -8(W /(m 2 K 4))
Sigrity PowerDC 是一种经过验证的电气和热量技术,多年来一直用于设计,分析和签署实际封装和PCB。集成的电气/热量联合仿真功能可帮助用户轻松确认设计是否符合规定的电压和温度阈值,而无需花费大量精力来筛选难以判断的影响。借助这项技术,您可以获得准确的设计余量并降低设计的制造成本。下图显示了PowerDC用于电气/热量联合仿真的方法:

图3. PowerDC电气/热协同仿真方案图
除了E / T协同仿真外,PowerDC还提供其他与热量有关的功能,例如:
-
热模型提取(图4)
-
热应力分析(图5)
-
多板分析(图6)
-
芯片封装板协同仿真(图7)
借助这些技术和功能,您可以方便快捷地评估包装或印刷电路板设计的图形和数字热流和热辐射。

图4.包热模型提取
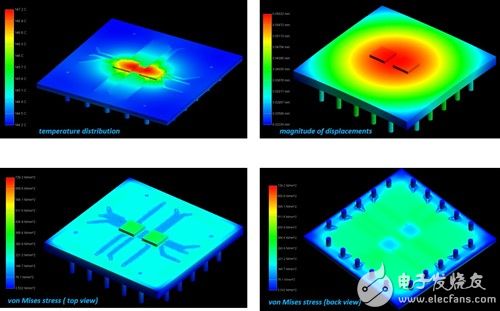
图5.封装热应力分析示例
图6.多电路板热分析
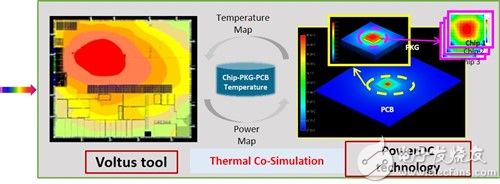
图7.使用Voltus-PowerDC进行芯片封装热协同仿真
-
电力系统设计面临什么挑战?2019-08-20 0
-
无线传感器网络有什么挑战2019-09-17 0
-
无线传感器网络的挑战和解决方案2019-09-17 0
-
高亮度LED照明:设计挑战和解决方案2010-05-08 628
-
智能照明解决方案的挑战和未来-佳比泰智能2016-12-26 858
-
MIPI测试挑战和解决方案的详解2017-11-15 1432
-
探讨无人机空投系统的方法、挑战和解决方案2018-09-10 11213
-
隔离栅极驱动器的常见挑战和应对方案介绍2019-04-23 3374
-
讨论AI与存储器互连的挑战和解决方案2020-12-09 1144
-
WP001-无线传感器网络面临的挑战和解决方案2021-04-25 636
-
无线传感器网络面临的挑战和解决方案2021-04-29 632
-
5G站点电源所面临的挑战和解决措施2021-06-28 518
-
5G基站电源所面临的挑战和解决方案2021-06-28 906
全部0条评论

快来发表一下你的评论吧 !

