

扇出型晶圆级封装工艺流程
描述
由于轻薄短小已经成为电子消费品的发展方向,既能省掉材料及工序,又能缩少元器件尺寸的晶圆级封装工艺,已经越来越普遍了。
晶圆级封装可分为扇入型及扇出型,如果封装后的芯片尺寸和产品尺寸在二维平面上是一样大,芯片有足够的面积把所有的 I/O 接口都放进去,就会采用扇入型。
如果芯片的尺寸不足以放下所有 I/O 接口时,就需要扇出型,当然一般的扇出型在面积扩展的同时也加了有源和/或无源器件以形成 SIP。

扇出型晶圆级封装工艺流程:
晶圆的制备及切割– 将晶圆放入划片胶带中,切割成各个单元准备金属载板– 清洁载板及清除一切污染物
层压粘合– 通过压力来激化粘合膜
重组晶圆– 将芯片从晶圆拾取及放置在金属载板上
制模– 以制模复合物密封载板
移走载板– 从载板上移走已成型的重建芯片
排列及重新布线– 在再分布层上(RDL),提供金属化工艺制造 I/O 接口
晶圆凸块– 在I/O外连接口形成凸块
切割成各个单元– 将已成型的塑封体切割
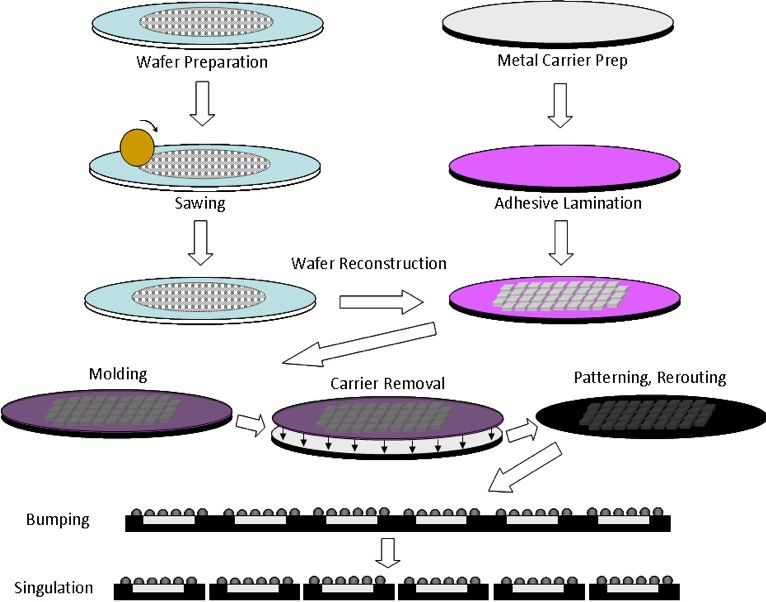
扇出型封装“核心”市场,包括电源管理及射频收发器等单芯片应用,一直保持稳定的增长趋势。扇出型封装“高密度”市场,包括处理器、存储器等输入输出数据量更大的应用,市场潜力巨大。
环球仪器的FuzionSC贴片机,配合Innova直接晶圆送料器
具备以下优势:
最高精度(±10微米)、最高速度、最大面积组装
支持最大达610毫米 x813毫米的基板
支持由AOI精度返馈进行贴装位置补偿
软件支持大量芯片的组装
精准的物料处理及热度阶段选项
可采用SECS-GEM系统追踪晶片
FuzionSC贴片机两大系列


Innova优点:
可直接导入倒装芯片及晶圆级裸晶片来进行拾取及贴装
可在同一平台上进行倒装芯片、裸晶片及表面贴装工序
具备单一晶圆送料(Innova),或13个晶圆送料(Innova +)
无需上游晶圆分选
系统封装应用的最佳方案
支持最大达300毫米的晶圆
支持墨水和无墨水晶圆片阵列测绘
支持最大达610毫米 x813毫米的基板
晶圆扩张深度:可编程(Innova +),由夹圈固定(Innova)
可直接导入倒装或不倒装芯片
具备晶片追踪功能
新品导入或量产的最佳方案
Innova直接晶圆送料器参数

-
扇出式封装的工艺流程2021-10-12 10222
-
晶圆制造工艺流程完整版2011-12-01 0
-
晶圆凸起封装工艺技术简介2011-12-01 0
-
晶圆级CSP贴装工艺吸嘴的选择2018-09-06 0
-
倒装晶片的组装工艺流程2018-11-23 0
-
用于扇出型晶圆级封装的铜电沉积2020-07-07 0
-
SMT组装工艺流程的应用场景2023-10-20 0
-
芯片封装工艺流程-芯片封装工艺流程图2008-05-26 7414
-
ic封装工艺流程2010-07-18 3002
-
LAMP-LED封装工艺流程图2010-03-29 3562
-
集成电路芯片封装工艺流程2021-07-28 12193
-
芯片封装工艺流程是什么2021-08-09 65305
-
封装工艺流程--芯片互连技术2022-12-05 1746
-
扇出型圆片级封装工艺流程与技术2023-05-08 1226
全部0条评论

快来发表一下你的评论吧 !

