

在硅衬底砷化镓量子点激光器中电泵激1.3μm砷化铟的材料生长工艺
电子说
描述
来自日本东京大学的研究团队声称首次实现了在硅衬底砷化镓(GaAs)量子点(QD)激光器中电泵激1.3μm砷化铟(InAs)的材料生长工艺,该砷化镓衬底是利用分子束外延技术(MBE)直接生长在同轴(001)硅衬底上的。
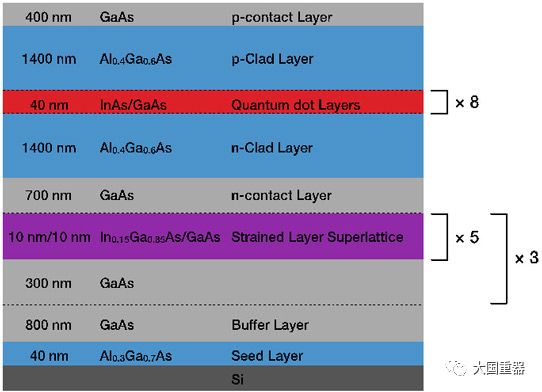
图1为生长在同轴Si(001)衬底上的InAs / GaAs QD激光器材料的示意图
传统方法
沿硅001轴生长通常从金属有机化学沉积(MOCVD)技术开始,继而生长分子束外延量子点层。实现分子束外延技术的替代技术包括切割衬底以防止类似于穿透位错(TDs),反相边界(APB)和裂缝之类的晶体缺陷。不幸的是,离轴硅与主流CMOS电子器件不兼容。 MOCVD不能有效地过滤位错或产生高效发光的量子点。
意义
该团队认为1.3μm激光器的发展有助于推动硅光子学“解决下一代计算的低带宽密度和高功耗等金属布线问题”。
新方法
研究人员将n型衬底作为分子束外延固体源(图1)。首先将腔室加热至950℃进行5分钟的基底退火,然后通过生长一系列三层300nm GaAs层结构,随后产生InGaAs / GaAs应变超晶格,从而实现阻碍穿透位错到达量子点层。量子点区域的穿透位错密度约为5×10 7 / cm 2。 该团队指出,在沉积过程中进行热循环退火可能会导致密度更低。
对于AlGaAs层,500℃的生长温度和1.1μm/小时较高生长速率避免了反相边界,使得反相边界在GaAs缓冲淀积物的400nm内湮灭。
实验结果
量子点横向测量约30nm,密度为5×10 10 / cm 2。来自该结构的光致发光具有来自在GaAs衬底上生长的结构的80%的强度。峰值波长为1250nm,半峰全宽为31meV。光谱中还可见1150nm(+ 86meV)的激发水平。
该材料被制造成80μm宽的广域法布里—珀罗激光器。接触层是金—锗—镍/金。衬底的背面被减薄到100μm。然后将结构切割成2mm长的激光器。镜面被切割而不应用高反射率涂层。
在脉冲注入下,最低激光阈值电流密度为320A / cm2。单个面的最大输出功率超过30mW。 在25-70°C范围内进行测量时,激光阈值的特征温度为51K。 在25°C时,斜率效率为0.052W / A。在连续波电流注入高达1000mA的情况下,器件不会发出激光。

图2为脉冲注入激光器的温度相关光输出功率与电流曲线
研究人员表示,与生长在 GaAs衬底上的器件相比,生长在硅片上的激光器表现出“输出和热特性等几个特性的退化”。该团队希望优化生长工艺,特别是种子层,以提高激光器的性能。
全部0条评论

快来发表一下你的评论吧 !

