

浅析深度学习在半导体行业的应用
电子说
描述
1
摩尔定律即将终结?
近年来摩尔定律增长的脚步放缓,关于摩尔定律的种种猜测甚嚣尘上。但半导体行业人,仍然对此持乐观态度:持续性的创新仍在发生,目前行业生态系统中的每个分支都在努力实现更多突破和改进。例如,可制造性设计(DFM)始终在优化,除此之外,更强大的计算能力无疑成为行业发展的重中之重。
过去,半导体行业以两派划分,物联网或消费类电子设备,以及高性能计算。追求低功耗曾在两派之间占据主导地位,但随后计算能力的进一步提升则成为很重要的一个方向。因此,图形处理器(Graphic Processing Unit)和大规模并行处理的体系结构将成为高性能计算的发展方向。当然,这不是一个突然的转变,而是随着时间推移而发生变化,但这已经是一个必然趋势。
提到图形处理技术,人工智能的问题不可回避。如今人工智能、机器学习和深度学习是业界风向标。但这究竟是炒作还是已然悄悄影响行业发展?
2
当人工智能遇到半导体
可以肯定,目前的人工智能根本不是炒作,而被深度学习所驱动的。深度学习是机器学习的一个分支,而机器学习是AI的一个分支。可以预见,深度学习包含了较多的非连续性、颠覆性的技术与重大的机遇。但它不像1980年代的Lisp机器热潮。因为Lisp编程语言并不适于一般编程人群。深度学习却颠覆了编程,与往常的编程 ——即编程者写代码并将一组输入转化成一组输出——不一样的是:深度学习会消化许多输入与输出的示例,并学习该模式下的匹配。从本质上讲,深度学习的输出是一个程序,它将输入转换为类似的输出,以此模仿训练数据集(training data set)。与之前的机器学习不同,深度学习解决了让软件工程师曾无法解决的编程问题,深度学习可以实现之前无法实现的软件应用程序。
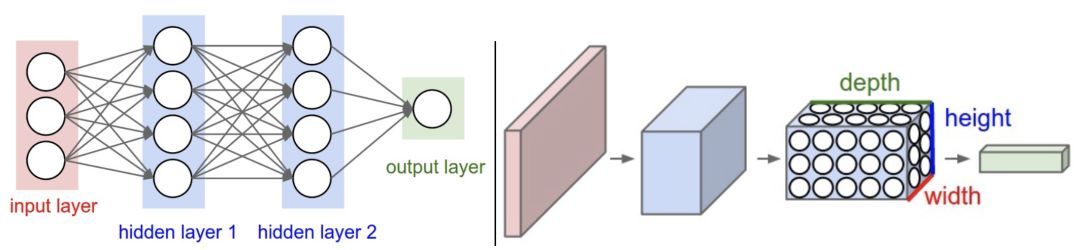
毫无疑问的是,
深度学习开始影响半导体芯片行业。
以ASML-Brion著名的OPC(光学邻近效应修正)示例来说:使用深度学习来加速OPC或ILT(反演光刻技术)的初始嵌入,运行时间将会减少一半。众所周知,运行时间是OPC中最重要的问题之一。其运作原理是使用深度学习的模式匹配能力,来创建一个比现有的替代方案更好的初始嵌入。这样做可以大大减少完成掩膜版(mask)设计所需的优化迭代次数,从而大幅度降低整体的运行时间。 ASML-Brion论文描述了运行OPC / ILT代码以用来获取一堆输入模式(所需的晶圆形状),并继而产生一堆输出模式(生成这些晶圆形状所需的掩膜形状)。现在,把这些输入和输出的搭配设置成在深度学习的模式下,即会生成一个程序,该程序将会把类似的输入(其他但仍是所需的晶圆形状)转换成类似的输出(掩膜形状)。
值得注意的是,深度学习是一种统计方法。
以ImageNet Competition和其他类似的事件举例,你可以在结果中获得95%的准确度,并且其中输出的掩膜形状将会生产出所需的晶圆形状,同时也对制造的变化有着适应力。当然,在半导体制造中,95%的精准度不算是一个完美数字。我们需要至少7-sigma的准确度。 这就是ASML-Brion的智慧所在,我们使用深度学习来加速计算。 在深度学习推理引擎生产出输出掩膜形状之后,这些掩膜形状在传统OPC/ILT程序中被用作为初始嵌入。加入了初始嵌入后的传统程序会比没有任何设置、或只有晶圆形状(乘以4倍放大系数)、或甚至用一些SRAF生成(SRAF generation)来的运行速度更快。
3
技术浪潮将引领半导体去向何方
自动缺陷分类(Automatic defect classification)作为一个检查掩膜和晶圆重要的领域,将普遍应用人工智能相关技术,包括大数据。晶圆厂(fabs)中蕴含大量的数据,而机器学习所擅长的,正是去关联大量数据和事件,总结其相关性。
半导体产业链中,光掩膜领域广泛融入深度学习,整个市场呈现增长态势。复合年均增长率(Compound annual growth rate)在过去三年中一直保持在4%,并预计这个增长将继续一段时间。
过去很长一段时间,技术前沿的掩膜领域,每个设计可能会包含多达100个的掩膜, 但技术前沿的掩膜则非常鲜有。由于前沿的掩膜技术非常昂贵,只有少数公司能够负担。无论是从盈利还是生产数量的角度来看,掩膜市场都主要是被非前沿技术的掩膜所统领。然而,当前沿的技术最终突破高容量节点(high volume node),未来的掩膜市场将实现飞跃。
然而,前沿技术的掩膜仍然昂贵,目前的掩膜领域在行业的发展还未达到一个最活跃的顶峰。深度学习和通过深度学习所完成的计算给予了这个市场很大的助动,同样,在这个市场中,还有极紫外光光刻(EUV)所带来的影响。在37亿美元的掩膜销售额中,很难看到极紫外光(EUV)的比重,是因为极紫外光(EUV)掩膜更加昂贵。可以预期,随着极紫外光(EUV)掩膜数量的增加,整个掩膜市场也将再次飞跃。
4
EUV即将迎来量产,是高峰还是挑战?
EUV光刻技术正在接近量产阶段,但仍存在一些挑战。掩膜行业也在为EUV做好准备。如今,多光束机器可以在掩膜版上绘制任何形状,而在过去,我们只能绘制直线形状。多光束的使用,突破了直线形状的局限,也带来了OPC和ILT的进一步突破。然后EUV带来的技术革新也绝不仅仅是输出曲线形状,由于它的写入性质,对于非常密集和小型设计(如EUV掩膜)也十分适用。因此,EUV掩膜,及纳米压印母版,都需要多光束技术。
从eBeam Initiative的调查中可以看到,周转时间对掩膜制造来说是一个巨大的挑战。 EUV掩膜则更加挑战,因为7nm及以下节点的单次曝光,致使EUV可能具有较少的SRAF甚至可能没有SRAF。
掩膜过程校正(Mask Process Correction - MPC)是OPC或ILT的掩膜版本。为了印制出想要的掩膜,需要仔细操作形状。我们来做个假设,如果要在掩膜上绘制一个40nm宽、200nm高的矩形,却没有使用制作掩膜的合理抗蚀剂,可能最终我们能得到36nm宽、但是160纳米长的形状。而在晶圆加工的过程中, 1nm的差异都至关重要,因此掩膜非常重要。
掩膜的进步是应对下一节点挑战的利器,不断利用新兴技术手段,也将不断满足精度准度及周转时间的要求。
-
标题:群“芯”闪耀的半导体行业2008-09-23 0
-
汽车半导体行业2012年或将基本实现复苏2012-01-15 0
-
机器视觉在半导体行业中的应用2012-02-15 0
-
类金刚石(DLC)涂层在半导体行业的应用2014-01-24 0
-
浅析化合物半导体技术2019-06-13 0
-
半导体行业的趋势2019-06-25 0
-
半导体芯片行业的运作模式有哪些2020-12-29 0
-
深度学习或将引领半导体行业变革2017-11-18 7204
-
2021年化合物半导体行业深度报告.zip2023-01-13 192
-
2021年半导体行业深度报告七之IC载板篇.zip2023-01-13 147
-
半导体硅片行业深度报告.zip2023-01-13 185
-
半导体行业深度.zip2023-01-13 362
-
半导体行业深度报告.zip2023-01-13 271
-
半导体设备行业深度.zip2023-01-13 297
-
电子行业半导体行业系列深度报告.zip2023-01-13 260
全部0条评论

快来发表一下你的评论吧 !

