

集成电路怎样进行封装?集成电路封装有什么目的?
制造/封装
描述
1 前言
随着集成电路的发展,小型化与多功能成了大家共同追求的目标,这不仅加速了IC设计的发展,也促进了IC封装设计的发展。IC封装设计也可以在一定程度上提高产品的集成度,同时也对产品的可靠性起着很重要的影响作用。本文总结和研究了一些封装工艺中提高可靠性的方法。
2 引线框架
引线框架的主要功能是芯片的载体,用于将芯片的I/O引出。在引线框架的设计过程中,需要考虑几个因素。
2.1 与塑封料的粘结性
引线框架与塑封料之间的粘结强度高,产品的气密性更佳,可靠性更高;与塑封料的粘结性不好,会导致分层及其他形式的失效。影响粘结强度的因素除了塑封料的性能之外,引线框架的设计也可以起到增强粘结强度的作用,如在引脚和基岛边缘或背面设计图案,如图1所示。
图1 各种增强型框架
2.2 芯片与引脚之间的连接
引线框架的最重要的功能是芯片与外界之间的载体,因此,引线框架应设计得利于芯片与引脚之间的连接,要考虑线弧的长度以及弧度。
2.3 考虑塑封料在型腔内的流动
对于多芯片类的复杂设计,还应考虑塑封时塑封料在芯片与芯片或芯片与模具之间的流动性。
3 焊线
3.1 增强焊线强度
焊线强度除了焊点处的结合强度外,线弧的形状也会对焊线强度有一定的影响。
增强焊线强度的方法之一是在焊线第二点种球,有BSOB和BBOS两种方式。如图2所示。
图2 BSOB和BBOS的示意图
BSOB的方法是先在焊线的第二点种球,然后再将第二点压在焊球上;BBOS的方法是在焊线的第二点上再压一个焊球。两种方法均能增强焊线强度,经试验,BBOS略强于BSOB。BBOS还应用于die todie(芯片与芯片)之间的焊接,如图3所示。
图3 BBOS用于叠晶及芯片与芯片之间焊接的情况
3.2 降低线弧高度
现在的封装都向更薄更小发展,对芯片厚度、胶水厚度和线弧高度都有严格控制。一般弧度的线弧,弧高(芯片表面至线弧最高点的距离)一般不低于100μm,要形成更低的线弧,有以下两种方法。RB(Reverse Bonding反向焊接)和FFB(FoldedForward Bonding折叠焊接 ),如图4和图5所示。
图4 反向焊接(RB)
图5 折叠正向焊接(FFB)
反向焊接虽然可以形成低的线弧,但是种球形成了大的焊球,使得焊线间距受到限制。折叠正向焊接方法是继反向焊接之后开发的用于低线弧的焊接方法,如图5所示。
低线弧不仅能够满足塑封体厚度更薄的要求,还能减少塑封时的冲丝以及线弧的摆动(wiresweep),对增加封装可靠性有一定的帮助。
3.3 等离子清洗
提高焊接可靠性的一个重要方法是使用等离子清洗。等离子清洗除能清洁掉芯片及引线框架表面的沾污和氧化物之外,还能激活表面,使结合面更加牢固。等离子清洗需要保证气体在产品各个表面均匀的流动,因此需要使用有孔料盒,如图6所示。
图6 等离子清洗使用的料盒
等离子清洗的几个关键影响因素有:
(1)气体成分。等离子清洗使用的气体一般为氩气、氧气和氢气,也可以使用混合气体。氩气和氧气用来清洗有机残留,氢气用来清洗氧化物。
(2)料盒和产品排布。清洗效果的一致性是很重要的,有利于获得封装组装工艺的高质量控制 [3]。对于射频型等离子清洗机而言,应该让料盒的排布顺应气体的流向,让气体均匀流通在料盒的各个位置。
(3)功率和时间。对不同厂家制造的等离子清洗机以及不同类型的产品,都要通过DOE实验方法,找出最合适的设定范围。
(4)评定方法。最直观的评定等离子清洗效果的方法是滴水试验,通过观察界面角来判定亲水性,如图7。
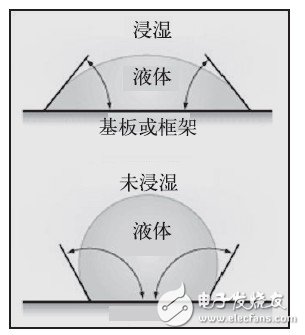
图7 浸湿示意图
浸湿角在20°~40°之间是合适状态,16h后浸湿角会大于40°。因此,等离子清洗后的延迟时间建议为8h。
评估等离子清洗效果的另一方法为比较PpK或CpK,这也是使用等离子清洗的最终目标。为了获得稳定的高质量控制,我们做了PpK的比较试验,结果证明,等离子清洗能够在一定程度上提高产品的质量稳定性。试验内容如下:
试验设备:EUROPLASMA;气体:Ar+H2(氩气+氢气);线径:30μm金线;焊球直径:82.5μm;等离子清洗机RF功率:300W;清洗时间:180s。
表1 等离子清洗前后样品焊球推力测试结果比较

由此可见,等离子清洗对金线的结合力有一定程度的提高,同时也提高了品质稳定性。
4 塑封
影响塑封效果的主要因素有以下几个方面。
4.1 模具和框架设计
前文中提到一些加强框架与塑封料之间结合力的设计方法,当需要用到大面积的基岛时,就需要考虑用到加强型的设计;同时,接近塑封体边缘的部分也是脆弱点,也需要一些加强结合力的方法。
框架和塑封模具之间关系密切,它们互补互足,设计模具时需要综合考量框架、内部芯片摆放位置、走线方向以及塑封料的物理化学性能。
4.2 塑封料
塑封料性能的好坏也直接影响可靠性。一般判断塑封料等级的首要因素为MSL(潮湿敏感度等级),MSL等级越高,其对芯片的保护越好。其次,热硬度即热转化温度及与不同金属面之间的粘结性能也是需要考虑的重要因素。
5 总结
在进行封装设计时,除了考虑电性能方面的稳定性之外,封装工艺的可靠性设计也是重要的环节。封装工艺需要依靠行业标准和各个公司总结出的经验,同时,封装工艺设计和可靠性测试与失效分析是密不可分的,它们具有相辅相成的关系。封装工艺需要通过可靠性试验来衡量,需要失效分析来寻找问题的原因,需要经验与技术来得出改进的方法。
-
如何对集成电路进行封装2021-08-30 2977
-
集成电路封装资料 PPT下载2009-10-21 0
-
555时基集成电路的特点和封装2010-02-25 0
-
常见集成电路封装含义及封装实物图2013-01-13 0
-
集成电路封装技术专题 通知2016-03-21 0
-
一文解读集成电路的组成及封装形式2019-04-13 0
-
集成电路的封装形式有哪几种?2021-11-02 0
-
集成电路封装设计的可靠性提高方法研究2011-10-25 9197
-
PCB集成电路封装知识全解析2017-11-29 1774
-
集成电路是什么_集成电路封装_集成电路的主要原材料2018-01-24 28276
-
集成电路是怎样进行封装的?2018-08-10 10480
-
常见的集成电路封装形式有哪些2020-10-13 28176
-
集成电路封装阐述2021-06-24 992
-
集成电路封装的分类与演进2023-02-11 1795
-
集成电路封装测试2023-05-25 1617
全部0条评论

快来发表一下你的评论吧 !

