
资料下载

×
IC封装无芯基板的发展与制造研究资料分析
消耗积分:0 |
格式:pdf |
大小:1.46 MB |
2018-12-07
手持电子产品的薄型化催生了IC封装无芯基板,它不仅比IC封装有芯基板更薄,而且电气性能更加优越。介绍了IC封装无芯基板的发展趋势和制造中面临的问题。IC封装无芯基板以半加成法制造,翘曲是目前制程中的首要问题。翘曲改善主要依靠改变绝缘层材料和积层结构,可用云纹干涉法进行量测,并以模拟为指导加快开发周期。
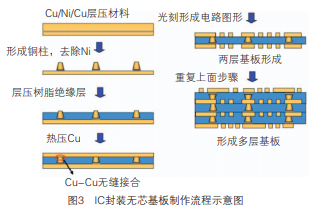
由于手持电子产品的薄型化需求,其核心的IC 封装也越来越薄,推动IC封装基板由有芯基板向更薄的无芯基板方向发展。2004年富士通互联科技向市场投放了名为“GigaModule-4”的IC封装无芯基板,随后发明了加入玻璃纤维以提高无芯基板强度的技术。2010年8月,索尼开始在家用游戏机 “PlayStation 3(PS3)”的Cell微处理器中采用IC封装无芯基板,如图1所示。近年来,苹果也掀起了便携电子产品的轻薄风潮,带动PCB制造厂商陆续研发出无芯封装基板制造技术,生产无芯封装基板的技术已趋于成熟,在手机、平板电脑上的规模应用成为发展潮流。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。 举报投诉
评论(0)
发评论
- 相关下载
- 相关文章







