

关于光刻机国内外市场现状分析
电子说
描述
一、背景
光刻机是半导体产业中最关键设备,也被誉为半导体产业皇冠上的明珠。集成电路里的晶体管是通过光刻工艺在晶圆上做出来的,光刻工艺决定了半导体线路的线宽,同时也决定了芯片的性能和功耗。
工欲善其事,必先利其器,要想半导体产业突破技术封锁,要想开发先进的半导体制程,就必需要有先进的光刻机。
近期,关于光刻机,中芯国际、长江存储、华虹先后传来好消息。
中芯国际(SMIC)订购的是最新型的使用EUV(极紫外线)技术的芯片制造机器光刻机,价值1.2亿欧元,与其去年净利润1.264亿美元大致相当。长江存储装入193nm浸润式光刻机,售价7200万美元(约合人民币4.6亿元),可用于14-20nm工艺。华虹集团旗下上海华力集成电路制造有限公司装入193nm双级沉浸式光刻机,用于10nm级(14~20nm)晶圆生产。
尽管它们装入或订购的光刻机型号不同,但它们来自同一个荷兰公司——ASML。
还有一个共同点不难发现,就是光刻机单价是极高的。由于光刻机涉及系统集成、精密光学、精密运动、精密物料传输、高精度微环境控制等多项先进技术,是所有半导体制造设备中技术含量最高的设备,因此也具备极高的单台价值量。
二、光刻机关键技术及工作原理
那么,在我国光刻机的发展现状如何呢?我们和国外的光刻机设备厂商存在哪些差距呢?在具体到每个厂商市场和产品介绍之前,本文会先介绍一下关于光刻机的关键技术及原理。
光刻机就是放大的单反,光刻机就是将光罩上的设计好集成电路图形通过光线的曝光印到光感材料上,形成图形。最核心的就是镜头,这个不是一般的镜头,可以达到高2米直径1米,甚至更大。
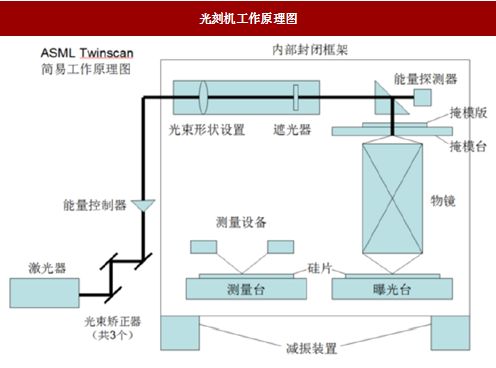
来源:互联网
● 光源:
光源是光刻机核心之一,光刻机的工艺能力首先取决于其光源的波长。下表是各类光刻机光源的具体参数:

最早光刻机的光源是采用汞灯产生的紫外光源(UV: Ultraviolet Light),从g-line一直发展到i-line,波长缩小到365nm,实际对应的分辨率大约在200nm以上。
随后,业界采用了准分子激光的深紫外光源(DUV: Deep Ultraviolet Light)。将波长进一步缩小到ArF的193nm。不过原本接下来打算采用的157nm的F2准分子激光上遇到了一系列技术障碍以后,ArF加浸入技术(Immersion Technology)成为了主流。
所谓浸入技术,就是让镜头和硅片之间的空间浸泡于液体之中。由于液体的折射率大于1,使得激光的实际波长会大幅度缩小。目前主流采用的纯净水的折射率为1.44,所以ArF加浸入技术实际等效的波长为193nm/1.44=134nm。从而实现更高的分辨率。F2准分子激光之所以没有得以发展的一个重大原因是,157nm波长的光线不能穿透纯净水,无法和浸入技术结合。所以,准分子激光光源只发展到了ArF。
这之后,业界开始采用极紫外光源(EUV: Extreme Ultraviolet Light)来进一步提供更短波长的光源。目前主要采用的办法是将准分子激光照射在锡等靶材上,激发出13.5nm的光子,作为光刻机光源。目前,各大Foundry厂在7nm以下的最高端工艺上都会采用EUV光刻机,其中三星在7nm节点上就已经采用了。而目前只有荷兰ASML一家能够提供可供量产用的EUV光刻机。
● 分辨率:
光刻机的分辨率(Resolution)表示光刻机能清晰投影最小图像的能力,是光刻机最重要的技术指标之一,决定了光刻机能够被应用于的工艺节点水平。但必须注意的是,虽然分辨率和光源波长有着密切关系,但两者并非是完全对应。具体而言二者关系公式是:

公式中R代表分辨率;λ代表光源波长;k1是工艺相关参数,一般多在0.25到0.4之间;NA(Numerical Aperture)被称作数值孔径,是光学镜头的一个重要指标,一般光刻机设备都会明确标注该指标的数值。
所以我们在研究和了解光刻机性能的时候,一定要确认该值。在光源波长不变的情况下,NA的大小直接决定和光刻机的实际分辨率,也等于决定了光刻机能够达到的最高的工艺节点。
● 套刻精度:
套刻精度(Overlay Accuracy)的基本含义时指前后两道光刻工序之间彼此图形的对准精度(3σ),如果对准的偏差过大,就会直接影响产品的良率。对于高阶的光刻机,一般设备供应商就套刻精度会提供两个数值,一种是单机自身的两次套刻误差,另一种是两台设备(不同设备)间的套刻误差。
套刻精度其实是光刻机的另一个非常重要的技术指标,不过有时非专业人士在研究学习光刻机性能时会容易忽略。我们在后面的各大供应商产品详细列表里,特意加上了这个指标。
● 工艺节点:
工艺节点(nodes)是反映集成电路技术工艺水平最直接的参数。目前主流的节点为0.35um、0.25um、0.18um、90nm、65nm、40nm、28nm、20nm、16/14nm、10nm、7nm等。传统上(在28nm节点以前),节点的数值一般指MOS管栅极的最小长度(gate length),也有用第二层金属层(M2)走线的最小间距(pitch)作为节点指标的。
节点的尺寸数值基本上和晶体管的长宽成正比关系,每一个节点基本上是前一个节点的0.7倍。这样以来,由于0.7X0.7=0.49,所以每一代工艺节点上晶体管的面积都比上一代小大约一半,也就是说单位面积上的晶体管数量翻了一番。这也是著名的摩尔定律(Moore's Law)的基础所在。一般而言,大约18~24个月,工艺节点就会发展一代。
但是到了28nm之后的工艺,节点的数值变得有些混乱。一些Foundry厂可能是出于商业宣传的考量,故意用一些图形的特征尺寸(Feature Size)来表示工艺节点,他们往往用最致密周期图形的半间距长度来作为工艺节点的数值。这样一来,虽然工艺节点的发展依然是按照0.7倍的规律前进,但实际上晶体管的面积以及电性能的提升则远远落后于节点数值变化。更为麻烦的是,不同Foundry的工艺节点换算方法不一,这便导致了很多理解上的混乱。根据英特尔的数据,他们20nm工艺的实际性能就已经相当于三星的14nm和台积电的16nm工艺了。
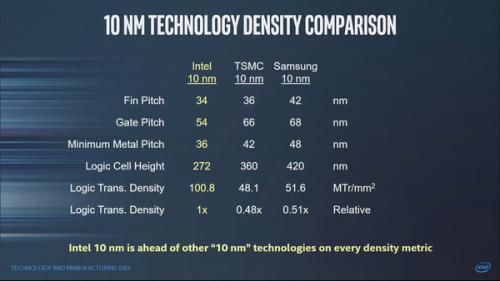
上图为英特尔公布的10nm节点详细工艺参数对比。由图可以明显看到,同样10nm工艺节点上,英特尔的晶体管密度大约是三星和台积电的两倍。(图片来源:与非网:迟来的英特尔10nm工艺,凭啥说比台积电/三星强?)
在65nm工艺及以前,工艺节点的数值几乎和光刻机的最高分辨率是一致的。由于镜头NA的指标没有太大的变化,所以工艺节点的水平主要由光源的波长所决定。ArF 193nm的波长可以实现的最高工艺节点就是65nm。
而到了65nm以后,由于光源波长难于进一步突破,业界采用了浸入式技术,将等效的光源波长缩小到了134nm。不仅如此,在液体中镜头的NA参数也有了较大的突破。根据ASML产品数据信息,采用浸入技术之后,NA值由0.50–0.93发展到了0.85–1.35,从而进一步提高了分辨率。同时,在相移掩模(Phase-Shift Mask)和OPC(Optical Proximity Correction)等技术的协同助力之下,在光刻设备的光源不变的条件下,业界将工艺节点一直推进到了28nm。
而到了28nm以后,由于单次曝光的图形间距已经无法进一步提升,所以业界开始广泛采用Multiple Patterning的技术来提高图形密度,也就是利用多次曝光和刻蚀的办法来产生更致密图形。
值得特别注意的是,Multiple Patterning技术的引入导致了掩模(Mask)和生产工序的增加,直接导致了成本的剧烈上升,同时给良率管理也带来一定的麻烦。同时由于前述的原因,节点的提升并没有带来芯片性能成比例的增加,所以目前只有那些对芯片性能和功耗有着极端要求的产品才会采用这些高阶工艺节点技术。于是,28nm便成为了工艺节点的一个重要的分水岭,它和下一代工艺之间在性价比上有着巨大的差别。大量不需要特别高性能,而对成本敏感的产品(比如IOT领域的芯片)会长期对28nm工艺有着需求。所以28nm节点会成为一个所谓的长节点,在未来比较长的一段时间里都会被广泛应用,其淘汰的时间也会远远慢于其它工艺节点。
根据业界的实际情况,英特尔和台积电一直到7nm工艺节点都依然使用浸入式ArF的光刻设备。但是对于下一代的工艺,则必须采用EUV光源的设备了。目前全球只有ASML一家能够提供波长为13.5nm的EUV光刻设备。毫无疑问,未来5nm和3nm的工艺,必然是EUV一家的天下。事实上,三星在7nm节点上便已经采用了EUV光刻设备,而中芯国际最近也订购了一台EUV用于7nm工艺的研发。
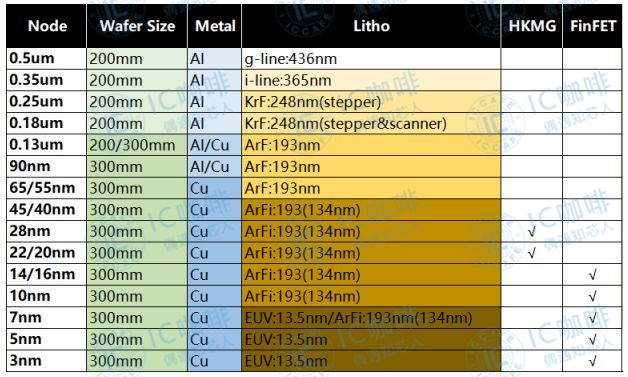
为方便读者理解,上图是我们整理的各个工艺节点和工艺及光刻机光源类型的关系图。
三、光刻设备及供应商概览
了解了光刻设备的基本知识,接下来我们便可以具体了解目前全球几家主要供应商的光刻机的情况了。
目前市场上主要的光刻机供应商有荷兰的ASML、日本的NIKON和CANON,以及中国大陆的上海微电子装备(SMEE)。

上图是从几家供应商的网站上收集到的目前在售的所有光刻机的列表及相关参数。需要注意的是,目前光刻设备按照曝光方式分为Stepper和Scanner两种。
Stepper是传统地一次性将整个区域进行曝光;而Scanner是镜头沿Y方向的一个细长空间曝光,硅片和掩模同时沿X方向移动经过曝光区动态完成整个区域的曝光。和Stepper相比,Scanner不仅图像畸变小、一致性高,而且曝光速度也更快。所以目前主流光刻机都是Scanner,只有部分老式设备依旧是Stepper。上表中如果没有特别注明,都是属于Scanner类型。
四、国外光刻机发展
● 荷兰ASML:强大的研发能力换来业界话语权
ASML (全称: Advanced Semiconductor Material Lithography,ASML Holding N.V),中文名称为阿斯麦(中国大陆)、艾司摩尔(中国***),是总部设在荷兰Veldhoven的全球最大的半导体设备制造商之一,向全球复杂集成电路生产企业提供领先的综合性关键设备。ASML的股票分别在阿姆斯特丹及纽约上市。另外,ASML的大股东是英特尔,三星和台积电(TSMC)。
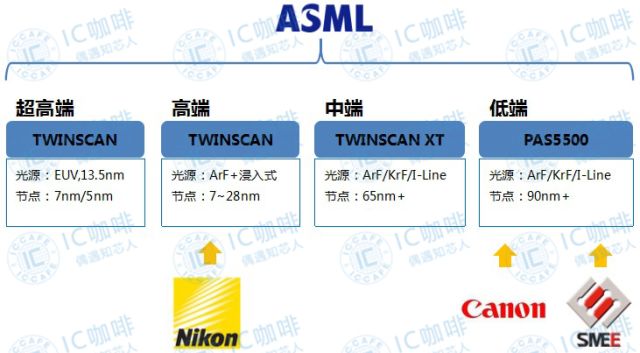
由于ASML是业界公认的领头羊,我们便以它为对象进行研究。由上表可知,ASML的产品一共有四个系列,非严格地,我们正好可以将其按照技术水平分为四个档次。
从其它三家的产品列表中可以看到,目前其它几家都没有正式发布的EUV级别产品能够和ASML一较高下,只有Nikon NRS系列有ArF浸入式光刻机,参数指标上勉强可以达到ASML高端产品的水准。但是从业界的反馈来看,Nikon高端系列实际性能相比ASML同档次设备仍有不小差距,尤其是在套刻精度上远远达不到官方宣称水准,以至于Nikon光刻设备在售价不到ASML同类产品一半的前提下,依旧销售不佳。

ASML一直以来保持了高研发投入(甚至让自己的客户掏钱),因此其专利申请量也长期保持高位。第一波高速上涨来自2000至2004年,这一时期Intel、AMD、VIA及IBM等企业设计的半导体芯片性能快速提升,为了克制芯片在高频率运行时产生的高温,他们对半导体制程提出了越来越高的要求,这间接导致了光刻机技术的不断提升。不过由于光物理性质的影响,在光刻机发展到193nm后,研发陷入了困局。几大芯片巨头合力将193nm沉浸式光刻技术延伸至15nm令光刻机企业研发及专利申请下滑。但是沉浸式光刻终于在7nm之后难以再次发展,EUV成为了解决这一问题的关键,近些年里ASML相关技术专利申请再次进入增长阶段。
作为一家荷兰的企业,ASML的专利地理布局上却值得我们思考。其在全球各地专利申请量的排名,依次是美国、日本、***、韩国以及中国。这个顺序的有意思之处在于ASML的专利地理布局是根据客户及竞争对手两个因素进行布局。美国既有ASML的几大客户,如Intel和德州仪器,又有ABM、Applied Materials、Lam Research、及Rudolph Technologies等竞争对手,自然是重中之重。

上图显示了ASML公司近3年的研发方向和关注技术的时间变化趋势。通过了解过去3年内重点技术的专利战略,我们借此来分析ASML公司近来关注重点的变化。如H01L半导体器件的方面ASML的申请量下滑,可能意味着其已经完成了EUV光刻机半导体器件的设计;而G02B 光学元件及H05G X射线技术两个IPC分类下专利申请量的增加,也行意味着ASML还在改善光刻技术中光学组件的性能以及X射线的强度。
正如ASML让Intel、三星和台积电投资自己,共同承担EUV的研发成本,ASML也投资了在光刻中起到关键作用的光学设备企业Carl Zeiss。

Carl Zeiss是ASML最重要的长期策略合作伙伴,长期以来为ASML的光刻设备提供最关火键且高效能的光学系统。在下文的EUV相关专利申请排名上,Carl Zeiss更是占据了头把交椅,这也说明了其在EUV相关光学设备上无可替代的地位。为了获得优先供货和在2020年代初期就能够让芯片制造行业使用搭载全新光学系统的新一代EUV光刻设备,ASML 和Carl Zeiss决定进一步强化合作关系。
● 日本Nikon和Canon:退出高端光刻机角逐台
Canon早已在很多年前便放弃了在高端光刻机上的竞争,目前产品主要集中在面板等领域。目前他们还在销售的集成电路光刻设备在指标标上只相当于ASML的低端产品PAS5500系列。
Nikon作为世界上仅有的三家能够制造商用光刻机的公司之一,似乎在这个领域不被许多普通人知道,许多人只知道Nikon的相机做的好,却不知道Nikon光刻机同样享誉全球。
Nikon (7731.JP)成立于1917年,是总部设在日本东京,主要分四个事业领域,分别精密设备公司、映像公司、仪器公司及其他(包括CMP装置事业、测量机事业、望远镜事业等)。

荷兰ASML一步步占据市场统治地位,Nikon光刻机唯一剩下的优势就是同类机型价格不到ASML的一半。但给予Nikon致命一击的还是英特尔,在新制程中停止采购Nikon的光刻机,据悉,所有主流半导体产线中只有少数低阶老机龄的光刻机还是Nikon或者Canon的。毕竟现在英特尔,三星和台积电都成为ASML的股东了。

在EUV技术领域内,ASML已经与其他竞争者之间拉开了差距。虽然其并未排名第一,但是排名第一的卡尔蔡司(Carl Zeiss)属于光学仪器企业,蔡司为ASML等光刻机企业提供光学组建。而ASML较其直接竞争对手NIKON(尼康)和CANON(佳能)在EUV专利数量上有很大的优势,甚至比NC两家之和还要多。
日本一桥大学创新研究中心教授中马宏之,曾对日本微影双雄尼康与佳能的败因深入检讨。他在研究论文指出,ASML微影机台有90%以上零件向外采购,这一比例远高于竞争对手Nikon和Canon,“这种独特的采购策略,是ASML成为市场领导者的关键。”
中马宏之认为,高度外包的策略,让ASML可以快速取得各领域最先进的技术,让自己专注在客户的需求,以及系统整合等两大关键重点。
五、国产光刻机主要厂商
● 上海微电子装备(SMEE)
作为国内光刻设备的龙头企业,由于起步较晚且技术积累薄弱,目前最先进的光刻设备也只能提供最高90mn的工艺技术。单从指标上看,基本也和ASML的低端产品PAS5500系列属于同一档次。

△ SMEE专利申请趋势图(来源:智慧芽专利数据库)
● 合肥芯硕半导体有限公司
合肥芯硕半导体有限公司成立与2006年4月,是国内首家半导体直写光刻设备制造商。该公司自主研发的ATD4000,已经实现最高200nm的量产。

△ 合肥芯硕重点专利技术(来源:智慧芽专利数据库)
● 无锡影速半导体科技有限公司
无锡影速成立与2015年1月,影速公司是由中科院微电子研究所联合业内资深技术团队、产业基金共同发起成立的专业微电子装备高科技企业。影速公司已成功研制用于半导体领域的激光直写/制版光刻设备、国际首台双台面高速激光直接成像连线设备(LDI),已经实现最高200nm的量产。

△ 无锡影速专利主要发明人(来源:智慧芽专利数据库)
六、国内外光刻机发展差距
从如上智慧芽专利数据库提供的专利数据来看,国外光刻机龙头ASML与国内佼佼者们之间的技术差距巨大。尽管如此,但我们也在努力追赶中。
5月24日“极大规模集成电路制造装备与成套工艺”专项(02专项)项目“极紫外光刻胶材料与实验室检测技术研究”完成了EUV光刻胶关键材料的设计、制备和合成工艺研究、配方组成和光刻胶制备、实验室光刻胶性能的初步评价装备的研发,达到了任务书中规定的材料和装备的考核指标。项目共申请发明专利15项(包括国际专利5项),截止到目前,共获得授权专利10项(包括国际专利授权3项)。
近日,中国科学院大学微电子学院与中芯国际集成电路制造有限公司在产学研合作中也取得新进展,成功在光刻工艺模块中建立了极坐标系下规避显影缺陷的物理模型。通过该模型可有效减小浸没式光刻中的显影缺陷,帮助缩短显影研发周期,节省研发成本,为确定不同条件下最优工艺参数提供建议。该成果已在国际光刻领域期刊Journal of Micro-Nanolithography MEMS and MOEMS发表。
中国目前有90纳米,用90纳米的升级到65纳米不难。但是45纳米就是一个技术台阶了。45纳米的研发比90纳米和65纳米难很多。如果解决了45纳米那个可以升级到32纳米不难。但是下一步升级到22纳米,不能直接45纳米升级到22纳米了。22纳米用到了很多新的技术。
中国16个重大专项中的02专项提出光刻机到2020年研发出22纳米。2015年出45纳米的并且65纳米的产业化。45纳米是目前主流的光刻机工艺,包括32纳米的还有28纳米基本都是在45纳米的侵入深紫外光刻机上面改进升级来的。所以中国掌握45纳米的很重要。45纳米光刻机是一个很重要的台阶,达到这个水平后,在45纳米光刻机上面进行物镜和偏振光升级可以达到32纳米。
另外,用于光刻机的固态深紫外光源也在研发,我国的光刻机研发是并行研发的,22纳米光刻机用到的技术也在研发,用在45纳米的升级上面。还有电子束直写光刻机,纳米压印设备,极紫外光刻机技术也在研发。对光刻胶升级,对折射液升级,并且利用套刻方法可以达到22纳米到14纳米甚至10纳米的水平。相应的升级的用的光刻胶,第3代折射液等也在相应的研发中。
所以,目前单纯从技术层面上看,全球光刻设备的格局是:ASML一家独占鳌头,成为唯一的一线供应商;Nikon凭借多年技术积累,勉强保住二线供应商地位;而Canon只能屈居三线;SMEE作为后起之秀,暂时勉强也挤入三线的档次,但由于光刻设备对技术积累和供应链要求极高,未来要想打入二线则非常艰难,短期内难有实质性突破。目前看来,如果没有特别原因,这一格局在未来的很长时间里都不会有任何太大变化。

上表为微信公众号芯思想通过三家上市公司财报统计的2017年度光刻机销售数量(数据来源:https://mp.weixin.qq.com/s/av2ra1Y8kx4Ptoe0aEr1Lw)。由数据可知,几家在市场份额的格局上几乎和技术格局一致,唯一的一些区别是Canon在面板领域拥有较大市场份额,使得它在低端光刻设备上有相对较大的销售量和份额。
中国目前的光刻机技术还在起步探索阶段,虽然取得了一些小成就,但离国外先进技术差距还很大,希望通过目前科研人员的努力,能真正用上性能强,稳定性高的高端国产芯片。
特别是在极紫外光刻光学技术方面,极紫外光刻光学技术代表了当前应用光学发展最高水平,作为前瞻性EUV光刻关键技术研究,项目指标要求高,技术难度大、瓶颈多,创新性高,同时国外技术封锁严重。
去年“极大规模集成电路制造装备及成套工艺”国家科技重大专项“极紫外光刻关键技术研究”项目顺利通过验收。项目研究团队历经八年的艰苦奋战,突破了制约我国极紫外光刻发展的超高精度非球面加工与检测、极紫外多层膜、投影物镜系统集成测试等核心单元技术,成功研制了波像差优于0.75 nm RMS 的两镜EUV 光刻物镜系统,构建了EUV 光刻曝光装置,国内首次获得EUV 投影光刻32 nm 线宽的光刻胶曝光图形。
评审专家组认为该项目的顺利实施将我国极紫外光刻技术研发向前推进了重要一步。但这仅仅是实现光刻机国产化万里长征的一部分,距离打破ASML的技术垄断还有很长的路要走。中国想要赶上,绝不是一朝一夕的事,需要各类基础领域扎实的人才,这也是最难的。
-
国内外光传输设备的市场分析!!!2012-06-13 0
-
电脑示波器--国内外主流仪器分析2012-08-20 0
-
谁有关于密码登录系统国内外研究现状的资料啊,2014-03-11 0
-
光刻机工艺的原理及设备2020-07-07 0
-
光刻机是干什么用的2020-09-02 0
-
魂迁光刻,梦绕芯片,中芯国际终获ASML大型光刻机 精选资料分享2021-07-29 0
-
树脂型氯化聚乙烯国内外市场研究2010-06-09 651
-
PCB产业发展分布以及国内外市场发展趋势2015-05-28 3891
-
RFID国内外发展现状与趋势探究2016-05-30 1240
-
分析国内外功能分配的研究现状和存在的问题2018-05-09 7354
-
复星国际宣布将投资动力电池企业捷威动力,并持续开拓国内外市场2018-07-10 3002
-
光刻机发展分析:光刻机国内外主要厂商与市场现状分析2018-06-16 56402
-
OPPO国内外市场的出货量均出现下滑,OPPO海外出货量为何下滑2019-05-11 3788
-
高通恢复芯片对华为手机支持有限,华为手机在国内外市场均出现下跌2020-11-30 1462
-
STM32国内外发展现状2024-04-08 76
全部0条评论

快来发表一下你的评论吧 !

