

SCD关于InAsSb nBn中波高温器件和InAs/GaSb二类超晶格pBp长波器件的研发历程
描述
0引言
以色列Semiconductor Device(SCD)公司是一家处于国际领先地位的高端红外探测器供应商。SCD在过去的30 年里积累了很多研发和制造上的经验,其产品被世界上许多顶级的公司所选择。SCD 生产研发能力包括了半导体器件工艺、液相外延(LPE)和分子束外延(MBE)薄膜生长,超大规模集成电路设计、杜瓦和真空技术、装配、辐照建模及测试。SCD的红外探测器产品包括制冷型和非制冷型两大类。制冷型又包括了碲镉汞(MCT)、InSb、InAsSb、InAs/GaSb二类超晶格4个材料体系,其中MCT和InAs/GaSb 二类超晶格用于长波探测器,而InSb和InAsSbHOT用于中波探测器。非制冷型只有VOx微型测热辐射计一类,主要用于长波探测器。SCD产品分类如图1所示。目前为止SCD的热像仪(包括制冷型与非制冷型)年产量能够达到5800套。
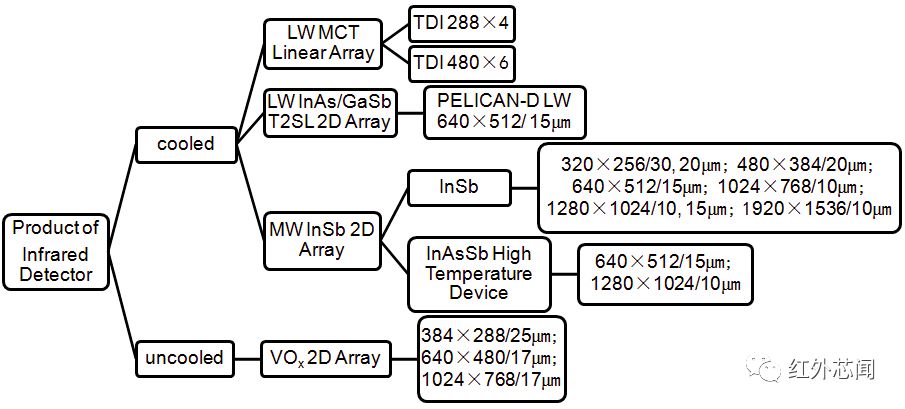
图1 SCD产品分类
SCD的优势及主流产品主要是III-V族红外探测器。20世纪90年代开始,SCD的研发重心就放在InSb上,早期主要研究离子注入型平面结工艺,工艺成熟后开始发展大面阵、小像元焦平面,目的在于减小整机的尺寸,功耗,重量与成本。2004年开始启动第三代红外探测器的研发。第三代红外探测器的研发重点在于III-V族材料的MBE外延技术。研发前期主要关注InSb的外延成结工艺(p型InSb外延到n型InSb衬底)。后来,于2008年提出XBn和XBp势垒型器件(其中X是加偏置的电极层,B是势垒层,n或是p是吸收层)以抑制器件的暗电流,从而提高器件的工作温度或灵敏度。提出XBn和XBp势垒型器件结构之后,SCD将其应用于InAsSb薄膜和InAs/GaSb二类超晶格材料,用以制备中波高温器件和高性能长波器件。研发重心从此转向对InAsSb中波高温器件(nBn结构)和高性能InAs/GaSb二类超晶格长波器件(pBp结构)的研制上。SCD在两种器件的研发过程中思路清晰(器件结构设计,单元器件测试,焦平面验证,推出产品),值得红外探测器研发人员借鉴。
本文主要介绍SCD关于InAsSb nBn中波高温器件和InAs/GaSb二类超晶格pBp长波器件的研发历程。文中将先介绍XBn和XBp型器件的工作原理,然后总结SCD对InAsSbnBn中波高温器件和InAs/GaSb二类超晶格长波pBp器件的研究。
1 XBn及XBp型器件工作原理
红外探测器的工作温度,主要是由器件的暗电流决定,而暗电流随温度指数增加的。对于材料质量高的碲镉汞,其暗电流主要由扩散电流主导,因此它的暗电流比较接近理论的扩散极限。扩散电流是在窄禁带吸收层材料中通过热激发产生电子-空穴对,然后扩散到内建电场区(耗尽层),被电场加速到电极层从而被收集产生的,这种暗电流随温度的变化满足Arrhenius公式:
Idiff=Trexp(-Ediff/kBT)
式中:Idiff是扩散电流;Ediff是扩散激活能,约为吸收层材料零温下的带隙;kB是玻尔兹曼常数;r~3。而对于III-V族材料,InSb、InAsSb 或者二类超晶格来说,它的暗电流主要是由器件耗尽区中所谓的产生复合(G-R)中心(也叫Shockley-Read-Hall陷阱)引起。当在器件上外加反向偏压时,耗尽区内的G-R中心将被激活,提供接近带隙中心位置的能级,使得将电子激发出价带(产生空穴)或者激发进入导带(产生电子)的热激活能降低一半。耗尽区内产生的电子空穴对将立即被其中的电场分开,从而被收集,形成暗电流,我们将这种暗电流简称为G-R电流(实际上,这里描述的SRH复合电流,而产生复合电流包括了SRH复合电流,辐射复合电流,俄歇复合电流等等,但SCD报道中都以G-R电流来简称,所以文中我们也采用G-R电流作为简称)。IG-R电流同样满足 Arrhenius 公式:IG-R=Trexp(-EGR/kBT),只不过其激活能 EGR仅为吸收层带隙的一半,r~1.5。
一般情况下,工作在液氮温度下的中波器件,扩散电流要比G-R电流小几个量级,而室温下,扩散电流却要大几个量级。将G-R电流和扩散电流相等时的温度定义为温度T0。对于中波红外探测器来说,T0大约在130~150 K。在暗电流随温度的变化图中(图2),在温度大于T0时,logI与温度倒数呈线性关系,其斜率乘以玻尔兹曼常数就是扩散激活能(约等于材料在低温下的带隙),而温度小于T0时,logI与温度倒数也呈线性关系,其斜率是高温下斜率的一半,乘以玻尔兹曼常数以后就是 G-R 电流激活能(约为材料低温带隙的一半)。一般器件的工作温度都在T0以下,因此想要提高工作温度或者降低暗电流就必须抑制G-R电流,使得器件工作在扩散限。
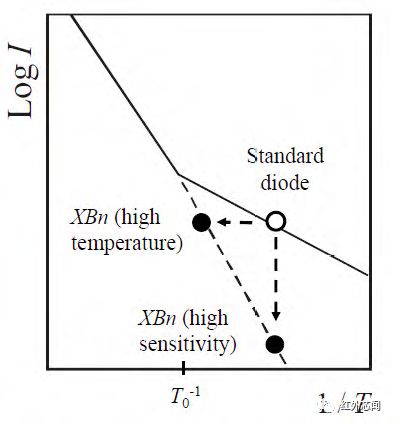
图2 普通二极管器件(实线)与XBn器件(虚线)的暗电流与温度的关系
为了抑制G-R电流,有两种方法可行,一种是提高吸收层材料的晶体质量,减少SRH复合中心;另外一种是制作势垒型探测器,将器件的耗尽区排除在吸收层外,进入势垒层中,从而抑制G-R电流。SCD选择了后者,于2008年提出了XBn和XBp型势垒型器件,思路是通过控制掺杂使得产生G-R电流的耗尽区排除在窄禁带的吸收层之外,进入宽带隙的势垒层。只要宽带隙势垒材料的带隙足够大,势垒层耗尽区内产生的G-R电流将小于吸收层的扩散电流,使得材料进入扩散限,从而达到抑制G-R电流的作用。具体有两种方法可以使得耗尽区进入势垒材料,一种是势垒层与吸收层同型掺杂,如图3所示;另一种是势垒层与吸收层反型掺杂,但吸收层需要高浓度掺杂。一般采用前一种方法,因为吸收层掺杂过高会使得吸收层截止波长蓝移,并且少子寿命变短。G-R电流得到抑制以后,可以在相同暗电流的情况下,提高探测器的工作温度;或者在相同工作温度下,提高探测器灵敏度,如图2。SCD提出XBn和XBp型器件结构后,将其应用于InAsSb薄膜和InAs/GaSb超晶格材料体系中,以研制InAsSb nBn中波高温器件和InAs/GaSb超晶格pBp长波器件。
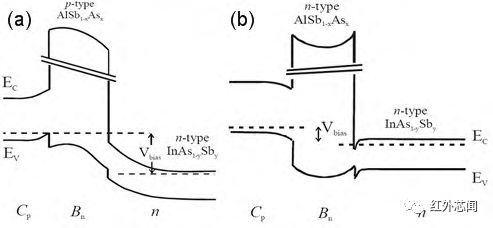
图3 XBn 器件抑制G-R电流的原理:(a)势垒层与吸收层反型掺杂,G-R 电流没有得到抑制;(b)势垒层与吸收层同型掺杂,G-R 电流被抑制
2 InAsSb nBn中波高温器件
SCD提出XBn和XBp器件结构后,最早将其应用于InAsSb中波高温器件,器件结构为nBn型势垒结构。2010-2012年分别报道了InAsSb nBn中波高温探测器的单元器件性能和焦平面性能。并于2013-2014年推出了两款InAsSb nBn中波高温探测器产品。
2.1 单元器件研究
2010 年,SCD 生长了 3 个 nBn 结构,命名为 A1、A2、B1,用于单元器件暗电流和光响应谱测试。A1、A2 势垒层为 n 型掺杂,B1 势垒层为 p 型掺杂。A1、A2、B1 器件的吸收层的掺杂分别为,A1:4×1016 cm-3,A2:4×1015 cm-3,B1:1.5×1017 cm-3。
1)暗电流
对于暗电流,SCD 的研究主要关注两个方面:第一,暗电流与温度的关系,以得到暗电流的主导机制,从而确认 G-R 电流是否得到抑制;第二,暗电流与尺寸的关系,以区分体电流和边界电流对暗电流的贡献。
SCD 研究人员制作了100~300 μm尺寸的单元器件用于暗电流测试。图 4 是 A1 样品制作的器件(尺寸200μm × 200 μm)在-0.2 V和-1 V偏压下,暗电流与温度的关系[4]。从图中得出:低偏压下,直到 125 K 都是线性,激活能与吸收层的带隙接近,可以认为整个温度区域都是扩散电流限制,证实 G-R 电流得到很好的抑制。而高偏压下,当温度低于 T0~200 K时,电流温度依赖关系开始偏离扩散电流,表明 G-R 电流开始起作用。对于 nBn 器件,当外加偏压增加到某一个临界值时,吸收层的价带将完全变成平带,空穴积累层将消失,进一步增加外加电压,吸收层将开始耗尽,使得 G-R 电流的抑制作用消失。A2、B1样品的结果与 A1 结果相似。3 个样品在低偏压下的暗电流都是扩散限,说明 nBn 结构对 G-R 的抑制在吸收层掺杂浓度跨度为两个量级范围内都有效。B1、A1、 A2 在 150 K 下的电流密度分别为 6.0×10-8 A/cm2、1.3×10-7 A/cm2、3.2×10-7A/cm2。
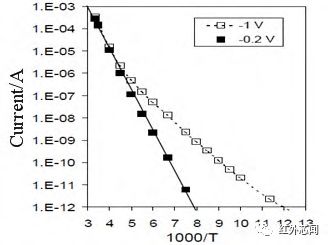
图4 A1 样品器件的(200 μm × 200 μm)暗电流与温度关系
为了研究体电流与边界电流分别对暗电流的贡献,SCD 研究人员测量了不同尺寸单元器件的暗电流。图 5是 A1(偏压为-0.2 V)和 A2(偏压-0.1 V)两个样品制作的单元器件在 150 K 下,电流与台面尺寸的比值(I/L)与台面尺寸(L)的关系。B1的结果与 A1 的结果类似。一般情况下,暗电流随着尺寸的变化满足 I=L+L2,L 和L2两项分别对应了边界和体电流密度。从图可以得到 A1 样品的边界电流贡献可以忽略;而 A2 样品的边界电流却有相当的贡献。SCD 研究人员认为这样的结果可以解释为少子寿命及迁移率随着吸收层的掺杂浓度降低而增加,少子的扩散长度也随之增加,因此,台面结构以外区域的载流子也将通过横向扩散,对暗电流起到贡献(SCD并没有将其归结于侧壁漏电流,因为台面结构的制作仅刻蚀到势垒层,可以认为不存在侧壁漏电流)。
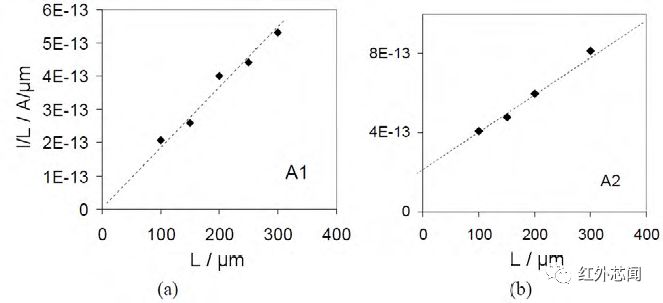
图 5 暗电流与器件台面尺寸的关系:(a) 样品 A1 在-0.2 V 偏压下 (b) 样品 A2 在-0.1 V 偏压下
2)光响应
除暗电流外,SCD 研究人员还研究了器件的光响应。对光响应的研究包括了两方面工作:第一,测量光响应谱,从而得到探测器对不同波长光的响应率,以及探测器的截至波长;第二,光响应随偏压的变化,以获得合适的工作电压。
图6 是 150 K 下 3 个样品的光响应谱,从图中可以得到,随着掺杂浓度增加,样品的截止波长随着掺杂浓度增加而减短。B1、A1、A2 的截止波长分别3.65 μm、3.82 μm、3.96μm。为了使探测器尽可能覆盖中波窗口,应尽量选择低的掺杂浓度。利用吸收系数的公式,通过标准的转移矩阵技术,SCD研究人员模拟了样品 B1 的光响应谱。由模拟结果得到,nBn器件的内量子效率很高,基本接近 100%。
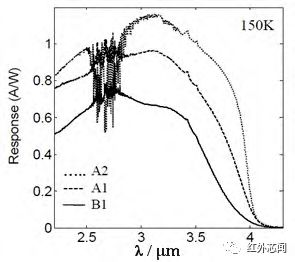
图6 150 K 和-0.6 V 偏压下,A1、A2 及 B1 样品(200 μm × 200 μm尺寸器件)的光响应谱
为了确定器件的工作电压,SCD 研究人员测量了 3 个样品在 150 K 下光响应与偏压的关系,如图 7。由图 7 可以得到,从-0.1 V 到-0.6 V,光响应的偏差不到 5%。因此,-0.1 V 可以作为器件的工作电压。
由于 A2 样品(吸收层低掺杂)内量子效率高,扩散长度大,SCD 研究人员认为利用低吸收掺杂浓度的样品制作的 nBn 探测器,将在 3~4 μm波段范围得到大于 70%的外量子效率。探测器在 150 K 和 f/3 光圈条件下的光电流将达到~4×10-6A/cm2,比其暗电流(~3×10-7 A/cm2)大接近一个量级。即使工作温度提高到160 K,样品A2 的暗电流升高到~9×10-7 A/cm2,依旧只有光电流的 1/4,说明直到 160 K,探测器都将工作在背景限条件。
2.2 焦平面研究
为了研究焦平面性质,SCD 制作了两种规格的焦平面:Blue Fairy(BF)和Pelican。Blue Fairy 焦平面阵列规模 320×256,像元中心距 30 μm;Pelican 焦平面阵列规模 640×512,像元中心距 15 μm。
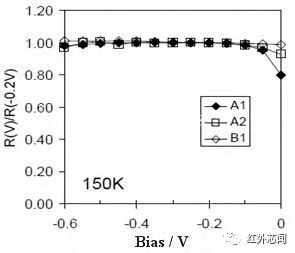
图7 A1、A2 及 B1 样品在 150 K 下光响应与偏压的关系
1)量子效率
2011 年,SCD 报道了 BF 焦平面量子效率谱的测量与计算的结果,如图 8中单程曲线(实线为测量结果,虚线为计算结果)。单程曲线是器件的单程量子效率结果,顶电极反射率只有 20%。为了改进器件工艺,SCD 优化了抗反膜的厚度,并将单程设计改为双程(通过将顶电极的反射率提高到 95%实现)。图中的双程曲线展示了器件工艺优化后的效果(计算结果)。即使在吸收层厚度只有 2.6 μm 的情况下,3~4 μm波段之间的量子效率依然可以超过 60%。
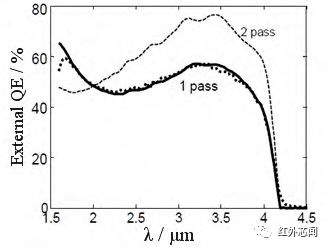
图8 BF 焦平面量子效率谱的测量(实线)与计算(虚线)结果
2)暗电流统计分布
2012 年,SCD 测量了 Pelican 焦平面在150 K 下的暗电流,其统计分布如图 9所示。暗电流平均值为200 fA,FWHM 为均值的 15%。一般在平均量子效率70%的情况下,器件光电流约为 12 pA,是暗电流的60 倍。在 150 K 下,焦平面达到了很好的背景限。这种情况下,背景限工作温度可进一步提升到175 K。
3)NETD 和有效像元率
同年,SCD 报道了Pelican-D 焦平面(数字化读出电路)的NETD 和有效像元率与温度的关系,如图10 所示。结果显示当温度高于170 K,NETD 与有效像元率才开始改变,同样证实器件的背景限工作温度可以达到175 K。

图9 Pelican 焦平面在 150 K 下的暗电流统计分布

图 10 Pelican-D 焦平面的 NETD、有效像元率与温度的关系(在 50℃黑体面前放置 F/3.2 光阑情况下测量)
2.3 两款焦平面探测器产品——Kinglet和Hercules
1)Kinglet
Kinglet 是SCD 第一款nBn 中波高温产品,于2013年推出,焦平面阵列规模为 640×512,像元中心距 15 μm,读出电路为 SCD 自己的“Hot Pelican-D”,制冷机为 Ricor’s K562S 循环斯特林制冷机。Kinglet探测器组件如图 11 所示,具体性能指标列于表 1。
2)HOT Hercules
HOT Hercules 是SCD 第二款nBn 中波高温产品,2014年推出,焦平面阵列规模 1280×1024,像元中心距 15 μm,读出电路为 SCD 自己的数字化读出电路“Hercules”,制冷机为 Ricor’s K508N 循环斯特林制冷机。Hercules 探测器具体性能指标列于表2,组件如图12 所示。
图11 Kinglet 探测器组件
表1 Kinglet 探测器的典型性能指标
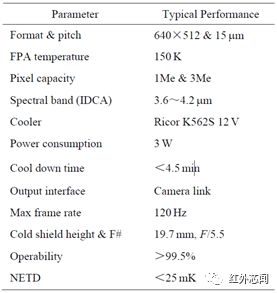
表2 Hercules 探测器的典型性能指标

图12 Hercules 探测器组件
3InAs/GaSb二类超晶格pBp长波器件
SCD 的InAs/GaSb 二类超晶格长波器件同样采用 XBn 和 XBp 器件结构,与 InAsSb 中波高温器件不同的是,超晶格采用 pBp 器件结构,其能带排列示意图如图 13所示。pBp 器件结构吸收层和电极层是 13 ML InAs/7 ML GaSb 超晶格,势垒层是 15 ML InAs/4 ML AlSb 超晶格。
SCD 在 2014 年报道了在 InAs/GaSb 二类超晶格长波焦平面探测器的研究进展。SCD 关于 InAs/GaSb 二类超晶格长波焦平面探测器的研究包括3 方面:计算模拟软件的开发与应用;单元器件性质研究;Pelican-D LW 焦平面产品。
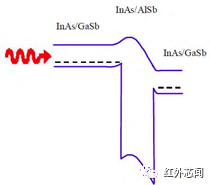
图13 pBp 器件的能带排列示意图
3.1 计算模拟软件的开发与应用
2010 年开始,SCD 发展了一个模拟程序包,可以用来计算超晶格的能带和 pBp 器件的响应光谱。具体流程如下:通过软件计算超晶格能带结构以及态密度,从而得到 XBp 器件的能带排列和吸收层的吸收光谱,进一步通过光学转移矩阵技术计算出 XBp 器件的响应光谱,如图 14 所示。

图 14 超晶格器件的模拟计算流程
他们能带结构的计算是用于晶格匹配材料的基于kp 模型的改进版本,改进模型中需要输入的参数比早期的模型要少。这个模型是由 SCD 的 P. C. Kipstein 发展的,模型比较新颖的地方包括:
1)对于无公共原子的超晶格,比如 InAs/GaSb、InAs/AlSb,其界面矩阵式对角化的,包括了 3 个主要的参数:DS、DX、DZ。
2)而对于有公共原子的超晶格,比如 GaSb/AlSb、InAs/InAsSb,界面矩阵是非对角化的,包括了两个主要的参数:α和β。
3)减少了独立 Luttinger 参数的数量。对于超晶格的 6 个 Luttinger(每种材料 3 个)参数中的 4 个可以由另外 2 个来表示。由这个结果可以得到,基于 InAs/GaSb 和 InAs/AlSb 的 XBpp 器件,只需要 2 个 Luttinger 参数(InAs 的γ1和γ2),而不是 9 个。
进一步计算光谱响应过程中需要输入的参数有每个超晶格层带隙、周期厚度、折射率、少子扩散长度、表面复合速率,以及抗反膜的光学厚度。
图15 是模型计算得到的超晶格材料带隙与 10 K 温度下测量得到的荧光峰位的比较。对于带隙能量100 meV 到 300 meV 之间的超晶格,测量和计算得到的能量偏差在 77 K 下的kBT之内。

图 15 超晶格计算带隙和 10 K 荧光峰位的比较
图16 是 MWIR 和 LWIR 超晶格材料的吸收光谱的测量和模拟结果。模拟结果与测量结果中的主要特征都可以对上,包括在 3 μm 以下由布里渊区边界HH2→E1跃迁产生的强烈的吸收峰。模拟结果表明,如果不考虑界面矩阵元,计算的带隙将会蓝移,中波超晶格材料将蓝移 0.75μm,长波将蓝移 4.5 μm。证明界面对于超晶格的能带结构的贡献不可忽略。

图16 MWIR(a)和 LWIR(b)超晶格材料的吸收光谱的实验值(灰线)与计算值(黑线)
3.2 单元器件性质研究
随后,SCD 报道了对 InAs/GaSb 二类超晶格 pBp单元器件暗电流的研究[11]。暗电流研究中,首先对比pBp 器件和 n+-on-p 二极管器件的暗电流,二者具有相同的 p 型超晶格吸收层,厚度都为 1.5 μm,截至波长都是 10 μm。两种器件(100 μm×100 μm台面)在工作偏压下的暗电流密度的温度依赖关系如图17所示。图中垂直虚线是器件的理想工作温度 77 K,在 77 K 下,二极管的暗电流比 pBp 器件的高一个量级,证实了在 pBp 器件中 G-R 电流得到了抑制。 pBp 器件的暗电流直到 71 K 都是由扩散电流主导的,而二极管器件在温度低于120 K 时,由G-R 电流主导。

图17 InAs/GaSb 100 μm×100 μm台面器件的暗电流随温度的变化关系:(a) pBp 器件@0.6 V;(b)n+-on-p 二极管@ 0.1 V
pBp 器件的暗电流包括了两部分,一部分是垂直扩散电流部分,由光生非平衡少子沿着生长方向输运到电极层被收集;另一部分是平行于势垒层的横向扩散部分,进入到台面的边界。这两部分对应了体电流和边界电流的贡献,具体由 IDark=JBL2+4JPL给出,JBJP分别是体电流和边界电流密度,L 是台面尺寸。在理想的 FPA 中,所有的像元都外加同样的偏压,所以边界电流部分可以忽略,因此体电流才是超晶格材料和器件质量的重要参数。通过测量 8 个不同台面尺寸pBp 器件的暗电流,得到了器件暗电流与台面尺寸的关系,如图 18所示。结果显示体电流与边界电流都对暗电流有贡献,利用公式 IDark/L=JBL+4JP对结果进行拟合,可以得到体电流密度为 6.0×10-6A cm-2。通过这种方法 SCD 研究人员测量了超过 10 个pBp 器件在 77 K 下的体电流密度,并且与 MCT 的 Rule 07 暗电流对比。结果表明 InAs/GaSb 超晶格 pBp器件的暗电流密度比MCT 的Rule07 暗电流大不到一量级,如图 19所示。
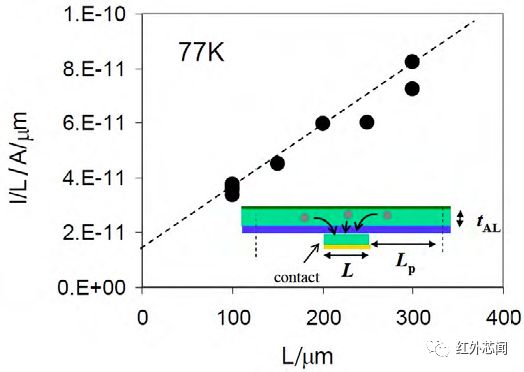
图 18 不同台面尺寸下,InAs/GaSb pBp 测试器件的暗电流
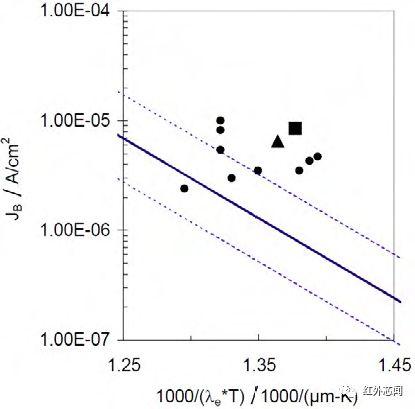
图19 pBp 单元器件暗电流与温度的关系,实线代表碲镉汞Rule07
SCD 研究人员接着研究了InAs/GaSb 二类超晶格 pBp 器件的量子效率。图 20(a)是台面尺寸为 100 μm × 100 μm的器件(吸收层厚度为 3 μm)在不同偏压下的量子效率。从图中可以得到器件的工作电压需要大于 0.6 V,在工作电压下,器件的量子效率接近40%。图 20(b)是量子效率实验值(点)与台面尺寸的关系,同时给出了公式 QE=QE∞(L+2Lp)2/L2的拟合结果(虚线),其中 Lp是横向扩散长度。通过拟合得
QE∞=36%和 Lp=2.3 μm。
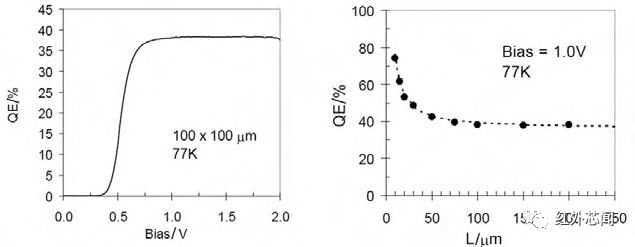
图20 InAs/GaSb pBp 器件量子效率:(a)InAs/GaSb pBp 器件的量子效率(台面尺寸100 μm × 100 μm吸收层厚度 3 μm);(b) 量子效率与台面尺寸的关系
3.3 Pelican-D LW焦平面产品
2015 年,SCD 利用 pBp 结构制研制了长波焦平面阵列 Pelican-D LW,阵列规模为 640×512,像元中心距 15 μm,焦平面阵列被互连到 SCD 公司新开发的读出电路上。“Pelican-D LW”是 SCD 第一款长波 XBp 焦平面产品。探测器工作温度为 77 K,截止波长为 9.5 μm。
文献[14]中同时报道了 Pelican-D LW 焦平面的光电性质及辐照性质。图21是78 K 下“Pelican-D LW”焦平面的暗电流统计分布,中值暗电流约为 100 pA,
对应暗电流密度 4.4×10-5 A/cm-2,仅比 MCT Rules 07 的暗电流大不到一个量级。暗电流的分布很窄,半高全宽大约为中值的 6%。窄的暗电流分布有利于焦平面阵列在微小温度或偏压波动下的稳定性。

图21 Pelican-D LW 焦平面在 78 K 下 FPA 暗电流的统计分布
Pelican-D LW 焦平面在 78 K、240 Hz 的帧频以及 F/2.7 下的 NETD 为36 mK。通过平均 8 个帧频,器件的有效帧频变为 30 Hz。这种情况下的 NETD 的统计分布情况如图 22所示。从图中可以得出峰值 NETD 为 13 mK,分布很窄,且不存在明显的分布尾。
图23是焦平面阵列的量子效率分布。失效像元数为 1446,相应的有效像元率为 99.56%。图中整个焦平面的量子效率值都在48%左右(吸收层厚度为4.5 μm,单程)。如果背景限温度定义为暗电流与光电流相等时的工作温度,可以得到光圈为 F/2.7 时焦平面的背景限温度为 90 K。
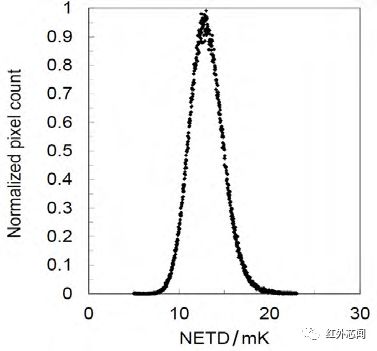
图22 Pelican-D LW 焦平面 NETD 的统计分布(@78 K 温度、30 Hz 的帧频)
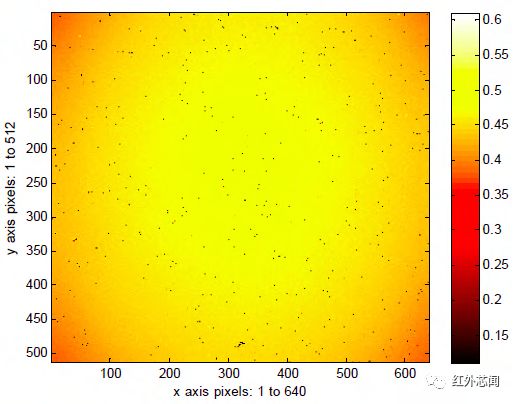
图23 78 K 下,Pelican-D LW 焦平面阵列的量子效率分布
Pelican-DLW 探测器组件照片如图 24 所示,具体性能指标列于表 3。图 25是 Pelican-DLW 焦平面相机在 77 K 下拍出的照片。
4 小结
本文从材料结构设计、单元器件测试、焦平面验证3 方面总结了 SCD 在 InAsSb nBn 中波高温探测器和InAs/GaSb 二类超晶格pBp 长波探测器两种探测器的研发历程。SCD 公司通过 XBn、XBp 势垒型器件结构设计抑制器件暗电流,成功研发出了中波高温器件和高性能长波探测器两种三代探测器的重要产品。InAsSb nBn 中波高温探测器工作温度可达 150℃; InAs/GaSb 二类超晶格 pBp 长波探测器 77 K 下的暗电流低至 4.4×10-5A/cm-2,仅比 MCT 的 Rule 07 暗电流大不到一量级。表 4 对比了 SCD 公司与其他研究机构III-V 族红外焦平面探测器的相关参数,从中可以看出,SCD 公司产品的部分典型性能处于领先地位。
图24 Pelican-D 探测器组件
图25 Pelican-DLW 焦平面在 77 K 下拍出的照片
表3 Pelican-DLW 焦平面探测器的性能指标

表4 SCD 与其他或研究机构红外焦平面探测器性能对比
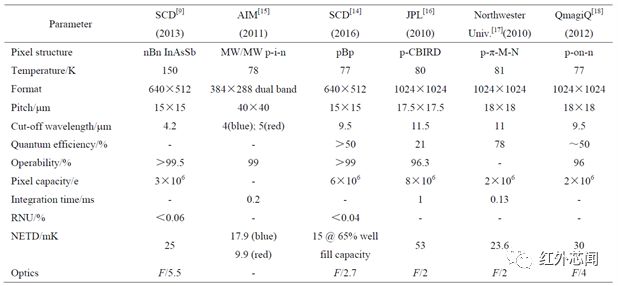
-
InAs/GaSb Ⅱ类超晶格长波红外探测器的表面处理研究2023-01-31 974
-
总结近十年对中波红外探测器的研究热点2020-08-31 3924
-
基于InAs/GaSbII类超晶格的长波红外探测器2020-09-15 3976
-
高性能锑化物超晶格中红外探测器研究进展2022-04-19 1561
-
基于锑化物Ⅱ类超晶格InAs/InAsSb的研究进展2022-08-13 1986
-
II类超晶格红外探测器原理2022-11-24 3716
-
InAs/GaSb II类超晶格长波焦平面阵列台面ICP刻蚀技术研究2022-11-29 1310
-
综述:铟砷锑(InAsSb)红外探测器的研究进展2022-12-02 1521
-
华北光电技术研究所研制中/长波双色二类超晶格红外探测器2023-01-13 1222
-
短波/中波/长波红外热像仪助力高温过程监控2023-02-06 1397
-
晶格失配对InAs基室温中波红外探测器性能的影响2023-05-23 551
-
二类超晶格制冷红外焦平面探测器2022-10-31 1218
-
InAs/GaSb Ⅱ类超晶格长波红外探测器研究进展2023-09-09 667
-
基于Ⅱ类超晶格的中波红外带间级联探测器设计实现2023-10-10 518
-
InAs/GaSb Ⅱ类超晶格红外探测器背减薄技术工作研究2023-11-09 466
全部0条评论

快来发表一下你的评论吧 !

