
资料下载

FD-SOI与深度耗尽沟道DDC MOS器件的详细资料介绍
当MOS器件的特征尺寸不断缩小至22nm及以下时,提高沟道的掺杂浓度和降低源漏结深已仍不能很好的改善短沟道效应。在SOI绝缘层上的平面硅技术基础上提出FD-SOI晶体管。研究发现要使FD-SOI有效抑制短沟道效应,并能正常工作,绝缘层上硅膜的厚度应限制在栅长的四分之一左右。FD-SOI晶体管的沟道厚度很小,下面紧贴着埋层氧化物,栅的垂直电场可以有效的控制器件的沟道,从而降低了器件关闭时的漏电流,抑制短沟道效应。SOI晶片有三层:1. 硅的薄表面层(形成晶体管);2.绝缘材料埋层;3.用于支撑的硅衬底。图3.和图4是CMOS集成电路体硅平面结构、FD-SOI结构与FinEFT结构对比。
掩埋氧化层是为了减少寄生结电容。寄生电容越小,晶体管工作越快。埋入氧化层薄到与沟道的深度相同,硅薄膜限定了源漏结深,且不存在远离栅极的泄漏路径。同时也限定了源漏结的耗尽区,减少源漏耗尽区横向扩展宽度,可改善DIBL,短沟道效应,亚阈特性,降低电路的静态功耗。此外,FDSOI晶体管无需沟道掺杂,可以避免随机掺杂涨落效应,从而保持稳定的阈值电压,同时还可以避免因掺杂而引起的迁移率退化。采用FD-SOI的功耗更低,成本更少。
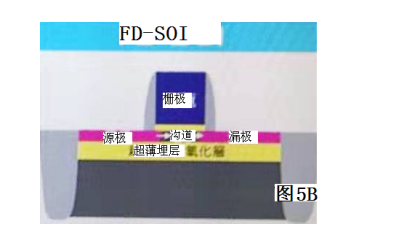
FD-SOI优势
FD-SOI具有低功耗,防辐射,低软错误率,耐高温和EMC。2.漏/源寄生电容减小,,提高了器件频率,降低漏电流与功耗。与体硅CMOS相比,器件的延迟和动态功耗更低。3.具有背面偏置能力,还可以降低电源电压,20nm厚度的氧化埋层 类似第二个栅氧化层(衬底是栅极)衬底加偏置电压可以获得调节阈值电压VT效果。(加强栅对沟道的控制能力) 4.消除了闩锁效应。5.与硅工艺相容,可减少13-20%工序,具有更好的mos器件特性,SOI器件的亚阈值特性更好。5.浮体效应很小。6.FD-SOI的生态圈已涵盖工具厂商、IP厂商、设计服务厂商、芯片厂商、制造厂商等,以提供易于获取的即插即用方案,可以最大限度降低客户成本。
存在问题:1.自加热效应。在SOI器件中,有源薄体在氧化硅上,氧化硅是绝热材料。在工作期间,有源区域消耗功率产生的热量不容易消散。导致硅薄体的温度升高,降低了器件的性能。2.晶圆埋入氧化层的制造工艺复杂,价格较贵。晶片的成本高于体硅晶片,且SOI晶圆合格供应商的数量有限。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。 举报投诉
- 相关下载
- 相关文章








