

半导体改质切割的应用、优势及加工方案
电子说
描述
1、半导体材料简介
半导体(semiconductor),指常温下导电性能介于导体(conductor)与绝缘体(insulator)之间的材料。
常用半导体材料分为元素半导体和化合物半导体。
元素半导体是由单一元素制成的半导体材料,主要有硅、锗、硒等,以硅、锗应用最广。
化合物半导体即是指由两种或两种以上元素以确定的原子配比形成的化合物,并具有确定的禁带宽度和能带结构等半导体性质。
半导体材料按其发展历程:

大族激光在半导体材料上与相关客户协作,共同完善现有半导体行业遇到的制程工艺问题,提供一整套的解决方案。特别针对半导体行业中晶圆片对加工过程洁净度高要求的需求,我们提出激光改质切割技术。
2、改质切割加工原理
激光改质切割是使用特定波长的激光束通过透镜聚焦在晶圆内部,产生局部形变层即改质层,该层主要是由孔洞、高位错密度层以及裂纹组成。改质层是后续晶圆切割龟裂的起始点,可通过优化激光和光路系统使改质层限定在晶圆内部,对晶圆表面和底面不产生热损伤,再借用外力将裂纹引导至晶圆表面和底面进而将晶圆分离成需要的尺寸。
图1改质加工示意图
3、半导体改质切割的应用、优势及加工方案
3.1半导体改质切割应用
改质切割工艺在半导体封装行业内可应用于MEMS芯片、FRID芯片、SIM芯片、存储芯片、SiC芯片等,但对晶圆而言需要一定的要求:
l拥有特定的图案便于CCD的精准定位;
l划片槽宽度大于等于20 um,在激光扫描和机台定位精度内。
l正面激光加工时,晶圆表面不能有TEG/金属层。
l背面激光加工时,晶圆背面需贴附改质专用贴膜。
3.2半导体改质切割优势
传统的晶圆切割通常使用刀轮,刀轮切割主要通过其稳定、高速的旋转对晶圆进行磨削,切割过程中需要使用冷却液降低温度和带走碎屑。
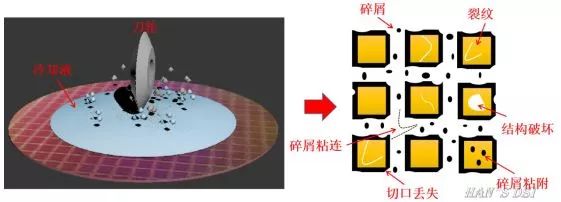
图2刀轮加工示意图

图3刀轮切割和改质切割对比
对比刀轮切割,改质切割具有明显的优势,具体如下:
l完全干燥的加工过程;
l切割表面无沾污,不产生碎片、损伤,截面陡直、无倾斜,零切割线宽;
l非接触式切割,使用寿命长。
3.3半导体改质切割工艺方案
大族激光全自动晶圆激光切割机为客户提供一整套晶圆(Si或SiC)切割工艺方案。针对晶圆片我们提供以下加工方案,将晶圆背面贴上特质膜,使用激光在晶圆正面划片槽内进行划片,最后对晶圆扩膜(部分晶圆需要裂片+扩膜,视实际产品及应用而定)。
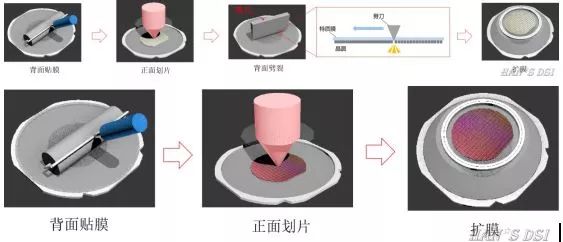
图4晶圆片改质加工方案
目前大部分半导体材料(如Si、SiC、GaN、GaAs等)或脆性材料(如玻璃、蓝宝石、钽酸锂等)均已用此技术方案进行生产加工。
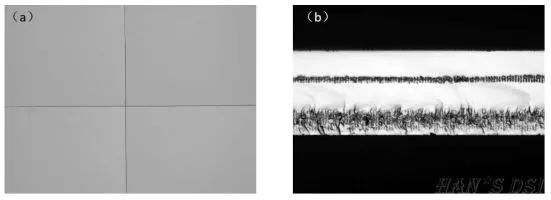
图5 Si改质效果:(a)上表面示意图,直线度小于5 um(b)晶圆加工的截面效果
-
半导体切割专用树脂垫条2012-03-10 0
-
半导体切割用的树脂垫条2012-03-17 0
-
半导体制造2012-07-11 0
-
半导体封装行业用切割片2017-10-21 0
-
瓷砖水刀切割加工,不锈钢水切割加工2018-07-04 0
-
金属材料水切割加工,数控水切割加工2018-07-05 0
-
铜花水切割加工,铜板切割镂空雕花加工2018-07-05 0
-
装饰屏风水切割加工,铜材雕花水切割加工2018-07-06 0
-
东莞茶山水切割加工,金属切割加工2018-08-17 0
-
半导体激光器的发展2019-05-13 0
-
什么是半导体晶圆?2021-07-23 0
-
意法半导体改组地区组织结构2009-12-05 574
-
半导体晶体的切割及磨削加工2021-04-09 917
-
晶圆划片机:晶圆封测切割精密加工类设备2022-04-29 968
-
博捷芯:晶圆切割提升晶圆工艺制程,国产半导体划片机解决方案2023-06-05 9247
全部0条评论

快来发表一下你的评论吧 !

