
资料下载

如何在工艺开发过程中提高新设计风格的良率
在工艺开发的早期阶段预测和提高良率是在测试掩模上创建测试宏的主要原因之一。在早期工艺开发阶段发现潜在故障,使得设计团队能够实施上游纠正措施和/或工艺变更,从而减少生产中达到期望制造良率所需的时间。
通常有三类缺陷会降低晶圆良率。第一类包括随机缺陷,发生的原因是不同处理室中存在污染粒子。导电粒子可以使两条或更多相邻导线短路,或建立漏电路径。非导电粒子或空隙可以使导线或过孔开路,或建立高阻性路径。图 1 显示了这两种随机缺陷的扫描电子显微镜 (SEM) 图像。
第二类包括系统缺陷,发生原因是物理版图架构不理想,或非最优化的光学处理方法和/或设备的影响。系统缺陷通常是良率减损的最大原因 。此类缺陷可以通过设计和工艺协同优化 (DTCO) 来消除。第三类包括参数缺陷,例如掺杂工艺缺乏均匀性(这可能影响器件可靠性),但本文不涉及此类缺陷。
对于新的工艺节点,常规良率提升技巧依赖于使用来自先前工艺节点的设计作为起点,以识别用于创建实验设计 (DoE) 的图形,但如果新设计工艺在先前的节点中不存在,那么将难以应用这些技巧。人类设计师的经验不适用,因为先前的设计中没有出现类似的问题。先前没有测试数据可供设计人员从中获取反馈,以创建新的测试结构,或确定能够更快提高良率的工艺或设计风格优化措施。
一种新方法有望缓解这些担忧。利用创新技术,设计团队可以生成额外的宏以添加到测试结构中,而无需依赖过去的设计提供输入。相反,这些宏基于单元图形的生成和随机放置,这些单元图形可以构建更有意义的更大图形。可以调整控制这些单元图形间关系的规范,以生成看起来像真实设计的版图剪辑。然后,DoE 实验中可以使用这些版图剪辑来预测良率,并确定有助于提高良率的潜在设计和工艺优化措施。通过使用这种新的版图模式生成器 (LSG) 流程,设计人员可以显著减少采用新设计技术的设计达到期望的良率所需的时间。
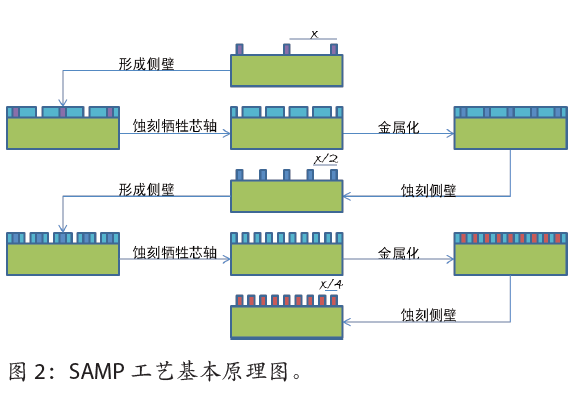
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。 举报投诉
- 相关下载
- 相关文章







