

MEMS综合学科,其涉及微加工技术、机械学、电子学等
电子说
描述
虽然大部分人对于MEMS(Microelectromechanical systems,微机电系统/微机械/微系统)还是感到很陌生,但其实MEMS在我们生产,甚至生活中早于无处不在了,智能手机、健身手环、打印机、汽车、无人机以及VR/AR头戴式设备,部分早期和几乎所有近期电子产品都应用了MEMS器件。
MEMS(微机电系统)是一门综合学科,其涉及微加工技术、机械学、电子学等等。MEMS器件的大小从1毫米到1微米不等,其主要优点是体积小、重量轻、功耗低、可靠性高、灵敏度高、易于集成等,是微型传感器的主力军,正在逐渐取代传统机械传感器,MEMS传感器的分类如下图,当然这里也没有将MEMS传感器的类型全部涵盖。
MEMS传感器作为获取信息的关键器件,对各种传感装置的微型化起着巨大的推动作用,已在太空卫星、运载火箭、航空航天设备、飞机、各种车辆、生特医学及消费电子产品等领域中得到了广泛的应用。MEMS传感器典型应用如下图。

以MEMS麦克风为例,其包含一个灵活悬浮的薄膜,它可在一个固定背板之上自由移动,所有元件均在一个硅晶圆上制造。该结构形成一个可变电容,固定电荷施加于薄膜与背板之间。传入的声压波通过背板中的孔,引起薄膜运动,其运动量与压缩和稀疏波的幅度成比例。这种运动改变薄膜与背板之间的距离,进而改变电容,如下图所示。在电荷恒定的情况下,此电容变化转换为电信号。
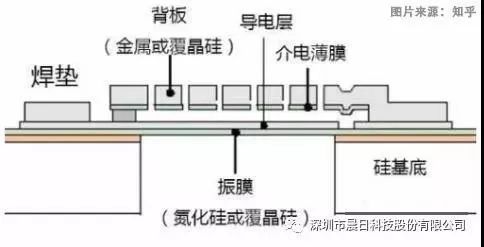
相较于ECM麦克风的聚合材料振动膜,在不同温度下,MEMS麦克风所展现的性能都相当稳定,不会受到时间、温度、湿度和振动的影响。MEMS麦克风的耐热性相当强,可以承受摄氏260度的高温回流焊,但是其性能不会有任何变化。再加上MEMS麦克风可以有效的降低射频所产生的干扰,这就让其逐渐发展成为麦克风主流,美国IHS全球产业研究报告表示全球MEMS麦克风市场仍将连续5年维持18%的年复合成长率(CAGR)。
MEMS的快速发展是基于MEMS之前已经相当成熟的微电子技术、集成电路技术及其加工工艺,MEMS需要专门的电子电路IC进行采样或驱动,一般工艺为先分别制造好MEMS和IC,然后将两者集成封装于同一个单芯片内,如图。
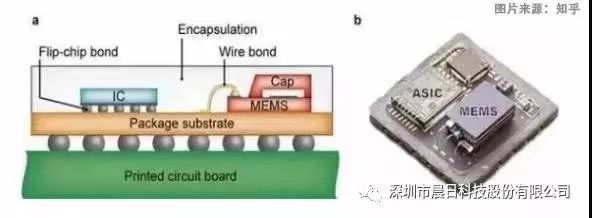
封装通常采用倒装焊(FCB)封装方式。焊接时在芯片有源面的铝压焊块上做出凸起的焊点,然后将芯片倒扣,直接与基板连接。由于芯片与基板直接相连,倒装焊实现了封装的小型化、轻便化,缩小了封装后器件的体积和重量。由于凸点可以布满整个管芯,所以有效增加了I/O互连密度。因连线缩短,引线电感减小,串扰变弱,信号传输时间缩短,所以电性能大为改善。从几何层面上看,倒装芯片面向下组装,为光信号提供了直线通路,故非常适合光MEMS器件的设计和封装。同时由物理层面上看,倒装芯片给MEMS器件提供了热力载体。此外,因为倒装焊对芯片与基板具有很强的适应性,所以非常适用于MEMS器件的热设计中。鉴于其本身的一系列优点,倒装焊已经成为MEMS封装中颇有吸引力的一种选择,也给锡膏这种倒装焊制造工艺流程的关键辅料带来了新的挑战。
为适应这一市场需求,深圳市晨日科技股份有限公司在十多年来在半导体封装材料、LED封装材料和电子组装材料技术研发的基础上,开发出了ES855-V和ES990-V两款用于MEMS倒装焊无铅锡膏。
1、SAC305合金,五号粉,适用于MEMS倒装封装工艺.
2、满足超细间距印刷工艺性要求,操作窗口宽,持续印刷一致性好.
3、高粘着力,保持元件黏着.
4、工艺窗口宽,使得回流温度曲线灵活.
5、焊点表面光亮、少皱褶、极低空洞率、高可靠性.
1、Sn90Sb10合金,五号粉,适用于MEMS倒装封装工艺和二次回流工艺.
2、满足超细间距印刷工艺性要求,操作窗口宽,持续印刷一致性好.
3、高粘着力,保持元件黏着.
4、工艺窗口宽,使得回流温度曲线灵活.
5、焊点表面光亮、少皱褶、极低空洞率、高可靠性.
-
机械学基础精品课程2009-07-05 0
-
电子学(第二版)2016-06-11 0
-
高速高压放大器——MEMS光栅控制驱动中的典型应用2016-07-27 0
-
ATA-2000系列 高压放大器——MEMS光栅控制驱动中的典型应用2016-08-04 0
-
MEMS传感器是什么?mems的工艺是什么?2016-12-09 0
-
任意波形发生器,MEMS中功率放大器应用2017-10-09 0
-
中国科学院电子学研究所2017年博士后招收启事2017-12-18 0
-
基于绿色机械加工技术的应用与研究2018-03-06 0
-
MEMS元器件的组成部分2018-09-07 0
-
表面硅MEMS加工技术的关键工艺2018-11-05 0
-
MEMS传感器概念和分类等基础知识详解2018-11-12 0
-
真空电子学对太赫兹辐射源会有什么贡献2019-05-28 0
-
MEMS传感器的主要应用领域2020-08-13 0
-
电子学综合实训台QY-DQJ05装置主要功能有哪些?2021-07-11 0
-
电力电子学和电力电子技术有何关系2021-07-12 0
全部0条评论

快来发表一下你的评论吧 !

