

PCB的焊盘润湿性不良的分析过程
电子说
1.4w人已加入
描述
一、样品描述
所送检的PCBA样品经电性能测试发现其BGA部位可能有焊接不良(怀疑虚焊)存在,现需分析该问题是该PCBA在SMT制程中造成或是PCB的(即上锡不良)原因。一件PCBA样品与所用的3件PCB样品。
二、分析过程
1.显微分析
将PCBA上的BGA部分切下,用环氧树脂镶嵌、刨磨、抛光、腐蚀制作BGA焊点的金相剖面或截面,然后用NikonOPTIPHOT金相显微镜与LEICAMZ6立体显微镜进行观察分析,发现在第一排的第四焊点存在缺陷,锡球与焊盘间有明显的分离现象(图1),其他焊点未检查到类似情况。
图1BGA焊点(第一排第4个)切片截面显微镜照片(1)
2.PCB焊盘的可焊性分析
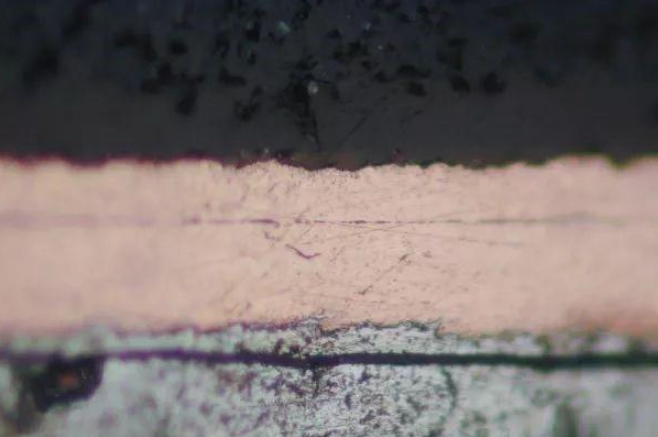
图2BGA焊点缺陷部位放大的显微镜照片(2)

图3PCB上的BGA焊接部位的润湿不良的焊盘(1)

图4PCB上的润湿不良的焊盘(2)
3.PCB表面状态分析

图5在PCB上检测到的一个不良焊盘的外观
4.SEM以及EDX分析

图6不良焊点截面的外观SEM分析照片。
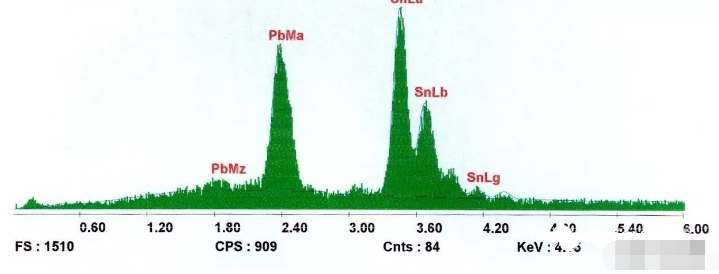
图7SEM照片中A部位的化学(元素)组成分析结果
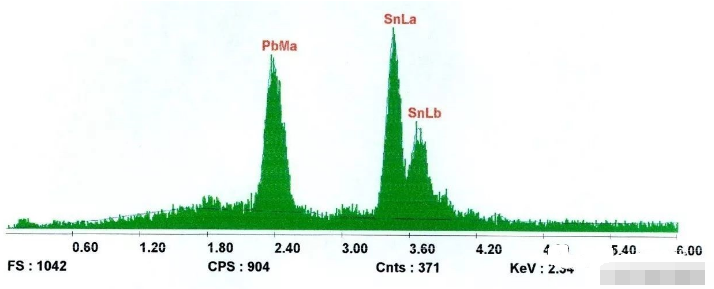
图8SEM照片中B部位的化学(元素)组成分析结果
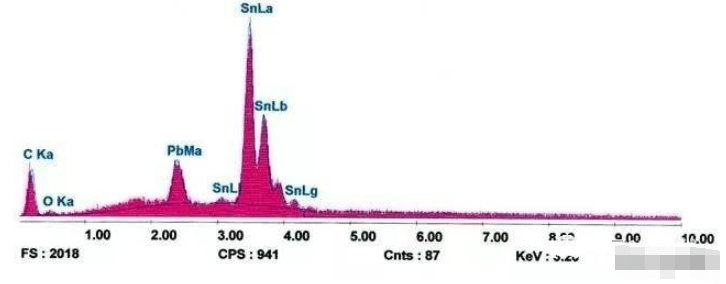
图9图5中不良焊盘的表面的化学(元素)组成分析结果
5.焊锡膏的润湿性分析
三、结论
经过以上分析,可以得出这样的结论:
送PCBA样品的BGA部位的第一排第4焊点存在不良缺陷,锡球焊点与焊盘间有明显开路。
造成开路的原因为:该PCB的焊盘润湿性(可焊性)不良,焊盘表面存在不明有机物,该有机物绝缘且阻焊,使BGA焊料球无法与焊盘在焊接时形成金属化层。
责任编辑人:CC
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
PCB加工时常见的问题及解决方法2021-02-05 2225
-
无铅喷锡(HASL)润湿不良问题及对策2012-08-29 1716
-
PCB焊盘大小规定2016-05-27 3905
-
PCBA加工润湿不良的原因_PCBA加工润湿不良的解决办法2019-09-10 2500
-
PCB熔锡不良失效分析2022-08-10 3487
-
沉金PCB焊盘不润湿问题的分析方法2022-11-28 4711
-
【设计干货】 PCB焊盘大小的DFA可焊性设计2023-03-14 2221
-
PCBA焊接润湿不良分析2023-05-23 2286
-
PCB焊盘设计之问题详解2023-06-21 3243
-
BGA焊接出现故障,印制板焊盘润湿不良的原因是什么2023-09-08 1172
-
PCB焊盘大小的DFA可焊性设计2024-01-06 3145
-
详解电子元件的润湿平衡实验2024-03-27 1885
-
pcb焊盘区域凸起可以焊吗2024-09-02 2521
-
PCB上锡不良的“元凶”分析:从材料到工艺的全链路拆解2025-11-06 2417
全部0条评论

快来发表一下你的评论吧 !

