

IGBT器件结壳热阻测试
今日头条
描述
IGBT热阻的研究对于延长IGBT的使用寿命和提高其应用可靠性具有重要的现实意义,目前获取IGBT热阻参数的试验方法多为热敏参数法,该方法方便简洁、对硬件要求低,但是传统的热敏参数法需要测量器件的壳温,而IGBT器件由于封装尺寸远大于芯片尺寸,所以壳温不易准确测量,测量过程中引入的误差较多,最终无法得到器件真正的热阻值。
与传统测试方法相比,JESD51-14热阻瞬态双界面测试法具有更高的准确性和重现性,而T3ster是目前全球唯一满足此测试标准的仪器。使用T3ster对IGBT器件进行测试,可以记录模块结温瞬态变化过程,能得到稳态的结壳热阻数据,也能得到结温随时间变化的瞬态曲线,还可以通过结构函数分析器件热传导路径上各层结构的热阻值。
金鉴实验室近期推出了“IGBT器件结壳热阻测试”,并成功应用于英飞凌IGBT产品上。
服务客户:IGBT器件厂家、代理商、用户等
服务内容:
1.器件结壳热阻测试
2.芯片结温测试
3.结构无损检测
4.封装材料和工艺优化
5.器件可靠性筛选
6.老化试验表征手段
测试数据包括:(1)瞬态温度响应曲线;(2)热阻抗曲线;(3)频域响应;(4)脉冲热阻;(5)积分结构函数与微分结构函数。
一、金鉴实验室应用举例:
某客户委托金鉴对近期购买的英飞凌IGBT器件进行结壳热阻测试,要求分别测试IGBT芯片及二极管芯片的结壳热阻值,测试结果如下所示:
IGBT芯片结壳热阻测试:
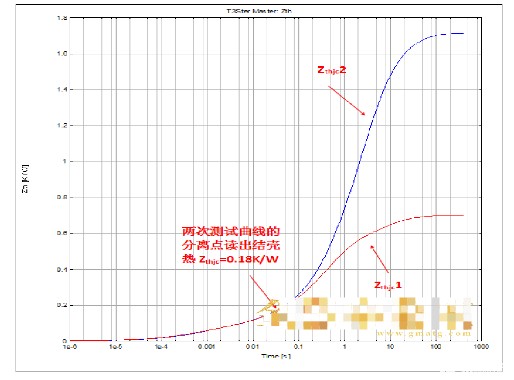
双界面测试法热阻抗曲线
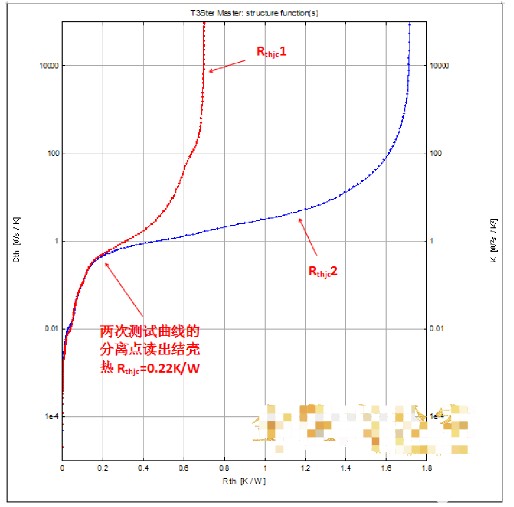
双界面测试法结构函数曲线
Zthjc1和Zthjc2两曲线在分离点的值Zthjc(ts)不一定等于稳态时的结壳热阻Rthjc,原因是在稳态时(需要很长时间)和在瞬态ts时器件内部的热流分布不一样。当Zthjc(ts)
二极管结壳热阻测试:
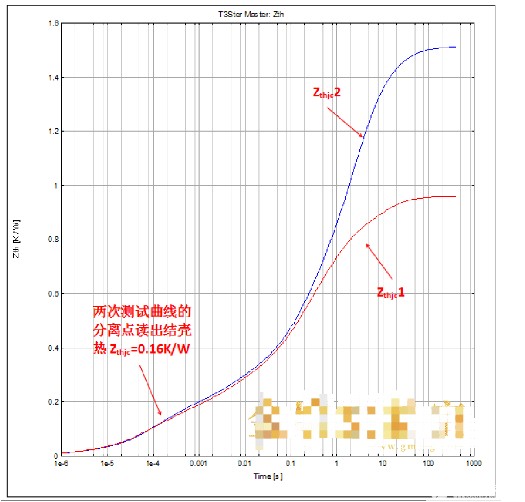
双界面测试法瞬态热阻曲线
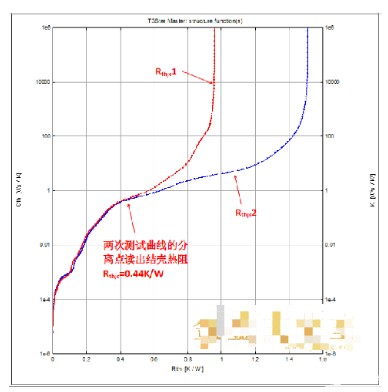
双界面测试法结构函数曲线
二极管芯片测试结果也是Zthjc(ts)
二、温度循环下IGBT热阻退化模型的研究
研究IGBT功率器件在热应力不断冲击过程中热阻的老化规律,并以此为依据对器件的健康状态进行评估,预测器件的剩余寿命具有十分重要的科学意义。
实验过程:先测试IGBT的初始热阻,再将IGBT器件放入老化设备中,每经过1000次温度循环,重新测量器件的结壳热阻值,直到器件失效为止。下图是温度循环下IGBT热阻及其偏移量的波形。

由图可知,随着热应力的不断冲击,IGBT的性能发生了一定程度的退化,热阻随着温度循环次数的增多不断增大,这代表器件焊接层出现了疲劳损伤。其它研究表明IGBT器件先发生焊接层失效,当焊接层失效到一定程度后铝引线才开始失效,所以监测IGBT器件热阻情况更能有效的掌握其健康状态。
责任编辑:tzh
-
T3Ste热测试仪的典型应用案例2013-01-08 10444
-
LED封装器件的热阻测试及散热能力评估2015-07-29 7747
-
关于热阻测试2017-09-29 5432
-
IGBT模块瞬态热特性退化分析2020-12-10 2149
-
半导体集成电路封装结到外壳热阻测试方法2011-11-22 1243
-
LED结温预算软件_测试贴片热阻小软件2013-03-06 543
-
LED封装器件热阻测试2021-05-26 4292
-
如何理解IGBT的热阻和热阻抗2023-02-23 1147
-
瞬态热阻抗准确计算IGBT模块结壳热阻的方法2023-04-04 4446
-
p柱浮空的超结IGBT器件的设计案例2023-08-08 752
-
半导体器件为什么热阻参数经常被误用?2023-09-25 4468
-
功率器件热设计基础(三)—— 结温计算完整流程与工程实用方法2026-03-01 199
全部0条评论

快来发表一下你的评论吧 !

