

针对(三五族)薄小芯片的挑片分选方案说明
描述
芯片分选(Die Sorting)是芯片封装过程中一个关键但被易忽视的步骤。传统封装中,芯片分选一般在晶圆切割之后。而在WLP中,则可能在芯片封装之后进行分选。
一般来说,不同于硅材料器件多用于存储和逻辑方面,三五族半导体材料如GaAs、InSb、GaN等多用于光电集成器件及功率器件制造。
Die Sorting本质上是一个对目标芯片的转移过程,挑片机(Sorter)对划切后wafer进行挑片的过程可以简述为:ejector顶起芯片→attach head吸取芯片→head移动至目标位置→将芯片放置于target carrier上。

(厚度0.05mm)
上图为某一6寸三五族材料晶圆上Die的尺寸规格,挑片方式为wafer to tray,将划切后钢圈蓝膜(或子母环)上的芯片挑到Gel-Pak上,过程及方案如下:
1.顶起芯片:
方案:设备的ejector装置需要针对薄小芯片进行定制,在顶针形状直径以及顶起高度上进行特别设计。易捷测试(GBIT)有独家的空气顶针方案(air eject module),通过空气而不是金属顶针的方式,将芯片在蓝膜上顶起的同时避免硬接触,对于超薄芯片有极佳的保护效果。

2.吸取芯片:
方案:attach head需要具备真空力度调整功能,同时需要配备定制吸嘴。我们(易捷测试GBIT)为此提供高平面度槽式结构吸嘴,尺寸及结构与芯片进行定制化适配。同时设备取片时attach head通过图像识别进行高精度定位,包括XY定位及高度定位,从而能够在平稳、快速地吸取芯片的同时,不对芯片带来二次污染或损伤。
3.转移芯片:
方案:如果只需要进行背面检查,则可以在转移区域下方放置相机,在芯片挑选移动的过程中拍摄芯片背面图像并进行对比检查。如果需要做正面光检,则需要添加AOI(自动光学检查)装置。包括上置的镜组相机和放置芯片的stage(放置平台)。同时移动芯片的动作进行相应更改:attach head取出芯片后,移动至stage放置芯片,进行AOI之后再次吸取芯片移动至target carrier。易捷测试(GBIT)提供定制化芯片检查方案option,可同时兼容背检和正面检查,并通过图像识别进行二次定位。Attach head移动通过直线电机驱动,运动平稳且定位精度高。易捷测试(GBIT)还提供双head配置,两个attach head进行分步挑片,能够有效提高挑片速度。

4.放置芯片:
方案:放置时attach head的放置压力需要在软件中可调整,放置时真空吸嘴不能有残余真空或者与芯片粘连。易捷测试(GBIT)为此提供专用的attach head unit,不仅放置压力(0~150gf)和抛片高度可调,还具备防振动结构,放片时更加平稳精准。

挑片设备整体考量:

最后是设备的挑片方式和上下料方式,其实这点在制定方案时应该放到一开始就进行考虑。不过因为这不是三五族薄小芯片挑片的制约因素,所以我们放到最后说明。
大批量快速挑片设备称为全自动挑片机或全自动芯片分选机,具备自动上下料机构,wafer由机械手从cassette中放置于wafer stage上,挑片结束后,载盒会被自动放置于magazine中,全程无需人工参与。小批次多种类的挑片一般使用半自动挑片机,这类设备需要手动将钢圈蓝膜放置于stage,挑片过程自动,结束后需要手动将tray盘取下。
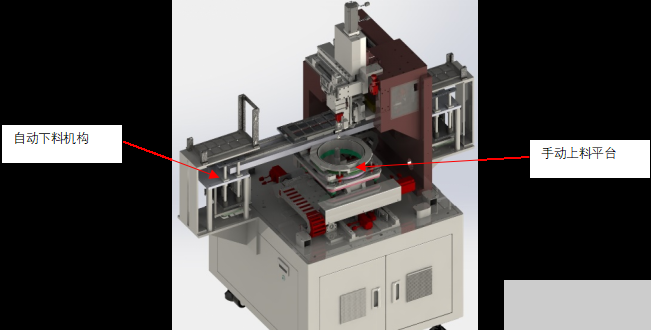
fqj
-
LED分选技术2017-08-04 3770
-
灵猴机器人应用方案 采用机械臂实现电芯的自动分选2017-08-22 5542
-
高速DAC和多片ADC电路的最佳医用隔离方案2018-08-13 5389
-
LED芯片测试的分选,LED的测试分选2018-08-24 5389
-
SDVS30智能光纤分选控制器2020-10-26 1398
-
基于图像处理的石英晶体片分选系统,看完你就懂了2021-04-22 1500
-
三五族太阳能电池性能 ( CPV ) 进展报告2010-01-22 2000
-
LED的分选方法及应用详述2017-10-26 2031
-
锂电池分选机的分选步骤介绍2021-12-24 2147
-
AOI对电池片的外观缺陷和颜色分选2023-05-31 4028
-
方型铝壳电芯自动分选机:高效精准的电池分选解决方案2024-12-03 961
-
流量传感器在半导体芯片测试的分选机中应用2025-04-23 835
全部0条评论

快来发表一下你的评论吧 !

