

氮化镓的蚀刻速率与氩离子电流的关系
今日头条
描述
引言
第三族氮化物已成为短波长发射器、高温微波晶体管、光电探测器和场发射尖端的通用半导体。这些材料的加工非常重要,因为它们具有异常高的键能。综述了近年来针对这些材料发展起来的湿法刻蚀方法。提出了通过电感耦合等离子体反应离子蚀刻获得的高蚀刻速率和高度各向异性的轮廓。光增强湿法蚀刻提供了一种获得高蚀刻速率而没有离子诱导损伤的替代途径。该方法适用于器件制造以及n-氮化镓中位错密度的估算。这有可能发展成为一种快速评估材料的方法。
介绍
在过去的十年中,宽带隙第三族氮化物的合成和生长的成功使得实现广泛的新器件成为可能。ⅲ族氮化物的带隙能量范围从InN的1.9电子伏到GaN的3.4电子伏到AlN的6.2电子伏。使用这些材料,已经证明了在短波长下工作的明亮发光二极管(LEDs)和激光二极管(LDs) [1,2]。事实上,具有寿命大于10,000小时的InGaN/AlGaN活性层的LDs已经被证明使得这些器件的商业化成为必然。氮化镓优异的电子传输特性,加上宽带隙、化学稳定性和AlGaN/GaN异质结构的可用性,也使得ⅲ族氮化物适用于高功率、高温晶体管。已经证明蓝宝石上的AlGaN/GaN异质结构场效应晶体管(HFETs)在大于70 GHz的频率下工作[3],并且还制造了生长在SiC上的类似HFETs,其功率密度高达6.8w/mm[4]。最近,AlGaN/GaN异质结双极晶体管已经被证明。
这些器件性能的提高取决于外延材料的质量和器件加工技术的发展。特别是,有效的蚀刻技术对于形成氮化镓发光二极管的刻面、定义光电探测器的台面和氟化铪的栅极凹陷至关重要。与传统的ⅲ-ⅴ族半导体相比,ⅲ族氮化物具有较高的键能。InN的键能为7.7电子伏/原子,GaN为8.9电子伏/原子,AlN为11.5电子伏/原子,而GaAs为6.5电子伏/原子。高的键强度和宽的带隙使它们在室温下基本上是化学惰性的,并且对碱和酸有很强的抵抗力。因此,已经研究了多种干法和湿法蚀刻技术来处理ⅲ族氮化物。由于ⅲ-氮化物的键强度很高,需要外部能量来引发和维持键的离解。对于不同的蚀刻方法,外部能量的来源包括高能离子、高能电子和光辐射。在本文中,我们介绍了这些蚀刻方法,并讨论了其中一些应用于ⅲ族氮化物的进展。
氮化镓的蚀刻速率与氩离子电流的关系。
显著不同,因此诸如用于激光器的异质结构基本上可以以相等的蚀刻速率被蚀刻。Ar/Cl2 CAIBE蚀刻在所有衬底温度下产生各向异性但仅接近垂直的蚀刻轮廓[9,31]。由于蚀刻过程中化学活性的增加,温度越高,剖面越垂直[8,9]。为了获得激光刻面所需的垂直度,Binet [31]和Kneissl等人。[30]在蚀刻时倾斜和旋转样品。Kneissl等人用这种方法制作并演示了具有CAIBE刻蚀刻面的InGaN/AlGaN激光二极管。[30]。 平等人也获得了高度垂直的蚀刻剖面。[8]在300℃使用氩/盐酸CAIBE,样品没有倾斜。在AlGaN/GaN异质结构中产生的这种垂直蚀刻剖面的一个例子如图2所示。2.图1所示的超光滑侧壁。2是使用再生长氧化物掩蔽工艺获得的[32]。在扫描电子显微镜中测量的侧壁粗糙度《 5纳米。
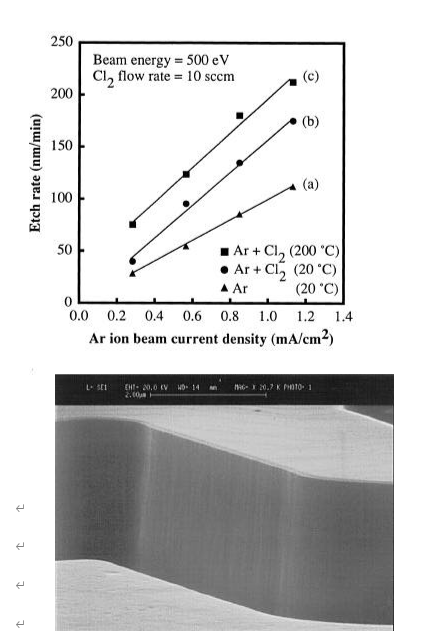
使用高密度等离子体反应离子蚀刻技术已经获得了高蚀刻速率和高度各向异性的蚀刻轮廓。由电子回旋共振反应离子刻蚀和电感耦合等离子体反应离子刻蚀方法产生的高刻蚀速率是由于可用的较高等离子体密度。高密度等离子体工具中的蚀刻产率与常规RIE系统中的相同,但是前者中大得多的离子通量导致更高的蚀刻速率。等离子体产生的更高效率也意味着等离子体可以在比传统RIE工具更高的真空环境中产生和维持。使用13.56兆赫发生器对样品进行独立偏置,可以控制高密度等离子蚀刻工具中离子轰击样品的能量。由于较高的真空环境,低能离子的方向性得以保留。这意味着在较低的离子能量下,蚀刻轮廓可以实现各向异性。
湿法腐蚀
湿法蚀刻它提供了低损伤蚀刻、低成本和复杂性。已经在碱和酸溶液中研究了GaN、AlN和InN的常规湿法蚀刻[39-43]。对低质量氮化镓进行的早期研究[39]产生了高达1米/分钟的蚀刻速率。然而,米勒姆等人最近的研究。[40]对于高质量的氮化镓,没有产生任何可测量的蚀刻。InN的蚀刻速率也很慢。Pearton等人。[41]发现InN在HCl/HNO3溶液中蚀刻非常慢。郭等。[42]报道了在60℃下使用氢氧化钾和氢氧化钠水溶液对InN的蚀刻速率约为10纳米/分钟。发现氮化铝的蚀刻高度依赖于样品的结晶度[39]。Mileham等人报道了AlN在氢氧化钾和AZ400K显影液中的蚀刻速率为10-1000纳米/分钟。[39,43]。 对于高质量的晶体氮化铝,获得了较低的蚀刻速率。可以得出结论,III族氮化物表现出的化学稳定性导致了传统湿法蚀刻剂的非常低的蚀刻速率。
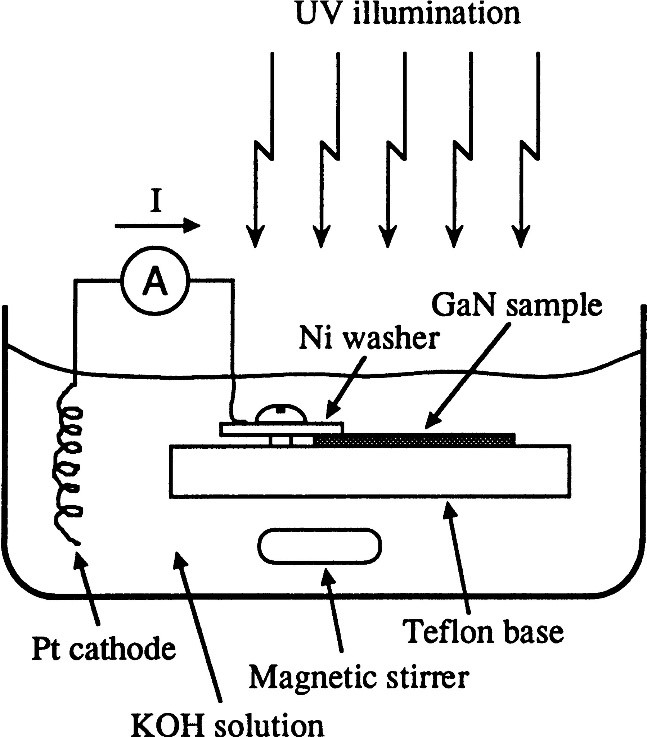
光电化学湿法蚀刻
近的一项进展是光电化学(PEC)湿法刻蚀的演示,这导致GaN的刻蚀速率显著提高[44-53]。PEC工艺利用光生电子空穴对来增强电化学电池中发生的氧化和还原反应。n-氮化镓的蚀刻通过表面氧化进行,然后溶解在水溶液中。通过将表面原子转化为更高的氧化态,光生空穴增强了这一过程。增加能量大于带隙能量的入射光辐射的吸收增加了表面处的空穴供应,从而提高了蚀刻速率。
结论
综述了ⅲ族氮化物的干法和湿法刻蚀方法。尽管高结合能对氮化物的蚀刻构成了障碍,但是高密度等离子体蚀刻方法已经产生了适合于器件制造的蚀刻速率。由这些高密度等离子体蚀刻方法实现的低偏压应该允许氮化物表面的低损伤蚀刻。在这一领域需要作出更多努力,量化国际比较方案反应离子刻蚀等技术提供的加工范围。光电化学蚀刻法已被证明是一种新兴的器件制造和材料表征方法。PEC被证明有潜力成为n-GaN中位错的快速评估工具。
审核编辑:何安
-
什么是氩离子抛光?2025-04-27 639
-
利用氩离子抛光技术还原LED支架镀层的厚度2025-02-21 748
-
利用氩离子抛光还原LED支架镀层的厚度2025-01-16 579
-
关于氮化镓的干蚀刻综述2023-10-07 2337
-
氮化镓: 历史与未来2023-06-15 1881
-
载体晶圆对蚀刻速率、选择性、形貌的影响2023-05-30 1472
-
氮化镓纳米线和氮化镓材料的关系2023-02-25 1496
-
通过热增强提高氮化镓的湿蚀刻速率报告2022-02-09 989
-
氮化镓的大面积光电化学蚀刻的实验报告2022-02-07 2180
-
关于氮化镓的晶体学湿式化学蚀刻的研究2022-01-17 2084
-
氮化镓充电器2021-09-14 4385
-
什么是氮化镓(GaN)?2019-07-31 7830
全部0条评论

快来发表一下你的评论吧 !

