

 含HF的有机清洗液中的铜薄膜溶解—华林科纳半导体
含HF的有机清洗液中的铜薄膜溶解—华林科纳半导体
今日头条
描述
引言
我们华林科纳研究了电化学沉积的铜薄膜在含高频的脱氧和非脱氧商业清洗溶液中的腐蚀行为。采用电感耦合等离子体质谱监测Cu2+,利用x射线光电子谱监测硅片表面的氧化态,研究了薄膜铜的溶解和反应动力学。确定了反应动力学相对于心衰和氧浓度都是一阶的。提出了一种涉及氧的Cu0和Cu1+的还原和氧化的动力学方案,这与实验确定的反应动力学顺序和在清洗过程中观察到的不良铜残留物在半导体晶片上的沉积相一致。我们研究目的是研究铜薄膜在含氟化氢和有机化合物的水溶液中腐蚀/溶解的动力学及其与铜互连DD过程的相关性。这种溶液通常用于工业中的等离子体蚀刻后清洗。给出了溶解氧、溶解氧和氟化氢浓度的动力学。
实验
我们实验使用铜在覆盖硅晶片铜/硅衬底上进行。使用典型的工业电镀设备5、13均匀沉积铜膜,然后进行化学机械平面化步骤,以在DD过程中紧密模拟实际的铜表面。由四点探针法表面电阻率仪测定,铜膜的厚度为400纳米。
在进行溶解实验之前,用0.49重量%的氟化氢进行表面处理,以确保表面清洁。进行了一组筛选实验来研究用于表面清洁的HF溶液中的最佳浸泡时间。图1描述了cleanH802的溶解氧浓度1分钟的高频治疗是合适的。这种预处理提供了清洁的表面,在该表面上天然氧化铜被部分去除,以暴露出清洁的元素铜表面。晶片长时间暴露在HF中5分钟没有改变X射线光电子能谱XPS光谱,该光谱由于CuI和Cu08而呈现出峰。

结果和讨论
我们讨论了清洗溶液中镀铜硅片的电化学腐蚀过程。腐蚀速率取决于空气非脱砷溶液中溶解氧的浓度;随着清洗溶液中氧浓度的增加,观察到腐蚀速率增加。为了进一步探究氧化剂(如何影响腐蚀过程,我们研究了铜的浓度随时间的变化,如图1所示。在这里,铜浓度最初增加后,随后溶解速度明显减慢。这一趋势与溶解氧浓度无关。较长时间内铜的浓度取决于溶解氧浓度。因此,我们还测量了氧浓度随时间的变化和晶片的数量。
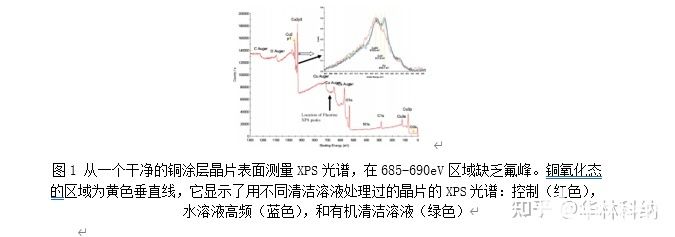
结果表明,在50min内,一个时间尺度与图中铜溶解的初始激增相当。清洗溶液中相应的氧浓度减小,达到SS。当以t=8700min浸在同一溶液中时,o2浓度在类似的时间尺度上进一步下降,达到新的较低的氧浓度1.5ppm。因此,腐蚀过程涉及氧参与正如进一步证明的那样。
图2提出了一个简单的溶解过程的电化学模型,它描述了氧气的减少与Cu0的氧化相结合,这可以通过清洗溶液中的歧化作用导致Cu2+物种的形成。
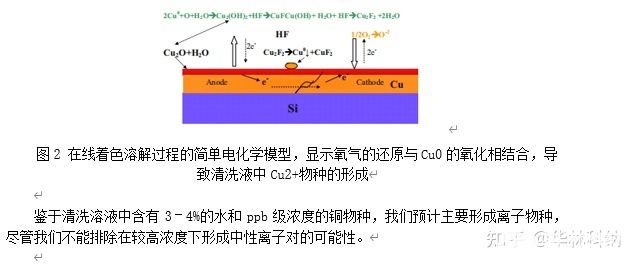
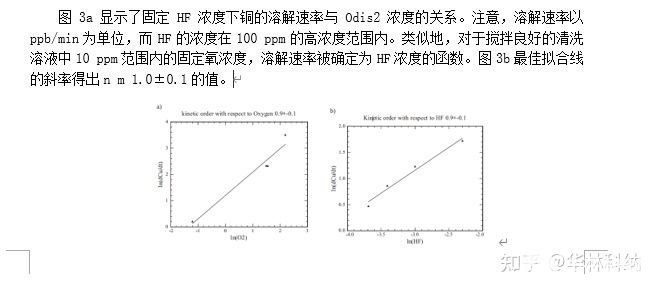
图3 初始铜溶解速率与溶解氧和氟化氢浓度的关系图可以确定动力学顺序。铜的溶解速率以ppb/min为单位,而溶解氧和氟化氢的浓度单位分别为毫克/升和百分比浓度。
总结
我们提出了一个简单的湿式化学清洗过程中铜溶解的动力学模型。它预测了实验观察到的涉及铜腐蚀的两个关键成分DO和HF的一阶动力学。如果消除了DO,则可以抑制铜的腐蚀速率。
审核编辑:符乾江
-
标准清洗液sc1成分是什么2025-08-26 2112
-
硅清洗液不能涂的部位有哪些2025-07-21 941
-
半导体湿法清洗有机溶剂有哪些2025-02-24 2369
-
华林科纳PFA管在半导体清洗工艺中的卓越应用2023-10-16 1373
-
含有机HF清洗液中铜薄膜的腐蚀行为2022-04-06 1881
-
柠檬酸清洗液对金属去除效果的评价2022-03-07 2247
-
铜薄膜在含HF清洗液中的腐蚀行为2022-02-14 1140
-
半导体有机酸清洗液中的铜的蚀刻速率和氧化机理分析2022-01-13 3497
-
铜薄膜在含HF清洗液中的腐蚀行为—江苏华林科纳半导体2022-01-12 1254
-
苏州华林科纳半导体设备技术有限公司招贤纳士2016-10-26 4969
-
招聘 苏州华林科纳半导体设备技术有限公司2015-07-28 2219
-
半导体薄膜厚度检测设备设备出售2015-04-02 4817
-
超声波清洗的工作原理2009-06-18 9625
-
怎样清洗液晶显示器|如何清洗液晶显示器2008-06-10 1158
全部0条评论

快来发表一下你的评论吧 !

