

 金刚石薄膜的等离子体沉积与刻蚀—华林科纳半导体
金刚石薄膜的等离子体沉积与刻蚀—华林科纳半导体
今日头条
描述
摘要
丁二烯、氢和氩的三元混合物在平行板等离子体反应器中沉积了类金刚石碳膜。这些薄膜的蚀刻量为02,cf4/02等离子体放电。推导出了沉积气体混合物的组成与根据蚀刻和沉积速率定义的无量纲数(EN)与沉积过程中的偏置电压之间的一种新的线性关系。EN是沉积过程中离子通量的函数。考虑了离子冲击电离过程与馈电气体组成和电离势的关系。蚀刻和沉积速率数据很好地遵循这种线性关系。这种线性关系中的cf4/02的蚀刻数据的比例常数随组成而变化。本文还描述了硅和玻璃基板上的薄膜硬度和失效模式。
介绍
碳膜以石墨、金刚石、类金刚石碳(DLC)、类金刚石烃和非晶形碳的形式沉积。金刚石和石墨是碳的晶体等构体。金刚石的各向同性、四面体配位结构和石墨的层状、二维结构代表了碳的两个极端结构。非晶态碳是碳的另一种同种异型,其结构是各向同性的。非晶态碳的键合微观结构已经引起了人们的广泛关注,并推测了十多年。微观结构的细节仍然是悬而未决的问题。等离子体沉积的非晶态的碳膜可能含有大量的氢,在这方面,类似于非晶态的氢化硅膜。然而,与硅不同的是,碳很容易形成双键和三重键。因此,碳可能的键结构比硅复杂得多。
本文研究了这方面的关系。 在射频平行板等离子体反应器中,由丁二烯、氢气和筑气的混合物沉积碳膜通过考虑随Vb的变化和沉积过程中的原料气组成,使刻蚀行为与沉积环境相关。一个新的非维数为所有发明的碳膜提供了一个很好的广义相关性。
实验方法
蚀刻室由类似大小的电极(直径0.28米)组成,与冷却剂混合物在其中循环,以保持25°C的恒温。待蚀刻的基底被放置在较低的动力电极上。上电极和腔室壁都是接地的。该室与沉积室共用射频发生器、真空管道和气体供应系统。丁二烯的三元混合物(纯度为99.99%)或甲烷(99.999%纯)、氩(99.999%纯)和氢(99.99%纯)用作反应物气体沉积。气体从两个腔室中以喷头结构的穿孔电极径向向外流动。这种流动结构不同于氮化铝沉积研究中使用的流动结构。沉积实验是通过保持总流量和压力固定在6.67xm3/s(100std下进行的。,分别为7.2Pa(55mtorr)。选择用于DLC沉积的21种原料气组成如图图所示(图1)。原料气成分和等离子体功率对等离子体的稳定性影响较大。添加氩气稳定在任何给定的等离子体功率水平。所有薄膜均以250W的射频功率沉积,其中等离子体在所有原料气体成分上都是稳定的。
结果
成长环境:压力、衬底偏置电压、放电中物质的性质和浓度是决定离子能量分布和薄膜性质的重要变量(Angusetal.,1986)。在一个固定的压力下,平均离子能量将随偏置电压Vb的增加而增加,这取决于供给气体的成分和功率水平。离子能量分布可以以不同的方式变化,这取决于偏置电压的变化。
薄膜硬度和开裂:薄膜对硅的粘附性远远优于发热玻璃。 对于在硅上厚度大于约3um,在玻璃上厚度大于约1um的膜,观察到膜破裂和剥离。失败其机制是底物特异性的,如图7、8和9所示,在纯丁二烯中生长的薄膜。在玻璃上观察到薄膜的屈曲,起源于基底的边缘,并以绕组路径传播到中心(图7)。相比之下,在硅上没有观察到屈曲。然而,对厚度小于总薄膜厚度的碳薄片进行了分层(图8)。
氧等离子体蚀刻:不同原料气成分沉积的所有薄膜的纯氧等离子体蚀刻率数据(见图1),这是原料气中不同氩浓度下氢的摩尔分数的函数。如前所述,薄膜的氧流速为6.67X10-7m3/s(100std .cm3。在13.3Pa(100mtorr)和恒定偏置电压230V的压力下,将基板放置在动力电极上。对于沉积进料混合物中的固定的氩气浓度,可以注意到蚀刻速率和V之间的负比例。每条曲线的蚀刻速率都达到了一个最小值,与V中的最大值大致相同(见图3)。
CF4/O2等离子体蚀刻:在图1中由A、B和C表示的条件下沉积的薄膜来测量CF4/02等离子体中的蚀刻率。气体混合物中四氟化碳的百分比从0%到100%不等。 结果如图11所示。与预期的一样,这三种薄膜在纯四氟化碳中的蚀刻率都可以忽略不计。在氧蚀刻过程中形成的碳氧化物比在四氟化碳等离子体中形成的氟碳物质具有更高的蒸气压。
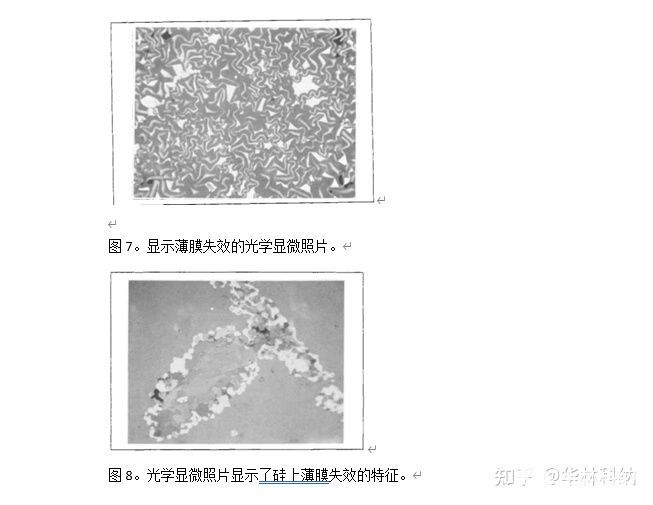
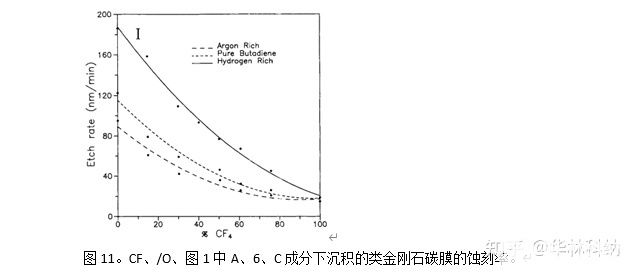
结论
从丁二烯、氩和氢的三元混合物中沉积了金刚石样碳薄膜。加入氩气提高了等离子体的稳定性。在三种不同组成极端情况下沉积的薄膜的红外光谱显示,sp3C-H键比sp2C-H键更为普遍。薄膜与硅粘附比与玻璃粘附更好,失效机理是基底特异性的。薄膜的硬度范围从容易刮到难以刮的碳化硅刻工具。最硬的薄膜沉积在大量的氩气下,最软的薄膜沉积在大量的氢气下。DLC薄膜在氧和CF4/02等离子体中的蚀刻速率是沉积条件的强函数。每个沉积分子的能量通量决定了沉积膜中sp3与sp2键的比值。将蚀刻速率、沉积速率和偏置电压组合成一个非维数EN。推导了EN与原料气组成的函数之间的线性关系。通过考虑电子冲击电离产生离子的问题。分别在130W和250W处测量的蚀刻和沉积速率数据与这一关系一致。
审核编辑:符乾江
-
为什么干法刻蚀又叫低温等离子体刻蚀2024-11-16 1550
-
新型金刚石半导体2023-07-31 2117
-
制造等离子纳米金刚石2023-06-26 1380
-
金刚石半导体应用与优缺点2023-02-14 6961
-
半导体金刚石有什么不同 每种金刚石都能造芯吗?2023-02-02 3628
-
半导体制造之等离子工艺2022-11-15 5606
-
等离子体蚀刻和沉积问题的解决方案2022-05-19 2521
-
等离子体应用2022-05-18 3702
-
TDK|低温等离子体技术的应用2022-05-17 2988
-
各向异性金刚石刻蚀的研究报告2022-01-21 1806
-
金刚石散热片在微波射频领域有什么应用2019-05-28 2192
-
类金刚石(DLC)涂层在半导体行业的应用2014-01-24 13945
-
P掺杂类金刚石薄膜的制备及生物学行为研究2009-05-16 996
全部0条评论

快来发表一下你的评论吧 !

