

p-NiO插入终端结合MOS结构实现高性能GaN基SBD
今日头条
描述
依托先进的半导体TCAD仿真平台,天津赛米卡尔科技有限公司技术团队设计了一种具有p-NiO插入终端结合侧壁MOS场板的混合式肖特基势垒二极管结构(Hybrid TMBS),期望通过该设计能同时改善传统GaN基SBD的正向导通特性和反向击穿特性。
图1展示了技术团队设计的Hybrid TMBS器件结构(Device A3),该结构的设计核心是利用p-NiO插入终端结合侧壁场板MOS结构形成混合式肖特基势垒二极管结构。如图2(a)所示,该设计方案,在器件正向偏置时,具有更高的电流密度,这主要归功于引入的p-NiO插入终端可以有效地改善器件的电流拥挤效应,使器件台面底部附近的电流分布更均匀,从而减小器件的导通电阻 [图2(b),(c)和(d)]。此外,图2(e)和(f)中台面底部附近横截的能带图也展示了对于参考器件而言存在0.42 eV的电子势垒,而Hybrid TMBS器件结构则不存在所谓的势垒,这很直观地证明了Hybrid TMBS器件结构可以有效地促进电子向器件两侧输运,从而增强器件的电流扩展。
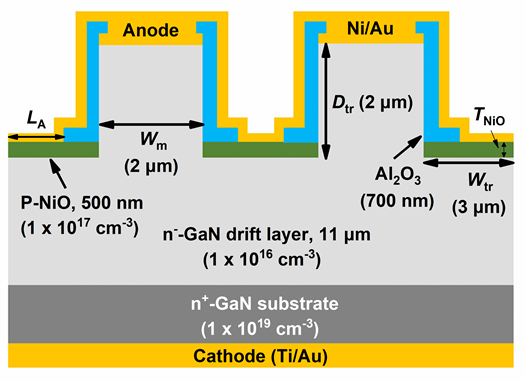
图1. GaN基混合式肖特基势垒二极管的结构示意图
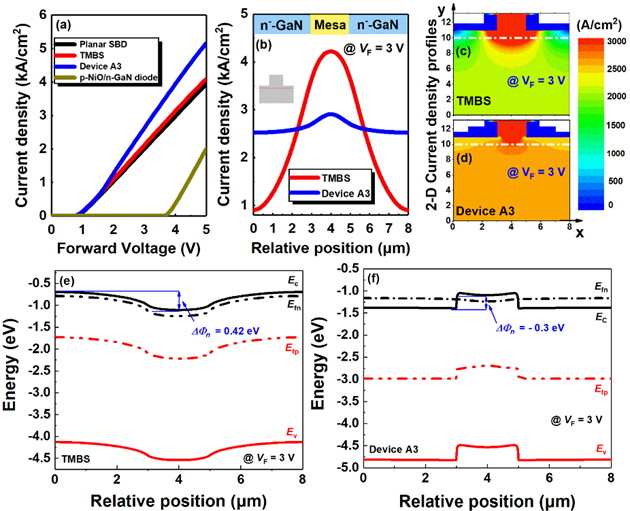
图2.(a)器件A3、平面SBD和TMBS器件以及p-NiO/n-GaN二极管的正向I-V特性曲线;(b)TMBS器件和器件A3于台面底部附近的横截电流密度分布图(VF = 3 V);(c)TMBS器件和(d)器件A3的二维正向电流密度分布图;(e)TMBS器件和(f)器件A3台面底部位置附近的横截能带分布图(VF = 3 V)
除此之外,如图3(a)所示,当器件外加反向偏置时,Hybrid TMBS器件结构能实现更高的击穿电压。这是由于当器件处于反向偏置时,p-NiO/n-GaN形成反偏PN结,可以有效地分担大部分电场,从而增强器件的电荷耦合效应,进而削弱金半接触界面以及台面拐角处的强电场,如图 3(c)和(d)所示。 另外,从图3(b)中的二维电场分布和二维漏电流分布图中也可以很直观地看出p-NiO插入终端结合侧壁场板MOS结构可以有效地减小金半接触界面的电场分布,从而降低由镜像力效应引起的漏电流。
基于前期的仿真结果,技术团队优化了器件架构,目前实验验证工作正在开展,初步的测试结果与仿真结果实现了高度的吻合。该研究成果丰富了GaN、GaO、SiC基SBD的技术模型,为研发更高性能的SBD提供了有力的研究基础。
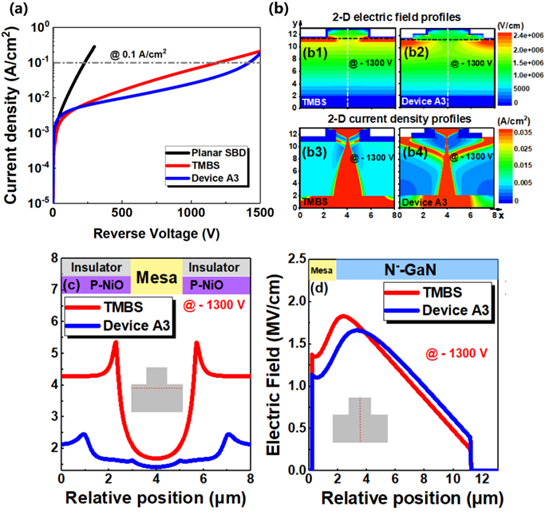
图3.(a)器件A3、平面SBD和TMBS器件的反向I-V特性曲线;(b1)TMBS器件和(b2)器件A3的二维电场分布图(Vr = -1300 V);(b3)TMBS器件和(b4)器件A3的二维电流密度分布图(Vr = -1300 V);(c)台面底部位置附近的横截电场分布图(Vr = -1300 V);(d)沿肖特基接触界面位置向下的纵切电场分布图(Vr = -1300 V)
该成果最近被应用物理领域权威SCI期刊Japanese Journal of Applied Physics, 61, 014002 (2022)收录。
审核编辑:符乾江
-
使用SiC-SBD的优势2018-11-29 4590
-
SiC SBD的器件结构和特征2019-03-14 5626
-
高性能卫星应用手持终端有什么优势?2021-05-17 2534
-
如何去实现一种高性能IP电话语音终端系统的设计?2021-06-04 1906
-
如何实现PMSM高性能控制2021-08-27 1271
-
日本以NaFlux法制成GaN基SBD用于LED驱动电路2010-03-04 1618
-
高性能Si基MOS肖特基二极管式氢气传感器研究2015-11-10 788
-
一种适用于任意余数基的高性能后向转换结构_杨鹏2017-01-07 774
-
Secondary aperture模型对于高性能GaN基VCSEL的作用2020-08-12 990
-
关于GaN基肖特基二级管结终端设计的思路探讨2021-05-12 1184
-
高性能肖特基功率二极管的设计与制备2021-12-27 1018
-
通过硅和GaN实现高性能电源设计2022-07-27 960
-
成果展示:具有1.1 kV级高击穿电压的GaN基肖特基二极管2022-08-04 2239
-
新型的GaN基SBD能实现器件性能的大幅改善2023-02-16 935
-
ROHM推出实现业界超快trr的100V耐压SBD2024-03-15 1260
全部0条评论

快来发表一下你的评论吧 !

