

 关于光刻胶溶解过程中表面粗糙度的变化研究报告
关于光刻胶溶解过程中表面粗糙度的变化研究报告
今日头条
描述
摘要
图案图像中纳米级粗糙度的最小化已成为微处理器生产中光刻过程的优先事项。为了探究表面粗糙度的分子基础,通过将临界电离模型应用于聚合物基体的三维分子晶格表示,模拟了光致抗蚀剂的发展。该模型被用于描述现在常用于微光刻的化学放大光刻剂。对溶解速率和表面粗糙度对聚合程度、多分散性和分数去保护程度的依赖性的模拟结果与实验结果一致。表面粗糙度的变化与实验观察到的诱导周期的长度有关。并提出了空隙分数和显影剂浓度对粗糙度影响的模型预测。显影剂浓度对顶表面和侧壁粗糙度影响的差异可以用模拟预测的临界显影时间来解释。
介绍
随着新一代微处理器的出现,对微光刻的需求变得越来越困难。与光刻胶图像的表面和边缘相关的粗糙度的最小化现在是光刻技术持续进步的挑战之一。顶表面和线边缘粗糙度的问题在过去的一年中引起了相当多的关注,以及最近的几个原子力显微镜AFM。研究已经对光刻胶粗糙度的过程依赖性产生了显著的见解。他和Cerrina1研究了正色调化学放大光刻剂在曝光后烘焙时间范围内的表面粗糙度和曝光剂量之间的关系。他们的结果表明,系统具有相同的整体平均去保护程度,但不同的过程历史,表现出相似的表面形态,但不同程度的粗糙度。
本文中描述的模拟允许聚合物共混,以便我们可以研究多分散性的影响。初始空隙分数,可以代表固有的聚合物自由体积或残留铸造溶剂。分子水平模型正确地预测了溶解率和粗糙度对聚合程度、多分散性、脱保护程度、聚合物自由体积、残留铸造溶剂和开发时间变化的响应趋势。
模型描述 略
模拟结果
聚合度的影响:从图中8可以看,随着聚合程度的增加,表面速率抑制变得更加明显。所有这些系统都显示出一个诱导周期,但诱导周期的长度比聚合程度的线性依赖所预测的要快。底层膜表面的表面速率抑制也随着聚合程度的增加而增加,但底部的依赖性没有顶部那么陡峭。
多分散性效应:图11显示了这两个系统的表面粗糙度的发展情况。高多分散性样品获得了更大程度的表面粗糙度。系统所需要的表面粗糙度到水平的时间随着多分散性的增加而增加,并与图中10的诱导周期相对应。 因此,增加了多分散性,增强了表面速率抑制的效果。那些制定抵抗者的人已经认识到这一现象已经有一段时间了,但对这一观察结果并没有令人满意的解释。
脱保护程度的影响:表面粗糙度随阻塞程度fb0的时间演化情况如图所示。 12.模拟结果预测,只要薄膜能够清除,粗糙度就会随着阻塞程度的增加而增加。溶解速率随阻塞程度的增加而减小。在超过临界阻塞程度后,胶片不能完全清晰,即使在胶片停止发展后,粗糙度仍然存在。因此,表面粗糙度从零开始,通过一个最大值,当分数去保护从0到1变化时返回到0。这一点如图所示。13,其中我们的模型对粗糙度作为设定开发时间的去保护函数的预测与He和Cerrina的实验数据进行了比较。暴露剂量和部分去保护之间的关系以前已经量化。
空隙率的影响:在图中。15考虑了聚合物基质中的空隙空间对表面粗糙度的影响。增加初始孔隙分数会导致发育速率增加,表面粗糙度降低。在多个模拟中,表面粗糙度的标准偏差没有显示随着初始空隙分数的增加而减少。
显影剂浓度的影响:在雷诺兹和泰勒的初始显影剂浓度对粗糙度的影响检验中,化学放大未暴露部分的表面粗糙度光致抗蚀剂的开发时间足够长,足以完全蚀刻暴露部分。在后来的研究中,同样的研究人员研究了显影剂浓度对粗糙度随发育时间的影响。在早期和后来的条件下,表面粗糙度被观察到随显影剂浓度的增加而增加,而侧壁粗糙度似乎与显影剂浓度无关。
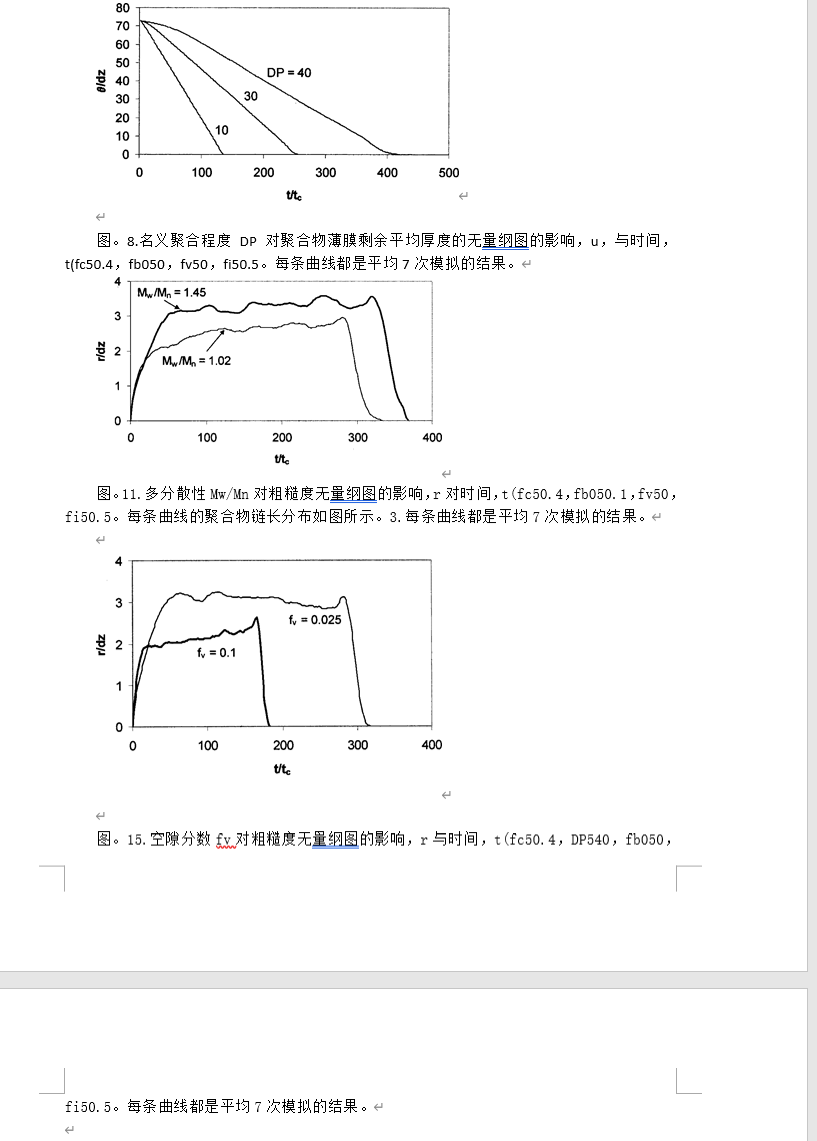
结论
光刻胶的发展被模拟为分子去除聚合物链的分子以临界电离分数为去除准则的维立方晶格。给出了溶解速率和表面粗糙度随开发时间函数的模型预测。该模型正确地预测了表面速率抑制,由诱导周期证明,这一现象对应于表面粗糙度的变化,对光致抗蚀剂面积的测量。表面粗糙度通常与溶解率成负比。聚合程度较低、多分散性较窄、孔隙分数较大的聚合物可以产生较低的表面粗糙度。该模型预测,随着阻塞程度的增加,表面粗糙度通过最大值,实验研究证实了这一预测。最近的AFM测量已经证实了发育时间对表面粗糙度影响的模型预测。该模型预测,表面粗糙度随着显影剂浓度的增加而发展得更快,并最终达到与显影剂浓度无关的最大值。这些模型的预测被用来解释在顶表面和侧壁粗糙度对显影剂浓度变化的响应中观察到的差异。
审核编辑:符乾江
-
【新启航】碳化硅衬底 TTV 厚度测量中表面粗糙度对结果的影响研究2025-08-18 861
-
表面粗糙度的评选及测量详解2023-11-29 1700
-
什么是表面粗糙度?表面粗糙度形成因素2023-09-01 3258
-
什么是表面粗糙度?2023-02-15 4989
-
什么是表面粗糙度?如何测量表面粗糙度?2022-08-10 3861
-
表面粗糙度对机械产品的影响2022-05-13 4318
-
多孔ZnO薄膜表面形貌和粗糙度的研究2022-05-09 1448
-
表面粗糙度您了解多少?2022-04-29 4608
-
表面粗糙度仪有哪些?2022-03-21 3955
-
《炬丰科技-半导体工艺》光刻前 GaAs 表面处理以改善湿化学蚀刻过程中的光刻胶附着力和改善湿蚀刻轮廓2021-07-06 2923
-
基于Xgboost算法的高锰钢表面粗糙度预测2021-06-19 729
-
光刻胶在集成电路制造中的应用2018-08-23 7420
-
表面粗糙度评定参数的程序2016-05-05 4190
-
100个表面粗糙度问与答题2011-04-21 1141
全部0条评论

快来发表一下你的评论吧 !

