

 华林科纳共注入BOE的化学实验报告
华林科纳共注入BOE的化学实验报告
今日头条
描述
缓冲氧化物蚀刻(BOE)是一种广泛应用于半导体行业的蚀刻解决方案,通过光刻胶掩模蚀刻氧化物层,我们使用计算的主要结果,通过ATMELFab7现场的实验实现,来测试共注入BOE的性能。
在我们的例子中,氢氧化铵将是保持最终溶液酸性的限制因素(少数),为了确保蚀刻步骤有过量的HF,必须制备混合物,使n2
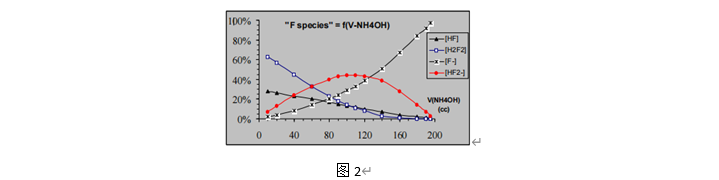
图2显示了使用1800cc去离子水、100cc49wt%HF和0~200cc28wt%氢氧化铵的溶液中不同物种的计算分布。随着更多氢氧化铵的加入,更多的HF反应产生NH4F,F增加的分数降低,同时HF和二聚体(HF)2的分数降低,hf2的行为是最有趣的,众所周知,HF2-是一种蚀刻物种,不同的研究显示了蚀刻速率或氟化物种与pH(3,4,5)之间的最优值,我们的模拟表明,最优的[HF2-]对应于1:1的HF:氢氧化铵混合物,对应的BOE比值接近3/1,稍后我们将看到这是一个临界值,在这种条件下,我们将通过实验观察到在没有蚀刻胶攻击的情况下最高的蚀刻速率。
利用八个方程组,可以确定每个物种的正确浓度,并与观察到的蚀刻速率相关联,从而揭示参与蚀刻机制的化学物种。通过一些模拟,观察了水对BOE系统的影响。实验中随着水量的增加,HF2浓度的下降速度远远快于HF浓度,HF2-/HF比值随着稀释度的增加而增加,事实上,hf2复合物通过稀释法被分解成HF和F-。水的hf2解离影响的所有物种都受到影响,pH也从4.6变为3.6,由于hf2的分离,导致心衰的产生,pH随稀释度的增加而下降。
实验结果是使用法国鲁塞特ATMELFab7的FSI汞MP表面调节系统获得的。这些测试是使用8英寸的晶圆进行的。经过9点测量后给出的均匀性。在我们的实验中,考虑了不同体积的28%的氢氧化铵与100cc的49%的HF的反应,由于氢氧化铵是反应的限制因素,氢氧化铵的体积是控制放热性的关键参数,并允许在蚀刻均匀性方面优化过程。
根据将在混合物中使用的氢氧化铵体积,有可能优化工艺条件,并考虑到共注射的放热性,图6为HF、氢氧化铵和去离子水共注入流所产生的BOE蚀刻速率,有大量的蚀刻速率,允许工艺优化,如果需要,可以获得相对较低的蚀刻率(小于1A/s)或更高的值,待蚀刻的厚度将决定最佳混合物的选择,此外,还可以制备不同的共注入混合物,以获得相似的蚀刻速率(例如,2A/s),最终的选择将由蚀刻的均匀性性能决定。
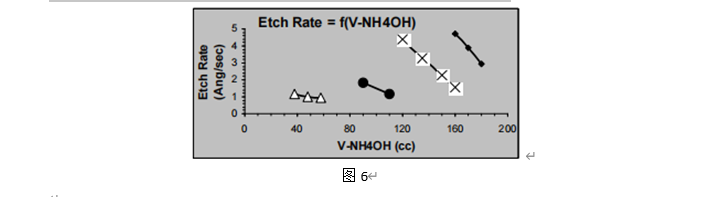
图7显示了不同共注入BOE在晶片上的不均匀性,晶片上的不均匀性降至0.7%,可达到良好的跨船不均匀性(约1%),载流子的槽24最差,但在优化的条件下,晶片上的不均匀性小于2%。可以观察到,NH4F的形成量越少,其均匀性就越好,我们将这一结果与NH4F使最终的解决方案更加粘稠,并在均匀性方面影响该过程的事实联系起来。最后,最重要的是避免氧化蚀刻过程中对光刻胶的损伤。在我们的模拟证实,当BOEX/1比值大于3(pH大于3)时,氧化物成功蚀刻,对光刻胶没有任何损伤,在同一张图中,即使是非常稀释(200倍)的高频溶液的pH仍低于3,这使得这些溶液对于临界蚀刻远不如BOE方便。

总结
通过我们求解的八个方程系统,我们能够估计出共注入BOE蚀刻过程中所涉及的蚀刻物种的浓度,混合比可以针对不同的应用程序进行优化,这些图显示了HF、氢氧化铵和水稀释对蚀刻系统中物种平衡的作用。
审核编辑:鄢孟繁
-
dsp软件实验报告2013-01-03 4448
-
苏州华林科纳半导体设备2015-04-02 3564
-
苏州华林科纳半导体设备技术有限公司招贤纳士2016-10-26 4967
-
自制电感器实验报告2009-11-17 665
-
数字图像处理实验报告2015-11-11 1061
-
模拟电子技术实验报告2015-12-14 1423
-
DSP实验报告2016-07-20 837
-
实验报告格式2016-12-15 1161
-
贵州大学实验报告2017-01-13 1156
-
系统辨识实验报告2017-06-12 1595
-
叮咚门铃实验报告2017-06-19 4439
-
直流稳压电源实验报告2021-09-18 2322
-
传感器原理及应用实验报告2022-03-21 1524
-
西电verilog实验报告2022-06-30 879
-
化学品酸碱输送供应管道为什么要选择华林科纳PFA管?2023-09-13 1600
全部0条评论

快来发表一下你的评论吧 !

