

碱性湿法蚀刻抗蚀剂的评价及应用
今日头条
描述
引言
本文主要报道了ProTEK PSB在实际应用条件下的图形化特性、抗蚀性和去除特性。研究发现了ProTEK PSB的两个问题:不可接受的大侧刻和有机溶剂或氧化灰难以去除引物。为了制造一个lsi集成的触觉传感器,我们使用了带有低温氧化物底层的ProTEK PSB。这种组合解决了ProTEK PSB的侧面刻蚀问题和低温氧化物的针孔问题,提供了可以在低温下制备的实用碱性刻蚀掩膜。
实验
首先,在Si基板上适量滴加底漆,在3000pm下旋转涂布1分钟。 涂布底漆后,使用热板在110C下280°℃分钟 用加热1分钟。 然后,滴下ProTEKPSB,与底漆相同,在3000 rpm下旋涂1分钟。 涂上ProTEK PSB后,用热板在110℃下加热1分钟加热。加热后,用I线以1000mJ/cm2的曝光量进行曝光。 曝光后,用热板在110℃下加热2分钟。 影时,在乳酸乙酯中浸泡5分钟,充分搅拌, 显影后,用异丙醇( IPA )清洗,用旋转干燥器干燥。 最后,用热板在220C下加热3分钟使之硬化。
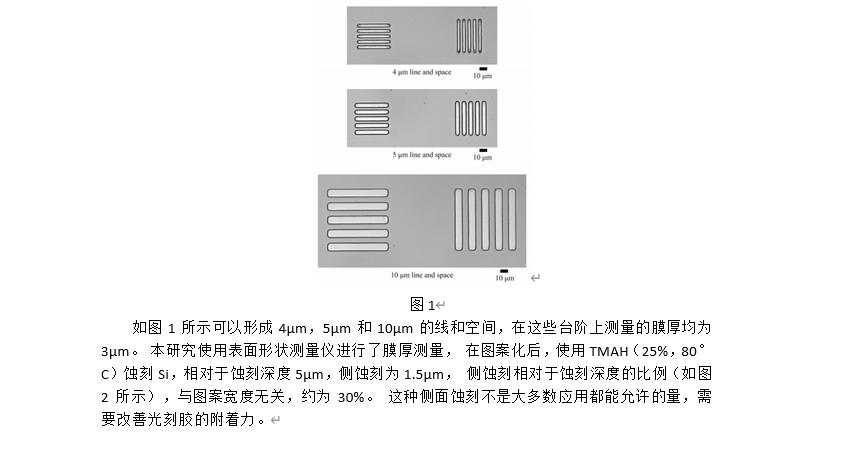
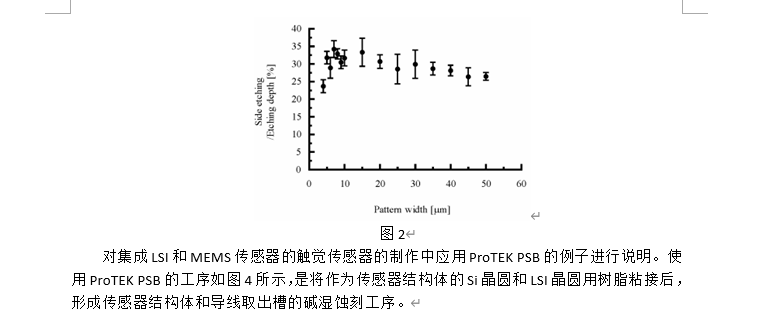

作为能够低温形成的碱性湿法蚀刻用掩模,与单独使用低温氧化膜和ProTEK PSB的掩模相比,低温氧化膜和ProTEK PSB组合的掩模能够抑制侧面蚀刻,为了更容易理解而进行的比较实验的结果。 作为掩膜,显示了使用(a)ProTEK PSB、(b)通过等离子CVD堆积的低温氧化膜、(c)通过等离子CVD堆积的低温氧化膜和ProTEK PSB的组合、以及(d)通过高频磁控溅射堆积的低温氧化膜和ProTEK PSB的组合的结果。 这里,蚀刻深度为200µm。 仅将低温氧化膜用于掩模时,针孔不仅会产生蚀刻坑,特别是在掩模端通过针孔进行侧面蚀刻。 另一方面,如果将低温氧化膜与ProTEK组合,则可以得到良好的结果。
结论
对新型碱性湿法蚀刻用负型光敏性抗蚀剂ProTEK PSB和非光敏性的ProTEK B3进行了评价。 使用ProTEK PSB可以形成4µm的线和空间。 另外,侧面蚀刻相对于蚀刻深度的比例约为30%,与蚀刻宽度无关。 另外,ProTEK PSB可以用O2灰化除去,残留的底漆可以用1%HF完全除去。 侧面蚀刻较大,以及底漆剥离需要HF,这是ProTEK PSB实际应用于器件时的问题。 本论文提出了回避这些问题的方法。
将涂有ProTEK B3的Si基板在TMAH(25%,80°C)中浸泡24小时后,通过侧面蚀刻从晶圆端剥离了1 mm。 另外,ProTEK B3可以用丙酮和O2灰化除去,残留的引物可以用1%HF完全除去,将LSI和MEMS传感器集成化的触觉传感器的制作工艺适用于ProTEK PSB。 在从LSI晶圆背面取出器件的电线的工序中,通过TMAH对LSI晶圆背面进行蚀刻,但由于工艺温度的限制,无法在LSI晶圆上形成热氧化膜和高温氮化膜作为掩模材料。
因此,在利用等离子CVD在350°C下沉积,或者利用高频磁控溅射沉积的低温氧化膜上对ProTEK PSB进行图案化,利用HF对低温氧化膜进行蚀刻,直接利用TMAH进行了蚀刻。 因此防止了低温氧化膜从针孔中的蚀刻,如果使用通过等离子体CVD在350℃下沉积的低温氧化膜,则侧蚀刻可以控制在9µm,如果使用通过高频磁控溅射沉积的低温氧化膜,则侧蚀刻可以控制在15µm。
审核编辑:汤梓红
-
湿法蚀刻问题2017-05-08 7524
-
PCB制作工艺中的碱性氯化铜蚀刻液-华强pcb2018-02-09 7854
-
PCB碱性蚀刻常见问题原因及解决方法2018-09-19 5405
-
PCB蚀刻机的原理及其工艺流程的介绍2020-12-24 10383
-
关于湿法蚀刻工艺对铜及其合金蚀刻剂的评述2022-01-20 3477
-
通过光敏抗蚀剂的湿蚀刻剂渗透2022-04-06 1308
-
通过光敏抗蚀剂的湿蚀刻剂渗透研究2022-04-22 1221
-
湿法蚀刻过程中影响光致抗蚀剂对GaAs粘附的因素2022-05-10 1071
-
用于Pt湿法蚀刻的铂薄膜图案化方案2022-05-30 4605
-
干法蚀刻与湿法蚀刻-差异和应用2023-04-12 3064
-
湿法蚀刻的发展2024-10-24 1185
全部0条评论

快来发表一下你的评论吧 !

