

碳化硅和二氧化硅之间稳定性的刻蚀选择性
电子说
描述
摘要
磷酸(H3PO4) -水(H2O)混合物在高温下已被使用多年来蚀刻对二氧化硅(二氧化硅)层有选择性的氮化硅(Si3N4)。生产需要完全去除Si3N4,同时保持二氧化硅损失最小。批量晶片清洗的挑战是如何保持Si3N4对二氧化硅的高蚀刻选择性,以获得更长的槽寿命。
实验表明,增加浴中水的浓度导致更高的选择性:蚀刻更多的Si3N4和更少的二氧化硅。随着水浓度监测器和水脉冲装置的安装,浴缸能够控制水浓度。每个产品批次后化学浴的部分更换降低了溶解硅的浓度。H2SO4的加入节省了初始调节时间。通过所有的努力,镀液以高选择性开始,并保持这种选择性以延长镀液寿命。
介绍
通常用于湿批清洗,Si3N4在热H3PO4浴中去除。这主要用于去除局部氧化掩模(LOCOS),其下具有二氧化硅作为应力消除层。常规获得40∶1的选择性,这对于该方法来说是足够的。如今,浅沟槽隔离是更普遍的应用,其中Si3N4层被用作CMP(化学机械平坦化)停止层。在该步骤中,使用化学机械抛光来去除晶片的形貌,并且在该工艺之后必须去除氮化硅层。二氧化硅层暴露在这一点上,最大限度地减少这些层的二氧化硅损失至关重要。因此,必须抑制二氧化硅层的蚀刻速率,提高氮化硅对二氧化硅蚀刻速率的选择性。这产生了对高选择性氮化硅蚀刻工艺的需求。
实验装置
使用200毫米Si3N4和二氧化硅晶片。Si3N4晶片的两面都有5 K厚的Si3N4膜,它们用于蚀刻速率评估和产品批次的模拟。一个产品批次等于在50个晶圆的两侧去除1500个Si3N4。二氧化硅晶片的两面都有二氧化硅薄膜。Si3N4和二氧化硅薄膜用鲁道夫S300椭圆仪以49个点和5毫米的边缘排除进行测量。Si3N4在某一点的重复误差低于1.0,二氧化硅低于0.5.在测试时从槽中收集化学样品,并通过电感耦合等离子体质谱分析元素硅浓度。
结果和讨论
水含量影响二氧化硅的蚀刻速率和氮化硅的蚀刻速率。图2描绘了Si3N4和二氧化硅在与图1所示测试相同的浴中随水浓度变化的蚀刻速率.水浴中的水浓度为3、7.8、10和14%,峰值分别为每两分钟5、8、10和14秒。图2(a)显示,随着水浓度从3%变化到14%,Si3N4蚀刻速率从46.4增加到68.2/分钟。图2(b)显示,随着水浓度从3%变化到14%,二氧化硅蚀刻速率从2.12降低到1.42/分钟。
图4显示了不同温度下的稳定水浓度。结果表明,在150、155、160和165℃时,水浓度分别稳定在17.7、16.6、15.4和14.0%,去离子水峰值为14秒/两分钟。该浴在较低的温度下具有较高的水浓度。
图7显示了生产数据。这些测试是在生产环境中进行的,在生产环境中,一个产品批次相当于在50个晶圆的两面去除2200个Si3N4。这意味着累积的220 kSi3N 4蚀刻量等于一个产品批次蚀刻量,如图7所示.在槽寿命开始时,在H3PO4中加入一定量的H2SO4。采用去离子水冲加和加料放气两种装置。图7显示Si3N4和SiO2蚀刻速率分别以49.2/分钟和0.07/分钟开始,速率保持在50.6英寸/分钟,平均为零,在生产过程中经历了8个产品批次及以上。
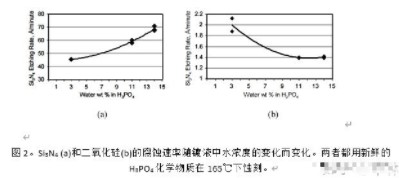
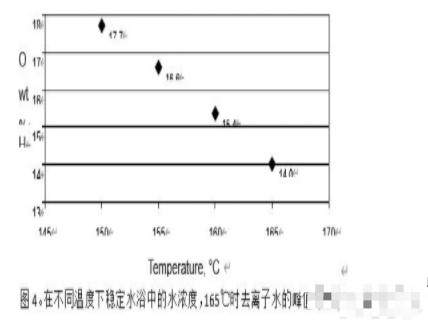

图7。稳定的Si3N4和二氧化硅蚀刻速率。通过在H3PO4浴中初始加入H2SO4以及进料和出料装置和阿迪水脉冲装置的操作,蚀刻速率可保持较长的生产时间。
结论
在用热H3PO4蚀刻Si3N4时,保持稳定的选择性是一个挑战。我们的实验表明,需要控制水含量、降低硅浓度和调节浴中的初始H3PO4化学物质,以实现长时间生产的稳定选择性。带有近红外光谱仪的阿迪水刺仪有助于控制水含量。加料和放气装置降低了浴中的硅浓度。在H3PO4中加入H2SO4节省了浴的初始调节。通过所有实施的改变,实现了稳定的Si3N4和二氧化硅蚀刻速率。实验和生产测试都表明,阿克里翁的GAMA批处理工具能够以高选择性开始,并在长时间的Si3N4蚀刻生产中保持稳定的选择性。
审核编辑:汤梓红
-
碳化硅压敏电阻 - 氧化锌 MOV2024-03-08 8428
-
什么是MOSFET栅极氧化层?如何测试SiC碳化硅MOSFET的栅氧可靠性?2025-01-04 2665
-
【转帖】干法刻蚀的优点和过程2018-12-21 5750
-
碳化硅深层的特性2019-07-04 6129
-
碳化硅二极管选型表2019-10-24 1931
-
碳化硅半导体器件有哪些?2020-06-28 4467
-
碳化硅基板——三代半导体的领军者2021-01-12 4461
-
石灰石二氧化硅化验仪器设备系列2021-03-11 2103
-
请教碳化硅刻蚀工艺2022-08-31 42029
-
PECVD工艺参数对二氧化硅薄膜致密性的影响2020-09-29 12896
-
二氧化硅层在芯片中有何作用2021-12-21 13639
-
用磷酸揭示氮化硅对二氧化硅的选择性蚀刻机理2021-12-28 8913
-
镀膜使用二氧化硅的作用2024-09-27 2948
-
芯片制造中的二氧化硅介绍2025-04-10 5925
-
晶圆背面二氧化硅边缘腐蚀的原因2025-07-09 1178
全部0条评论

快来发表一下你的评论吧 !

