

KOH溶液中氮化铝的湿化学蚀刻
今日头条
描述
引言
本文研究了KOH基溶液中AIN的湿式化学蚀刻与蚀刻温度和材料质量的关系。这两种材料的蚀刻速率都随着蚀刻温度的增加而增加,从20~80°C不等。通过在1100°C下快速热退火,提高了反应性溅射制备的A1N的晶体质量,随着退火温度的增加,材料的湿蚀刻率降低。在1100°C退火后,在80°C蚀刻温度下,蚀刻速率降低了约一个数量级。用金属有机分子束外延生长的In019A1081N在硅上的蚀刻速率大约是在砷化镓上的三倍。这与在砷化镓上生长的材料的优越的晶体质量相对应。我们还比较了掺杂浓度对蚀刻速率的影响。蚀刻两个晶体质量相似的主要样品,一个用nc1016cm3(2.6%In)完全耗尽,另一个用n5><10的cm3(3.1%In)。在低蚀刻温度下,速率相似,但在60°C以上,n型样品蚀刻更快,在80时大约快3倍°C。这些蚀刻的活化能非常低,溅射的A1N为2.0 0.5 千卡摩尔。主要的活化能依赖于成分,在2-6千卡摩尔。在80时,GaN和InN层在氢氧化钾温度下没有显示任何蚀刻°C。
实验
在IntevacGenII系统中,使用半绝缘、(100)砷化镓基质或p型(1 11 cm)硅基质的金属加纳分子束外延(MOMBE)基质上生长。III组源分别为三乙基镓、三甲胺亚烷和三甲基钠,原子氮来自于在200W正向功率下运行的ECR脉波源。各层为高密度(1011~1012cm2)的堆积断层和微双晶。发现偶离子样品同时含有六角形和立方形。所检测的成分分别为100、75、36、29、19、3.1、2.6和0%In。
AIN样品在RTA系统(AG410T)中,在n2大气中,温度在500~1150°C下,表面向下退火10s。在湿蚀刻研究中,所有样品都被掩盖。去除掩模后,用Dektak手写笔轮廓测量法获得切口深度,误差约为5%。采用扫描电子显微镜(SEM)检查蚀刻样品的下切口。AZ400K显影剂溶液(具有活性铟氢氧化钾)用于蚀刻,蚀刻温度在20-80°C之间。
结果和讨论
A1N图1显示了在500、700、900、1000和1100°C下生长或退火的样品时,溅射的A1N的蚀刻速率与蚀刻温度的函数。随着蚀刻温度从20°C到50°C的升高,沉积蚀刻样品和500°C的蚀刻速率急剧增加,然后变平;500°C退火后,速率下降了约10%。在700、900和1000°C下退火的样品也显示出类似的趋势,在较高的退火温度下,速率单调下降。随着蚀刻速率的降低,晶体质量随着退火温度的降低而显著增加。每次连续退火时,蚀刻率继续下降-10%,至1000°C。1100°后,蚀刻速率下降,温度较小。总的来说,从沉积的A1N到1100°C退火的80°C蚀刻速率降低了90%。
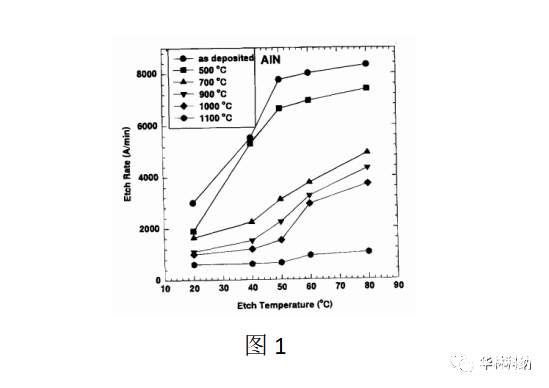
如图2所示,所有样品的活化能在实验误差内相同。这表明了一个扩散受限的反应。这远低于Mileham等人报道的用金属有机分子束外延生长的a1n的15.45千卡的活化能。然而,在目前的实验中,材料的质量要低得多,蚀刻可能以如此快的速度进行,以至于溶液在材料表面附近的反应物正在耗尽。
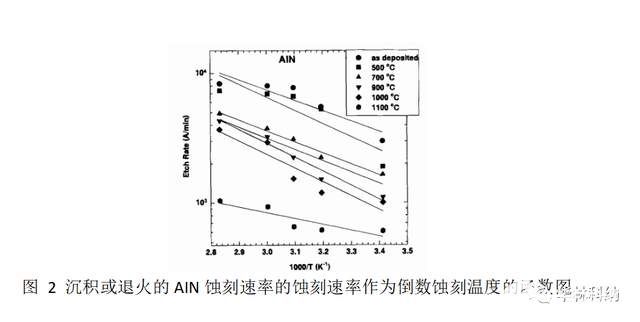
除了材料质量或成分外,另一个通常在决定蚀刻速率中起作用的因素是样品的电导率。图6显示了2.6和3.1%In样品的main蚀刻与蚀刻速率温度的图,分别耗尽(nc1016cm3)和n-5)<1018蚀刻cm3。由于自掺杂在该成分周围变化迅速,但浓度变化很大,这些样品代表了对与电导率相关的任何影响的一个很好的测试。样品在低溶液温度下具有相似的蚀刻速率。然而,在60°C以上,n型样品蚀刻率增加得更快,大约比耗尽的图快两倍。这些结果表明,在快速蚀刻速率发生的温度下,n型样品中的电子是臭氧离子与InAlN薄膜中的铝之间的化学反应的一部分。它们可能会增强这些离子的形成,从而提高蚀刻率。用KOH溶液蚀刻对InAIN比氮化镓或InN具有完全的选择性。
总结
AIN的退火提高了薄膜的晶体质量,降低了氢氧化钾基溶液中的化学蚀刻率。ina1n蚀刻速率也随着结晶质量的降低而增加。InAIN的蚀刻率最初随着In成分从0增加到36%而增加,然后对于纯InN下降到零。n型InA1N的蚀刻速度大约是60°C以上未掺杂材料的两倍,表明电子在蚀刻机制中起着作用。
审核编辑:汤梓红
-
氮化镓的晶体学湿式化学蚀刻法2023-11-24 2535
-
KOH硅湿法蚀刻工艺详解2022-07-14 6284
-
硅碱性蚀刻中的绝对蚀刻速率2022-03-04 1976
-
氮化铝单晶的湿法化学蚀刻2022-02-21 3427
-
关于硅的湿化学蚀刻机理的研究报告2022-01-25 2980
-
关于氮化铝单晶的湿法化学蚀刻的研究报告2022-01-18 1433
-
关于氮化镓的晶体学湿式化学蚀刻的研究2022-01-17 2199
-
温度对KOH溶液中多晶硅电化学纹理化的影响2022-01-13 1448
-
低浓度KOH中的各向异性蚀刻2021-12-28 2285
-
晶圆湿式用于硅蚀刻浴晶圆蚀刻2021-12-23 1116
-
《炬丰科技-半导体工艺》GaN、ZnO和SiC的湿法化学蚀刻2021-10-14 2219
-
《炬丰科技-半导体工艺》n-GaN的电化学和光刻2021-10-13 928
-
《炬丰科技-半导体工艺》GaN的晶体湿化学蚀刻2021-07-07 2485
-
湿蚀刻2021-01-08 13189
全部0条评论

快来发表一下你的评论吧 !

