

化学清洗过程中重金属污染的监测方法
今日头条
描述
摘要
本文通过绘制少数载流子扩散长度、体中铁浓度和表面污染(表面电荷和表面重组),介绍了表面光电电压(SPV)在监测化学清洗和化学品纯度方面的应用。新的SPV方法和精密仪器的非接触性、晶片级的特性使该技术特别适合于重金属监测。该方法用于监测BHF中的铜污染,通过测量其对表面重组的影响,并通过其对整体重组的影响,快速热退火步骤用于驱动在清洗过程中沉积在表面的铁。铁表面污染测量到1X109cm-2水平,而该方法的检测限为2x108cm-2。不同等级的H202中不同的铁污染水平(1~13ppb)很容易区分。该程序应允许人们在1ppt水平上监测H202中的铁污染。进口化学品的清洁度并不总是一个限制因素,而且通常与使用点(在清洁站)的化学品的清洁度无关。
实验
在我们的实验中,我们使用RTA来驱动重金属,尽管炉退火也可以使用。之所以选择RTA,是因为它与传统的炉膛退火相比具有速度优势,而且RTA中的背景污染水平通常非常低,因为RTA是一个冷链系统。测定表面剩余铁浓度的典型程序如图所示。图中显示了由最先进的清洗过程留下的表面铁污染的一个例子。用该方法测量到的最低铁污染为1x109cm-2 (2 x1010cm-3)。目前,我们还不确定铁的污染水平是否是由RTA引入的。不幸的是,没有其他方法具有足够的灵敏度来交叉关联我们的测量结果。假设RTA污染背景不是一个限制因素,而铁检测仅与SPV测量的灵敏度有关(4x109cm-3)有关,我们认为这种方表面的灵敏度为2x108cm-2(用于标准厚度的硅晶片)和2x107cm-2(用于2.5mm厚的超纯硅样品)。对其他重金属的这一限制尚未确定。
结果和讨论
某些沉积在硅表面的金属杂质,而不是被驱动到体中,可以表现为有效的表面重组中心或可能引入表面电荷。我们对重金属对表面电荷和表面重组的影响的研究才刚刚开始,我们的知识仍然相当有限。到目前为止,我们已经确定了p型10t2cm硅表面的铜对势垒高度(表面电荷)有相当有限的影响,但对表面重组有显著的影响。图1显示了铜对故意被铜污染的p型硅片表面电荷的影响。这些晶圆在污染前用SC-1、SC-2溶液清洗,铜从被铜盐污染的BHF中沉积下来,浓度在1ppb到1ppm之间。 随后用去离子水冲洗样品。用TXRF测定相应的铜浓度。除非铜表面浓度超过少数1014cm-2,否则其对表面电荷的影响不明显。铜对表面重组的影响更为明显。图2显示了暴露于100ppbCu污染BHF和未污染(铜浓度分别为1.5X1014和1X1011cm-2)的两个样品的SPV函数,这是在DI冲洗后测量的。
收集并测量了四组晶圆(n型和p型体积)。晶片处理和结果总结如下:
第1组:已接收的p型和n型批量控制晶片。没有热处理。
第2组:两种类型的晶片都经过预先清洁处理以去除通常在到来的控制晶片上发现的表面污染。清洗后,晶片被给予一个1150℃的RTA驱动器2min,以将表面污染扩散到本体中。
第3组:Wafers与第2组一样进行初始预清洗处理。然后将晶片浸入沸腾的“半”级(ICP/MS的13ppb)过氧化氢中浸泡30min。随后是与第2组相同的RTA驱动器。
第4组:这些晶片除高纯度处理(ICP/MS处理1ppb)外,具有与第3组有相同的处理顺序。1150℃RTA经过化学处理。

图1.p型(10Ω-cm)硅中的表面电荷(表面屏障)与铜表面浓度的函数。铜在表面用TXRF测量

图2.SPV图,I/AV与~1,测量了铜表面污染前后相同的晶圆。截距值决定了扩散长度L,它保持不变。由于高表面重组(估计为S=8X104cm/s),线路的斜率增加

图3.由最先进的清洁留下的铁表面浓度的一个例子
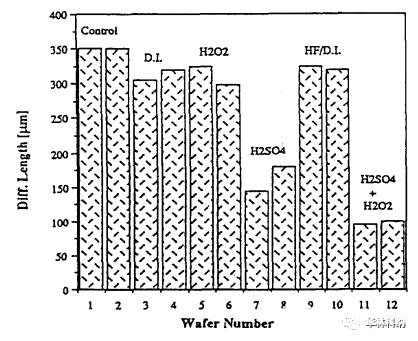
图4.暴露于单一化学物质清洗中的晶片中的扩散长度(图5)和氧化的。H2SO4被鉴定为重金属的来源。
结论
本文介绍了SPV通过绘制少数载流子扩散长度、体中铁浓度和表面污染(表面电荷和表面重组)在监测化学物质的化学清洁和纯度方面的应用。新的SPV方法的非接触性,晶片级的特点,和改进的仪器,使该技术特别适合于重金属监测。该方法用于监测BHF中的铜污染,通过测量其对表面重组的影响,通过对整体重组的影响对铁污染的影响表面在清洗过程中,进入整体。铁表面污染被测量到1X109cm-2水平,而该方法的检测限为2X108cm-2。制定了一种监测液体化学品中重金属污染水平的程序。不同等级的H202中不同的铁污染水平(1~13ppb)很容易区分。该程序应允许在1ppt水平上监测H202中的铁污染。进口化学品的清洁度并不总是一个限制因素,而且通常与使用点(在清洁站)的化学品的清洁度无关。设备本身通常会造成严重的限制。很明显,设备设计师可以受益更好地了解他们的设备性能限制。
与TXRF和AAS等传统方法相比,SPV方法非常新,但它已经证明了它在监测集成电路处理线中湿化学问题方面的有效性。与更传统的方法相比,SPV测量的主要优点是其测量速度;信息是在一个过程步骤完成几分钟后获得的。该方法还具有在图案产品晶片中进行非接触式测量的能力。
审核编辑:汤梓红
-
全国大学生数学建模竞赛A题 城市表层土壤重金属污染分析2011-09-09 8974
-
如何规避等离子清洗过程中造成的金属离子析出问题?2021-06-08 5294
-
土壤重金属快速测定仪是土壤重金属含量的检测方法之一2020-09-09 3343
-
关于土壤重金属检测仪的简单介绍2021-06-09 594
-
土壤重金属测试仪器的应用、参数及优势2021-06-18 712
-
土壤重金属检测方法有哪些2021-06-25 4692
-
食品重金属检测仪的功能特点2021-08-03 614
-
稻谷重金属镉检测仪/重金属分析仪的特点2021-09-30 840
-
粮食重金属快速检测仪的详细介绍2021-10-11 1501
-
土壤重金属检测仪的使用方法说明2021-11-09 1403
-
IC制造化学清洗过程中硅上重金属污染的电压监测2022-01-06 730
-
盘点国内目前常用的几种重金属检测方法2023-02-03 6468
-
XRF手持式土壤重金属检测仪(土壤普查重金属污染监测设备)2022-03-21 3256
-
地物光谱仪:矿山环境土壤重金属污染状况监测方法研究2024-07-08 1181
-
湿法清洗过程中如何防止污染物再沉积2025-08-05 1250
全部0条评论

快来发表一下你的评论吧 !

