

半导体制造CMP工艺后的清洗技术
今日头条
描述
引言
近年来,由于以移动性为中心的生活方式,将其处理的大数据作为云,物联网、机器人领域开始显示出活跃的面貌。这种新的技术创新也对半导体产业业务产生了巨大的影响,因此需要符合目的的产品。因此,作为电子介质的半导体芯片的结构也变得复杂,包括从微粉化一边倒到三维化,半导体制造工艺也变得多样化。其中使用的材料也被迫发生变化,用于制造的半导体器件和材料的技术革新还没有停止。为了解决作为半导体制造工艺之一的CMP技术需要更严格地管理半导体芯片中使用的材料的变化、平坦度和缺陷的问题,尽管用于嵌入和平坦化的基本工艺保持不变。在此,从CMP装置的基本变迁,特别阐述CMP清洗的基本技术。
各CMP的清洗目的和技术
将CMP设备和清洗设备集成在一起的Dry-in/Dry-out技术不仅有助于考虑下一工艺的晶圆,而且有助于考虑洁净室。此外,可以稳定地缩短从抛光到清洁装置的时间,并且增加了容易粘附的浆料的去除效果,从而改善了晶片表面的清洁度。本文描述了从基本作用到设备的发展,以考虑在第二代中对每个CMP要执行的清洁方法和设备中的机制。
药液和装置的基本
图1对抛光后晶圆的表面状态和后续清洗,用一个简单的图展示了比较复杂的Cu-CMP工艺。CMP后的表面状态是从浆料中的磨粒开始的刮擦行为产生的与其他工艺无法比较的各种异物如抛光碎屑、有机残渣等附着在其上(见图1左上图)。为了使该表面处于下一工序所需的表面状态,除了CMP的轮廓之外,还必须熟悉CMP中使用的浆料和耗材所改变的表面状态。在洗涤侧,需要掌握各个工序的表面状态,包括选择与该表面状态相对应的化学液体、化学液体的处理方法、与物理洗涤的组合方法、用纯水替换化学液体的方法、纯水冲洗方法和干燥方法。
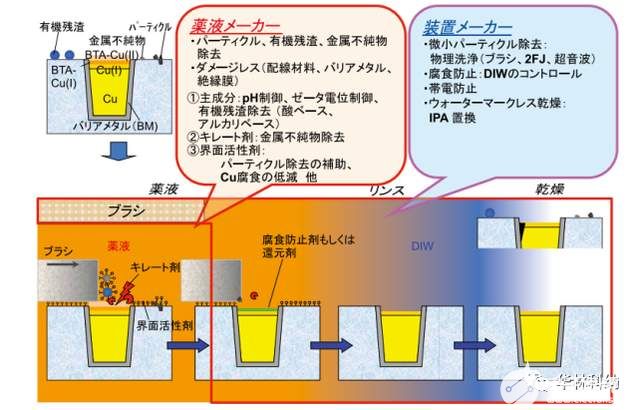
图1 CMP后的清洗流程和药液和装置的定位
粒子去除技术
使粘附在晶片表面上的颗粒漂浮,并使颗粒从该位置流到晶片的外部。为了使颗粒漂浮,通常通过用化学液体蚀刻晶片表面的微小部分的剥离动作和物理移动颗粒的物理动作的组合来执行。由于近年来半导体器件具有非常精细的结构,因此蚀刻受到限制,并且在许多情况下依赖于物理作用,并且化学液体起到辅助作用。关于药液的作用,将委托给专业的药液制造者,并描述在洗涤装置中使用的颗粒去除方法。
防止颗粒再粘附技术
虽然说清洗技术的目的是制造下一工序所要求的表面状态,但即使清洗装置的环境、使用的耗材、药液和纯水得到完全管理,也会发生缺陷。图2是清洗技术人员经常经历的晶圆表面状态。不仅是清洗工序的问题,还有可能是前一道工序造成的缺陷,需要充分把握前后一道工序。
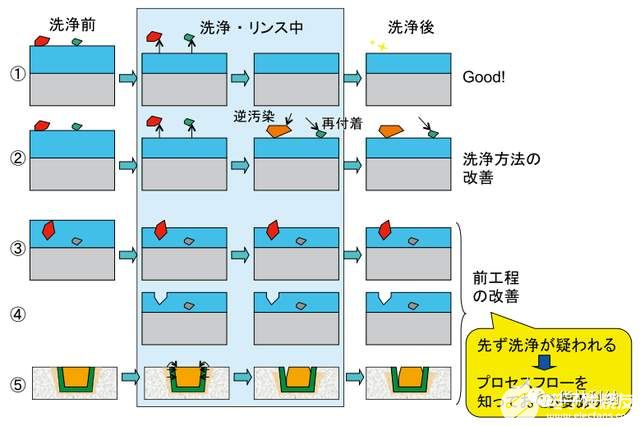
图5 清洗工程师经历的晶圆表面状况
在BEOL工艺中,由于进一步的微细化和阻挡金属材料的改变,以电偶腐蚀为中心的腐蚀对策变得重要。在FEOL工艺中,到目前为止使用的是对药液具有相对耐受性的材料,但近年来由于越来越微细化和结构复杂化,材料开始多样化,与BEOL工艺一样,面临着困难的应对。特别地,在装置侧,需要去除化学成分,并且需要干燥而不产生诸如水印的产物。例如,即使用漂洗剂稀释,也需要保持防止颗粒再粘附和防腐蚀作用的功能而不降低性能。在药液制造商中,主要是成分和添加剂的开发变得很重要,但能够最大限度地利用药液性能的环境始终在设备方面,今后在处理环境方面也需要合作。
总结
CMP后的清洁技术是用于清洁被污染的晶片的技术,这与其他清洁工艺相比是不可比拟的。今后从越来越微细化的器件结构出发,对清洗的要求必然会越来越严格。再次,浆料制造商,消耗构件制造商,化学品制造商和设备制造商之间的协作对于掌握每个过程中的表面状态是重要的。
审核编辑:汤梓红
-
最全最详尽的半导体制造技术资料,涵盖晶圆工艺到后端封测2025-04-15 1781
-
《半导体制造工艺》学习笔记2012-08-20 67956
-
半导体制造2012-07-11 5176
-
半导体制造技术经典教程(英文版)2014-03-06 26534
-
半导体制程2018-11-08 5547
-
半导体制造的难点汇总2020-09-02 4918
-
《炬丰科技-半导体工艺》DI-O3水在晶圆表面制备中的应用2021-07-06 2063
-
半导体清洗工艺全集2011-12-15 4574
-
Entegris 发布针对先进半导体制造的新型化学机械研磨后清洗解决方案2016-01-29 1375
-
MEMS工艺——半导体制造技术2021-04-08 4457
-
半导体制造过程中的新一代清洗技术2022-03-22 5611
-
半导体制造工序中CMP后的晶圆清洗工序2022-04-18 5989
-
半导体制造CMP工艺后的清洗技术2022-04-20 3541
-
探秘半导体制造中单片式清洗设备2022-08-15 6569
-
半导体制造工艺之光刻工艺详解2023-08-24 3355
全部0条评论

快来发表一下你的评论吧 !

