

 氧清洗硅晶片污染物的实验研究
氧清洗硅晶片污染物的实验研究
今日头条
描述
本研究的目的是为高效半导体器件的制造提出高效的晶圆清洗方法,主要特点是清洗过程是在室温和标准压力下进行的,没有特殊情况。尽管该方法与实际制造工艺相比,半导体公司的效率相对较低,但本研究可以提出在室温和标准压力下进行硅片干洗工艺的可能性。这意味着可以减少使用化学品,节省能源的加热基板和疏散清洁室,并为这些设施节省资金。
由于与其他半导体相比,线宽18㎛相对较宽,因此在实验中得到的蚀刻率相对较低。
在六氟化硫等离子体蚀刻晶片的SEM显微图中显示,当臭氧/紫外清洗时间为5min时,光刻胶没有被去除,图中有大量污染物颗粒和光刻胶碎片,臭氧/紫外清洗时间为5min,图4.16为臭氧/紫外清洗时间为20min时不去除光刻胶的晶片,在图4.16中也可以确认清洁的晶片表面,以500次放大倍数拍摄。
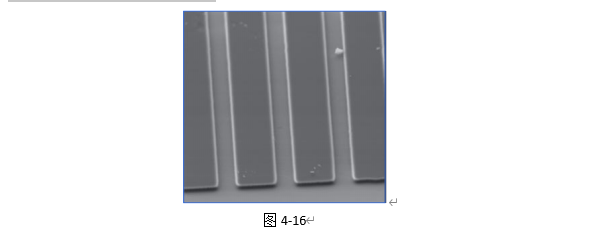

从每个实验和分析中可以得出以下结果:(1)在流量0.5ℓ/min和放电功率分别为22.9W、21.0W、21.0W、26.2W和每个真空0.1Torr、1个Torr和760Torr下,最大臭氧浓度分别为8840ppm、7770ppm和6595ppm;(2)在流速为1ℓ/min、1ℓ/min、0.5ℓ/min、放电功率为23.4W、21.3W、26.3W、26.2W,每个真空分别为0.1Torr、1Torr和760Torr时,最大臭氧发电量分别为593㎎/h、506㎎/h和388㎎/h;(3)臭氧浓度和臭氧生成量随放电功率的增加而逐渐增加,且与真空水平成正比。因此,在真空0.1Torr,流速0.5ℓ/mim时,最大臭氧浓度为8840ppm,在真空0.1Torr下,最大臭氧产生浓度为593㎎/h,流速1-186-ℓ/min时,最大臭氧产生功率为23.4W;(4)在流速1.1ℓ/min、1ℓ/min、0.5ℓ/min下获得32.59ℓ/㎾h,排放功率4.94W、7.30W、10.25g/㎾h和15.25g/㎾h。
审核编辑:汤梓红
-
电路板的大气污染物典型腐蚀分析及防护2019-10-25 1993
-
《炬丰科技-半导体工艺》硅工艺清洗2021-07-01 1163
-
讨论污染物对PCB点焊的影响以及有关清洁的一些问题2023-04-21 1306
-
多晶硅生产污染物回收处理流程图2009-11-20 1215
-
半导体IC制程中的各种污染物类型以及污染物的去除方法2020-12-29 13568
-
减少硅片金属污染的方法是什么2021-12-20 1974
-
硅片表面有机污染物的吸附行为2022-03-01 2232
-
湿法清洗系统对晶片表面颗粒污染的影响2022-03-02 1335
-
半导体工艺—晶片清洗工艺评估2022-03-04 3522
-
一种抛光硅片表面颗粒和有机污染物的清洗方法2022-05-18 2119
-
清洗晶圆基板的方法是什么2022-06-29 4574
-
硅晶片清洗方式的详细说明2022-07-08 5445
-
PCBA污染物分类与洁净度检测方法2025-01-10 1364
-
碳化硅外延晶片硅面贴膜后的清洗方法2025-02-07 317
-
如何检测晶振内部污染物2025-04-24 980
全部0条评论

快来发表一下你的评论吧 !

