

多通道晶圆缺陷检测方法
今日头条
描述
摘要
检测图案化半导体晶圆上的缺陷是晶圆生产中的关键步骤。为此目的已经开发了许多检查方法和设备。我们最近提出了一种基于几何流形学习技术的异常检测方法。这种方法是数据驱动的,通过使用扩散图将异常与图像固有几何结构引起的背景分离。在本文中,我们将算法扩展到多通道晶圆缺陷检测中的 3D 数据。我们在一组半导体晶片上测试了我们的算法,并证明了我们的多尺度多通道算法与单尺度和单通道方法相比具有卓越的性能。
简介
缺陷检测对于半导体晶圆的制造至关重要,但依赖手动检测既费时又昂贵,并且可能导致良率下降。对此问题的强大自动化解决方案至关重要,因为将仅向用户显示可疑区域,从而节省宝贵的时间。缺陷检测具有挑战性,因为可能的缺陷没有精确的特征,它们可能包括颗粒、开路、线间短路或其他问题。缺陷可能属于晶片背景或其图案,并且可能占主导地位或几乎不明显。这种多样性使得基于一些先验特征或检测训练数据库执行模板匹配变得非常困难,因此鼓励开发无监督的数据驱动方法。
各种各样的图像处理技术已应用于晶圆中的自动缺陷检测。晶圆缺陷检测的常用方法是利用无缺陷的参考图像,并对参考图像和检查图像之间的差异进行检测 。差异图像的计算对参考图像和检查图像之间的图像配准非常敏感,并且会影响基于参考的方法的性能。
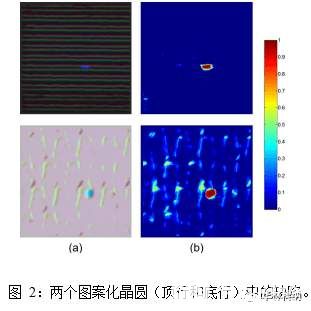
(a) 根据与扩散图的前三个坐标相关的 RGB 颜色着色的图像像素。(b) 多通道多尺度 (MCMS) 方法的异常分数。只有缺陷会获得高分。
结论
我们已将我们的多尺度异常检测算法扩展到多通道晶圆缺陷检测中的 3D 数据。所提出的算法在半导体晶片 SEM 图像数据集上进行了测试,与单尺度和单通道方法相比,表现出优越的性能。
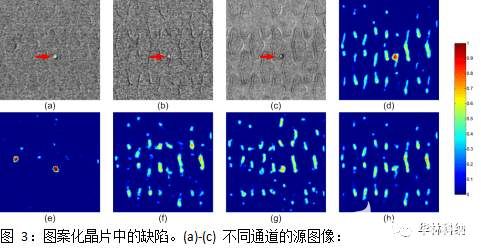
映射嵌入在此应用中特别有吸引力,因为扩散映射提供了晶片图像中重复几何结构的紧凑表示,无需参考图像,此外对这些图像中的主要噪声具有鲁棒性。该算法以前应用于水雷检测中的侧扫声纳图像。本文证明了所提出算法的鲁棒性及其对成像传感器、背景和噪声模型的鲁棒性。
审核编辑:汤梓红
-
请问谁有12英寸晶圆片的外观检测方案吗?2019-08-27 3109
-
改善薄晶圆制造中的检测挑战2019-03-12 1032
-
三维压电偏摆台在晶圆表面检测中的应用分析2020-09-07 1076
-
简仪科技解决方案助力实现晶圆缺陷的精准定位2024-08-13 1299
-
深入探索晶圆缺陷:科学分类与针对性解决方案2024-10-17 5096
-
晶圆表面污染及其检测方法2024-11-21 3692
-
有什么方法可以去除晶圆键合边缘缺陷?2024-12-04 584
-
晶圆隐裂检测提高半导体行业效率2025-05-23 1040
-
半导体晶圆检测与直线电机的关系2025-06-06 1090
-
探秘晶圆宏观缺陷:检测技术升级与根源追踪新突破2025-08-19 1663
-
Moritex 5X高精度大靶面远心镜头助力晶圆缺陷检测2025-10-17 607
全部0条评论

快来发表一下你的评论吧 !

