

 关于晶片背面的薄膜蚀刻法说明
关于晶片背面的薄膜蚀刻法说明
电子说
描述
随着半导体技术的发展,为了在有限的面积内形成很多器件,技术正在向多层结构发展,要想形成多层结构,将形成比现有的更多的薄膜层,这时晶片背面也会堆积膜。如果在背面有膜的情况下进行batch方式的润湿工序,背面的膜会脱落,污染晶片正面。特别是Cu如果受到全面污染,就会成为严重的问题。 目前,在枯叶式设备中,冷却晶片背面膜的方法是翻转,翻转晶片进行蚀刻工艺的话,蚀刻均匀度最好在1%以下,但是,如果一面进行工程,工程时间将增加一倍,为了减少工序时间,对在进行顶面工序的同时进行背面工序的方法进行了评价。
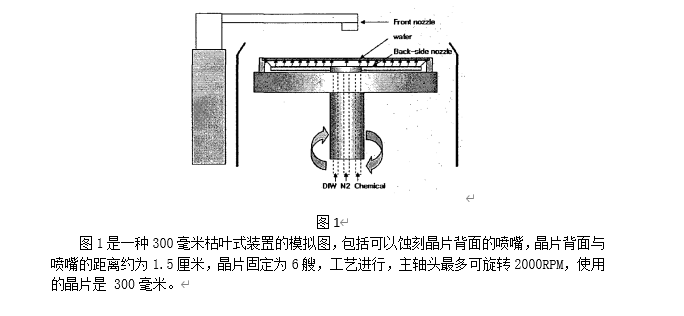
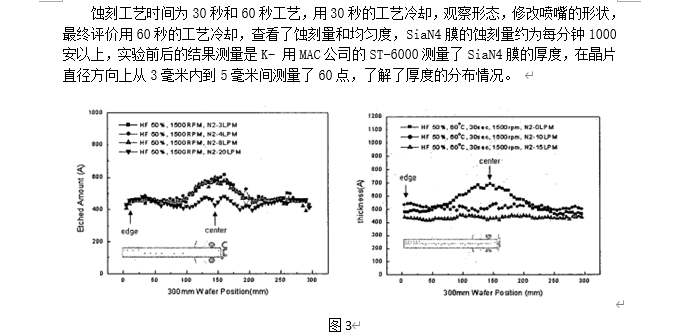
实验首先制作了双面蚀刻用喷嘴,调整药液喷射喷嘴的间距和氮气气体喷射量后进行图3,银喷嘴中间喷射的氮气体喷射量不同的SiaN4膜的蚀刻量和膜厚分布。图3(a)是有11个药液喷射孔的喷嘴,冷却30秒的结果。蚀刻结果表明,在没有药液喷射孔的位置上,蚀刻不良,根据氮气体量,中间部分的蚀刻量存在差异,氮气气体喷射量为20LPM时,食角量的偏差为85 a,平均食角量为443A,均匀度为9.6%。图3(b)是有13个药液喷射孔的诺兹罗,冷却30秒的结果,随着氮气体喷射量的变化,中间部分的食角量发生了变化,在食角量较小的部分添加了药液喷射孔,增加了中间部分的食角量,氮气体分射量为15LPM时,食死量偏差为42A,平均食死量为436A,均匀度为4.8%。
图4是通过改变喷嘴中喷射药液的孔的位置进行评价的结果。图4(a)的结果是蚀刻60秒后的结果,食角量的偏差约为199A,平均食角量约为1052A, 均匀度约为9.5%,喷嘴中央喷射了30LPM氮气,但口感不均匀。图4(b)的结果是,(a)的结果中,在食死量较小的位置添加一个药液喷射孔,从喷嘴中心喷射氮气体33LPM,从而提高食死量,平均识字量为1023A,体食角偏差为86A,均匀度为4.21%。喷嘴中药液喷射孔的位置与蚀刻均匀度密切相关,位置调节可提高均匀度。
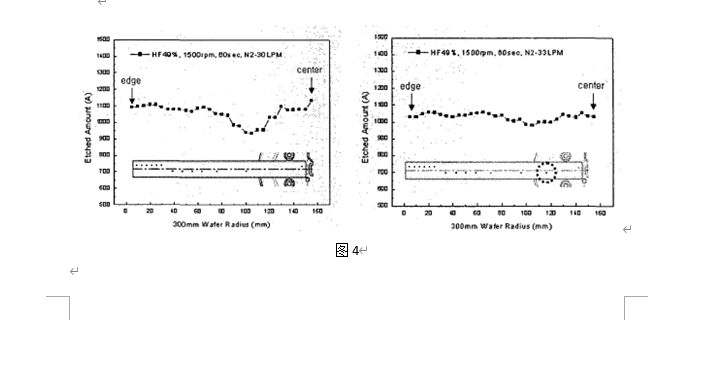
本研究确定药液的流量和流速是冷却晶片背面SiaN%膜的重要变量,另外,通过分析它们的相关性,达到了目标食角量1000A和均匀度5%,在枯叶式系统中,可以了解晶片背面的蚀刻结果和喷嘴设计中需要考虑的事项。首先,根据晶片的位置,离心力的大小不同,所以药液的喷射量必须不同。特别是300毫米晶片面积大,离心力的梯度很大。因此,不同位置与晶片接触的药液量和时间会有所不同,湿食方法根据与药液接触的时间,食角量会有所不同,所以要根据基板的面积和转速控制喷嘴喷射的药液量。第二,高温的药液比常温的药液反应性高,因此细微的茶叶中的食死量也出现了显着的差异。据认为,晶片中央喷射氮气体有两种效果:降低药液温度,减少食角量,以及将药液发送到边框,通过控制前面提到的各种变量,制作了能使晶片背面冷却的喷嘴,使SiaN的膜在60秒内冷却了1000A以上,得到了均匀度为4.21%的结果。
审核编辑:符乾江
-
使用单一晶圆加工工具蚀刻晶圆背面薄膜的方法2022-01-05 1663
-
KOH硅湿法蚀刻工艺设计研究2022-03-28 3212
-
蚀刻系统操作条件对晶片蚀刻速率和均匀性的影响2022-06-29 4582
-
晶片边缘蚀刻机及其蚀刻方法2018-03-16 3474
-
PCB制造方法的蚀刻法2018-09-21 4735
-
用蚀刻法对金属陶瓷薄膜进行电阻修整2022-02-25 893
-
使用酸性溶液对硅晶片进行异常各向异性蚀刻2022-03-09 1180
-
用蚀刻法测定硅晶片表面的金属杂质2022-03-21 800
-
单晶硅晶片的超声辅助化学蚀刻2022-04-12 803
-
硅晶片的蚀刻预处理方法包括哪些2022-04-13 1507
-
利用蚀刻法消除硅晶片表面金属杂质2022-04-24 1195
-
硅晶片的化学蚀刻工艺研究2022-04-28 1406
-
使用单晶片自旋处理器的背面清洁研究2022-05-06 1089
-
单晶片背面和斜面清洁(下篇)2022-06-27 1621
-
硅晶片的酸基蚀刻:传质和动力学效应2023-05-16 1803
全部0条评论

快来发表一下你的评论吧 !

