

一种用非金属掩模层蚀刻碳化硅的方法
今日头条
描述
摘要
一种用非金属掩模层蚀刻碳化硅的方法。该方法包括提供碳化硅基底;通过在基底上施加一层材料来形成非金属掩模层;形成掩模层以暴露基底的底层区域;并以第一速率用等离子体蚀刻基底的底层区域,同时以低于第一速率蚀刻掩模层。
介绍
本文涉及半导体处理方法,特别是涉及碳化硅半导体的处理技术。碳化硅)由于其较大的能带隙和高击穿场,是高温度、高功率电子器件的重要材料。碳化硅还具有优越的机械性能和化学惰性,适合制造微机电系统(MEMS)和纳米机电系统(NEMS)在恶劣环境中的应用;暴露在高温、强辐射、强烈振动、腐蚀性和研磨介质中的环境。因此,基于sic的MEMS在高温传感器和执行器和微机燃气涡轮机中得到了应用。此外,由于其高声速(定义为杨氏模量与质量密度E/p之比的平方根)和非常稳定的表面,碳化硅被认为是一种制造很有前途的超高频微机械硅的结构材料。
本文实施例是针对使用非金属掩模层用高选择性RIE工艺蚀刻碳化硅的方法。在某些实施例中,分别使用氢蚀刻化学和溴蚀刻化学形成。这允许使用非金属材料在蚀刻过程中掩盖碳化硅衬底。在一方面,蚀刻是在等离子体室中使用溴化氢(“HBr)蚀刻化学方法进行的。氢溴酸蚀刻化学已被用于蚀刻硅,但不是二氧化硅、氮化硅或碳化硅。那些精通该艺术的人的传统智慧将教导远离使用氢溴酸来蚀刻碳化硅。因为碳化硅是一种非常稳定的材料。此外,一般预计二氧化硅或氮化硅的蚀刻速度会比碳化硅更快。因此,氢溴酸通常不会被认为是一种有效的稳定材料的蚀刻剂。然而,本发明已经证明了在某些条件下,氢溴酸可以用于蚀刻碳化硅。
示例
图中是根据本发明的一个实施例的碳化硅蚀刻方法的一部分的流程图。2a-b是氢溴酸等离子体中聚sic、SiO和SiN的蚀刻率作为源功率和室压力的蚀刻图。3a-b是显示SiC/SiO和作为源功率的SiC/SiN的函数和图中的典型蚀刻速率比的图。腔室的压力是示例性碳化硅蚀刻轮廓的SEM图像,显示(a)使用高蚀刻速率比条件的实施例蚀刻的2毫米线;(b)(a)的(a)和(c)使用高蚀刻速率条件的实施例蚀刻的2um线的特写。图中是一种根据本发明实施例的使用碳化硅蚀刻方法制备的多晶碳化硅MEMS谐振器的扫描电镜图像。
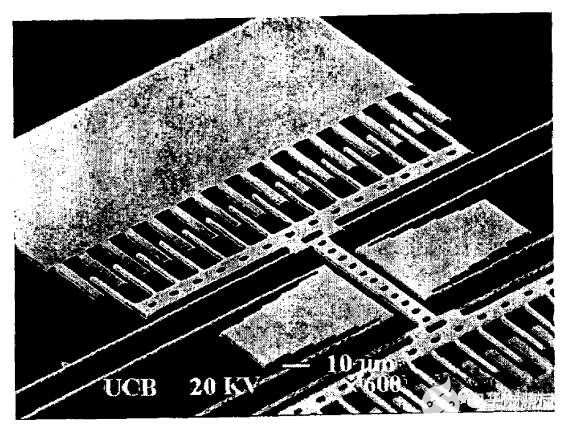
图1
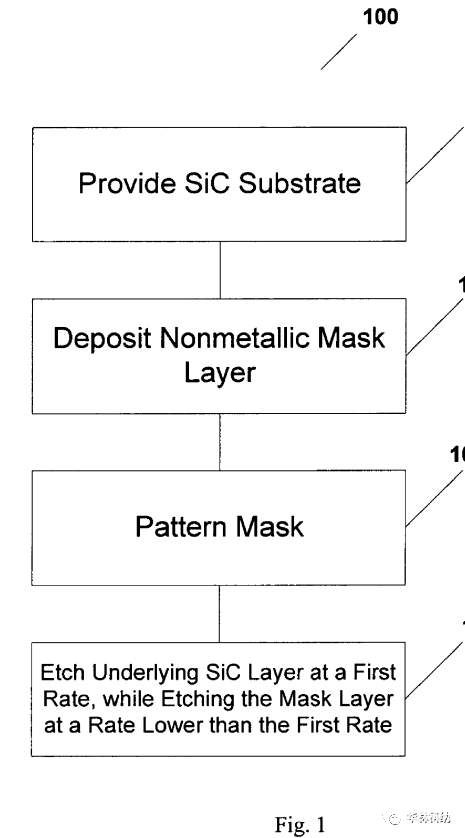
图2

图3

图4
审核编辑:汤梓红
-
碳化硅压敏电阻 - 氧化锌 MOV2024-03-08 8375
-
什么是MOSFET栅极氧化层?如何测试SiC碳化硅MOSFET的栅氧可靠性?2025-01-04 2583
-
碳化硅(SiC)肖特基二极管的特点2019-01-11 8276
-
碳化硅的历史与应用介绍2019-07-02 5034
-
碳化硅深层的特性2019-07-04 6073
-
碳化硅半导体器件有哪些?2020-06-28 4391
-
碳化硅基板——三代半导体的领军者2021-01-12 4418
-
什么是碳化硅(SiC)?它有哪些用途?2021-06-18 9390
-
碳化硅的应用2021-08-19 3973
-
《炬丰科技-半导体工艺》GaN、ZnO和SiC的湿法化学蚀刻2021-10-14 2194
-
请教碳化硅刻蚀工艺2022-08-31 41987
-
归纳碳化硅功率器件封装的关键技术2023-02-22 2936
-
浅谈硅IGBT与碳化硅MOSFET驱动的区别2023-02-27 2997
-
中科院物理研究所探索用一种新的方法生长碳化硅晶体2023-01-31 1035
-
碳化硅薄膜的选择性刻蚀2023-02-20 679
全部0条评论

快来发表一下你的评论吧 !

